PAM-XIAMEN は MOSFET デバイス用の SiC エピタキシャル ウェーハを供給できます。追加情報は以下をお読みください。https://www.powerwaywafer.com/sic-mosfet-structural.html。 SiC のエピタキシャルプロセスでは、必然的にさまざまな欠陥が発生し、SiC パワーデバイスの性能や信頼性に影響を与えます。 以下では、SiC MOSFET デバイスの性能に対する三角形欠陥の影響を具体的に調査します。
1. 三角形欠陥とは何ですか?
三角形欠陥は、SiC エピタキシャル層の表面まで基底面方向に沿って伸びる 3C-SiC ポリタイプ介在物です。 エピタキシャル成長プロセス中に、SiC エピタキシャル層の表面にパーティクルが落下することによって発生する可能性があります。 粒子はエピタキシャル層に埋め込まれ、成長プロセスを妨げ、その結果、粒子が三角形領域の頂点に位置する鋭い三角形の表面特徴を示す 3C-SiC ポリタイプ介在物が形成されます。 多くの研究では、多形介在物の原因が、表面の傷、微小管、成長プロセスなどの不適切なパラメータにあると考えられています。
ただし、成長メカニズムが異なるため、エピタキシャル層の表面にある多くの三角形欠陥の形態には大きな違いがあります。 大きく分けて以下の種類に分けられます。
1.1 上部に大きな粒子を持つ三角形欠陥
このタイプの三角形欠陥は、上部に大きな球形の粒子があり、成長過程での落下物によって引き起こされる可能性があります。 頂点の下方向に、表面が粗い小さな三角形の領域が観察されます。 これは、エピタキシャル プロセス中に 2 つの異なる 3C-SiC 層が三角形領域に連続して形成され、最初の層が界面で核生成し、4H-SiC ステップ フローによって成長したためです。 エピタキシャル層の厚さが増加すると、3C ポリタイプの 2 番目の層が核生成し、より小さな三角形のピット内で成長しますが、4H 成長ステップでは 3C ポリタイプ領域が完全にカバーされず、3C-SiC の V 字型の溝領域が依然として明確になります。図 1 のように表示されます。

図1 上部に大きな粒子を有する三角形欠陥の表面形態
1.2 上部の小さな粒子と表面の粗い三角形の欠陥
図 2 に示すように、このタイプの三角形欠陥の頂点の粒子ははるかに小さいです。そして、三角形領域のほとんどは 4H-SiC のステップ フローで覆われています。つまり、3C-SiC 層全体が完全に覆われています。 4H-SiC層の下に埋め込まれています。 三角形の欠陥表面には 4H SiC の成長ステップしか見えませんが、これらのステップは従来の 4H 結晶成長ステップよりもはるかに大きくなっています。
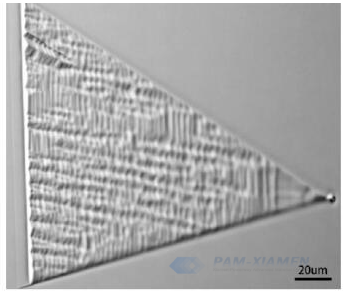
図2 上部の小さな粒子と表面の粗い三角形の欠陥の図
1.3 表面の滑らかな三角形の欠陥
このタイプの三角形欠陥は、図3に示すように、滑らかな表面形態を持っています。このような三角形欠陥では、3C-SiC層が4H-SiCのステップフローで覆われ、表面の4H結晶成長がより細かく滑らかになります。
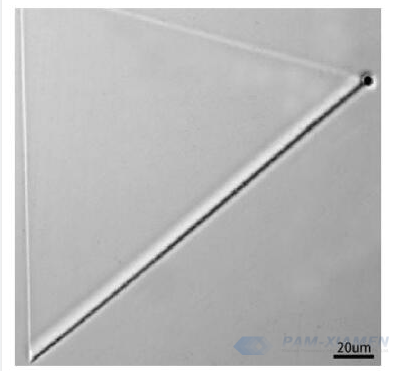
図3 表面上の滑らかな三角形欠陥の表面形態
2. SiC MOSFET デバイスの特性に対する三角形欠陥の影響
研究者らは、SiC MOSFET の性能に対する三角形欠陥の影響を研究しており、その結果を図 4 に示します。これは、三角形欠陥のあるデバイスの 5 つの特性の統計的分布のヒストグラムを示しています。 青い破線はデバイスの劣化の分割線を表し、赤い破線はデバイスの故障の分割線を表します。 表 1 に示すデバイスの故障では、三角形の欠陥が重大な影響を及ぼし、故障率は 93% を超えています。 これは主に、デバイスの逆漏れ特性に対する三角形欠陥の影響に起因しており、最大 93% の三角欠陥を含むデバイスでは逆漏れが大幅に増加しています。 さらに、ゲートリーク特性に対する三角欠陥の影響も非常に深刻で、劣化率は60%に達します。 表1に示すように、閾値電圧とボディダイオード特性の劣化については、三角欠陥の影響は比較的小さく、劣化率はそれぞれ26%、33%となっています。 導通抵抗の増加に関しては、三角欠陥の影響は比較的弱く、劣化率は33%程度です。
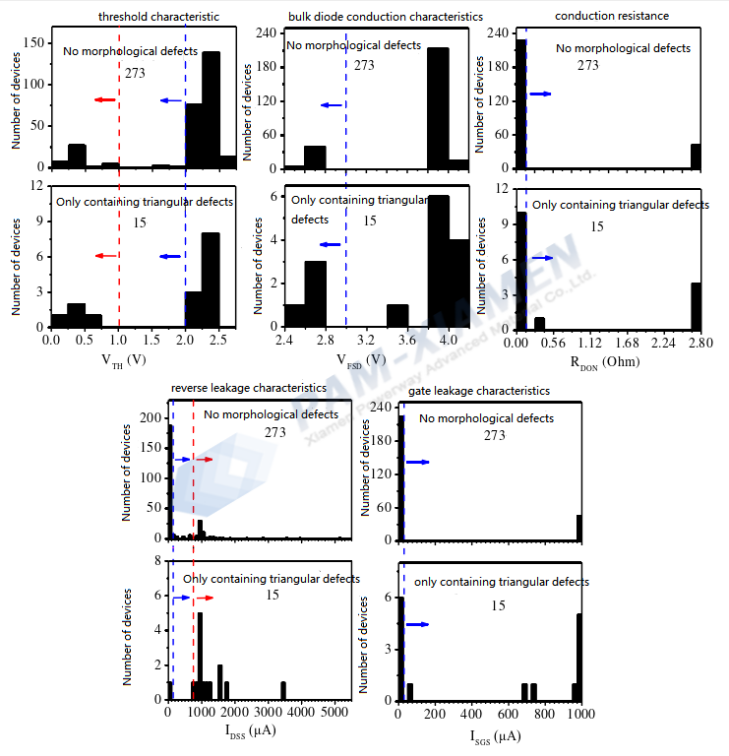
図4 三角欠陥を有するSiC MOSFETの各種特性分布のヒストグラム
| 表1 三角欠陥とSiC MOSFETデバイス特性の相関関係の統計表 | |||||
| デバイス特性 | VTH劣化速度 | VFSD劣化速度 | Rドン劣化速度 | IDSS劣化速度 | ISGS劣化速度 |
| 三角欠陥 | 26% | 33% | 33% | 93% | 60% |
全体として、この研究は、三角形の欠陥が SiC MOSFET デバイスの故障と特性劣化に重大な影響を与えることを示しました。 三角形の欠陥の存在は最も致命的であり、故障率は最大 93% に達し、主にデバイスの逆リークの大幅な増加として現れます。
詳細については、メールでお問い合わせください。victorchan@powerwaywafer.com と powerwaymaterial@gmail.com.

