PAM-XIAMEN peut fournir des plaquettes épitaxiales SiC pour les dispositifs MOSFET. Pour plus d'informations, veuillez lire :https://www.powerwaywafer.com/sic-mosfet-structure.html. Le processus épitaxial du SiC forme inévitablement divers défauts qui affectent les performances et la fiabilité des dispositifs de puissance SiC. Ci-dessous, nous explorons spécifiquement l'impact des défauts triangulaires sur les performances des dispositifs SiC MOSFET.
1. Que sont les défauts triangulaires ?
Le défaut triangulaire est une inclusion polytype 3C-SiC qui s'étend le long de la direction du plan basal jusqu'à la surface de la couche épitaxiale de SiC. Il peut être généré par la chute de particules à la surface de la couche épitaxiale de SiC lors du processus de croissance épitaxiale. Les particules sont incorporées dans la couche épitaxiale et interfèrent avec le processus de croissance, ce qui entraîne des inclusions de polytype 3C-SiC qui présentent des caractéristiques de surface triangulaires nettes, les particules étant situées aux sommets de la région triangulaire. De nombreuses études attribuent également l'origine des inclusions polymorphes à des paramètres inappropriés tels que les rayures de surface, les microtubules et les processus de croissance.
Cependant, en raison de différents mécanismes de croissance, il existe des différences significatives dans la morphologie de nombreux défauts triangulaires à la surface de la couche épitaxiale. Il peut être grossièrement divisé selon les types suivants :
1.1 Défaut triangulaire avec de grosses particules au sommet
Ce type de défaut triangulaire présente une particule sphérique de grande taille au sommet, qui peut être provoquée par la chute d'objets pendant le processus de croissance. Une petite zone triangulaire avec une surface rugueuse peut être observée dans la direction descendante du sommet. En effet, au cours du processus d'épitaxie, deux couches différentes de 3C-SiC se sont formées successivement dans la région triangulaire, la première couche nucléant à l'interface et se développant par étapes de flux de 4H-SiC. À mesure que l'épaisseur de la couche épitaxiale augmente, la deuxième couche du polytype 3C se nuclée et se développe dans des creux triangulaires plus petits, mais l'étape de croissance 4H ne couvre pas entièrement la zone du polytype 3C, ce qui rend la zone de rainure en forme de V du 3C-SiC encore clairement visible, comme sur la figure 1.

Fig. 1 Morphologie de surface des défauts triangulaires avec de grosses particules au sommet
1.2 Petites particules au sommet et défauts triangulaires rugueux à la surface
Les particules aux sommets de ce type de défaut triangulaire sont beaucoup plus petites, comme le montre la figure 2. Et la plupart des régions triangulaires sont couvertes par le flux échelonné de 4H-SiC, c'est-à-dire que la totalité de la couche de 3C-SiC est complètement intégré sous la couche 4H-SiC. La surface du défaut triangulaire ne peut voir que les étapes de croissance du SiC 4H, mais ces étapes sont beaucoup plus grandes que les étapes de croissance cristalline 4H conventionnelles.
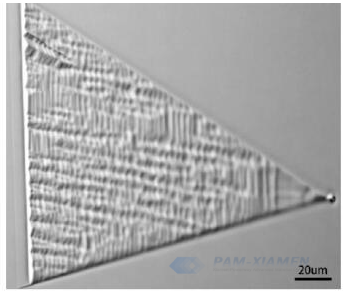
Fig. 2 Diagramme de petites particules en haut et de défauts triangulaires rugueux en surface
1.3 Défauts triangulaires lisses sur la surface
Ce type de défaut triangulaire a une morphologie de surface lisse, comme le montre la figure 3. Pour de tels défauts triangulaires, la couche de 3C-SiC est recouverte d'un écoulement échelonné de 4H-SiC et la croissance cristalline de 4H en surface est plus fine et plus lisse.
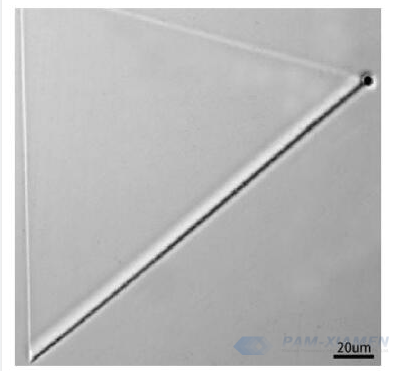
Fig. 3 Morphologie de surface des défauts triangulaires lisses sur la surface
2. Influences des défauts triangulaires sur les caractéristiques des dispositifs SiC MOSFET
Les chercheurs ont étudié l'influence des défauts triangulaires sur les performances du MOSFET SiC et les résultats sont présentés sur la figure 4, qui montre un histogramme de la distribution statistique de cinq caractéristiques de dispositifs présentant des défauts triangulaires. La ligne pointillée bleue représente la ligne de segmentation de la dégradation du périphérique et la ligne pointillée rouge représente la ligne de segmentation de la défaillance du périphérique. Pour les défaillances de dispositifs présentées dans le tableau 1, les défauts triangulaires ont un impact significatif, avec un taux de défaillance supérieur à 93 %. Ceci est principalement attribué à l'influence des défauts triangulaires sur les caractéristiques de fuite inverse des appareils, avec jusqu'à 93 % des appareils contenant des défauts triangulaires connaissant une augmentation significative des fuites inverses. De plus, l'influence des défauts triangulaires sur les caractéristiques de fuite de la grille est également très grave, avec un taux de dégradation de 60 %. Comme le montre le tableau 1, pour la dégradation des caractéristiques de tension de seuil et de diode corporelle, l'influence des défauts triangulaires est relativement faible, avec des taux de dégradation de 26 % et 33 %, respectivement. En termes d'augmentation de la résistance de conduction, l'influence des défauts triangulaires est relativement faible, avec un taux de dégradation d'environ 33 %.
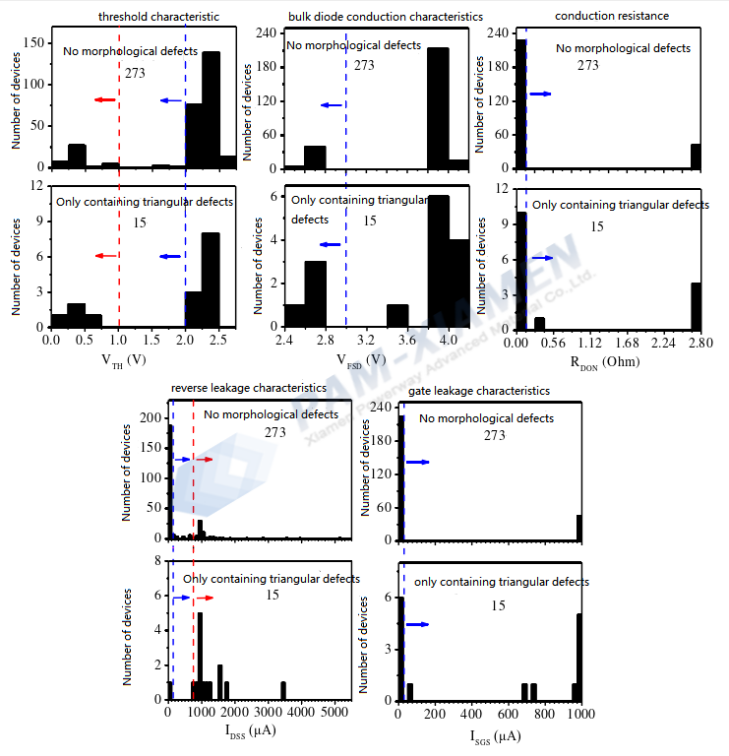
Fig. 4 Histogrammes de diverses distributions caractéristiques de MOSFET SiC avec défauts triangulaires
| Table 1 Statistical table of the correlation between triangle defects and SiC MOSFET device characteristics | |||||
| Device characteristic | VTH degradation rate | VFSD degradation rate | RDON degradation rate | IDSS degradation rate | ISGS degradation rate |
| Triangle defect | 26% | 33% | 33% | 93% | 60% |
Overall, the study showed that the triangle defects have a significant impact on the failure and characteristic degradation of SiC MOSFET devices. The existence of triangle defects is the most fatal, with a failure rate of up to 93%, mainly manifested as a significant increase in reverse leakage of the device.
Pour plus d'informations, veuillez nous contacter par email àvictorchan@powerwaywafer.cometpowerwaymaterial@gmail.com.

