Enkeltkrystal AlN-substrat kan leveres med specifikationer som findes ihttps://www.powerwaywafer.com/aln-substrate.html.
AlN-enkeltkrystal er det direkte båndgab-halvledermateriale med den største båndgab-bredde (6,2 eV), som har fremragende egenskaber såsom ekstrem høj nedbrydningsfeltstyrke, fremragende termisk ledningsevne, stabile fysiske og kemiske egenskaber. Desuden har AlN enkeltkrystal meget lille gitter og termisk uoverensstemmelse med GaN og AlGaN og betragtes som det bedste substrat for III-V epitaksiale materialer. Det har brede anvendelsesmuligheder inden for dybe ultraviolette detektorer, dybe ultraviolette lysdioder, dybe ultraviolette LD'er og højeffektfelter i mikrobølger.
I øjeblikket er den fysiske gastransport (PVT) metode den almindelige metode til fremstilling af AlN bulk-enkeltkrystaller. Den primære faktor, der begrænser udviklingen af PVT-baseret AlN-enkeltkrystalvækstteknologi, er erhvervelsen af AlN-frøkrystaller af høj kvalitet, såvel som korrelationen mellem vækstbetingelser og vækstmåder, når AlN-frøkrystaller vokser homogent.
Forskere har brugt PVT-metoden til at dyrke højkvalitets AlN-enkeltkrystaller på selvfremstillede AlN-frøkrystaller. Overflademorfologien af AlN-enkeltkrystaller under forskellige vækstmåder (tredimensionelle ø- og enkelthelix-vækstcentre) blev observeret. På basis af optimering af den termiske feltstruktur blev det fundet, at overfladetemperaturen af AlN-frøkrystaller spiller en vigtig rolle i krystalvækst, og vækstbetingelserne bestemmer direkte krystalvæksttilstanden. Det er værd at bemærke, at halvbredden (FWHM) af (002) og (102) diffraktionstoppene af AlN-enkeltkrystaller dyrket i enkelt helix-vækstcentertilstand er henholdsvis 65 og 36 buesekunder. Et AlN-bufferlag og en AlxGa1-xN-tynd film med høj Al-komponent blev sekventielt epitaksielt dyrket på et AlN-enkeltkrystalsubstrat af høj kvalitet ved anvendelse af MOCVD. Overfladen af AlN-bufferlaget udviser god overfladekrystallisationskvalitet. Al-komponenten af AlxGa1-xN epitaksial tynd film er 0,54, og halvbredden ved halv maksimum (FWHM) af (002) og (102) refleksioner af Al x Ga1-xN er henholdsvis 202 og 496 buesekunder. Ovenstående forskningsresultater indikerer, at sammenlignet med SiC- eller safirsubstrater udviser AlN-enkeltkrystalsubstrater overlegne fordele ved homogen epitaksial vækst af AlN- og AlGaN-film med høj Al-komponent.
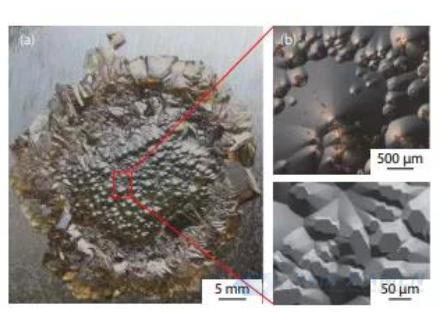
Fig. 1 Overflademorfologi af AlN-enkeltkrystal
Denne undersøgelse vil yderligere guide forberedelsen af højkvalitets AlN enkeltkrystaller og fremme udviklingen af AlGaN epitaksi og relaterede enheder.
For mere information, kontakt os venligst e-mail påvictorchan@powerwaywafer.com og powerwaymaterial@gmail.com.

