Kvaternære direkte båndgab-forbindelsesmaterialer, såsom InGaAsP og AlGaInAs, kan dyrkes på InP-substrat, som er gittermatch med InP. På nuværende tidspunkt inden for forskellige områder har forskere designet halvlederlasere, optiske forstærkere, detektorer osv., ved hjælp af disse to typer materialer vokser på InP-substrat. Til optiske forstærkere er højeffekt 1460nm halvlederlaser baseret på AlGaInAs / InP MQW en ideel pumpekilde. PAM-XIAMEN kan dyrke 1460nm AlGaInAs / InP pumpelaserdiode epitaksial wafertil optisk forstærkning. Den nøjagtige pumpelaser-epi-struktur henvises til nedenstående tabel:

1. 1460nm pumpe laserdiode epitaksi struktur
PAM230509 – 1460LD
| Lag nr. | Materiale | Tykkelse (nm) | dopingmiddel | Type |
| 6 | InP | – | – | – |
| 5 | Gain (x) Som | – | – | – |
| 4 | GaIn(x)As(y)P | – | – | – |
| 3 | InP | 2100 | – | – |
| 2 | AlGaInAs MQW + SCH
PL 1430~1460nm |
– | – | – |
| 1 | InP buffer | – | Silicon | N |
| InP substrat |
For kvantebrøndstrukturer med laserbølgelængder fra 1300 til 1700 nm, epitakserer vi normalt laserdiodewafer baseret på InP-substrat og bruger InGaAlAs-materiale som kvantebrønd. Ved at justere AlGaInAs-sammensætningen og vælge passende kvantebrøndtykkelse, kan vi frit designe diodepumpens laserbølgelængde over et stort område. Fra fig. 1 kan det ses, at den justerbare tilsvarende bølgelængde af AlGaInAs / InP materialesystem til Raman pumpelaser kan være fra 1,3 μm til 1,5 μm.
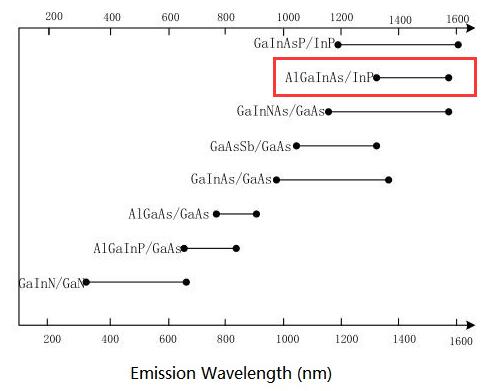
Fig. 1 Bølgelængdeområde svarende til AlGaInAs / InP-materiale
2. Udfordringer for AlGaInAs materialevækst på InP
Vanskeligheden ved epitaksial vækst af AlGaInAs omfatter hovedsageligt:
1) Al-komponenten oxideres let og danner dybe energiniveauer med O;
2) Ved Al (Ga) InAs / InP-grænsefladen er As- og P-interdiffusion tilbøjelig til at forekomme, hvilket påvirker kvaliteten af det epitaksiale lag. Ved at øge temperaturen og V/II-forholdet kan højkvalitets Al-holdige materialer opnås. Imidlertid er høje temperaturer skadelige for væksten af In-holdige materialer. Ved høje temperaturer er forreaktionen af In og desorptionen af vækstoverfladen mere alvorlig, hvilket let fører til dannelsen af In-dråbefordeling på overfladen, hvilket påvirker materialets luminescerende effektivitet. Desuden, jo højere væksttemperaturen er, desto alvorligere er As- og P-interdiffusionsproblemet ved grænsefladen mellem AlGaInAs og InP, hvilket påvirker ensartetheden og fladheden af grænsefladen. Derfor er væksttemperaturområdet for AIGalnAs-materialer af høj kvalitet meget begrænset og kræver præcis kontrol.
3. Optimering af energibåndstrukturen af AlGalnAs / InP Quantum Well Laser
For yderligere at forbedre temperaturegenskaberne for pumpelaserfiberforstærkeranordninger og forbedre den begrænsende evne af bærere på begge sider af laserens aktive område, er energibåndstrukturen af AIGalnAs / InP strain quantum well lasere blevet optimeret i de seneste år . For at opsummere kort:
1) Elektronbarrierelaget (ESL) indføres i det graderede indeksbølgelederlag eller det begrænsende lag for at forhindre elektroner i at lække ind i det begrænsende lag. Den karakteristiske temperatur og hældningseffektivitet af pumpelaserdiode kan forbedres ved at tilføje p-AllnAs elektronbarrierelag mellem MQW og p-SCH lag;
2) Introducer InP på N-siden af det aktive område for at forbedre indeslutningsevnen af huller på N-siden;
3) Introduktion af AllInAs/AlGalnAs multiple quantum barriers (MQB'er) i indeslutningslaget for at forbedre ladningsbærernes indeslutningsevne.
For mere information, kontakt os venligst e-mail påvictorchan@powerwaywafer.com og powerwaymaterial@gmail.com.

