Quaternary direct bandgap compound materials, such as InGaAsP and AlGaInAs, can be grown on InP substrate, which are lattice match with InP. At present, in various fields, researchers have designed semiconductor lasers, optical amplifiers, detectors, etc., using these two types of materials grow on InP substrate. For optical amplifiers, high power 1460nm semiconductor laser based on AlGaInAs / InP MQW is an ideal pump source. PAM-XIAMEN can grow 1460nm AlGaInAs / InP pump laser diode epitaxial wafer for optical amplification. The exact pump laser epi structure please refer to the table below:

1. 1460nm Pump Laser Diode Epitaxy Structure
PAM230509 – 1460LD
| Layer No. | Material | Thickness(nm) | dopante | Type |
| 6 | InP | – | – | – |
| 5 | GaIn(x)As | – | – | – |
| 4 | GaIn(x)As(y)P | – | – | – |
| 3 | InP | 2100 | – | – |
| 2 | AlGaInAs MQW + SCH
PL 1430~1460nm |
– | – | – |
| 1 | InP buffer | – | Silicon | N |
| InP substrate |
Para estruturas de poços quânticos com comprimentos de onda de laser variando de 1300 a 1700 nm, geralmente bombeamos wafer de diodo laser com bomba epitaxia com base no substrato InP e usamos material InGaAlAs como poço quântico. Ajustando a composição do AlGaInAs e selecionando a espessura apropriada do poço quântico, podemos projetar livremente o comprimento de onda do laser da bomba de diodo em uma ampla faixa. 1, pode-se observar que o comprimento de onda correspondente ajustável do sistema de material AlGaInAs / InP para o laser de bomba Raman pode ser de 1,3 μm a 1,5 μm.
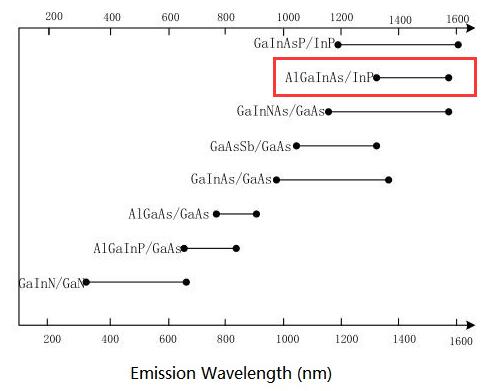
Fig. 1 Faixa de comprimento de onda correspondente ao material AlGaInAs / InP
2. Desafios para o crescimento do material AlGaInAs no InP
A dificuldade de crescimento epitaxial de AlGaInAs inclui principalmente:
1) O componente Al é facilmente oxidado e forma níveis de energia profundos com O;
2) Na interface Al (Ga) InAs / InP, a interdifusão As e P é propensa a ocorrer, afetando a qualidade da camada epitaxial. Ao aumentar a temperatura e a relação V/II, podem ser obtidos materiais contendo Al de alta qualidade. No entanto, as altas temperaturas são prejudiciais ao crescimento de materiais contendo In. Em altas temperaturas, a pré-reação do In e a dessorção da superfície de crescimento são mais severas, o que facilmente leva à formação de distribuição de gotículas de In na superfície, afetando a eficiência luminescente do material. Além disso, quanto maior a temperatura de crescimento, mais grave é o problema de interdifusão de As e P na interface entre AlGaInAs e InP, o que afeta a uniformidade e planicidade da interface. Portanto, a faixa de temperatura de crescimento de materiais AIGalnAs de alta qualidade é muito limitada e requer controle preciso.
3. Otimizando a estrutura da banda de energia do laser de poço quântico AlGalnAs / InP
A fim de melhorar ainda mais as características de temperatura dos dispositivos amplificadores de fibra de laser de bomba e aumentar a capacidade limitante dos portadores em ambos os lados da região ativa do laser, a estrutura da banda de energia dos lasers de poço quântico de deformação AIGalnAs / InP foi otimizada nos últimos anos . Para resumir brevemente:
1) A camada de barreira eletrônica (ESL) é introduzida na camada de guia de ondas de índice graduado ou na camada limitante para evitar que os elétrons vazem para a camada limitante. A temperatura característica e a eficiência de inclinação do diodo laser da bomba podem ser melhoradas adicionando uma camada de barreira eletrônica p-AllnAs entre as camadas MQW e p-SCH;
2) Introduzir InP no lado N da região ativa para melhorar a capacidade de confinamento dos buracos no lado N;
3) Introdução de múltiplas barreiras quânticas AllInAs/AlGalnAs (MQBs) na camada de confinamento para aumentar a capacidade de confinamento dos portadores de carga.
Para mais informações, por favor contacte-nos e-mail emvictorchan@powerwaywafer.com e powerwaymaterial@gmail.com.

