GaAs baseret AlGaInPlaser diode wafer can be supplied by PAM-XIAMEN with a band of 635nm. The III-V AlGaInP semiconductor material that can be lattice matched with the GaAs substrate has a wide direct band gap (1.9~2.3eV), a wide range of luminous wavelengths and high luminous efficiency. AlGaInP is the best material for preparing high-brightness red, orange, and yellow lasers and light-emitting diodes (LEDs). Following is a 635nm visible diode laser epi structure of GaInP / AlGaInP for reference:
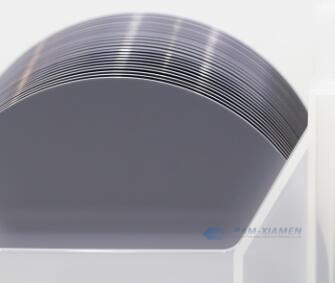
1. Epi-struktur af AlGaInP Laser Diode på GaAs Substrat
PAM210709-635LD
| Lag | Materiale | Molbrøk (x) | Molbrøk (y) | Belastning (%) | PL (nm) | Lagtykkelse (um) | Doping (E+18/cm3) | Type | dopingmiddel |
| 12 | GaAs | 0.2 | >100 | P++ | C | ||||
| 11 | Gevinst(x)P | 0.49 | – | – | p | Mg | |||
| 10 | (AlyGevinst(x)P | 0.485 | – | p | Mg | ||||
| 9 | AlIn(x)P | 0.485 | – | p | Mg | ||||
| 8 | AlIn(x)P | 0.485 | 0.3 | p | Mg | ||||
| 7 | (AlyGevinst(x)P | 0.485 | UD | ||||||
| 6 | Gevinst(x)P | xx | 627 | UD | |||||
| 5 | (AlyGevinst(x)P | 0.485 | UD | ||||||
| 4 | AlIn(x)P | 0.485 | – | n | Si | ||||
| 3 | AlIn(x)P | 0.485 | – | n | Si | ||||
| 2 | Gevinst(x)P | 0.49 | – | n | Si | ||||
| 1 | GaAs | 0.5 | – | n | Si |
2. Hvorfor dyrke GaInP / AlGaInP LD-struktur på GaAs-substrat uden for vinkel?
Materialerne i GaInP / AlGaInP kvantebrøndlasere med trykbelastningsindeslutning opnås ved MOCVD engangs-epitaksial vækst. Brugen af trykspænding i det aktive område kan reducere tærskelstrømmen og driftsstrømmen og samtidig forbedre effektiviteten. Da GaInP- og AlGaInP-materialer nemt kan danne metastabile ordnede strukturer under MOCVD-epitaksiprocessen, hvilket bør undgås så meget som muligt i lasere, og uordnede strukturer har smallere forstærkningsspektrallinjebredder. For at undgå dannelsen af ordnet struktur i MOCVD-væksten af GalnP / AlGaInP-materialer, bruger AlGaInP kvantebrøndlasere generelt GaAs-substrater, der ikke er vinklet. Ydermere kan off-angle substratet øge p-type dopingkoncentrationen i indeslutningslaget og derved øge den effektive barriere af elektroner i det aktive område, reducere lækagen af bærere og hjælpe med at forbedre enhedens højtemperaturydelse.
3. Hvorfor dyrke MQW'er af AlGaInP i stedet for DH?
Sammenlignet med DH (dobbelt heterojunction) kan MQW (multiple quantum well) strukturen af AlGalnP generere højere bærertæthed og derved øge den radioaktive rekombinationseffektivitet; effektivt forkorte længden af det lysemitterende område og derved reducere materialets selvabsorption af fotoner. GaInP / AlGaInP MQW producerer en kvantestørrelseseffekt, undgår forurening af AlGaInP-materialer med høj Al-sammensætning med oxygen og reducerer effektivt emissionsbølgelængden under lav Al-sammensætning. Derfor dyrkes AlGaInP laserdiodearrayet med multiple kvantebrøndstrukturer i stedet for AlGaInP laserdiodeforbindelse, der er meget udbredt i optoelektroniske enheder, såsom LD og LED osv.
4. Om dopant af AlInP lag i AlGaInP LD epitaksial struktur
For at løse problemerne med bærerlækage anvendes AlInP med det største bånd som beklædningslag. På grund af det lave brydningsindeks kan det stærkt begrænse lysledningsbølger. Og AlInP-lagene skal i høj grad dope sig med p-type eller n-type, for at opnå den elektriske ledningsevne så høj som muligt. Det er bevist, at på grund af den lavere diffusivitet og bedre kontrollerbarhed er Mg mere egnet til at blive brugt som p-type dopingmiddel for AlInP end Zn. I mellemtiden har det vist sig, at tilføjelse af udopet Mg-barriere i Al(Ga) InP-beklædningslag kan forbedre emissionseffektiviteten af AlGaInP-laserdiode.
Med hensyn til n-type-dotering af AlInP-beklædningslag bruges Si normalt som n-type-dotering til AlInP epi-lag.
For mere information, kontakt os venligst e-mail på victorchan@powerwaywafer.com og powerwaymaterial@gmail.com.

