يمكن لـ PAM-XIAMEN توفير الركيزة البلورية المفردة AlN، يرجى الرجوع إلى المواصفات الإضافيةhttps://www.powerwaywafer.com/aln-substrate.html.
إن المنشطات الرئيسية المرشحة لـ AlN من النوع n هي الأكسجين (O) والسيليكون (Si)، بينما بالنسبة للنوع p AlN، فهي المغنيسيوم (Mg) والبريليوم (Be). حتى الآن، كان معدل نجاح المنشطات Mg و O منخفضًا جدًا. ومع ذلك، O هو شوائب تعويضية مهمة لكل من Mg و Be، حيث يميل كل من المنشطات و Al نفسه إلى امتصاص الأكسجين. لفهم منشطات AlN، من الضروري فهم أدوار الوظائف الشاغرة للنيتروجين (VN) والوظائف الشاغرة للألمنيوم (VAl) والمجمعات المرتبطة بها. إن الفهم الحالي لكيمياء العيوب والشوائب، فضلاً عن طرق المنشطات غير المتوازنة، سيُعتبر نهجاً واعداً للتغلب على القيود التكنولوجية الحالية.
1. دأونورDافتتاح آلن:Silicon
بالنسبة لـ AlN من النوع n، يعتبر السيليكون المتبرع النظري الأمثل للكاتيونات لأن نصف قطره الذري قريب جدًا من نصف قطر Al، كما هو مبين في الشكل 1 (Al هو 118 مساءً، Si هو 111 مساءً). على الرغم من أن السيليكون هو متبرع ضحل في GaN مع طاقة تنشيط ED تبلغ حوالي 17 ميجا فولت، في AlGaN، مع زيادة محتوى Al، فإن ED الخاص به يزيد من 24 ميجا فولت في Al0.85Ga0.15N إلى 211 ميجا فولت في Al0.96Ga0.04N. يتسبب السيليكون، كشوائب بديلة في AlN، في انكماش نظري بنسبة 6% في أقرب رابطة N قاعدية مجاورة. يشير هذا إلى انخفاض في موضع شبكة السيليكون، بالقرب من الروابط القاعدية الثلاثة، والتي يتم خلالها تمديد روابط المحور Si-N. عندما يلتقط السيليكون إلكترونًا ثانويًا ويخضع لإعادة ترتيب هندسي، يتم تشكيل مركز DX، والذي يتضمن انكماشًا بنسبة 2٪ لروابط Si-N في ثلاثة مواضع قاعدية وتمزق رابطة Si-N على المحور c، كما هو موضح في الشكل 1. مما يؤدي إلى الانتقال من الحالة الضحلة إلى الحالة العميقة. عندما تنكسر رابطة المحور c Si-N تحت الضغط، سيتم إنشاء حالة عميقة معوضة. على الرغم من وجود عيوب التعويض هذه، فقد أظهر تعاطي المنشطات من النوع n لـ AlN من خلال زرع الأيونات في المنطقة القريبة من السطح نتائج واعدة. ومع ذلك، في المنشطات من النوع n للأغشية الرقيقة MOCVD AlN غير المعوضة، فقط تركيز إلكترون قابل للتكرار يصل إلى 1015سم-3يتم عرض، والذي ينطبق فقط على مناطق مجال الانجراف العالي في الجهاز.

الشكل 1. المواضع والأحجام النسبية (بالنسبة) لـ (أ) مستقبلات Mg وBe في AlN، (ب) شوائب Si المعاد ترتيبها بواسطة الجهات المانحة Si وDX، و(ج) المواضع والأحجام النسبية لعيوب الأكسجين المستبدلة بالأكسجين و إعادة ترتيب DX (بالنسبة)
ولأن إحدى التقنيات تثبت جدوى المنشطات في حين لا تفعلها تكنولوجيا أخرى، فإن السيليكون في حد ذاته لا يمكن أن يكون هو المشكلة. تعتمد الفرضية القائلة بأن MBE غير المتوازن ودرجة الحرارة المنخفضة تساهم في تعاطي المنشطات من النوع n لـ AlN على النقطتين التاليتين:
1) عند استخدام درجة حرارة منخفضة، يتم تحقيق الحد الأدنى من التمدد الحراري، وبالتالي يكون الحد الأدنى الإضافي لاستطالة رابطة Si-N للمحور c أمرًا مرغوبًا فيه؛
2) التقليل إلى أدنى حد من ظروف إثراء المعادن لمجمعات Al vacancy Si، تظهر هذه المجمعات سلوكًا مشابهًا لمجمعات Al vacancy O، مما يؤدي إلى التعويض الذاتي عن منشطات المانحين عند مستويات تعاطي Si العالية.
من المفترض أن هذا التعويض الذاتي لـ Si يرجع إلى تليين الشبكة الناتجة عن VAl، مما يجعل من السهل كسر رابطة المحور c Si-N وبالتالي تشكيل مركز Si-DX معوض. على غرار O، نظرًا لحياد الشحنة، يجب أيضًا أخذ مجمع VAl-XSiAl في الاعتبار، حيث X عدد صحيح. لذلك ، فإن المطالبة بـ MBE غير المتوازن ودرجة الحرارة المنخفضة والمعدن المخصب يعد ذا قيمة كبيرة بالنسبة لتعاطي المنشطات من النوع n لـ AlN.
2. متقبلDافتتاح آلن:ملغ، كنو C
بالنسبة لـ AlN من النوع p، تعتبر المستقبلات، مثل الكربون المستبدل بالأنيون (C) والكاتيون المستبدل Be وMg، ممكنة. عند الاقتراب من حد التخفيف، تؤدي طاقات المستقبل المعزولة إلى اعتبار هذه المستقبلات بمثابة مستقبلات ذات مستوى عميق، مع طاقات تنشيط مستقبل ذات قيمة واحدة مُبلغ عنها نظريًا لـ Mg وBe تتراوح من 510 إلى 630 ميجا فولت ومن 220 إلى 340 ميجا فولت، على التوالي. إذا لم تكن هناك قدرة على تشكيل نطاقات شوائب لتقليل طاقات التنشيط الكبيرة هذه، فمن غير المتوقع وجود تركيز كبير في المسام.
ومع ذلك، كما هو موضح من خلال التداخل المداري لبور عند التركيزات العالية للمنشطات في GaN، فمن الممكن أن تنخفض طاقة التنشيط الفعالة للمغنيسيوم من حوالي 210 ميلي فولت إلى حوالي 50 ميلي فولت، مما يؤدي إلى تركيز مسام قدره 1 × 1020سم-3. وقد ثبت أيضًا أن هذا فعال بالنسبة لـ AlGaN بنسبة تصل إلى حوالي 60% من Al، وتم عرض الثنائيات النفقية.
وبصرف النظر عن تركيز المسام ما يقرب من 1010 سم-3، لم يتم استخدام Mg بنجاح لتعاطي المنشطات AlN. النتائج الحديثة لاستخدام Be للحصول على تركيز مسام في درجة حرارة الغرفة يبلغ حوالي 3×1018سم-3(تم الإبلاغ هنا بحوالي 4.4 × 1018سم-3) وتشير طاقة التنشيط الفعالة التي تبلغ حوالي 37 ميغا فولت إلى أنه يمكن تحقيق انخفاض في طاقة التنشيط.
الثوابت العازلة النسبية لنتريد الغاليوم (GaN)، ونيتريد الألومنيوم (AlN)، ونيتريد الإنديوم (InN) هي 8.9، 8.5، و15.3 على التوالي. الكتل الفعالة المبلغ عنها للثقوب الثقيلة هي 0.8 مو، 3.53 مو، و1.63 مو، على التوالي. وهذا يعني أن تركيزات Mott الحرجة التي تشكلها النطاقات المستقبلة لـ GaN وAlN وInN تبلغ تقريبًا 4×1019سم-3, 4×1021سم-3و 6.5×1019سم-3، على التوالى. يتوافق هذا التقريب المبسط بشكل جيد مع نتائج المنشطات لتجارب النفوق المشكل بالمعادن (MME) لـ GaN، حيث تكون تركيزات الثقب في حدود 1019سم-3يمكن تحقيقه بشكل روتيني. وبالمثل، تشير هذه التنبؤات إلى أن AlN وInN سيكونان أكثر صعوبة في الخضوع لتعاطي المنشطات من النوع p، حيث يتطلب كل منهما تركيزًا أعلى للمنشطات لتشكيل نطاقات شوائب.
بالنسبة لـ AlN، قد يكون من المستحيل في البداية تحقيق تركيز المنشطات العالي المطلوب لتشكيل نطاقات الشوائب، وهو ما يتعارض مع النتائج التجريبية الحالية. ومع ذلك، فمن الضروري النظر في بنية نطاق التكافؤ الفريد لـ AlN، حيث يكون النطاق المنفصل في الواقع أعلى من نطاق الثقب ونطاق الثقب الخفيف (انظر الشكل 2)، وله تباين عالي. نظرًا لنقص الإلكترونات المدارية d، فإن إشارة تقسيم طاقة المجال البلوري تكون معاكسة لإشارة GaN. يُظهر الشريط المنفصل انحناءًا أكبر ويقع على نطاق أوسع من نطاقات الفتحات الثقيلة والخفيفة من حيث الطاقة. يوضح الشكل 2 حساب نظرية الكثافة الوظيفية (DFT) مع الأخذ في الاعتبار هذا التأثير. الكتل الفعالة المحسوبة بواسطة نظرية الكثافة الوظيفية (DFT) هي 3.66 مو للمكون المتوازي و0.24 مو للمكون الرأسي، مما يؤدي إلى تركيزات موت الحرجة البالغة 4.3×1021سم-3و1.2×1018سم-3، على التوالى. يتم إعطاء الحدود العليا والدنيا لتركيز Mott الحرج للتأكيد على أنه عند النظر في تفرد بنية نطاق AlN، فمن الممكن التنبؤ بتكوين نطاقات شوائب في AlN، مما قد يؤدي إلى حركة ثقب أعلى من GaN، مما يجلب الأمل لأجهزة p-channel وAlN ثنائية القطب.
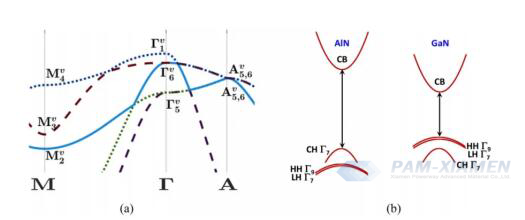
الشكل 2 (أ) تشتت الإلكترون الوظيفي للكثافة للمسار الخطي لنطاق التكافؤ AlN غير المجهد (خالي من الدوران) من wurtzite على طول نقاط التماثل M و Γ و A داخل منطقة Brillouin. في وسط المنطقة، حالات النطاق المنفصل ΓV1 هي انحطاط مفرد، في حين أن حالات الثقب الثقيل والخفيف ΓV 6 تتحلل بشكل مضاعف. ( ب ) تشتت الإلكترون النوعي للورزيتيت غير المجهد AlN و GaN على طول الاتجاه k⊥. على عكس GaN، فإن أعلى نطاق تكافؤ في AlN هو نطاق التفكك، والذي يُظهر كتلة فعالة أصغر. يؤدي إدخال التفاعل في مدار الدوران إلى تخفيف انحطاط نطاقات الفتحات الثقيلة والخفيفة في مركز المنطقة، مما يؤدي إلى ظهور حالة متدهورة واحدة ΓV؛ 17، ΓV9 و Γ V؛27.
لمزيد من المعلومات، يرجى الاتصال بنا على البريد الإلكترونيvictorchan@powerwaywafer.com و powerwaymaterial@gmail.com.

