PAM-XIAMEN puede suministrar sustrato monocristalino de AlN; especificaciones adicionales consultehttps://www.powerwaywafer.com/aln-substrate.html.
Los principales dopantes candidatos al AlN tipo n son el oxígeno (O) y el silicio (Si), mientras que para el AlN tipo p son el magnesio (Mg) y el berilio (Be). Hasta ahora, la tasa de éxito del dopaje con Mg y O ha sido muy baja. Sin embargo, el O es una impureza compensadora importante tanto para el Mg como para el Be, ya que tanto los dopantes como el propio Al tienden a absorber oxígeno. Para comprender el dopaje de AlN, es necesario comprender el papel de las vacantes de nitrógeno (VN) y las vacantes de aluminio (VAl) y sus complejos relacionados. La comprensión actual de la química de defectos e impurezas, así como de los métodos de dopaje sin equilibrio, se considerará un enfoque prometedor para superar las limitaciones tecnológicas actuales.
1. DonorDfuncionamiento de AlN:Silicon
Para el AlN de tipo n, el silicio es el donante de cationes teórico óptimo porque su radio atómico es muy cercano al del Al, como se muestra en la Fig. 1 (Al es 118 pm, Si es 111 pm). Aunque el silicio es un donante superficial en GaN con una energía de activación ED de aproximadamente 17 meV, en AlGaN, con un aumento en el contenido de Al, su ED aumenta de 24 meV en Al0.85Ga0.15N a 211 meV en Al0.96Ga0.04N. El silicio, como impureza sustituta en AlN, provoca una contracción teórica del 6% en el enlace N del plano basal vecino más cercano. Esto indica una disminución en la posición de la red de silicio, más cerca de los tres enlaces basales, durante la cual los enlaces del eje c Si-N se estiran. Cuando el silicio captura un electrón secundario y sufre un reordenamiento geométrico, se forma un centro DX, que incluye una contracción del 2% de los enlaces Si-N en tres posiciones basales y una ruptura del enlace Si-N en el eje c, como se muestra en la Fig. 1. lo que lleva a una transición de estados de nivel superficial a estados de nivel profundo. Cuando el enlace Si-N del eje c bajo tensión se rompe, se generará un estado profundo compensado. A pesar de la existencia de tales defectos de compensación, el dopaje de tipo n de AlN mediante la implantación de iones en la región cercana a la superficie ha mostrado resultados prometedores. Sin embargo, en el dopaje de tipo n de películas delgadas de MOCVD AlN no compensadas sólo se consigue una concentración de electrones reproducible de hasta 1015cm-3Se muestra, que solo es aplicable a regiones de campo de alta deriva en el dispositivo.

Fig. 1 Las posiciones y tamaños relativos (en proporción) de (a) aceptores de Mg y Be en AlN, (b) impurezas de Si reorganizadas por donantes de Si y DX, y (c) posiciones y tamaños relativos de defectos de oxígeno sustituidos por oxígeno y Reordenamientos DX (en proporción)
Dado que una tecnología demuestra la viabilidad del dopaje mientras que otra no, el silicio en sí no puede ser el problema. La hipótesis de que el MBE en desequilibrio y a baja temperatura contribuye al dopaje de tipo n de AlN se basa en los dos puntos siguientes:
1) cuando se utiliza baja temperatura, se logra la expansión térmica mínima, por lo que es deseable un alargamiento adicional mínimo del enlace Si-N en el eje c;
2) Al minimizar las condiciones de enriquecimiento de metales para los complejos de Al vacante Si, estos complejos exhiben un comportamiento similar a los complejos de Al vacante O, lo que lleva a la autocompensación del dopaje del donante en altos niveles de dopaje de Si.
Se especula que esta autocompensación de Si se debe al ablandamiento de la red causado por VAl, lo que facilita la ruptura del enlace Si-N del eje c y así formar un centro Si-DX compensado. Al igual que O, debido a la neutralidad de la carga, también se debe considerar el complejo VAL-XSiAl, donde X es un número entero. Por lo tanto, afirmar que MBE no está en equilibrio, está a baja temperatura y enriquecido con metal es muy valioso para el dopaje de tipo n de AlN.
2. AceptadorDfuncionamiento de AlN:magnesio,Ser, yC
Para el AlN de tipo p, se consideran factibles aceptores, como el carbono (C) sustituido con aniones y el Be y Mg sustituidos con cationes. Cuando se acerca al límite de dilución, las energías de aceptor aisladas dan como resultado que estos aceptores se consideren receptores de nivel profundo, con energías de activación de aceptor de valor único teóricamente informadas para Mg y Be que varían de 510 a 630 meV y de 220 a 340 meV, respectivamente. Si no hay capacidad para formar bandas de impurezas para reducir estas grandes energías de activación, no se espera una concentración significativa de los poros.
Sin embargo, como lo muestra el solapamiento de los orbitales de Bohr a altas concentraciones de dopaje en GaN, es posible que la energía de activación efectiva del Mg disminuya de aproximadamente 210 meV a aproximadamente 50 meV, lo que resulta en una concentración de poro de 1 x 1020cm-3. También se ha demostrado que esto es eficaz para AlGaN con hasta aproximadamente un 60% de Al, y se han demostrado diodos de túnel.
Aparte de una concentración de poros de aproximadamente 1010cm-3, Mg no se ha utilizado con éxito para dopar AlN. Los resultados recientes del uso de Be para obtener una concentración de poros a temperatura ambiente de aproximadamente 3 x 1018cm-3(reportado aquí como aproximadamente 4,4 x 1018cm-3) y una energía de activación efectiva de aproximadamente 37 meV indican que se puede lograr una reducción en la energía de activación.
Las constantes dieléctricas relativas del nitruro de galio (GaN), el nitruro de aluminio (AlN) y el nitruro de indio (InN) son 8,9, 8,5 y 15,3, respectivamente. Las masas efectivas informadas de agujeros pesados son 0,8 mo, 3,53 mo y 1,63 mo, respectivamente. Esto significa que las concentraciones críticas de Mott formadas por las bandas aceptoras de GaN, AlN e InN son aproximadamente 4×1019cm-3, 4×1021cm-3y 6,5×1019cm-3, respectivamente. Esta aproximación simplificada concuerda bien con los resultados de dopaje de los experimentos de epitaxia modulada por metal (MME) para GaN, donde las concentraciones de huecos en el rango de 1019cm-3se puede lograr de forma rutinaria. De manera similar, estas predicciones indican que será más difícil que AlN e InN se sometan a un dopaje degenerado de tipo p, ya que cada uno requerirá una mayor concentración de dopaje para formar bandas de impurezas.
En el caso del AlN, inicialmente puede considerarse imposible alcanzar la alta concentración de dopaje necesaria para formar bandas de impurezas, lo que va en contra de los resultados experimentales actuales. Sin embargo, es necesario considerar la estructura única de la banda de valencia del AlN, donde la banda dividida es en realidad más alta que la banda hueca y la banda hueca ligera (ver Fig. 2), y tiene una alta anisotropía. Debido a la falta de electrones en el orbital d, el signo de la energía de división del campo cristalino es opuesto al del GaN. La banda de separación presenta una mayor curvatura y se encuentra en una gama más amplia de bandas de agujeros pesados y ligeros en términos de energía. La figura 2 muestra el cálculo de la teoría funcional de la densidad (DFT) considerando este efecto. Las masas efectivas calculadas por la teoría funcional de la densidad (DFT) son 3,66 mo para el componente paralelo y 0,24 mo para el componente vertical, lo que da como resultado concentraciones críticas de Mott de 4,3 × 1021cm-3y 1,2×1018cm-3, respectivamente. Los límites superior e inferior de la concentración crítica de Mott se dan para enfatizar que, al considerar la singularidad de la estructura de bandas de AlN, es posible predecir la formación de bandas de impurezas en AlN, lo que puede conducir a una mayor movilidad de huecos que en GaN, lo que brinda esperanza. para dispositivos de canal p y AlN bipolar.
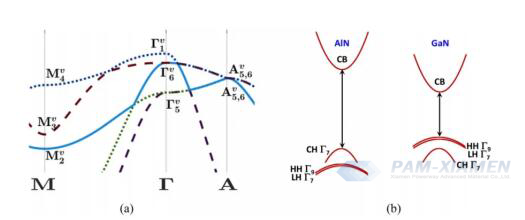
Fig. 2 (a) Dispersión electrónica funcional de densidad de la trayectoria lineal de la banda de valencia AlN no estresada (sin espín) de wurtzita a lo largo de los puntos de simetría M, Γ y A dentro de la zona de Brillouin. En el centro de la región, los estados de banda dividida ΓV1 son degeneración singlete, mientras que los estados de huecos pesados y ligeros ΓV 6 son doblemente degenerados. (b) Dispersión cualitativa de electrones de wurtzita AlN y GaN sin estrés a lo largo de la dirección k⊥. A diferencia del GaN, la banda de valencia más alta en el AlN es la banda de disociación, que exhibe una masa efectiva menor. La introducción de la interacción de la órbita de espín alivia la degeneración de las bandas de agujeros pesados y ligeros en el centro de la región, lo que resulta en la aparición de un único estado degenerado ΓV; 17, ΓV9 y ΓV;27.
Para obtener más información, por favor contáctenos por correo electrónico avictorchan@powerwaywafer.comypowerwaymaterial@gmail.com.

