PAM-XIAMEN peut fournir un substrat monocristallin AlN, spécifications supplémentaires, veuillez vous référer àhttps://www.powerwaywafer.com/aln-substrate.html.
Les principaux dopants candidats pour l'AlN de type n sont l'oxygène (O) et le silicium (Si), tandis que pour l'AlN de type p, ce sont le magnésium (Mg) et le béryllium (Be). Jusqu’à présent, le taux de réussite du dopage au Mg et à l’O a été très faible. Cependant, O est une impureté compensatrice importante pour Mg et Be, car les dopants et Al lui-même ont tendance à absorber l'oxygène. Pour comprendre le dopage de l’AlN, il est nécessaire de comprendre les rôles des lacunes d’azote (VN) et d’aluminium (VAl) et de leurs complexes associés. La compréhension actuelle de la chimie des défauts et des impuretés, ainsi que des méthodes de dopage hors équilibre, sera considérée comme une approche prometteuse pour surmonter les limitations technologiques actuelles.
1.DhonneurDfonctionnement de l'AlN :Silicone
Pour l'AlN de type n, le silicium est le donneur de cations théorique optimal car son rayon atomique est très proche de celui de Al, comme le montre la figure 1 (Al est de 118 pm, Si est de 111 pm). Bien que le silicium soit un donneur peu profond dans GaN avec une énergie d'activation ED d'environ 17 meV, dans AlGaN, avec une augmentation de la teneur en Al, son ED augmente de 24 meV dans Al0,85Ga0,15N à 211 meV dans Al0,96Ga0,04N. Le silicium, en tant qu'impureté de substitution dans l'AlN, provoque une contraction théorique de 6 % dans la liaison N du plan basal voisin le plus proche. Cela indique une diminution de la position du réseau de silicium, plus proche des trois liaisons basales, au cours de laquelle les liaisons Si-N de l'axe c sont étirées. Lorsque le silicium capture un électron secondaire et subit un réarrangement géométrique, un centre DX se forme, qui comprend une contraction de 2 % des liaisons Si-N en trois positions basales et une rupture de liaison Si-N sur l'axe C, comme le montre la figure 1, conduisant à une transition des états superficiels aux états profonds. Lorsque la liaison Si-N sur l'axe C se brise sous contrainte, un état profond compensé est généré. Malgré l’existence de tels défauts de compensation, le dopage de type n de l’AlN par implantation d’ions dans la région proche de la surface a donné des résultats prometteurs. Cependant, dans le dopage de type n de couches minces d'AlN MOCVD non compensées, seule une concentration électronique reproductible allant jusqu'à 1015cm-3s'affiche, ce qui s'applique uniquement aux régions de champ de dérive élevé dans l'appareil.

Fig. 1 Les positions et tailles relatives (en proportion) de (a) les accepteurs de Mg et Be dans AlN, (b) les impuretés de Si réarrangées par les donneurs de Si et DX, et (c) les positions et les tailles relatives des défauts d'oxygène substitués à l'oxygène et Réarrangements DX (en proportion)
Étant donné qu’une technologie démontre la faisabilité du dopage alors qu’une autre technologie ne le fait pas, le silicium lui-même ne peut pas être le problème. L'hypothèse selon laquelle le MBE hors équilibre et à basse température contribue au dopage de type n de l'AlN repose sur les deux points suivants :
1) lors de l'utilisation à basse température, la dilatation thermique minimale est obtenue, par conséquent l'allongement supplémentaire minimum de la liaison Si-N sur l'axe C est souhaitable ;
2) En minimisant les conditions d'enrichissement en métaux pour les complexes Si à lacune Al, ces complexes présentent un comportement similaire aux complexes O à lacune Al, conduisant à une auto-compensation du dopage du donneur à des niveaux de dopage Si élevés.
On suppose que cette auto-compensation du Si est due au ramollissement du réseau provoqué par VAl, ce qui facilite la rupture de la liaison Si-N sur l'axe c et forme ainsi un centre Si-DX compensé. Semblable à O, en raison de la neutralité de charge, le complexe VAl-XSiAl doit également être pris en compte, où X est un nombre entier. Par conséquent, revendiquer un MBE hors équilibre, à basse température et enrichi en métaux est très utile pour le dopage de type n de l’AlN.
2. AccepteurDfonctionnement de l'AlN :Mg,Être, etC
Pour l'AlN de type p, les accepteurs, tels que le carbone (C) à substitution anionique et Be et Mg à substitution cationique, sont considérés comme réalisables. À l'approche de la limite de dilution, les énergies des accepteurs isolés font que ces accepteurs sont considérés comme des récepteurs de niveau profond, avec des énergies d'activation d'accepteur à valeur unique théoriquement rapportées pour Mg et Be allant de 510 à 630 meV et de 220 à 340 meV, respectivement. S’il n’est pas possible de former des bandes d’impuretés pour réduire ces grandes énergies d’activation, une concentration significative dans les pores n’est pas attendue.
Cependant, comme le montre le chevauchement orbital de Bohr à des concentrations de dopage élevées dans GaN, il est possible que l'énergie d'activation effective du Mg diminue d'environ 210 meV à environ 50 meV, ce qui entraîne une concentration dans les pores de 1 x 10.20cm-3. Cela s'est également avéré efficace pour l'AlGaN avec jusqu'à environ 60 % d'Al, et des diodes tunnel ont été démontrées.
Outre une concentration poreuse d'environ 10dixcm-3, Mg n’a pas été utilisé avec succès pour doper l’AlN. Les résultats récents de l'utilisation de Be pour obtenir une concentration poreuse à température ambiante d'environ 3 x 1018cm-3(rapporté ici comme environ 4,4 x 1018cm-3) et une énergie d'activation effective d'environ 37 meV indiquent qu'une réduction de l'énergie d'activation peut être obtenue.
Les constantes diélectriques relatives du nitrure de gallium (GaN), du nitrure d'aluminium (AlN) et du nitrure d'indium (InN) sont respectivement de 8,9, 8,5 et 15,3. Les masses effectives déclarées des trous lourds sont respectivement de 0,8 Mo, 3,53 Mo et 1,63 Mo. Cela signifie que les concentrations critiques de Mott formées par les bandes acceptrices de GaN, AlN et InN sont d'environ 4 × 10.19cm-3, 4×1021cm-3, et 6,5×1019cm-3, respectivement. Cette approximation simplifiée est en bon accord avec les résultats de dopage des expériences d'épitaxie modulée par métal (MME) pour GaN, où les concentrations de trous sont de l'ordre de 1019cm-3peut être réalisé systématiquement. De même, ces prédictions indiquent qu’AlN et InN seront plus difficiles à subir un dopage dégénéré de type p, chacun nécessitant une concentration de dopage plus élevée pour former des bandes d’impuretés.
Pour l’AlN, il peut initialement être considéré comme impossible d’atteindre la concentration de dopage élevée requise pour former des bandes d’impuretés, ce qui est contraire aux résultats expérimentaux actuels. Cependant, il est nécessaire de prendre en compte la structure unique de la bande de valence de l'AlN, dans laquelle la bande séparée est en réalité supérieure à la bande de trous et à la bande de trous légers (voir Fig. 2) et présente une anisotropie élevée. En raison du manque d’électrons sur l’orbite d, le signe de l’énergie de division du champ cristallin est opposé à celui du GaN. La bande de séparation présente une plus grande courbure et est située sur une gamme plus large de bandes de trous lourds et légers en termes d'énergie. La figure 2 montre le calcul de la théorie fonctionnelle de la densité (DFT) prenant en compte cet effet. Les masses effectives calculées par la théorie fonctionnelle de la densité (DFT) sont de 3,66 Mo pour la composante parallèle et de 0,24 Mo pour la composante verticale, ce qui donne des concentrations critiques de Mott de 4,3 × 10.21cm-3et 1,2×1018cm-3, respectivement. Les limites supérieure et inférieure de la concentration critique de Mott sont données pour souligner que si l'on considère le caractère unique de la structure de la bande d'AlN, il est possible de prédire la formation de bandes d'impuretés dans l'AlN, ce qui pourrait conduire à une mobilité des trous plus élevée que celle du GaN, ce qui porte l'espoir. pour les appareils à canal P et AlN bipolaire.
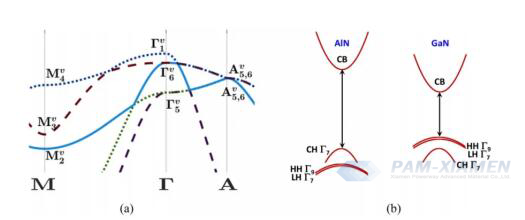
Fig. 2 (a) Dispersion électronique fonctionnelle de densité de la trajectoire linéaire de la bande de valence AlN non stressée (sans spin) de la wurtzite le long des points de symétrie M, Γ et A dans la zone de Brillouin. Au centre de la région, les états de bande séparés ΓV1 sont une dégénérescence singulet, tandis que les états de trous lourds et légers ΓV 6 sont doublement dégénérés. (b) Dispersion qualitative des électrons de wurtzite AlN et GaN non stressés le long de la direction k⊥. Contrairement au GaN, la bande de valence la plus élevée dans AlN est la bande de dissociation, qui présente une masse effective plus petite. L'introduction de l'interaction spin-orbite atténue la dégénérescence des bandes de trous lourds et légers dans la région centrale, entraînant l'émergence d'un seul état dégénéré ΓV ; 17, ΓV9 et ΓV;27.
Pour plus d'informations, veuillez nous contacter par email àvictorchan@powerwaywafer.cometpowerwaymaterial@gmail.com.

