PAM-XIAMEN kann AlN-Einkristallsubstrate liefern. Weitere Spezifikationen finden Sie hierhttps://www.powerwaywafer.com/aln-substrate.html.
Die wichtigsten möglichen Dotierstoffe für AlN vom n-Typ sind Sauerstoff (O) und Silizium (Si), während es sich bei AlN vom p-Typ um Magnesium (Mg) und Beryllium (Be) handelt. Bisher war die Erfolgsquote der Mg- und O-Dotierung sehr gering. Allerdings ist O eine wichtige kompensierende Verunreinigung sowohl für Mg als auch für Be, da sowohl Dotierstoffe als auch Al selbst dazu neigen, Sauerstoff zu absorbieren. Um die Dotierung von AlN zu verstehen, ist es notwendig, die Rolle von Stickstoff-Leerstellen (VN) und Aluminium-Leerstellen (VAl) und den damit verbundenen Komplexen zu verstehen. Das aktuelle Verständnis der Defekt- und Verunreinigungschemie sowie der Nichtgleichgewichtsdotierungsmethoden wird als vielversprechender Ansatz zur Überwindung aktueller technologischer Einschränkungen angesehen.
1.DonorDBetrieb von AlN:Silicon
Für AlN vom n-Typ ist Silizium der optimale theoretische Kationendonor, da sein Atomradius dem von Al sehr nahe kommt, wie in Abb. 1 dargestellt (Al beträgt 118 μm, Si beträgt 111 μm). Obwohl Silizium in GaN ein flacher Donor mit einer Aktivierungsenergie ED von etwa 17 meV ist, steigt seine ED in AlGaN mit zunehmendem Al-Gehalt von 24 meV in Al0,85Ga0,15N auf 211 meV in Al0,96Ga0,04N. Silizium als Ersatzverunreinigung in AlN verursacht eine theoretische Kontraktion von 6 % in der nächstgelegenen benachbarten N-Bindung auf der Basisebene. Dies weist auf eine Abnahme der Position des Siliziumgitters näher an den drei Basisbindungen hin, während der die Si-N-c-Achsenbindungen gedehnt werden. Wenn Silizium ein Sekundärelektron einfängt und eine geometrische Neuordnung erfährt, wird ein DX-Zentrum gebildet, das eine 2 %ige Kontraktion der Si-N-Bindungen an drei Basispositionen und einen c-Achsen-Si-N-Bindungsbruch beinhaltet, wie in Abb. 1 dargestellt. Dies führt zu einem Übergang von flachen zu tiefen Zuständen. Wenn die c-Achsen-Si-N-Bindung unter Spannung bricht, wird ein kompensierter tiefer Zustand erzeugt. Trotz der Existenz solcher Kompensationsdefekte hat die n-Typ-Dotierung von AlN durch Ionenimplantation im oberflächennahen Bereich vielversprechende Ergebnisse gezeigt. Bei der n-Typ-Dotierung von unkompensierten MOCVD-AlN-Dünnfilmen ist jedoch nur eine reproduzierbare Elektronenkonzentration von bis zu 10 möglich15cm-3angezeigt, was nur für Bereiche mit hohem Driftfeld im Gerät gilt.

Abb. 1 Die Positionen und relativen Größen (im Verhältnis) von (a) Mg- und Be-Akzeptoren in AlN, (b) Si-Verunreinigungen, die durch Si-Donoren und DX umgeordnet wurden, und (c) Positionen und relative Größen von Sauerstoffdefekten, die durch Sauerstoff ersetzt wurden DX-Umordnungen (im Verhältnis)
Da eine Technologie die Machbarkeit einer Dotierung zeigt, eine andere jedoch nicht, kann Silizium selbst nicht das Problem sein. Die Hypothese, dass Nichtgleichgewichts- und Niedertemperatur-MBE zur n-Typ-Dotierung von AlN beitragen, basiert auf den folgenden zwei Punkten:
1) Bei Verwendung niedriger Temperaturen wird die minimale Wärmeausdehnung erreicht, daher ist die minimale zusätzliche c-Achsen-Si-N-Bindungsverlängerung wünschenswert;
2) Durch die Minimierung der Metallanreicherungsbedingungen für Al-Leerstellen-Si-Komplexe zeigen diese Komplexe ein ähnliches Verhalten wie Al-Leerstellen-O-Komplexe, was zu einer Selbstkompensation der Donordotierung bei hohen Si-Dotierungsniveaus führt.
Es wird spekuliert, dass diese Si-Selbstkompensation auf eine durch VAl verursachte Gittererweichung zurückzuführen ist, die es einfacher macht, die c-Achsen-Si-N-Bindung aufzubrechen und so ein kompensiertes Si-DX-Zentrum zu bilden. Ähnlich wie bei O muss aufgrund der Ladungsneutralität auch der VAl-XSiAl-Komplex berücksichtigt werden, wobei X eine ganze Zahl ist. Daher ist die Behauptung von Nichtgleichgewichts-, Niedertemperatur- und metallangereichertem MBE für die n-Typ-Dotierung von AlN sehr wertvoll.
2. AkzeptorDBetrieb von AlN:mg, SeinUnd C
Für AlN vom p-Typ gelten Akzeptoren wie anionsubstituierter Kohlenstoff (C) und kationsubstituiertes Be und Mg als machbar. Bei Annäherung an die Verdünnungsgrenze führen isolierte Akzeptorenergien dazu, dass diese Akzeptoren als Rezeptoren auf tiefer Ebene betrachtet werden, wobei theoretisch berichtete einwertige Akzeptoraktivierungsenergien für Mg und Be im Bereich von 510 bis 630 meV bzw. 220 bis 340 meV liegen. Wenn es nicht möglich ist, Verunreinigungsbänder zu bilden, um diese großen Aktivierungsenergien zu reduzieren, ist keine nennenswerte Porenkonzentration zu erwarten.
Wie die Bohr-Orbitalüberlappung bei hohen Dotierungskonzentrationen in GaN zeigt, ist es jedoch möglich, dass die effektive Aktivierungsenergie von Mg von etwa 210 meV auf etwa 50 meV abnimmt, was zu einer Porenkonzentration von 1 x 10 führt20cm-3. Dies hat sich auch für AlGaN mit bis zu etwa 60 % Al als wirksam erwiesen, und es wurden Tunneldioden nachgewiesen.
Abgesehen von einer Porenkonzentration von ca. 1010 cm-3, Mg wurde nicht erfolgreich zur Dotierung von AlN eingesetzt. Die jüngsten Ergebnisse der Verwendung von Be zur Erzielung einer Porenkonzentration bei Raumtemperatur von etwa 3 x 1018cm-3(hier angegeben als ca. 4,4 x 1018cm-3) und eine effektive Aktivierungsenergie von etwa 37 meV deuten darauf hin, dass eine Reduzierung der Aktivierungsenergie erreicht werden kann.
Die relativen Dielektrizitätskonstanten von Galliumnitrid (GaN), Aluminiumnitrid (AlN) und Indiumnitrid (InN) betragen 8,9, 8,5 bzw. 15,3. Die gemeldeten effektiven Massen schwerer Löcher betragen 0,8 Mio., 3,53 Mio. bzw. 1,63 Mio. Dies bedeutet, dass die kritischen Mott-Konzentrationen, die durch die Akzeptorbänder von GaN, AlN und InN gebildet werden, etwa 4×10 betragen19cm-3, 4×1021cm-3und 6,5×1019cm-3, jeweils. Diese vereinfachte Näherung stimmt gut mit den Dotierungsergebnissen von Experimenten zur metallmodulierten Epitaxie (MME) für GaN überein, bei denen Lochkonzentrationen im Bereich von 10 liegen19cm-3routinemäßig erreicht werden können. In ähnlicher Weise deuten diese Vorhersagen darauf hin, dass es bei AlN und InN schwieriger sein wird, eine degenerierte p-Typ-Dotierung zu erfahren, da jeweils eine höhere Dotierungskonzentration erforderlich ist, um Verunreinigungsbänder zu bilden.
Für AlN kann es zunächst als unmöglich angesehen werden, die hohe Dotierungskonzentration zu erreichen, die zur Bildung von Verunreinigungsbändern erforderlich ist, was im Widerspruch zu aktuellen experimentellen Ergebnissen steht. Es ist jedoch notwendig, die einzigartige Valenzbandstruktur von AlN zu berücksichtigen, bei der das abgespaltene Band tatsächlich höher ist als das Lochband und das Band leichter Löcher (siehe Abb. 2) und eine hohe Anisotropie aufweist. Aufgrund des Mangels an d-Orbitalelektronen ist das Vorzeichen der Kristallfeldspaltungsenergie entgegengesetzt zu dem von GaN. Das Abspaltungsband weist eine stärkere Krümmung auf und liegt energetisch in einem breiteren Bereich schwerer und leichter Lochbänder. Abb. 2 zeigt die Berechnung der Dichtefunktionaltheorie (DFT) unter Berücksichtigung dieses Effekts. Die durch die Dichtefunktionaltheorie (DFT) berechneten effektiven Massen betragen 3,66 mo für die parallele Komponente und 0,24 mo für die vertikale Komponente, was zu kritischen Mott-Konzentrationen von 4,3 × 10 führt21cm-3und 1,2×1018cm-3, jeweils. Die oberen und unteren Grenzen der kritischen Mott-Konzentration werden angegeben, um zu betonen, dass es bei Berücksichtigung der Einzigartigkeit der AlN-Bandstruktur möglich ist, die Bildung von Verunreinigungsbändern in AlN vorherzusagen, was zu einer höheren Lochmobilität als in GaN führen kann, was Hoffnung macht für p-Kanal- und bipolare AlN-Geräte.
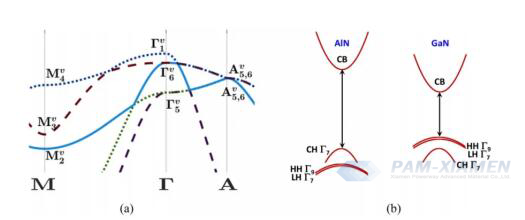
Abb. 2 (a) Dichtefunktionale Elektronendispersion der linearen Flugbahn des unbelasteten AlN-Valenzbandes (spinfrei) von Wurtzit entlang der M-, Γ- und A-Symmetriepunkte innerhalb der Brillouin-Zone. Im Zentrum der Region sind die abgespaltenen Bandzustände ΓV1 Singulett-Entartung, während die schweren und leichten Lochzustände ΓV 6 doppelt entartet sind. (b) Qualitative Elektronendispersion von unbelastetem Wurtzit-AlN und GaN entlang der k⊥-Richtung. Im Gegensatz zu GaN ist das höchste Valenzband in AlN das Dissoziationsband, das eine kleinere effektive Masse aufweist. Die Einführung der Spin-Bahn-Wechselwirkung lindert die Entartung schwerer und leichter Lochbänder im Zentrum der Region, was zur Entstehung eines einzelnen entarteten Zustands ΓV führt; 17, ΓV9 und Γ V;27.
Für weitere Informationen kontaktieren Sie uns bitte per E-Mail untervictorchan@powerwaywafer.com und powerwaymaterial@gmail.com.

