PAM-XIAMEN kan levere AlN enkeltkrystal substrat, yderligere specifikation se venligsthttps://www.powerwaywafer.com/aln-substrate.html.
De vigtigste n-type AlN-kandidater er oxygen (O) og silicium (Si), mens de for p-type AlN er magnesium (Mg) og beryllium (Be). Indtil videre har succesraten for Mg- og O-doping været meget lav. O er dog en vigtig kompenserende urenhed for både Mg og Be, da både dopingmidler og Al selv har tendens til at absorbere ilt. For at forstå dopingen af AlN er det nødvendigt at forstå rollerne for nitrogen-vacances (VN) og aluminium-vacances (VAl) og deres relaterede komplekser. Den nuværende forståelse af defekt- og urenhedskemi, såvel som ikke-ligevægtsdopingmetoder, vil blive betragtet som en lovende tilgang til at overvinde nuværende teknologiske begrænsninger.
1. DonorDåbning af AlN:Silicon
For n-type AlN er silicium den optimale teoretiske kationdonor, fordi dens atomradius er meget tæt på den for Al, som vist i fig. 1 (Al er 118 pm, Si er 111 pm). Selvom silicium er en lavvandet donor i GaN med en aktiveringsenergi ED på ca. 17 meV, i AlGaN, med en stigning i Al indhold, stiger dens ED fra 24 meV i Al0.85Ga0.15N til 211 meV i Al0.96Ga0.04N. Silicium, som en erstatningsurenhed i AlN, forårsager en teoretisk sammentrækning på 6% i den nærmeste nabobasalplan N-binding. Dette indikerer et fald i positionen af siliciumgitteret, tættere på de tre basale bindinger, hvorunder Si-N c-aksebindingerne strækkes. Når silicium fanger en sekundær elektron og gennemgår geometrisk omlejring, dannes et DX-center, som omfatter en 2% kontraktion af Si-N-bindinger ved tre basale positioner og en c-akse Si-N-bindingsbrud, som vist i fig. fører til en overgang fra lavvandede til dybe niveauer. Når c-aksen Si-N-bindingen under stress bryder, vil en kompenseret dyb tilstand blive genereret. På trods af eksistensen af sådanne kompensationsdefekter har n-type doping af AlN gennem ionimplantation i området nær overflade vist lovende resultater. Ved n-type doping af ukompenserede MOCVD AlN tynde film er der dog kun en reproducerbar elektronkoncentration på op til 1015cm-3vises, hvilket kun gælder for områder med høj drift i enheden.

Fig. 1 Positionerne og relative størrelser (i forhold) af (a) Mg- og Be-acceptorer i AlN, (b) Si-urenheder omarrangeret af Si-donorer og DX, og (c) positioner og relative størrelser af oxygendefekter substitueret med oxygen og DX-omlægninger (i forhold)
I betragtning af at en teknologi demonstrerer gennemførligheden af doping, mens en anden teknologi ikke gør det, kan silicium i sig selv ikke være problemet. Hypotesen om, at ikke-ligevægt og lavtemperatur MBE bidrager til n-type doping af AlN er baseret på følgende to punkter:
1) ved brug af lav temperatur opnås den minimale termiske udvidelse, derfor er den minimale yderligere c-akse Si-N-bindingsforlængelse ønskelig;
2) Ved at minimere metalberigelsesbetingelser for Al ledige Si-komplekser udviser disse komplekser adfærd svarende til Al ledige O-komplekser, hvilket fører til selvkompensation af donordoping ved høje Si-dopingniveauer.
Det spekuleres i, at denne Si-selvkompensation skyldes gitterblødgøring forårsaget af VAl, hvilket gør det lettere at bryde c-aksen Si-N-bindingen og dermed danne et kompenseret Si-DX-center. I lighed med O skal VAl-XSiAl-komplekset på grund af ladningsneutralitet også tages i betragtning, hvor X er et heltal. Derfor er påstand om ikke-ligevægt, lav temperatur og metalberiget MBE meget værdifuldt for n-type doping af AlN.
2. AcceptorDåbning af AlN:Mg, VæreOg C
For p-type AlN anses acceptorer, såsom anionsubstitueret carbon (C) og kationsubstitueret Be og Mg som mulige. Når man nærmer sig fortyndingsgrænsen, resulterer isolerede acceptorenergier i, at disse acceptorer betragtes som receptorer på dybt niveau, med teoretisk rapporterede enkeltværdisatte acceptoraktiveringsenergier for Mg og Be i området fra henholdsvis 510 til 630 meV og 220 til 340 meV. Hvis der ikke er mulighed for at danne urenhedsbånd for at reducere disse store aktiveringsenergier, forventes der ikke signifikant porekoncentration.
Men som vist af Bohr-orbital-overlapningen ved høje dopingkoncentrationer i GaN, er det muligt for den effektive aktiveringsenergi af Mg at falde fra ca. 210 meV til ca. 50 meV, hvilket resulterer i en porekoncentration på 1 x 1020cm-3. Dette har også vist sig at være effektivt for AlGaN med op til omkring 60% Al, og tunneldioder er blevet demonstreret.
Bortset fra en porekoncentration på cirka 1010 cm-3, Mg er ikke blevet anvendt med succes til doping af AlN. De seneste resultater af brugen af Be til at opnå en porekoncentration ved stuetemperatur på ca. 3 x 1018cm-3(rapporteret her som cirka 4,4 x 1018cm-337 meV indikerer, at en reduktion i aktiveringsenergi kan opnås.
De relative dielektriske konstanter for galliumnitrid (GaN), aluminiumnitrid (AlN) og indiumnitrid (InN) er henholdsvis 8,9, 8,5 og 15,3. De rapporterede effektive masser af tunge huller er henholdsvis 0,8 mo, 3,53 mo og 1,63 mo. Dette betyder, at de Mott-kritiske koncentrationer dannet af acceptorbåndene af GaN, AlN og InN er ca. 4×1019cm-3, 4×1021cm-3og 6,5×1019cm-3, henholdsvis. Denne forenklede tilnærmelse er i god overensstemmelse med dopingresultaterne af metalmoduleret epitaksi (MME) eksperimenter for GaN, hvor hulkoncentrationer i området 1019cm-3kan rutinemæssigt opnås. Tilsvarende indikerer disse forudsigelser, at AlN og InN vil være sværere at gennemgå degenereret p-type doping, der hver kræver en højere dopingkoncentration for at danne urenhedsbånd.
For AlN kan det i første omgang anses for umuligt at opnå den høje dopingkoncentration, der kræves for at danne urenhedsbånd, hvilket er i modstrid med nuværende forsøgsresultater. Det er dog nødvendigt at overveje den unikke valensbåndstruktur af AlN, hvor det afsplittede bånd faktisk er højere end hulbåndet og lette hulbånd (se fig. 2) og har høj anisotropi. På grund af manglen på d-orbitale elektroner er tegnet på krystalfeltsspaltningsenergi modsat GaN. Afskæringsbåndet udviser større krumning og er placeret på et bredere udvalg af tunge og lette hulbånd med hensyn til energi. Fig. 2 viser beregningen af densitetsfunktionsteori (DFT) under hensyntagen til denne effekt. De effektive masser beregnet ved densitetsfunktionsteori (DFT) er 3,66 mo for den parallelle komponent og 0,24 mo for den vertikale komponent, hvilket resulterer i Mott kritiske koncentrationer på 4,3 × 1021cm-3og 1,2×1018cm-3, henholdsvis. De øvre og nedre grænser for den kritiske Mott-koncentration er givet for at understrege, at når man overvejer det unikke ved AlN-båndstrukturen, er det muligt at forudsige dannelsen af urenhedsbånd i AlN, hvilket kan føre til højere hulmobilitet end GaN, hvilket bringer håb til p-kanal og bipolære AlN-enheder.
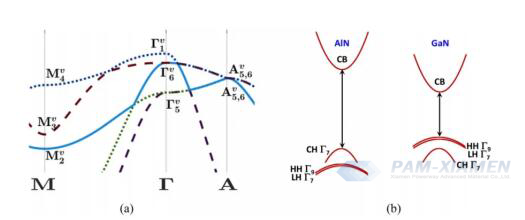
Fig. 2 (a) Tæthedsfunktionel elektronspredning af den lineære bane af det ubelastede AlN-valensbånd (spinfrit) af wurtzite langs M-, Γ- og A-symmetripunkterne inden for Brillouin-zonen. I midten af regionen er afsplittede båndtilstande ΓV1 singlet degeneration, mens tunge og lette hultilstande ΓV 6 er dobbelt degenererede. (b) Kvalitativ elektronspredning af ubetonet wurtzit AlN og GaN langs k⊥-retningen. I modsætning til GaN er det højeste valensbånd i AlN dissociationsbåndet, som udviser en mindre effektiv masse. Indførelsen af spin-kredsløbsinteraktion lindrer degenerationen af tunge og lette hulbånd i regionens centrum, hvilket resulterer i fremkomsten af en enkelt degenereret tilstand ΓV; 17, ΓV9 og ΓV;27.
For mere information, kontakt os venligst e-mail påvictorchan@powerwaywafer.com og powerwaymaterial@gmail.com.

