تتميز مواد رقاقة SiC بفجوة نطاق واسعة، وقابلية تنقل عالية للتشبع الإلكتروني، وخصائص حرارية ممتازة، والتي لها آفاق تطبيق رائعة في الأجهزة ذات درجة الحرارة العالية والتردد العالي والطاقة العالية. تؤثر جودة سطح سطح Si بشكل مباشر على جودة الأغشية الرقيقة الفوقية SiC وأداء أجهزتها. ومع ذلك، يمكن للعيوب الموجودة على سطح C أن تزيد من كثافة الاضطرابات البلورية، مما قد يؤدي أيضًا إلى تكوين عيوب في طبقة نمو الغشاء الرقيق الفوقي ويؤثر على أداء الجهاز. لذلك، يتطلب كل من سطحي Si وC لرقائق SiC أن تكون أسطحهما فائقة النعومة، وخالية من العيوب، وغير تالفة.
PAM-شيامنيمكننا توفير رقائق SiC من الكربون (C) المعالجة CMP لأبحاث إعداد الجهاز، مثل مكثف MOS، ومعلمات محددة يرجى الاتصال بفريق المبيعات لدينا:victorchan@powerwaywafer.com
1.Sدراسة عن CMPTمعالجةمن سطح سيو CSوجهكعلى الركيزة SiC
تم استخدام K2S2Os كمؤكسدات وجسيمات Al2O3 النانوية كمواد كاشطة لمقارنة تأثيرات تلميع CMP على أسطح Si وC للركيزة 6H-SiC. تم استخدام XPS لتحليل آلية تأثير الوجوه البلورية المختلفة على تأثيرات تلميع CMP الخاصة بها. يوجد فرق كبير في تأثير تلميع CMP بين أسطح Si وC لرقائق 6H-SiC.
يصل معدل إزالة المواد على سطح Si إلى قيمة قصوى تبلغ 349 نانومتر/ساعة عند درجة الحموضة = 6، بينما يصل معدل إزالة المواد على السطح C إلى قيمة قصوى تبلغ 1184 نانومتر/ساعة عند درجة الحموضة = 2. ومع ذلك، فإن وجوه Si وC المصقولة ناعمة نسبيًا، مع قيم خشونة Ra تبلغ 0.58 نانومتر و0.55 نانومتر، على التوالي.
بعد التلميع، يكون أطياف XPS لأسطح Si وC متشابهة بشكل عام، ولكن هناك اختلافات كبيرة في التركيب الذري بين أسطح Si وC. يوضح الشكل 1 أن تركيز ذرات O1s ونسبة C/Si وO/Si على سطح Si أعلى من تلك الموجودة على سطح C، لكن تركيز ذرات C1s وSi2p على سطح C أعلى من ذلك على سطح سي. علاوة على ذلك، فإن نسبة C/Si على كلا السطحين أعلى من النسبة الطبيعية المتكافئة البالغة 1. كثافة ذروة طاقة الربط Si-C على المستوى C أعلى من تلك الموجودة على المستوى Si، ولكن محتوى منتجات الأكسدة ( مثل Si4-C4-x-O2 وSi4-C4-O4 وCO وC=O) على المستوى Si أعلى من تلك الموجودة على المستوى C، كما هو موضح في الشكل 2. يشير هذا إلى أن إزالة الأكاسيد الموجودة على المستوى C أسهل من إزالتها على المستوى Si، وبالتالي فإن الحصول على المستوى C أسهل في الحصول على معدل إزالة مواد أعلى من المستوى Si.
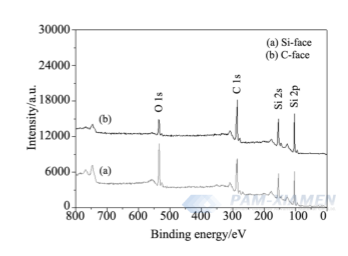
الشكل 1: طيف XPS للسطح المصقول لرقاقة 6H-SiC
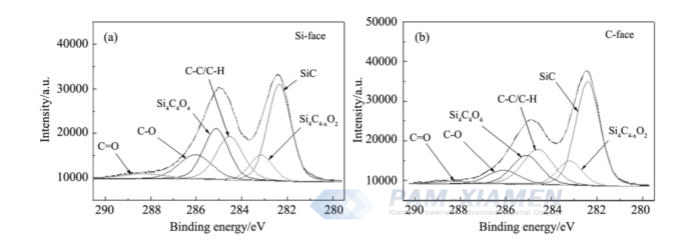
الشكل 2: طيف C1s من الأسطح المصقولة لسطح 6H-SiC (a) Si؛ (ب) الوجه C
2. دراسة مكثفات MOS على رقاقة Si- وC-Face SiC
لقد درس الباحثون العلاقة بين التركيب الذري والأداء الكهربائي لمكثفات SiC MOS المقابلة، وناقشوا التأثيرات الجوهرية والخارجية لبنية الواجهة والعيوب الكهربائية على تعديل إزاحة النطاق.
تم الحصول على هياكل النطاق لهياكل SiO2/SiC المحضرة في ظل ظروف مختلفة. تشير النتائج إلى أن إزاحة نطاق التوصيل الذي يحدد تيار تسرب البوابة لأجهزة SiC MOS وموثوقية أكسيد البوابة الناتجة تعتمد بشكل أساسي على اتجاه الركيزة وسمك الأكسيد. نظرًا للتحول الأصغر في نطاق التوصيل الذي أظهره الأكسيد الرقيق على ركيزة سطح C مقارنةً بركيزة سطح Si، فقد خلص إلى أن انخفاض موثوقية أجهزة SiC MOS المصنعة على وجه C هي مشكلة متأصلة، والتي قد تكون بسبب إلى الفرق في السالبية الكهربية بين ذرات Si وC المرتبطة بذرات O عند الواجهة.
بالإضافة إلى ذلك، وبالنظر إلى تراكم الشحنات الثابتة السالبة في واجهة SiO2/SiC، يمكن تفسير الزيادة في تحول نطاق التوصيل للأكاسيد السميكة على ركائز Si وC من خلال تعديل النطاق غير الجوهري الناتج عن عيوب الواجهة.
من منظور تقليل تسرب البوابة، يُفضل إزاحة النطاق الموسع لأجهزة MOS السميكة، ولكن يجب أن يكون للعيوب الكهربائية تأثير سلبي على أداء الجهاز وموثوقيته. ولذلك، فإن الاستراتيجيات الأساسية مثل تطبيق أكاسيد البوابة المودعة واستخدام الهياكل المكدسة في هندسة النطاق ضرورية لاستخدام أجهزة MOS على C-face SiC.
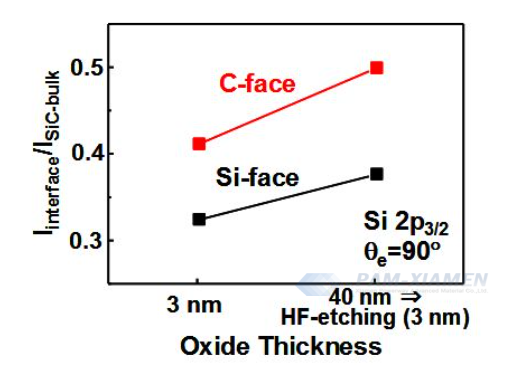
الشكل 3. طيف Si 2p3/2 من التغييرات في المقدار الإجمالي لحالات الأكسيد الوسيطة من واجهة الأكسيد المزروعة على وجوه SiC (0001) Si وC
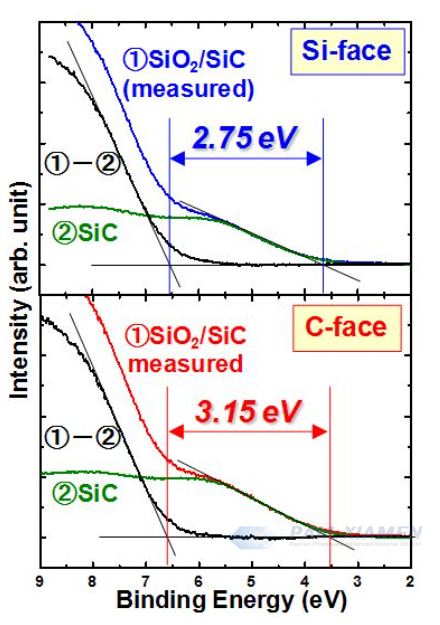
الشكل 4. أطياف نطاق التكافؤ للقياس وتفكيك هياكل SiO2/SiC المتكونة على Si وC التي تواجه ركائز 4H-SiC، مما يشير إلى أن تحول نطاق التكافؤ لـ SiO2/SiC على ركائز السطح C أعلى بنحو 0.4 فولت من ذلك الموجود على سطح Si. .
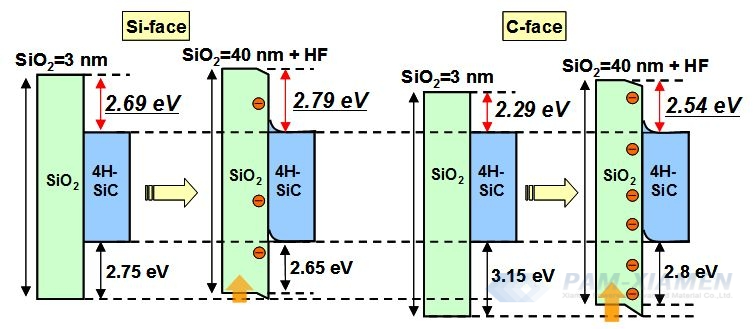
الشكل 5: مخطط نطاق الطاقة لهيكل SiO2 / Si أو C المستوي 4H-SiC عن طريق تحليل السنكروترون XPS. قياس تحول نطاق التكافؤ عند واجهة SiO2/SiC المتكونة في ظل ظروف مختلفة.
مراجع:
1. تشن جو مي، ني زي فنغ، تشيان شان هوا، ليو يوان شيانغ، دو تشون كوان، تشو لينغ، شو يي إي
أون، تشاو يونغ وو. تأثير المستويات البلورية المختلفة على أداء CMP لرقاقة SiC
2. هيجي واتانابي، تاكوجي هوسوي. الجوانب الأساسية لأكسدة كربيد السيليكون
لمزيد من المعلومات، يرجى الاتصال بنا على البريد الإلكترونيvictorchan@powerwaywafer.com و powerwaymaterial@gmail.com.

