Los materiales de oblea de SiC tienen una banda prohibida amplia, una alta movilidad de saturación de electrones y excelentes propiedades térmicas, que tienen grandes perspectivas de aplicación en dispositivos de alta temperatura, alta frecuencia y alta potencia. La calidad de la superficie de Si afecta directamente la calidad de la película delgada epitaxial de SiC y el rendimiento de sus dispositivos. Sin embargo, los defectos en la superficie C pueden aumentar la densidad de las dislocaciones de los cristales, lo que también puede conducir a la formación de defectos en la capa de crecimiento de la película delgada epitaxial y afectar el rendimiento del dispositivo. Por lo tanto, tanto la superficie de Si como la de C de las obleas de SiC requieren que sus superficies sean ultralisas, libres de defectos y sin daños.
PAM-XIAMENPuede proporcionar obleas de SiC planas de carbono (C) procesadas con CMP para investigaciones de preparación de dispositivos, como condensadores MOS. Parámetros específicos, comuníquese con nuestro equipo de ventas:victorchan@powerwaywafer.com
1.Sestudio en CMPTtratamientode superficie de SiyCSTu carasobre sustrato de SiC
Se utilizaron K2S2O como oxidantes y nanopartículas de Al2O3 como abrasivos para comparar los efectos de pulido CMP en las superficies de Si y C del sustrato 6H-SiC. Se utilizó XPS para analizar el mecanismo de influencia de diferentes caras de cristal en sus efectos de pulido CMP. Existe una diferencia significativa en el efecto de pulido CMP entre las superficies Si y C de las obleas 6H-SiC.
La tasa de eliminación de material en la superficie de Si alcanza un valor máximo de 349 nm/h a pH=6, mientras que la tasa de eliminación de material en la superficie de C alcanza un valor máximo de 1184 nm/h a pH=2. Sin embargo, las caras pulidas de Si y C son relativamente lisas, con valores de rugosidad Ra de 0,58 nm y 0,55 nm, respectivamente.
Después del pulido, los espectros XPS de las superficies de Si y C son generalmente similares, pero existen diferencias significativas en la composición atómica entre las superficies de Si y C. La figura 1 muestra que la concentración de átomos de O1s y la relación de C/Si y O/Si en la superficie de Si son mayores que las de la superficie de C, pero la concentración de átomos de C1s y Si2p en la superficie de C es mayor que eso. en la superficie del Si. Además, la relación C/Si en ambas superficies es mayor que su relación estequiométrica normal de 1. La intensidad máxima de la energía de enlace Si-C en el plano C es mayor que en el plano Si, pero el contenido de productos de oxidación ( como Si4-C4-x-O2, Si4-C4-O4, CO y C=O) en el plano Si es mayor que en el plano C, como se muestra en la Fig.2. Esto indica que los óxidos en el plano C son más fáciles de eliminar que en el plano Si, por lo que en el plano C es más fácil obtener una tasa de eliminación de material más alta que en el plano Si.
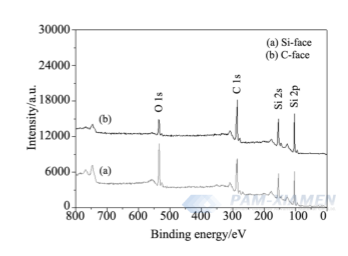
Fig. 1 Espectro XPS de la superficie pulida de una oblea de 6H-SiC
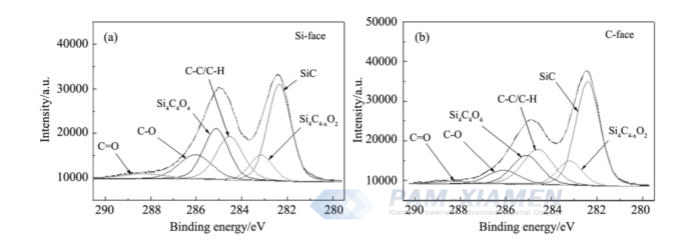
Fig. 2 Espectro C1s de superficies pulidas de 6H-SiC (a) Superficie de Si; (b) cara C
2. Estudio de condensadores MOS en oblea de SiC con cara de Si y C
Los académicos han estudiado la correlación entre la estructura atómica y el rendimiento eléctrico de los condensadores MOS de SiC correspondientes y han discutido los efectos intrínsecos y extrínsecos de la estructura de la interfaz y los defectos eléctricos en la modulación de compensación de banda.
Se obtuvieron estructuras de bandas de estructuras SiO2/SiC preparadas en diversas condiciones. Los resultados indican que el desplazamiento de la banda de conducción que determina la corriente de fuga de la compuerta de los dispositivos MOS de SiC y la confiabilidad del óxido de la compuerta resultante depende principalmente de la orientación del sustrato y el espesor del óxido. Debido al menor desplazamiento de la banda de conducción exhibido por el óxido fino en el sustrato de la superficie C en comparación con el sustrato de la superficie de Si, se concluye que la confiabilidad reducida de los dispositivos MOS de SiC fabricados en la cara C es un problema inherente, que puede deberse a la diferencia de electronegatividad entre Si y los átomos de C unidos a los átomos de O en la interfaz.
Además, considerando la acumulación de cargas fijas negativas en la interfaz SiO2/SiC, el aumento en el desplazamiento de la banda de conducción de óxidos gruesos en sustratos de Si y C puede explicarse por la modulación de banda no intrínseca causada por defectos en la interfaz.
Desde la perspectiva de reducir las fugas de puerta, se prefiere este desplazamiento de banda expandida de dispositivos MOS gruesos, pero los defectos eléctricos deberían tener un impacto negativo en el rendimiento y la confiabilidad del dispositivo. Por lo tanto, estrategias básicas como la aplicación de óxidos de compuerta depositados y la utilización de estructuras apiladas en ingeniería de bandas son esenciales para utilizar dispositivos MOS en SiC con cara C.
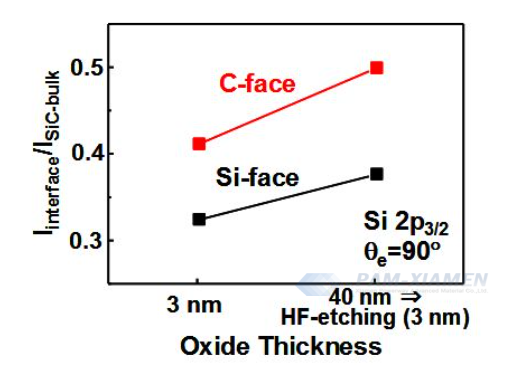
Fig. 3 Espectro de cambios de Si 2p3/2 en la cantidad total de estados de óxido intermedios de la interfaz de óxido cultivada en SiC (0001) Caras de Si y C
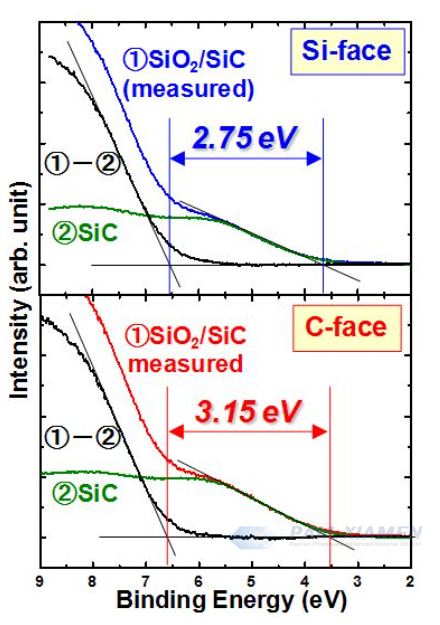
Fig. 4 Espectros de banda de valencia de medición y deconvolución de estructuras de SiO2/SiC formadas en sustratos de 4H-SiC con revestimiento de Si y C, lo que indica que el desplazamiento de la banda de valencia de SiO2/SiC en sustratos con superficie de C es aproximadamente 0,4 eV mayor que el de la superficie de Si .
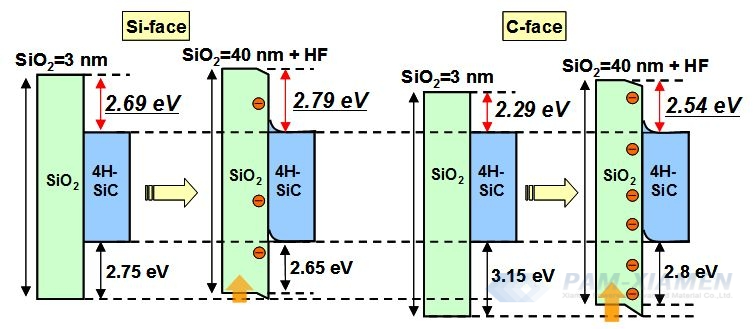
Fig. 5 Diagrama de bandas de energía de la estructura 4H-SiC del plano C de SiO2/Si o mediante análisis XPS sincrotrón. Medición del desplazamiento de la banda de valencia en la interfaz SiO2/SiC formada en diversas condiciones.
Referencias:
1. CHEN Guo-mei, NI Zi-feng, QIAN Shan-hua, LIU Yuan-xiang, DU Chun-kuan, ZHOU Ling, XU Yi-e
es, ZHAO Yong-wu. Influencia de diferentes planos cristalográficos en el rendimiento CMP de oblea de SiC
2. Heiji Watanabe, Takuji Hosoi. Aspectos fundamentales de la oxidación del carburo de silicio
Para obtener más información, por favor contáctenos por correo electrónico avictorchan@powerwaywafer.comypowerwaymaterial@gmail.com.

