يمكن لشركة PAM-XIAMEN تقديم رقائق SiC، ويمكن العثور على المواصفات والمعلمات المحددة في:https://www.powerwaywafer.com/sic-wafer
تتميز البلورة المفردة 4H-SiC بخصائص ممتازة مثل فجوة النطاق الواسعة وحركة الناقل العالية والتوصيل الحراري العالي والاستقرار الجيد. وله آفاق تطبيق واسعة في الإلكترونيات عالية الطاقة، وإلكترونيات الترددات الراديوية/الميكروويف، والمعلومات الكمومية. بعد سنوات من التطوير، تم تطبيق ركائز بلورية أحادية 4H SiC مقاس 6 بوصة وأغشية رقيقة فوقي متجانسة صناعيًا. ومع ذلك، فإن كثافة التفكك الإجمالية في رقائق 4H SiC لا تزال مرتفعة حتى 103~104سم-2، مما يعيق الإمكانات الكاملة لرقائق 4H-SiC. كيف تؤثر الاضطرابات على خصائص رقائق وأجهزة 4H-SiC؟ التحليل المحدد هو كما يلي:
1. تأثير الاضطرابات على الخواص الكهربائية في رقائق وأجهزة 4H-SiC
قامت الأبحاث بتحليل العلاقة بين أداء رقائق وأجهزة 4H-SiC وتوزيع الاضطرابات داخل المنطقة الوظيفية، مما يشير إلى أن وجود الاضطرابات يمكن أن يكون له آثار ضارة على أداء الجهاز. ولذلك فإن دراسة الخواص الكهربائية للاضطرابات نفسها لها أهمية كبيرة لفهم سلوكها في الأجهزة.
1.1 تأثير الاضطرابات على الخواص الكهربائية في الركيزة 4H-SiC
من خلال الجمع بين التآكل القلوي المنصهر والمجهر المجهري لقوة مسبار كلفن (KPFM)، يمكن ملاحظة أن خلع حافة الخيط (TED) وخلع المستوى القاعدي (BPD) يظهران حالات متقبلة في ركائز شبه عازلة عالية النقاء (HPSI) 4H SiC والحالات المانحة في ركائز n-type 4H SiC (انظر الشكل 1). في الطبقة الفوقي 4H SiC ذات تركيز المنشطات المنخفض، وجد أيضًا أن الاضطرابات المخترقة تظهر خصائص متقبلة. لقد وجدت حسابات المبادئ الأولى أن TED وBPD يقدمان مستويات طاقة معيبة، حيث يكون مستوى الطاقة بالقرب من الجزء السفلي من نطاق التكافؤ هو النطاق الفارغ. بسبب هيمنة عيوب المستوى العميق مثل ذرات الشوائب، فإن الشواغر الكربونية (VC)، أو أزواج الشواغر (VC-الخامسسي) في HPSI 4H SiC، يمكن أن يستقبل النطاق الشاغر الناتج عن عمليات الخلع إلكترونات ذات مستوى عميق، وتظهر عمليات الخلع خصائص متقبلة. في الركيزة من النوع n، تظهر الحسابات أن ذرات N أكثر استقرارًا في الارتباط بخلع TED وBPD، وبالتالي تميل ذرات N إلى التجمع بالقرب من الاضطرابات. نظرًا لهيمنة الذرات المخدرة في الركائز الموصلة، فإن تجميع ذرات N يمكن أن يسبب خلعًا في خصائص المانحين.
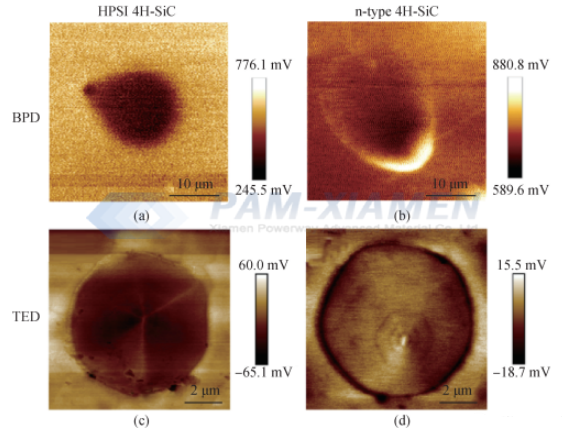
الشكل 1. التوزيع السطحي المحتمل لـ BPD وTED في HPSI وn-type 4H-SiC
1.2 تأثير الاضطرابات على الخواص الكهربائية لأجهزة 4H-SiC
من خلال مسح الحفر الدقيقة الناتجة عن خلع المسمار اللولبي (TSD)، أظهرت نتائج اختبار C-AFM زيادة كبيرة في التيار في أسفل الحفر الدقيقة، في حين أن التيار السطحي في المناطق الأخرى داخل الحفر الدقيقة لم يختلف بشكل كبير من ذلك خارج الحفر الصغيرة. يشير هذا إلى أن خطوط خلع TSD في 4H SiC تعزز تأثير التسرب. بالإضافة إلى ذلك، يمكن أن تؤدي عمليات الخلع كمراكز إعادة التركيب إلى إعادة تركيب ثقب الإلكترون في أجهزة الطاقة 4H-SiC وتؤدي أيضًا إلى انخفاض موثوقية الجهاز.
لا تؤثر خطوط الخلع على أداء الجهاز فحسب، بل تسبب أيضًا حفرًا صغيرة سطحية على عمق النانو على سطح الطبقة الفوقي بسبب اضطراب تدفق الخطوة الخارجية الناجم عن خطوط الخلع. يمكن أن يؤثر وجود الحفر الصغيرة أيضًا على أداء الجهاز. على سبيل المثال، تحت الضغط العالي، تظهر البلازما الدقيقة في موضع الحفرة الصغيرة الناتج عن خلع الخيوط (TD)، مما يشير إلى أن بوابة الأكسجين في موضع الحفرة الصغيرة يتم تقسيمها أولاً. يمكن أن يؤدي وجود الحفر الصغيرة أيضًا إلى انخفاض عمر ناقلات الأقلية، وزيادة تيار التسرب العكسي، وانخفاض الجهد الأمامي، مما له آثار ضارة على ثنائيات حاجز شوتكي (SBDs) القائمة على SiC 4H، وثنائيات الوصلة pn (PNDs) والثنائيات الضوئية الانهيارية (انظر الشكل 2 (أ) و (ب)).
لذلك، يعتقد بعض الباحثين أن التأثير الحالي للاضطرابات على أداء الجهاز ناتج بشكل أساسي عن الحفر الدقيقة، وأن تأثير خطوط الإزاحة نفسها ثانوي. من خلال المحاكاة والتجارب، وجد أن استبعاد وجود الحفر الصغيرة يمكن أن يقلل من تأثير TSD على الأجهزة القائمة على 4H-SiC (انظر الشكل 2 (ج)). يمكن أن يعمل BPD أيضًا كمركز مركب في 4H-SiC. عند التشغيل في الأجهزة ثنائية القطب 4H-SiC، يمكن أن يتسبب الحقن الكهربائي في حدوث انزلاقات غير كاملة في قلب السيليكون، مما يؤدي إلى توسيع خطأ التراص والتأثير بشكل خطير على الأداء الأمامي والخلفي للجهاز. من المعتقد عمومًا أن أخطاء التراص الناتجة عن الاضطرابات غير الكاملة في قلب السيليكون في BPD يتم تطويرها عند السطح البيني بين الركيزة والطبقة الفوقي، وتتوسع للخارج على سطح الطبقة الفوقي. بالنظر إلى الحركة الاتجاهية لاثنين من الاضطرابات غير الكاملة في BPD، فإن توسيع أخطاء التراص الناتجة عن BPD أمر معقد. لقد وجدت الأبحاث أن أخطاء التراص الناتجة عن اضطراب الشخصية الحدية يمكن أن تتحرك أيضًا نحو الواجهة بين الطبقة السفلية والطبقة الفوقي (انظر الشكل 2 (د)).
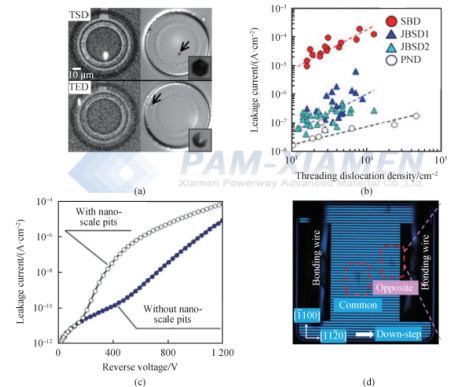
الشكل 2 تأثير الاضطرابات على تيار التسرب لأجهزة الطاقة 4H-SiC وتوسيع أخطاء التراص في 4H-SiC: (أ) صور EL لثنائيات الانهيار الجليدي (يسار) وصور DIC بعد ذوبان تآكل KOH (يمين) ؛ (ب) العلاقة بين تيار التسرب للأجهزة المختلفة وكثافة TDs؛ (ج) سلوك التسرب العكسي للثنائيات 4H-SiC واعتمادها على حفر النانو؛ ( د ) صورة EL لجهاز 4H SiC PIN تمت ملاحظتها بواسطة مرشح 420 نانومتر
2. تأثير الاضطرابات على الخصائص البصرية في 4H-SiC
كمركز إعادة التركيب الإشعاعي، تظهر الاضطرابات في 4H-SiC تلألؤًا ضوئيًا، ويعتمد تباين تلألؤ ضوئي الانخلاع (PL) على عمر حاملات الأقليات. عندما يكون تركيز عيوب المستوى العميق في البلورة منخفضًا، يكون عمر حاملة الأقلية طويلًا، وينتقل عدد كافٍ من حاملات الأقلية إلى منطقة الخلع لإعادة تجميع الضوء وإصداره. في هذا الوقت، تكون كثافة التلألؤ في منطقة الخلع أعلى من المناطق الأخرى، وتظهر كنقطة مضيئة. عندما يكون تركيز عيوب المستوى العميق في البلورة مرتفعًا، يكون عمر حامل الأقلية منخفضًا، ويتحد مع عيوب المستوى العميق القريبة لإصدار الضوء. يتم قمع إعادة التركيب عند الخلع، وتكون كثافة الانبعاث في منطقة الخلع أضعف منها في المناطق الأخرى، مما يظهر بقعة مظلمة. وجدت التجربة أنه في اختبار PL، بالنسبة لـ 4H-SiC مع عمر ناقلات الأقلية أقل من 0.5μs، لا يمكن لمعظم ناقلات الأقلية الانتقال إلى الاضطرابات، ويتم التقاط عدد صغير من ناقلات الأقلية بواسطة عيوب متأصلة. لا تظهر الاضطرابات تباينًا كبيرًا في صورة المسح السطحي PL. عندما يكون عمر حاملات الأقلية أكبر من 0.5 ميكروثانية، فإن إعادة تركيب ثقب الإلكترون عند الخلع يمكن أن تميز بشكل كبير تباين الخلع عن المناطق الأخرى.
تعرض TSD وTED أحجامًا مختلفة من البقع الداكنة أو الساطعة في صور المسح السطحي PL لـ 4H-SiC. تقع قمم انبعاث PL الجوهرية لـ TED وTSD عند 600 نانومتر و800-850 نانومتر، على التوالي. يظهر BPD كخطوط داكنة أو ساطعة في صورة المسح السطحي PL لـ 4H-SiC (انظر الشكل 3 (أ)). تنشأ قمم انبعاث PL الخاصة بـ BPDs من قمم انبعاث PL الخاصة بالخلع غير الكامل وأخطاء التراص التي تشكل BPDs. تقع قمم انبعاث الاضطرابات غير الكاملة في نواة السيليكون، والخلعات غير الكاملة في نواة الكربون، وأخطاء التراص عند 670-700 نانومتر، و720-850 نانومتر، و420 نانومتر، على التوالي. من خلال ضبط الطول الموجي للضوء المنبعث، يمكن تحقيق عرض الاضطرابات الفردية غير الكاملة وأخطاء التراص بشكل منفصل.
في الآونة الأخيرة، وجد الباحثون أيضًا أن TDs يمكن أن تعزز التلألؤ D1 لـ 4H-SiC، كما هو مبين في الشكل 3 (ب) و(ج)، والذي يمثل شدة التلألؤ في حفر التآكل TED وTSD، على التوالي. وهذا يعني أن شدة التلألؤ D1 يمكن أن تعكس أيضًا كثافة وتوزيع الاضطرابات في الركيزة 4H-SiC والطبقة الفوقي.

الشكل 3. خصائص الإنارة للخلع في 4H-SiC: (أ) صور المسح السطحي PL للمنطقة الدقيقة للأغشية الرقيقة الفوقي 4H SiC التي تم الحصول عليها باستخدام مرشح ممر الموجة 900 نانومتر؛ ( ب ) صور المسح السطحي PL للمنطقة الصغيرة TED و ( ج ) صور المسح السطحي للمنطقة الصغيرة TSD PL في الركيزة N-type 4H-SiC التي تم الحصول عليها في انبعاث 450 نانومتر ~ 750 نانومتر.
تعد زيادة حجم المادة وتقليل كثافة الخلع هي الاتجاهات العامة لتطوير ركائز 4H-SiC والأغشية الرقيقة الفوقي. لتقليل كثافة الخلع، من ناحية، من الضروري تحسين تصميم المجالات الحرارية والتدفقية، وتصميم تقنيات معالجة بلورات البذور أو الركيزة، وتحسين تقنيات المعالجة البلورية أو الفوقية لتقليل كثافة الخلع؛ من ناحية أخرى، واستنادا إلى تقنيات العملية الناضجة بشكل متزايد، هناك حاجة إلى مزيد من البحث المتعمق حول كيفية تعزيز التحول أو التفاعل بين أنواع مختلفة من الاضطرابات لتقليل كثافة الخلع المنخفضة. فيما يتعلق بتنظيم أداء الاضطرابات، هناك حاجة إلى مزيد من البحث حول كيفية تعزيز التفاعل بين الشوائب والعيوب النقطية مع الاضطرابات، وبالتالي ضبط موضع مستوى طاقة الخلل والسلوك الديناميكي للاضطرابات.
مرجع:
جياجون لي، غوانغ يانغ، شياوشوانغ ليو، هاو لو، لينغبو شو، ييكيانغ تشانغ، كان كوي، شياودونغ بي، ديرين يانغ ورونغ وانغ
الاضطرابات في كربيد السيليكون 4H
لمزيد من المعلومات، يرجى الاتصال بنا على البريد الإلكترونيvictorchan@powerwaywafer.com و powerwaymaterial@gmail.com.

