PAM-XIAMEN kan tilbyde SiC-wafere, specifikke specifikationer og parametre kan findes i:https://www.powerwaywafer.com/sic-wafer
4H-SiC enkeltkrystal har fremragende egenskaber såsom bred båndgab, høj bærermobilitet, høj termisk ledningsevne og god stabilitet. Det har brede anvendelsesmuligheder inden for højeffektelektronik, radiofrekvens-/mikrobølgeelektronik og kvanteinformation. Efter års udvikling er 6-tommer 4H SiC enkeltkrystalsubstrater og homogene epitaksielle tynde film blevet påført industrielt. Den totale dislokationstæthed i 4H SiC-wafere er dog stadig så høj som 103~104cm-2, hvilket hindrer det fulde potentiale af 4H-SiC wafere. Hvordan påvirker dislokationerne egenskaberne af 4H-SiC wafere og enheder? Den specifikke analyse er som følger:
1. Virkningen af dislokationer på elektriske egenskaber i 4H-SiC wafere og enheder
Forskning har analyseret forholdet mellem ydeevnen af 4H-SiC-wafere og enheder og fordelingen af dislokationer inden for den funktionelle region, hvilket tyder på, at tilstedeværelsen af dislokationer kan have negative virkninger på enhedens ydeevne. Derfor er undersøgelse af de elektriske egenskaber ved dislokationer i sig selv af stor betydning for forståelsen af deres adfærd i enheder.
1.1 Virkning af dislokationer på elektriske egenskaber i 4H-SiC-substrat
Ved at kombinere smeltet alkalikorrosion og Kelvin-probekraftmikroskopi (KPFM), kan det observeres, at gevindkantforskydning (TED) og basalplanforskydning (BPD) udviser acceptortilstande i højrent semi-isolerende (HPSI) 4H SiC-substrater og donortilstande i n-type 4H SiC-substrater (se figur 1). I det 4H SiC epitaksiale lag med lav dopingkoncentration blev det også fundet, at penetrerende dislokationer udviser acceptorkarakteristika. Første principberegninger har fundet ud af, at TED og BPD introducerer defekte energiniveauer, hvor energiniveauet nær bunden af valensbåndet er det tomme bånd. På grund af dominansen af defekter på dybe niveauer, såsom urenhedsatomer, kulstoftomgange (VC), eller ledige stillingspar (VC-VSi) i HPSI 4H SiC kan det ledige bånd, der indføres af dislokationer, modtage elektroner på dybt niveau, og dislokationer udviser acceptorkarakteristika. I n-type-substratet viser beregninger, at N-atomer er mere stabile i binding til TED- og BPD-dislokationer, derfor har N-atomer en tendens til at aggregere nær dislokationer. På grund af dominansen af doterede atomer i ledende substrater, kan aggregeringen af N-atomer forårsage donorkarakteristika for dislokationer.
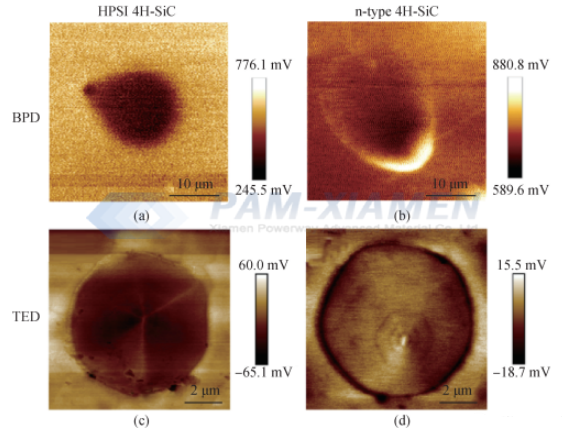
Fig. 1 Overfladepotentialfordeling af BPD og TED i HPSI og n-type 4H-SiC
1.2 Virkning af dislokationer på elektriske egenskaber af 4H-SiC-enheder
Ved at scanne mikrohullerne forårsaget af gevindskrueforskydning (TSD) viste C-AFM-testresultaterne en signifikant stigning i strømmen i bunden af mikrohullerne, mens overfladestrømmen i andre områder inde i mikrohullerne ikke var signifikant anderledes fra det udenfor mikrogruberne. Dette indikerer, at dislokationslinjerne af TSD i 4H SiC øger lækageeffekten. Derudover kan dislokationer som rekombinationscentre forårsage elektronhul-rekombination i 4H-SiC-effektenheder og også føre til et fald i enhedens pålidelighed.
Dislokationslinjer har ikke kun en indvirkning på enhedens ydeevne, men forårsager også overflademikrohuller i nanoskaladybden på overfladen af det epitaksiale lag på grund af forstyrrelsen af den eksterne trinstrøm forårsaget af dislokationslinjer. Tilstedeværelsen af mikrohuller kan også påvirke enhedens ydeevne. For eksempel, under højt tryk, vises mikroplasma ved mikrokraterpositionen forårsaget af gevinddislokation (TD), hvilket indikerer, at gate-ilten ved mikrokraterpositionen først nedbrydes. Tilstedeværelsen af mikrohuller kan også føre til et fald i levetiden for minoritetsbærere, en stigning i omvendt lækstrøm og et fald i fremadspænding, hvilket har negative virkninger på 4H SiC-baserede Schottky-barrieredioder (SBD'er), pn-junction-dioder (PND'er) og lavinefotodioder (se fig. 2 (a) og (b)).
Derfor mener nogle forskere, at den nuværende indvirkning af dislokationer på enhedens ydeevne hovedsageligt er forårsaget af mikrohuller, og at virkningen af dislokationslinjer selv er sekundær. Gennem simulering og eksperimenter blev det fundet, at udelukkelse af tilstedeværelsen af mikrogruber kan reducere virkningen af TSD på 4H-SiC-baserede enheder (se fig. 2 (c)). BPD kan også fungere som et sammensat center i 4H-SiC. Ved drift i 4H-SiC bipolære enheder, kan elektrisk indsprøjtning forårsage glidning af ufuldstændige dislokationer i siliciumkernen, hvilket fører til stablingsfejludvidelse og alvorligt påvirke enhedens fremad- og tilbagegående ydeevne. Det antages generelt, at stablingsfejl forårsaget af ufuldstændige dislokationer i siliciumkernen i BPD udvikles ved grænsefladen mellem substratet og det epitaksiale lag og udvider sig udad på overfladen af det epitaksiale lag. I betragtning af retningsbevægelsen af to ufuldstændige dislokationer i BPD er udvidelsen af stablingsfejl forårsaget af BPD kompleks. Forskning har fundet ud af, at stablingsfejl forårsaget af BPD også kan bevæge sig mod grænsefladen mellem substratet og epitaksiallaget (se fig. 2 (d)).
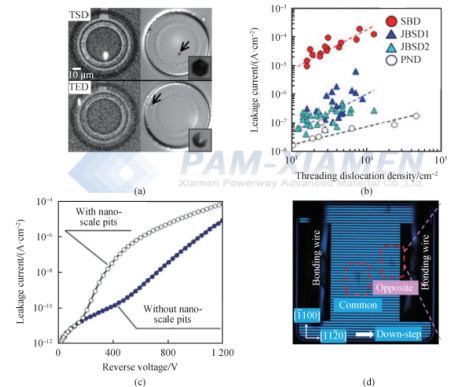
Fig. 2 Virkningen af dislokationer på lækstrømmen af 4H-SiC-effektenheder og udvidelsen af stablingsfejl i 4H-SiC: (a) EL-billeder af lavinedioder (venstre) og DIC-billeder efter smeltende KOH-korrosion (højre); (b) Forholdet mellem lækstrøm fra forskellige enheder og TDs tæthed; (c) Den omvendte lækageadfærd af 4H-SiC dioder og deres afhængighed af nano-huller; (d) EL-billede af 4H SiC PIN-enhed observeret af 420nm filter
2. Virkning af dislokationer på optiske egenskaber i 4H-SiC
Som et strålingsrekombinationscenter udviser dislokationer i 4H-SiC fotoluminescens, og kontrasten af dislokationsfotoluminescens (PL) afhænger af minoritetsbærernes levetid. Når koncentrationen af dybe niveaudefekter i krystallen er lav, er minoritetsbærerens levetid lang, og nok minoritetsbærere bevæger sig til dislokationsområdet til at rekombinere og udsende lys. På dette tidspunkt er luminescensintensiteten af dislokationsregionen højere end andre regioners luminescensintensitet, hvilket fremstår som et lyst sted. Når koncentrationen af dybe niveaudefekter i krystallen er høj, er minoritetsbærerens levetid lav, og den kombineres med nærliggende dybe niveaudefekter for at udsende lys. Rekombinationen ved dislokationen undertrykkes, og emissionsintensiteten i dislokationsområdet er svagere end i andre regioner og udviser en mørk plet. Eksperimentet fandt, at i PL-testning, for 4H-SiC med en levetid for minoritetsbærere mindre end 0,5 μs, kan de fleste minoritetsbærere ikke migrere til dislokationer, og et lille antal minoritetsbærere fanges af iboende defekter. Dislokationer viser ikke signifikant kontrast i PL-overfladescanningsbilledet. Når levetiden for minoritetsbærere er større end 0,5 μs, kan elektronhulsrekombinationen ved dislokationen signifikant skelne dislokationens kontrast fra andre regioner.
TSD og TED udviser forskellige størrelser af mørke eller lyse pletter i PL-overfladescanningsbillederne af 4H-SiC. De iboende PL-emissionstoppe for TED og TSD er placeret ved henholdsvis 600nm og 800-850nm. BPD vises som mørke eller lyse linjer i PL-overfladescanningsbilledet af 4H-SiC (se fig. 3 (a)). PL-emissionstoppene for BPD'er stammer fra PL-emissionstoppene af ufuldstændige dislokationer og stablingsfejl, der udgør BPD'er. Emissionstoppene for ufuldstændige dislokationer af siliciumkerne, ufuldstændige dislokationer af kulstofkerner og stablingsfejl er placeret ved henholdsvis 670-700 nm, 720-850 nm og 420 nm. Ved at justere bølgelængden af det udsendte lys kan visningen af enkelte ufuldstændige dislokationer og stablingsfejl opnås separat.
For nylig har forskere også fundet ud af, at TD'er kan øge D1-luminescensen af 4H-SiC, som vist i Fig. 3 (b) og (c), som repræsenterer luminescensintensiteten af henholdsvis TED- og TSD-korrosionsgrave. Dette betyder, at intensiteten af D1-luminescens også kan afspejle tætheden og fordelingen af dislokationer i 4H-SiC-substratet og epitaksiallaget.

Fig. 3 Luminescerende egenskaber af dislokationer i 4H-SiC: (a) Mikroareal PL overfladescanningsbilleder af 4H SiC epitaksiale tynde film opnået ved anvendelse af et 900 nm båndpasfilter; (b) TED mikroregion PL overfladescanningsbilleder og (c) TSD mikroregion PL overfladescanningsbilleder i N-type 4H-SiC substrat opnået i emissionen på 450nm~750nm.
Forøgelse af materialestørrelse og reduktion af dislokationstæthed er de overordnede retninger for udviklingen af 4H-SiC-substrater og epitaksiale tynde film. For at reducere dislokationstætheden er det på den ene side nødvendigt at optimere designet af termiske felter og strømningsfelter, designe frøkrystal- eller substratbehandlingsteknikker og optimere enkeltkrystal- eller epitaksiale procesteknologier for at reducere dislokationstætheden; På den anden side, baseret på de stadig mere modne procesteknologier, er der behov for yderligere dybdegående forskning i, hvordan man kan fremme transformationen eller reaktionen mellem forskellige typer af dislokationer for at reducere lav dislokationstæthed. Med hensyn til regulering af ydeevnen af dislokationer er der behov for yderligere forskning i, hvordan man kan fremme reaktionen mellem urenheder og punktdefekter med dislokationer, og derved justere defektens energiniveauposition og dynamiske adfærd af dislokationer.
Reference:
Jiajun Li, Guang Yang, Xiaoshuang Liu, Hao Luo, Lingbo Xu, Yiqiang Zhang, Can Cui, Xiaodong Pi, Deren Yang og Rong Wang
Dislokationer i 4H siliciumcarbid
For mere information, kontakt os venligst e-mail påvictorchan@powerwaywafer.com og powerwaymaterial@gmail.com.

