PAM-XIAMEN puede ofrecer obleas de SiC, las especificaciones y parámetros específicos se pueden encontrar en:https://www.powerwaywafer.com/sic-wafer
El monocristal 4H-SiC tiene excelentes características como banda prohibida amplia, alta movilidad del portador, alta conductividad térmica y buena estabilidad. Tiene amplias perspectivas de aplicación en electrónica de alta potencia, electrónica de radiofrecuencia/microondas e información cuántica. Después de años de desarrollo, se han aplicado industrialmente sustratos monocristalinos de SiC 4H de 6 pulgadas y películas delgadas epitaxiales homogéneas. Sin embargo, la densidad total de dislocaciones en las obleas de 4H SiC sigue siendo tan alta como 103~104cm-2, lo que impide aprovechar todo el potencial de las obleas de 4H-SiC. ¿Cómo afectan las dislocaciones a las propiedades de las obleas y dispositivos de 4H-SiC? El análisis específico es el siguiente:
1. El efecto de las dislocaciones sobre las propiedades eléctricas en dispositivos y obleas de 4H-SiC
La investigación ha analizado la relación entre el rendimiento de las obleas y dispositivos de 4H-SiC y la distribución de las dislocaciones dentro de la región funcional, lo que sugiere que la presencia de dislocaciones puede tener efectos adversos en el rendimiento del dispositivo. Por lo tanto, estudiar las propiedades eléctricas de las propias dislocaciones es de gran importancia para comprender su comportamiento en los dispositivos.
1.1 Efecto de las dislocaciones sobre las propiedades eléctricas del sustrato 4H-SiC
Al combinar la corrosión alcalina fundida y la microscopía de fuerza de sonda Kelvin (KPFM), se puede observar que la dislocación del borde de roscado (TED) y la dislocación del plano basal (BPD) exhiben estados aceptores en sustratos de SiC 4H semiaislantes de alta pureza (HPSI) y estados donantes. en sustratos de SiC 4H tipo n (ver Figura 1). En la capa epitaxial de 4H SiC con baja concentración de dopaje, también se encontró que las dislocaciones penetrantes exhiben características aceptoras. Los cálculos de primeros principios han encontrado que TED y BPD introducen niveles de energía defectuosos, siendo el nivel de energía cerca del fondo de la banda de valencia la banda vacía. Debido al predominio de defectos de nivel profundo, como átomos de impurezas, vacantes de carbono (VC), o pares de vacantes (VC-VSi) en HPSI 4H SiC, la banda vacante introducida por las dislocaciones puede recibir electrones de nivel profundo y las dislocaciones exhiben características aceptoras. En el sustrato de tipo n, los cálculos muestran que los átomos de N son más estables al unirse a las dislocaciones TED y BPD, por lo tanto, los átomos de N tienden a agregarse cerca de las dislocaciones. Debido al predominio de los átomos dopados en los sustratos conductores, la agregación de átomos de N puede provocar dislocaciones con características donantes.
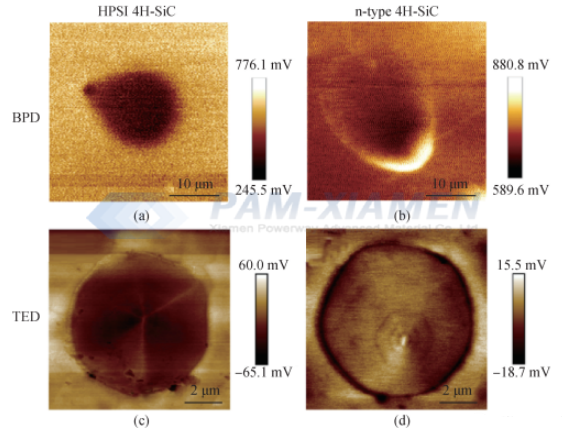
Fig. 1 Distribución del potencial superficial de BPD y TED en HPSI y 4H-SiC tipo n
1.2 Efecto de las dislocaciones sobre las propiedades eléctricas de los dispositivos 4H-SiC
Al escanear los micro hoyos causados por la dislocación del tornillo roscado (TSD), los resultados de la prueba C-AFM mostraron un aumento significativo en la corriente en el fondo de los micro hoyos, mientras que la corriente superficial en otras áreas dentro de los micro hoyos no fue significativamente diferente. desde afuera de los micro pozos. Esto indica que las líneas de dislocación de TSD en 4H SiC mejoran el efecto de fuga. Además, las dislocaciones como centros de recombinación pueden causar recombinación de huecos de electrones en dispositivos de potencia de 4H-SiC y también conducir a una disminución de la confiabilidad del dispositivo.
Las líneas de dislocación no solo tienen un impacto en el rendimiento del dispositivo, sino que también causan micropicaduras en la superficie a una profundidad de nanoescala en la superficie de la capa epitaxial debido a la alteración del flujo escalonado externo causado por las líneas de dislocación. La presencia de micro hoyos también puede afectar el rendimiento del dispositivo. Por ejemplo, bajo alta presión, aparece microplasma en la posición del microcráter causado por la dislocación del hilo (TD), lo que indica que el oxígeno de la puerta en la posición del microcráter se descompone primero. La presencia de micropicaduras también puede provocar una disminución en la vida útil de los portadores minoritarios, un aumento en la corriente de fuga inversa y una disminución en el voltaje directo, lo que tiene efectos adversos en los diodos de barrera Schottky (SBD) basados en 4H SiC y en los diodos de unión pn. (PND) y fotodiodos de avalancha (ver Fig. 2 (a) y (b)).
Por lo tanto, algunos investigadores creen que el impacto actual de las dislocaciones en el rendimiento del dispositivo es causado principalmente por micropozos, y el impacto de las líneas de dislocación en sí es secundario. A través de simulaciones y experimentos, se descubrió que excluir la presencia de micropicaduras puede reducir el impacto de TSD en dispositivos basados en 4H-SiC (ver Fig. 2 (c)). BPD también puede servir como centro compuesto en 4H-SiC. Cuando se opera en dispositivos bipolares 4H-SiC, la inyección eléctrica puede causar deslizamientos de dislocaciones incompletas en el núcleo de silicio, lo que lleva a la expansión de fallas de apilamiento y afecta seriamente el rendimiento hacia adelante y hacia atrás del dispositivo. En general, se cree que las fallas de apilamiento causadas por dislocaciones incompletas en el núcleo de silicio en BPD se desarrollan en la interfaz entre el sustrato y la capa epitaxial, y se expanden hacia afuera en la superficie de la capa epitaxial. Considerando el movimiento direccional de dos dislocaciones incompletas en BPD, la expansión de las fallas de apilamiento causadas por BPD es compleja. Las investigaciones han descubierto que las fallas de apilamiento causadas por BPD también pueden moverse hacia la interfaz entre el sustrato y la capa epitaxial (ver Fig. 2 (d)).
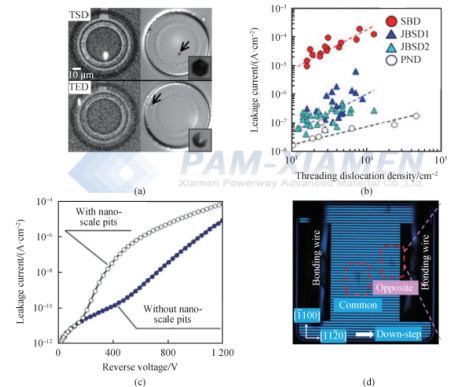
Fig. 2 El efecto de las dislocaciones en la corriente de fuga de los dispositivos de potencia 4H-SiC y la expansión de fallas de apilamiento en 4H-SiC: (a) imágenes EL de diodos de avalancha (izquierda) e imágenes DIC después de fundir la corrosión de KOH (derecha); (b) La relación entre la corriente de fuga de diferentes dispositivos y la densidad de los TD; (c) El comportamiento de fuga inversa de los diodos 4H-SiC y su dependencia de los nanopozos; (d) Imagen EL del dispositivo PIN 4H SiC observado mediante un filtro de 420 nm
2. Efecto de las dislocaciones sobre las propiedades ópticas del 4H-SiC
Como centro de recombinación radiativa, las dislocaciones en 4H-SiC exhiben fotoluminiscencia, y el contraste de la fotoluminiscencia (PL) de las dislocaciones depende de la vida útil de los portadores minoritarios. Cuando la concentración de defectos de nivel profundo en el cristal es baja, la vida útil de los portadores minoritarios es larga y suficientes portadores minoritarios se mueven a la región de dislocación para recombinarse y emitir luz. En este momento, la intensidad de luminiscencia de la región de dislocación es mayor que la de otras regiones, apareciendo como un punto brillante. Cuando la concentración de defectos de nivel profundo en el cristal es alta, la vida útil del portador minoritario es baja y se combina con defectos de nivel profundo cercanos para emitir luz. La recombinación en la dislocación se suprime y la intensidad de la emisión en la región de la dislocación es más débil que en otras regiones, exhibiendo una mancha oscura. El experimento encontró que en las pruebas de PL, para el 4H-SiC con una vida útil de los portadores minoritarios inferior a 0,5 μs, la mayoría de los portadores minoritarios no pueden migrar a dislocaciones y un pequeño número de portadores minoritarios quedan capturados por defectos inherentes. Las dislocaciones no muestran un contraste significativo en la imagen de exploración de la superficie PL. Cuando la vida útil de los portadores minoritarios es superior a 0,5 μs, la recombinación del hueco de electrones en la dislocación puede distinguir significativamente el contraste de la dislocación con respecto a otras regiones.
TSD y TED exhiben diferentes tamaños de puntos oscuros o brillantes en las imágenes de escaneo de superficie PL de 4H-SiC. Los picos de emisión intrínsecos de PL de TED y TSD se encuentran a 600 nm y 800-850 nm, respectivamente. BPD aparece como líneas oscuras o brillantes en la imagen de escaneo de superficie PL de 4H-SiC (ver Fig.3 (a)). Los picos de emisión de PL de los BPD se originan a partir de los picos de emisión de PL de dislocaciones incompletas y fallas de apilamiento que componen los BPD. Los picos de emisión de dislocaciones incompletas del núcleo de silicio, dislocaciones incompletas del núcleo de carbono y fallas de apilamiento se ubican a 670-700 nm, 720-850 nm y 420 nm, respectivamente. Al ajustar la longitud de onda de la luz emitida, se puede lograr por separado la visualización de dislocaciones individuales incompletas y fallas de apilamiento.
Recientemente, los investigadores también han descubierto que los TD pueden mejorar la luminiscencia D1 del 4H-SiC, como se muestra en las figuras 3 (b) y (c), que representan la intensidad de luminiscencia de las picaduras de corrosión de TED y TSD, respectivamente. Esto significa que la intensidad de la luminiscencia D1 también puede reflejar la densidad y distribución de las dislocaciones en el sustrato 4H-SiC y la capa epitaxial.

Fig. 3 Propiedades luminiscentes de las dislocaciones en 4H-SiC: (a) Imágenes de escaneo de superficie PL de microárea de películas delgadas epitaxiales de 4H SiC obtenidas utilizando un filtro de paso de banda de 900 nm; (b) Imágenes de escaneo de superficie PL de la microrregión TED y (c) Imágenes de escaneo de superficie PL de la microrregión TSD en sustrato 4H-SiC tipo N obtenidas en la emisión de 450 nm ~ 750 nm.
Aumentar el tamaño del material y reducir la densidad de dislocaciones son las direcciones generales para el desarrollo de sustratos de 4H-SiC y películas delgadas epitaxiales. Para reducir la densidad de dislocaciones, por un lado, es necesario optimizar el diseño de los campos térmicos y de flujo, diseñar técnicas de tratamiento de sustrato o cristal semilla y optimizar las tecnologías de proceso epitaxial o de monocristal para reducir la densidad de dislocaciones; Por otro lado, basándose en las tecnologías de proceso cada vez más maduras, se necesita una investigación más profunda sobre cómo promover la transformación o reacción entre diferentes tipos de dislocaciones para reducir la baja densidad de dislocaciones. En términos de regular el desempeño de las dislocaciones, se necesita más investigación sobre cómo promover la reacción entre las impurezas y los defectos puntuales con las dislocaciones, ajustando así la posición del nivel de energía del defecto y el comportamiento dinámico de las dislocaciones.
Referencia:
Jiajun Li, Guang Yang, Xiaoshuang Liu, Hao Luo, Lingbo Xu, Yiqiang Zhang, Can Cui, Xiaodong Pi, Deren Yang y Rong Wang
Dislocaciones en carburo de silicio 4H
Para obtener más información, por favor contáctenos por correo electrónico avictorchan@powerwaywafer.comypowerwaymaterial@gmail.com.

