PAM-XIAMEN kann SiC-Wafer anbieten. Spezifische Spezifikationen und Parameter finden Sie in:https://www.powerwaywafer.com/sic-wafer
4H-SiC-Einkristall weist hervorragende Eigenschaften wie große Bandlücke, hohe Trägermobilität, hohe Wärmeleitfähigkeit und gute Stabilität auf. Es bietet breite Anwendungsaussichten in der Hochleistungselektronik, der Hochfrequenz-/Mikrowellenelektronik und der Quanteninformation. Nach Jahren der Entwicklung wurden 6-Zoll-4H-SiC-Einkristallsubstrate und homogene epitaktische Dünnfilme industriell eingesetzt. Allerdings beträgt die Gesamtversetzungsdichte in 4H-SiC-Wafern immer noch bis zu 103~104cm-2, was das volle Potenzial von 4H-SiC-Wafern beeinträchtigt. Wie wirken sich die Versetzungen auf die Eigenschaften von 4H-SiC-Wafern und -Geräten aus? Die spezifische Analyse lautet wie folgt:
1. Die Auswirkung von Versetzungen auf die elektrischen Eigenschaften in 4H-SiC-Wafern und -Geräten
Die Forschung hat den Zusammenhang zwischen der Leistung von 4H-SiC-Wafern und -Geräten und der Verteilung von Versetzungen innerhalb des Funktionsbereichs analysiert, was darauf hindeutet, dass das Vorhandensein von Versetzungen negative Auswirkungen auf die Geräteleistung haben kann. Daher ist die Untersuchung der elektrischen Eigenschaften von Versetzungen selbst von großer Bedeutung für das Verständnis ihres Verhaltens in Geräten.
1.1 Einfluss von Versetzungen auf die elektrischen Eigenschaften im 4H-SiC-Substrat
Durch die Kombination von Korrosion durch geschmolzenes Alkali und Kelvin-Sondenkraftmikroskopie (KPFM) kann beobachtet werden, dass Threading-Edge-Dislokation (TED) und Basalebenen-Dislokation (BPD) Akzeptorzustände in hochreinen halbisolierenden (HPSI) 4H-SiC-Substraten und Donorzuständen aufweisen in n-Typ-4H-SiC-Substraten (siehe Abbildung 1). In der 4H-SiC-Epitaxieschicht mit niedriger Dotierungskonzentration wurde außerdem festgestellt, dass eindringende Versetzungen Akzeptoreigenschaften aufweisen. First-Principles-Rechnungen haben ergeben, dass TED und BPD Defektenergieniveaus einführen, wobei das Energieniveau am unteren Ende des Valenzbands das leere Band ist. Aufgrund der Dominanz von Defekten auf tiefer Ebene, wie z. B. Verunreinigungsatomen, Kohlenstofffehlstellen (VC) oder Leerstellenpaare (VC-VSi) in HPSI 4H SiC kann das durch Versetzungen eingeführte Leerstellenband Elektronen aus tiefen Schichten aufnehmen und Versetzungen weisen Akzeptoreigenschaften auf. Berechnungen zeigen, dass N-Atome im n-Typ-Substrat stabiler an TED- und BPD-Versetzungen binden, weshalb N-Atome dazu neigen, in der Nähe von Versetzungen zu aggregieren. Aufgrund der Dominanz dotierter Atome in leitfähigen Substraten kann die Aggregation von N-Atomen zu Donoreigenschaften von Versetzungen führen.
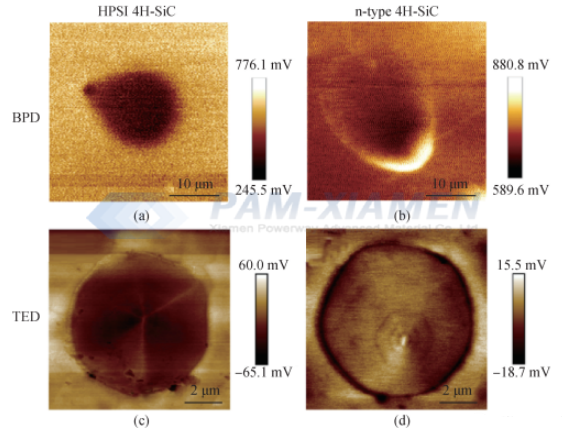
Abb. 1 Oberflächenpotentialverteilung von BPD und TED in HPSI und n-Typ 4H-SiC
1.2 Einfluss von Versetzungen auf die elektrischen Eigenschaften von 4H-SiC-Geräten
Beim Scannen der durch Gewindeschraubenversetzung (TSD) verursachten Mikrogruben zeigten die C-AFM-Testergebnisse einen signifikanten Anstieg des Stroms am Boden der Mikrogruben, während sich der Oberflächenstrom in anderen Bereichen innerhalb der Mikrogruben nicht wesentlich unterschied davon außerhalb der Mikrogruben. Dies weist darauf hin, dass die Versetzungslinien von TSD in 4H-SiC den Leckeffekt verstärken. Darüber hinaus können Versetzungen als Rekombinationszentren eine Rekombination von Elektronenlöchern in 4H-SiC-Leistungsbauelementen verursachen und auch zu einer Verringerung der Gerätezuverlässigkeit führen.
Versetzungslinien wirken sich nicht nur auf die Geräteleistung aus, sondern verursachen aufgrund der durch Versetzungslinien verursachten Störung des externen Stufenflusses auch Oberflächenmikrogruben in nanoskaliger Tiefe auf der Oberfläche der Epitaxieschicht. Das Vorhandensein von Mikrogruben kann sich auch auf die Geräteleistung auswirken. Beispielsweise erscheint unter hohem Druck Mikroplasma an der Mikrokraterposition, das durch eine Fadenversetzung (TD) verursacht wird, was darauf hindeutet, dass der Gate-Sauerstoff an der Mikrokraterposition zuerst abgebaut wird. Das Vorhandensein von Mikrogruben kann auch zu einer Verkürzung der Lebensdauer von Minoritätsträgern, einem Anstieg des Sperrleckstroms und einer Verringerung der Durchlassspannung führen, was sich nachteilig auf 4H-SiC-basierte Schottky-Barrierendioden (SBDs) und pn-Übergangsdioden auswirkt (PNDs) und Lawinenphotodioden (siehe Abb. 2 (a) und (b)).
Daher glauben einige Forscher, dass die aktuellen Auswirkungen von Versetzungen auf die Geräteleistung hauptsächlich durch Mikrovertiefungen verursacht werden und dass die Auswirkungen von Versetzungslinien selbst zweitrangig sind. Durch Simulationen und Experimente wurde festgestellt, dass der Ausschluss des Vorhandenseins von Mikrogruben die Auswirkungen von TSD auf 4H-SiC-basierte Geräte verringern kann (siehe Abb. 2 (c)). BPD kann auch als Verbundzentrum in 4H-SiC dienen. Beim Betrieb in bipolaren 4H-SiC-Geräten kann die elektrische Einspeisung zum Verrutschen unvollständiger Versetzungen im Siliziumkern führen, was zu einer Stapelfehlerausdehnung führt und die Vorwärts- und Rückwärtsleistung des Geräts ernsthaft beeinträchtigt. Es wird allgemein angenommen, dass die Stapelfehler, die durch unvollständige Versetzungen im Siliziumkern bei BPD verursacht werden, an der Grenzfläche zwischen dem Substrat und der Epitaxieschicht entstehen und sich auf der Oberfläche der Epitaxieschicht nach außen ausdehnen. Betrachtet man die Richtungsbewegung zweier unvollständiger Versetzungen in BPD, ist die durch BPD verursachte Ausbreitung von Stapelfehlern komplex. Untersuchungen haben ergeben, dass durch BPD verursachte Stapelfehler auch in Richtung der Grenzfläche zwischen Substrat und Epitaxieschicht wandern können (siehe Abb. 2 (d)).
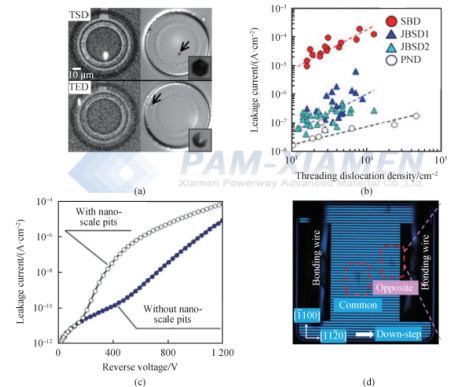
Abb. 2 Die Auswirkung von Versetzungen auf den Leckstrom von 4H-SiC-Leistungsbauelementen und die Ausbreitung von Stapelfehlern in 4H-SiC: (a) EL-Bilder von Lawinendioden (links) und DIC-Bilder nach Schmelzkorrosion von KOH (rechts); (b) Die Beziehung zwischen dem Leckstrom verschiedener Geräte und der TD-Dichte; (c) Das Sperrleckverhalten von 4H-SiC-Dioden und ihre Abhängigkeit von Nano-Pits; (d) EL-Bild eines 4H-SiC-PIN-Geräts, beobachtet mit einem 420-nm-Filter
2. Einfluss von Versetzungen auf die optischen Eigenschaften in 4H-SiC
Als strahlendes Rekombinationszentrum zeigen Versetzungen in 4H-SiC Photolumineszenz, und der Kontrast der Versetzungsphotolumineszenz (PL) hängt von der Lebensdauer der Minoritätsträger ab. Wenn die Konzentration tiefer Defekte im Kristall niedrig ist, ist die Lebensdauer der Minoritätsträger lang und es bewegen sich genügend Minoritätsträger in den Versetzungsbereich, um dort zu rekombinieren und Licht zu emittieren. Zu diesem Zeitpunkt ist die Lumineszenzintensität der Versetzungsregion höher als die anderer Regionen und erscheint als heller Fleck. Wenn die Konzentration von Defekten tiefer Ebenen im Kristall hoch ist, ist die Lebensdauer der Minoritätsträger gering und sie verbinden sich mit nahegelegenen Defekten tiefer Ebenen, um Licht zu emittieren. Die Rekombination an der Versetzung wird unterdrückt und die Emissionsintensität in der Versetzungsregion ist schwächer als in anderen Regionen und weist einen dunklen Fleck auf. Das Experiment ergab, dass bei PL-Tests für 4H-SiC mit einer Lebensdauer der Minoritätsträger von weniger als 0,5 μs die meisten Minoritätsträger nicht zu Versetzungen wandern können und eine kleine Anzahl von Minoritätsträgern durch inhärente Defekte eingefangen wird. Versetzungen zeigen im PL-Oberflächenscanbild keinen signifikanten Kontrast. Wenn die Lebensdauer der Minoritätsträger mehr als 0,5 μs beträgt, kann die Elektronen-Loch-Rekombination an der Versetzung den Kontrast der Versetzung deutlich von anderen Regionen unterscheiden.
TSD und TED weisen in den PL-Oberflächenscanbildern von 4H-SiC unterschiedliche Größen dunkler oder heller Flecken auf. Die intrinsischen PL-Emissionsspitzen von TED und TSD liegen bei 600 nm bzw. 800–850 nm. BPD erscheint als dunkle oder helle Linien im PL-Oberflächenscanbild von 4H-SiC (siehe Abb. 3 (a)). Die PL-Emissionsspitzen von BPDs stammen von den PL-Emissionsspitzen unvollständiger Versetzungen und Stapelfehler, aus denen BPDs bestehen. Die Emissionsspitzen unvollständiger Siliziumkernversetzungen, unvollständiger Kohlenstoffkernversetzungen und Stapelfehler liegen bei 670–700 nm, 720–850 nm bzw. 420 nm. Durch die Anpassung der Wellenlänge des emittierten Lichts kann die getrennte Darstellung einzelner unvollständiger Versetzungen und Stapelfehler erreicht werden.
Kürzlich haben Forscher auch herausgefunden, dass TDs die D1-Lumineszenz von 4H-SiC verstärken können, wie in Abb. 3 (b) und (c) gezeigt, die die Lumineszenzintensität von TED- bzw. TSD-Korrosionsgruben darstellen. Dies bedeutet, dass die Intensität der D1-Lumineszenz auch die Dichte und Verteilung von Versetzungen im 4H-SiC-Substrat und in der Epitaxieschicht widerspiegeln kann.

Abb. 3 Lumineszenzeigenschaften von Versetzungen in 4H-SiC: (a) Mikrobereichs-PL-Oberflächenscanbilder von epitaktischen 4H-SiC-Dünnfilmen, die mit einem 900-nm-Bandpassfilter erhalten wurden; (b) TED-Mikroregion-PL-Oberflächenscanbilder und (c) TSD-Mikroregion-PL-Oberflächenscanbilder in 4H-SiC-Substrat vom N-Typ, erhalten bei der Emission von 450 nm bis 750 nm.
Die zunehmende Materialgröße und die Verringerung der Versetzungsdichte sind die allgemeinen Richtungen für die Entwicklung von 4H-SiC-Substraten und epitaktischen Dünnfilmen. Um die Versetzungsdichte zu reduzieren, ist es einerseits notwendig, das Design von Wärme- und Strömungsfeldern zu optimieren, Impfkristall- oder Substratbehandlungstechniken zu entwerfen und Einkristall- oder Epitaxieprozesstechnologien zu optimieren, um die Versetzungsdichte zu reduzieren; Andererseits bedarf es aufgrund der immer ausgereifteren Prozesstechnologien weiterer eingehender Forschung darüber, wie die Transformation oder Reaktion zwischen verschiedenen Versetzungstypen gefördert werden kann, um eine geringe Versetzungsdichte zu reduzieren. Im Hinblick auf die Regulierung der Leistung von Versetzungen sind weitere Untersuchungen erforderlich, um die Reaktion zwischen Verunreinigungen und Punktdefekten mit Versetzungen zu fördern und dadurch die Position des Defektenergieniveaus und das dynamische Verhalten von Versetzungen anzupassen.
Referenz:
Jiajun Li, Guang Yang, Xiaoshuang Liu, Hao Luo, Lingbo Xu, Yiqiang Zhang, Can Cui, Xiaodong Pi, Deren Yang und Rong Wang
Versetzungen in 4H-Siliziumkarbid
Für weitere Informationen kontaktieren Sie uns bitte per E-Mail untervictorchan@powerwaywafer.com und powerwaymaterial@gmail.com.

