PAM-XIAMEN peut proposer des plaquettes SiC. Les spécifications et paramètres spécifiques peuvent être trouvés dans :https://www.powerwaywafer.com/sic-wafer
Le monocristal 4H-SiC présente d'excellentes caractéristiques telles qu'une large bande interdite, une mobilité élevée des porteurs, une conductivité thermique élevée et une bonne stabilité. Il a de larges perspectives d’application dans l’électronique de haute puissance, l’électronique radiofréquence/micro-ondes et l’information quantique. Après des années de développement, des substrats monocristallins 4H SiC de 6 pouces et des films minces épitaxiaux homogènes ont été appliqués industriellement. Cependant, la densité totale de dislocations dans les tranches de SiC 4H atteint toujours 103~104cm-2, ce qui entrave le plein potentiel des plaquettes 4H-SiC. Comment les dislocations affectent-elles les propriétés des plaquettes et des dispositifs 4H-SiC ? L’analyse spécifique est la suivante :
1. L'effet des dislocations sur les propriétés électriques des plaquettes et des dispositifs 4H-SiC
La recherche a analysé la relation entre les performances des plaquettes et des dispositifs 4H-SiC et la répartition des luxations dans la région fonctionnelle, suggérant que la présence de luxations peut avoir des effets néfastes sur les performances des dispositifs. Par conséquent, l’étude des propriétés électriques des dislocations elles-mêmes revêt une grande importance pour comprendre leur comportement dans les dispositifs.
1.1 Effet des dislocations sur les propriétés électriques du substrat 4H-SiC
En combinant la corrosion par les alcalis fondus et la microscopie à force de sonde Kelvin (KPFM), on peut observer que la dislocation du bord de filetage (TED) et la dislocation du plan basal (BPD) présentent des états accepteurs dans les substrats SiC 4H semi-isolants de haute pureté (HPSI) et les états donneurs. dans des substrats SiC 4H de type n (voir Figure 1). Dans la couche épitaxiale de SiC 4H à faible concentration de dopage, il a également été constaté que les dislocations pénétrantes présentent des caractéristiques d'accepteur. Les calculs des premiers principes ont montré que TED et BPD introduisent des niveaux d'énergie défectueux, le niveau d'énergie situé près du bas de la bande de valence étant la bande vide. En raison de la prédominance de défauts profonds tels que les atomes d'impuretés, les lacunes en carbone (VC), ou des paires de postes vacants (VC-VSi) dans HPSI 4H SiC, la bande vacante introduite par les dislocations peut recevoir des électrons de niveau profond et les dislocations présentent des caractéristiques d'accepteur. Dans le substrat de type n, les calculs montrent que les atomes de N sont plus stables dans leur liaison aux dislocations TED et BPD, par conséquent les atomes de N ont tendance à s'agréger à proximité des dislocations. En raison de la prédominance d’atomes dopés dans les substrats conducteurs, l’agrégation d’atomes de N peut provoquer des dislocations caractéristiques de donneur.
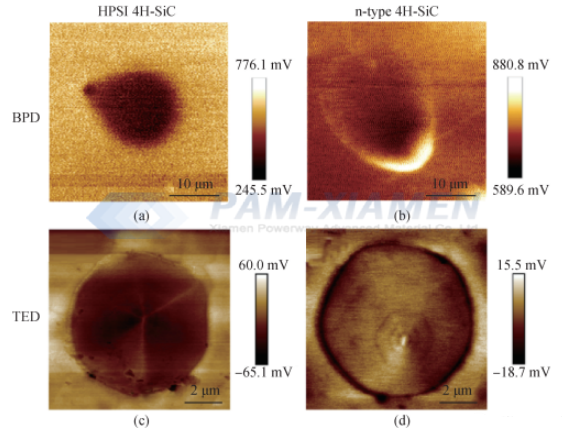
Fig. 1 Distribution du potentiel de surface du BPD et du TED dans le HPSI et le 4H-SiC de type n
1.2 Effet des dislocations sur les propriétés électriques des dispositifs 4H-SiC
En scannant les micro-puits provoqués par la dislocation des vis filetées (TSD), les résultats du test C-AFM ont montré une augmentation significative du courant au fond des micro-puits, tandis que le courant de surface dans d'autres zones à l'intérieur des micro-puits n'était pas significativement différent. de cela en dehors des micro-fosses. Cela indique que les lignes de dislocation du TSD dans le SiC 4H renforcent l'effet de fuite. De plus, les dislocations en tant que centres de recombinaison peuvent provoquer une recombinaison de trous électroniques dans les dispositifs de puissance 4H-SiC et également entraîner une diminution de la fiabilité des dispositifs.
Les lignes de dislocation ont non seulement un impact sur les performances du dispositif, mais provoquent également des micro-piqûres de surface à l'échelle nanométrique sur la surface de la couche épitaxiale en raison de la perturbation de l'écoulement échelonné externe provoquée par les lignes de dislocation. La présence de micro-piqûres peut également affecter les performances de l'appareil. Par exemple, sous haute pression, un micro plasma apparaît à la position du micro cratère provoqué par une luxation du filetage (TD), indiquant que l'oxygène de la porte à la position du micro cratère est d'abord décomposé. La présence de micro-piqûres peut également entraîner une diminution de la durée de vie des porteurs minoritaires, une augmentation du courant de fuite inverse et une diminution de la tension directe, ce qui a des effets néfastes sur les diodes à barrière Schottky (SBD) à base de SiC 4H et les diodes à jonction pn. (PND) et photodiodes à avalanche (voir Fig. 2 (a) et (b)).
Par conséquent, certains chercheurs pensent que l’impact actuel des luxations sur les performances de l’appareil est principalement dû aux micro-piqûres et que l’impact des lignes de luxation elles-mêmes est secondaire. Grâce à des simulations et à des expériences, il a été constaté que l'exclusion de la présence de micropuces peut réduire l'impact du TSD sur les dispositifs basés sur 4H-SiC (voir Fig. 2 (c)). BPD peut également servir de centre composite dans le 4H-SiC. Lors du fonctionnement dans des dispositifs bipolaires 4H-SiC, l'injection électrique peut provoquer un glissement de luxations incomplètes dans le noyau de silicium, conduisant à une expansion des défauts d'empilement et affectant sérieusement les performances avant et arrière du dispositif. On pense généralement que les défauts d'empilement provoqués par des dislocations incomplètes dans le noyau de silicium dans le BPD se développent à l'interface entre le substrat et la couche épitaxiale et s'étendent vers l'extérieur sur la surface de la couche épitaxiale. Compte tenu du mouvement directionnel de deux luxations incomplètes dans le BPD, l’expansion des défauts d’empilement provoqués par le BPD est complexe. Des recherches ont montré que les défauts d'empilement provoqués par le BPD peuvent également se déplacer vers l'interface entre le substrat et la couche épitaxiale (voir Fig. 2 (d)).
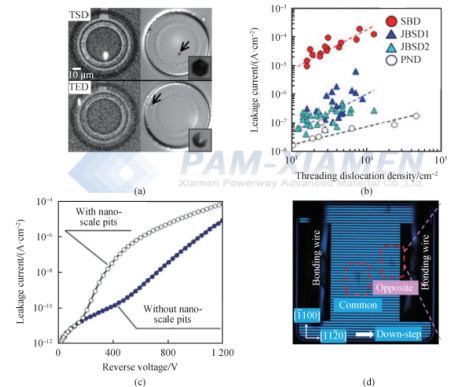
Fig. 2 Effet des dislocations sur le courant de fuite des dispositifs d'alimentation en 4H-SiC et expansion des défauts d'empilement dans le 4H-SiC : (a) Images EL de diodes à avalanche (à gauche) et images DIC après fusion de la corrosion du KOH (à droite) ; (b) La relation entre le courant de fuite de différents appareils et la densité des TD ; (c) Le comportement de fuite inverse des diodes 4H-SiC et leur dépendance aux nano-puits ; (d) Image EL du dispositif PIN SiC 4H observée par un filtre de 420 nm
2. Effet des dislocations sur les propriétés optiques du 4H-SiC
En tant que centre de recombinaison radiative, les dislocations dans le 4H-SiC présentent une photoluminescence et le contraste de la photoluminescence des dislocations (PL) dépend de la durée de vie des porteurs minoritaires. Lorsque la concentration de défauts profonds dans le cristal est faible, la durée de vie des porteurs minoritaires est longue et suffisamment de porteurs minoritaires se déplacent vers la région de dislocation pour se recombiner et émettre de la lumière. À ce stade, l’intensité de luminescence de la région de dislocation est supérieure à celle des autres régions, apparaissant comme un point lumineux. Lorsque la concentration de défauts profonds dans le cristal est élevée, la durée de vie du porteur minoritaire est faible et elle se combine avec les défauts profonds proches pour émettre de la lumière. La recombinaison au niveau de la dislocation est supprimée et l'intensité de l'émission dans la région de dislocation est plus faible que dans les autres régions, présentant une tache sombre. L'expérience a révélé que lors des tests PL, pour le 4H-SiC avec une durée de vie des porteurs minoritaires inférieure à 0,5 μs, la plupart des porteurs minoritaires ne peuvent pas migrer vers des luxations et qu'un petit nombre de porteurs minoritaires sont capturés par des défauts inhérents. Les luxations ne présentent pas de contraste significatif dans l’image numérisée de la surface PL. Lorsque la durée de vie des porteurs minoritaires est supérieure à 0,5 μs, la recombinaison des trous électroniques au niveau de la dislocation peut distinguer de manière significative le contraste de la dislocation par rapport aux autres régions.
TSD et TED présentent différentes tailles de points sombres ou lumineux dans les images de numérisation de surface PL du 4H-SiC. Les pics d'émission PL intrinsèques de TED et TSD sont situés respectivement à 600 nm et 800-850 nm. Le BPD apparaît sous forme de lignes sombres ou lumineuses dans l'image de balayage de surface PL du 4H-SiC (voir Fig.3 (a)). Les pics d'émission PL des BPD proviennent des pics d'émission PL des dislocations incomplètes et des défauts d'empilement qui constituent les BPD. Les pics d'émission des luxations incomplètes du noyau de silicium, des dislocations incomplètes du noyau de carbone et des défauts d'empilement sont situés respectivement à 670-700 nm, 720-850 nm et 420 nm. En ajustant la longueur d’onde de la lumière émise, l’affichage de dislocations incomplètes uniques et de défauts d’empilement peut être réalisé séparément.
Récemment, des chercheurs ont également découvert que les TD peuvent améliorer la luminescence D1 du 4H-SiC, comme le montrent les figures 3 (b) et (c), qui représentent respectivement l'intensité de luminescence des piqûres de corrosion TED et TSD. Cela signifie que l'intensité de la luminescence D1 peut également refléter la densité et la répartition des dislocations dans le substrat 4H-SiC et la couche épitaxiale.

Fig. 3 Propriétés luminescentes des dislocations dans le 4H-SiC : (a) Images de balayage de surface PL en micro-zone de films minces épitaxiaux de 4H SiC obtenues à l'aide d'un filtre passe-bande de 900 nm ; (b) Images de balayage de surface PL de la microrégion TED et (c) Images de balayage de surface de la microrégion PL TSD dans un substrat 4H-SiC de type N obtenues lors d'une émission de 450 nm ~ 750 nm.
L'augmentation de la taille du matériau et la réduction de la densité des dislocations sont les orientations générales du développement de substrats 4H-SiC et de films minces épitaxiaux. Pour réduire la densité de dislocations, d'une part, il est nécessaire d'optimiser la conception des champs thermiques et d'écoulement, de concevoir des techniques de traitement des germes de cristal ou du substrat et d'optimiser les technologies de processus monocristaux ou épitaxiaux pour réduire la densité de dislocations ; D'autre part, sur la base de technologies de processus de plus en plus matures, des recherches plus approfondies sont nécessaires sur la manière de promouvoir la transformation ou la réaction entre différents types de dislocations afin de réduire la faible densité de dislocations. En termes de régulation des performances des dislocations, des recherches supplémentaires sont nécessaires sur la manière de favoriser la réaction entre les impuretés et les défauts ponctuels avec les dislocations, ajustant ainsi la position du niveau d'énergie du défaut et le comportement dynamique des dislocations.
Référence:
Jiajun Li, Guang Yang, Xiaoshuang Liu, Hao Luo, Lingbo Xu, Yiqiang Zhang, Can Cui, Xiaodong Pi, Deren Yang et Rong Wang
Dislocations dans le carbure de silicium 4H
Pour plus d'informations, veuillez nous contacter par email àvictorchan@powerwaywafer.cometpowerwaymaterial@gmail.com.

