Hyung Koun Cho∗
Institut for Metallurgisk Teknik, Dong-A University, Busan 604-714
Jeong Yong Lee
Institut for Materialevidenskab og Teknik,
Korea Advanced Institute of Science and Technology, Daejon 305-701
Vi har undersøgt dannelsen af V-formede gruber i nitridfilm som InGaN/GaN og AlGaN/GaN dyrket på safirsubstrat ved hjælp af transmissionselektronmikroskopi. Mekanismen for grubedannelse afhænger stærkt af indium (In) og aluminium (Al) sammensætningerne i Inxga1-xN og Alxga1-xN lag hhv. Med en forøgelse af indiumsammensætningen opstod V-formede fordybninger fra toppunktet af gevindforskydninger til stakningsmistilpasningsgrænserne induceret af stablingsforkastninger og den tredimensionelle ø-vækst i det indledende stadium på grund af den store gittermistilpasning. Med en forøgelse af aluminiumsammensætningen varierede oprindelsen af gruberne også fra overfladens bølgeform på grund af den elastiske mistilpasning til toppen af gevindforskydninger.
PACS-numre: 61.72.Ff, 68.55.Ln, 68.55.-a
Nøgleord: Pit, Nitride, TEM, AlGaN, InGaN
I. INTRODUKTION
Wurtzite GaN-baserede (GaN, InGaN og AlGaN) halvledere er i øjeblikket under enorm undersøgelse som lovende materialer til optoelektroniske, højtemperatur- og højeffektenheder på grund af nogle egenskaber såsom stort direkte båndgab, høj termisk stabilitet og stærk interatomisk obligationer [1, 2]. For Inxga1-xN og Alxga1-xN-lag dyrket på GaN, en stigning i indium (In) og aluminium (Al) sammensætninger kan uundgåeligt forårsage misfit stammer i film. Ud over en kritisk tykkelse genereres adskillige strukturelle defekter såsom mistilpasningsforskydninger, stablingsfejl, V-formede fordybninger osv. ved plastisk afslapning [3, 4]. Men også ved mindre tykkelser kan elastisk afslapning fremkaldes af dannelsen af øer, overfladebølger osv., som observeret i InGaP/InAsP, In0.77Ga0.23As/InGaAs, SiGe/Si og så videre [5-7 ].Derudover kan en stigning i In-sammensætning forårsage den kemiske inhomogenitet af Inxga1-xN brøndlag på grund af den dårlige blandbarhed mellem InN og GaN [8, 9].Den lave opløselighed af In i GaN blev beregnet til at være mindre end 6 % ved 800 ◦C ved hjælp af Stringfellows model [10].Disse egenskaber kan i væsentlig grad påvirke de optiske og strukturelle egenskaber af enheder [11, 12].
For nylig rapporterede vi to modeller for dannelsen af V-formede gruber i InGaN/GaN multiple kvantebrønde (MQW'er) med høj sammensætning [13]. Også uønsketheden og virkningen på emissionsegenskaberne af disse gruber blev tidligere demonstreret ved transmissionselektronmikroskopi (TEM), katodeluminescens og fotoluminescens [3, 14, 15]. Til undertrykkelse af grubedannelse er der derfor behov for en klar forståelse af mekanismerne for grubedannelse, og mikrostrukturen af gruberne observeret i forskellige III-nitridfilm dyrket på safirsubstrat skal evalueres i detaljer. I dette arbejde undersøgte vi pitdannelsen, der stammer fra forskellige kilder i InGaN/GaN- og AlGaN/GaN-heterostrukturer med forskellige In- og Al-sammensætninger ved hjælp af TEM.
II. EKSPERIMENTEL
Alle prøver blev dyrket på c-plan safirsubstrater med et nominelt 25 nm tykt GaN nukleationslag af en horisontal metalorganisk kemisk dampaflejringsreaktor, der arbejdede ved lavt tryk. Trimethylgallium, trimethylindium, trimethylaluminium og ammoniak blev brugt som kildeprækursorer for henholdsvis Ga, In, Al og N. For at analysere effekten af stammen på mekanismen for grubedannelse i III-nitrider blev tykke InxGa1−xN lag (~ 800 ˚A) dyrket ved temperaturer fra 830 ◦C (x)I = 35 %) til 880 ◦C (xI = 10 %) og tykke AlxGa1−xN-lag (1000 A) blev dyrket ved 1040 ◦C efter dyrkning af det Si-dopede underliggende GaN-lag på ~2 mm tykkelse ved 1080 ◦C. In- og Al-kompositionerne i Inxga1-xN og Alxga1-xN-lag var henholdsvis 10, 13, 19 og 35 % og 16, 25, 44 og 54 %.
For at karakterisere grubedannelsen af III-nitrider blev TEM-prøver forberedt i tværsnit langs [11-20] zoneaksen ved hjælp af Tripod mekanisk polering efterfulgt af lavtemperatur Ar ion-fræsning ved 4,5 kV i en Gatan DuoMill 660 DIF med sektorhastighed styring. Ionenergien blev gradvist reduceret under de sidste stadier af udtynding for at minimere overfladebeskadigelse af prøver. Bright-field (BF) billeder og højopløselige TEM (HRTEM) billeder blev optaget på en JEOL JEM-2000EX TEM ved 200 kV og JEOL JEM-3010EX ved 300 kV.
III. RESULTATER OG DISKUSSION
For at undersøge virkningen af Al-sammensætning på grubedannelse, skal TEM-mikrografer i tværsnit af lysfelter fra Alxga1-xN-lag dyrket med forskellige Al-sammensætninger på GaN-bufferlaget blev opnået som vist i fig. 1. Den teoretiske kritiske Al-sammensætning for dannelsen af misfit-dislokationen i 1000 A Alxga1-xN-lag dyrket på GaN-lag er mindre end 15 % [16]. Ingen gruber er fundet i Alxga1-xN lag med op til 25 % Al sammensætning. Kun stablingsfejl og revner i AlGaN-lagene observeres på grund af henholdsvis misfit-deformationen og den termiske koefficientforskel (ikke vist). For Al0.44ga0.56N/GaN-prøven er imidlertid overfladen af Al0.44ga0.56N-laget viser mange huller, der ikke er forbundet med strukturelle defekter, såsom gevindforskydninger, stablingsfejl og så videre [fig. 1(b) og (d)]. Størrelsen af disse gruber er meget lille, en gennemsnitlig diameter på 7 nm og en gennemsnitlig højde på ~3 nm, sammenlignet med størrelsen af gruber i InGaN-lag dyrket på GaN [13, 14, 16]. Det menes, at dannelsen af gruber i Al0.44ga0.56N/GaN kan tilskrives overfladeundulationen af den øgede elastiske misfit-belastning som observeret i III-V og II-VI halvledersystemer [5, 6].
Grubens tæthed er mere end 1010 cm−2 i overfladen. På den anden side genereres mistilpassede dislokationer ved grænsefladen af Al0.54ga0.46N/GaN-prøve for plastisk at slappe af den lagrede misfit-stamme som vist i fig. 1(c). Også V-formede fordybninger forbundet med gevinddislokationer ved bunden observeres ligesom InGaN/GaN heterostrukturer. Disse V-formede gruber har en åben sekskantet, omvendt pyramide med sidevægge [14, 16].
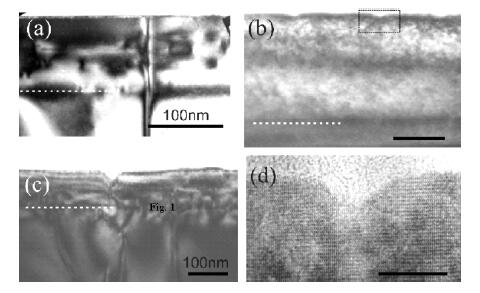
Fig. 1 Tværsnits TEM-billeder af lysfelter ved hjælp af g = 0002 fra Alxga1-xN-lag dyrket med Al-sammensætningen på (a) 16 %, (b) 44 % og (c) 54 %. (d) HRTEM-billede opnået fra det stiplede rektangel i (b). De stiplede linjer angiver Alxga1-xN/GaN interface.
Som følge heraf klassificerede vi oprindelsen af grubedannelsen i Alxga1-xN dyrket på GaN-bufferlaget til to modeller som vist i fig. 4(a) og (d). For Alxga1-xN-lag med ~40 % Al-sammensætning, gruber genereres af overfladens bølgeform på grund af den lagrede elastiske misfit-belastning [Fig. 4(d)]. For Alxga1-xN-lag med mere end ~50 % Al-sammensætning, dog genereres gruber hovedsageligt ved toppunktet af gevindforskydninger [Fig. 4(a)].
Figur 2 viser TEM-mikrobilleder af det lyse felt i tværsnit fra Inxga1-xN-lag dyrket med forskellige In-sammensætninger på GaN-bufferlaget. Den teoretiske kritiske sammensætning om dannelsen af den mistilpassede dislokation af ∼800˚A Inxga1-xN dyrket på GaN-lag er mindre end 5 %, hvorunder InGaN-lagene viser sammenhængende vækst [16]. Derfor forventer vi In-sammensætningen af alle Inxga1-xN lag undersøgt her for at have en værdi mere end den kritiske In-sammensætning på dannelsen af misfit-dislokationen. For In0.1ga0.9N/GaN, ingen strukturelle defekter såsom mistilpasningsforskydninger, stablingsfejl, gruber osv., blev observeret i In0.1Ga0.9N-laget. Med en yderligere stigning i In-sammensætningen af Inxga1-xN-lag (xI = 13%), genereres de V-formede pits for at slappe af den lagrede misfit-stamme, som tidligere rapporteret [14]. Det er blevet rapporteret, at en V-formet pit altid er forbundet med en gevinddislokation fra GaN bufferlaget i bunden, og kun en lille del af gevinddislokationerne forårsager dannelsen af de V-formede pits i InGaN lagene og InGaN/GaN MQW'erne [14]. Imidlertid er tætheden af V-formede gruber i In0.19ga0.81N-laget i fig. 2(c) har en større værdi end gevinddislokationstætheden i GaN-bufferlaget, hvilket indikerer, at dannelsen af V-formede fordybninger i InGaN med høj In-sammensætning har en anden oprindelse, som tidligere rapporteret for InGaN/GaN MQW-systemerne [13]. Vi rapporterede, at i InGaN/GaN MQW'erne med høj sammensætning (~ 30 % i sammensætning), er de fleste af de V-formede gruber genereret fra stablingsmismatch-grænser induceret af stablingsfejl [13]. Selvom In0.19ga0.81N/GaN anvendt her har en sammensætning på mindre end 20 %, den del af V-formede gruber stammer fra stablingsmismatchgrænser induceret af stablingsfejl på grund af den øgede InGaN-lagtykkelse [Fig. 3(a)] sammenlignet med InGaN/GaN MQW. For In0.35ga0.65N/GaN, V-formede gruber med en tæthed på mere end 1010 cm−2 observeres på overfladen. I modsætning til gruberne i In0.19ga0.81N/GaN-prøven, In0.35ga0.65N regioner med flade (0001) topoverflader mellem gruber har et stort antal stablingsfejl og stablingsmismatch-grænser dannet ved det indledende vækststadium af InGaN [fig. 3(b)], det vil sige søjlestrukturer inklusive stablingsfejl. For at slække på det store gittermisforhold mellem In0.35ga0.65N og GaN, den indledende In0.35ga0.65N-laget blev dyrket med morfologien af tredimensionelle (3D) facetterede øer [17]. En høj tæthed af stablingsforkastninger ses tydeligt på øerne, og grænserne mellem underkorn ved øer er synlige som væksten af et GaN-kernelag dyrket på safirsubstrat [18].
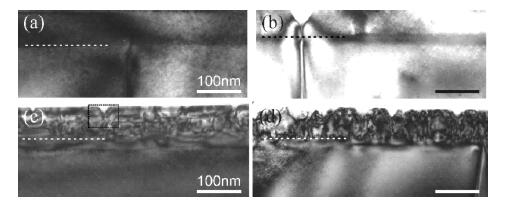
Fig. 2 Tværsnits TEM-billeder med lysfelt ved hjælp af g = 0002 fra Inxga1-xN-lag dyrket med In-sammensætningen på (a) 10 %, (b) 13 %, (c) 19 % og (d) 35 % på GaN-bufferlaget. De stiplede linjer angiver Inxga1-xN/GaN interface.
Derfor tænker vi, at hullerne i In0.35ga0.65N/GaN-prøve er forårsaget af en sådan 3D-vækst på grund af gittermistilpasningen ved den indledende vækst af InGaN-laget.
Som et resultat klassificerede vi oprindelsen af grubedannelse i Inxga1-xN dyrket på GaN-bufferlaget i tre modeller som vist i fig. 4(a), (b) og (c). For Inxga1-xN-lag med lav sammensætning genereres fordybninger ved toppunktet af gevindforskydninger [Fig. 4(a)]. For Inxga1-xN-lag med medium I sammensætningen genereres gruber hovedsageligt fra stablingsmismatch-grænserne induceret af stablingsfejl [Fig. 4(b)]. En yderligere stigning i In-sammensætningen af Inxga1-xN-laget resulterer i 3D-øvækst i det indledende stadium og grubedannelse ved den kontinuerlige vækst [Fig. 4(c)].
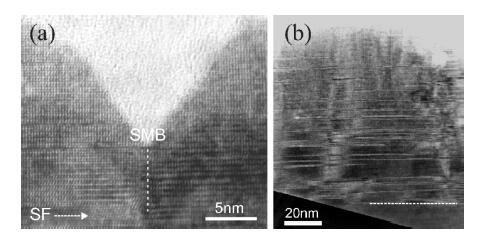
Fig. 3 (a) HRTEM-billede opnået fra det stiplede rektangel i Fig. 2(c). Den observerede V-formede pit har en stablingsfejl på (0001) planer i sin nederste position. (b) HRTEM-billede opnået fra In0.35ga0.65N på GaN bufferlaget.
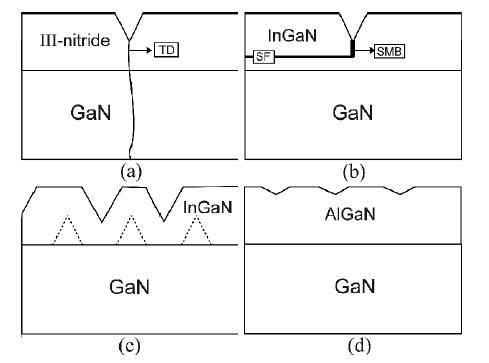
Fig. 4 Skematiske modeller for grubedannelse relateret til (a) en gevinddislokation observeret i InGaN/GaN- og AlGaN/GaN-heterostrukturer, (b) en stablingsmismatch-grænse induceret af stablingsfejl og (c) 3d-øvæksten i det indledende stadium observeret i en InGaN/GaN-heterostruktur, og (d) overfladeundulationen på grund af den elastiske misfit-deformation observeret i en AlGaN/GaN-heterostruktur.
IV. RESUMÉ
Grubedannelsen i Inxga1-xN og Alxga1-xN-lag med forskellige In- og Al-sammensætninger dyrket på GaN-bufferlagene blev undersøgt under anvendelse af TEM. Vi fandt ud af, at gruber blev dannet fra forskellige oprindelser såsom gevinddislokationer, stablingsmismatch-grænser, 3D-øvækst og overfladebølgedannelse afhængigt af In- og Al-sammensætninger.
ANKENDELSER
Dette arbejde blev støttet af en bevilling nr. R01-2002- 000-00096-0 fra Korea Science & Engineering Foundation og University Research Program fra Ministeriet for Information og Kommunikation i republikken Korea.
REFERENCER
[1] H. Morkoc, Nitride Semiconductors and Devices (Springer, Heidelberg, 1999).
[2] YS Park, J. Korean Phys. Soc. 34, S199 (1999).
[3] HK Cho, JY Lee, CS Kim, GM Yang, N. Sharma og CJ Humphreys, J. Cryst. Growth 231, 466 (2001).
[4] HK Cho, JY Lee, KS Kim og GM Yang, J. Korean Phys. Soc. 39, S165 (2001).
[5] P. Desjardins, H. Marchand, L. Isnard og RA Masut, J. Appl. Phys. 81, 3501 (1997).
[6] M. Mitsuhara, M. Ogasawara og H. Sugiura, J. Cryst. Growth 210, 463 (2000).
[7] JM Hartmann, B. Gallas, J. Zhang og JJ Harris, Semicond. Sci. Teknol. 15, 370 (2000).
[8] D. Doppalapudi, SN Basu, KF Ludwig, Jr. og TD Moustakas, J. Appl. Phys. 84, 1389 (1998).
[9] T. Takeuchi, H. Takeuchi, S. Sota, H. Sakai, H. Amano og I. Akasaki, Jpn. J. Appl. Phys. 36, L177 (1997).
[10] GB Stringfellow, J. Cryst. Growth 58, 194 (1982). [11] CA Tran, RF Karlicek, Jr., M. Schurman, A. Osinsky, V. Merai, Y. Li, I. Eliashevich, MG Brown, J. Nering, I. Ferguson og R. Stall, J. Cryst . Growth 195, 397 (1998).
[12] MG Cheong, RJ Choi, CS Kim, HS Yoon, C.-H. Hong, E.-K. Suh, HJ Lee, HK Cho og JY Lee, J. Korean Phys. Soc. 38, 701 (2001).
[13] HK Cho, JY Lee, GM Yang og CS Kim, Appl. Phys. Lett. 79, 215 (2001).
[14] XH Wu, CR Elsass, A. Abare, M. Mack, S. Keller, PM Petroff, SP DenBaars og JS Speck og SJ Rosner, Appl. Phys. Lett. 72, 692 (1998).
[15] G. Pozina, JP Bergman, B. Monemar, T. Takeuchi, H. Amano og I. Akasaki, J. Appl. Phys. 88, 2677 (2000).
[16] JW Matthews og AE Blakeslee, J. Cryst. Growth 32, 265 (1974).
[17] Z. Liliental-Weber, M. Benamara, J. Washburn, JZ Domagala, J. Bak-Misiuk, EL Piner, J. C. Roberts og SM Bedair, J. Electron. Mater. 30, 439 (2001).
[18] K. Lorenz, M. Gonsalves, Wook Kim, V. Narayanan og S. Mahajan, Appl. Phys. Lett. 77, 3391 (2000).
