Hyung Koun Cho ∗
Departamento de Ingeniería Metalúrgica, Universidad Dong-A, Busan 604-714
Jeong Yong Lee
Departamento de Ciencia e Ingeniería de Materiales,
Instituto Avanzado de Ciencia y Tecnología de Corea, Daejon 305-701
Hemos investigado la formación de hoyos en forma de V en películas de nitruro como InGaN / GaN y AlGaN / GaN cultivadas en sustrato de zafiro utilizando microscopía electrónica de transmisión. El mecanismo de formación de picaduras depende en gran medida de las composiciones de indio (In) y aluminio (Al) en InxGeorgia1 − xN y AlxGeorgia1 − xN capas, respectivamente. Con el aumento de la composición de indio, las picaduras en forma de V se originaron desde el vértice de las dislocaciones de roscado hasta los límites de desajuste de apilamiento inducidos por las fallas de apilamiento y el crecimiento de islas tridimensionales en la etapa inicial debido al gran desajuste de la red. Con el aumento de la composición de aluminio, el origen de las picaduras también varió desde la ondulación de la superficie debido a la deformación por desajuste elástico hasta el vértice de las dislocaciones de roscado.
Números PACS: 61.72.Ff, 68.55.Ln, 68.55.-a
Palabras clave: pozo, nitruro, TEM, AlGaN, InGaN
I. INTRODUCCIÓN
Los semiconductores basados en Wurtzite GaN (GaN, InGaN y AlGaN) se encuentran actualmente bajo una enorme investigación como materiales prometedores para dispositivos optoelectrónicos, de alta temperatura y alta potencia debido a algunas propiedades como gran banda prohibida directa, alta estabilidad térmica y fuerte interatomía. enlaces [1, 2]. Para enxGeorgia1 − xN y AlxGeorgia1 − xN capas cultivadas en GaN, un aumento en las composiciones de indio (In) y aluminio (Al) puede causar inevitablemente deformaciones inadaptadas en las películas. Más allá de un espesor crítico, varios defectos estructurales, como dislocaciones, fallas de apilamiento, picaduras en forma de V, etc., son generados por la relajación plástica [3, 4]. Sin embargo, también en espesores más pequeños, la relajación elástica puede ser inducida por la formación de islas, ondulación de la superficie, etc., como se observa en InGaP / InAsP, In0.77Ga0.23As / InGaAs, SiGe / Si, etc. [5-7 ].Además, un aumento en la composición puede causar la falta de homogeneidad química delxGeorgia1 − xN capas de pozos debido a la escasa miscibilidad entre InN y GaN [8, 9].Se calculó que la baja solubilidad de In en GaN era inferior al 6% a 800 ◦C utilizando el modelo de Stringfellow [10].Estas propiedades pueden influir significativamente en las propiedades ópticas y estructurales de los dispositivos [11, 12].
Recientemente, informamos de dos modelos de formación de pozos en forma de V en pozos cuánticos múltiples (MQW) de InGaN / GaN con una composición alta [13]. Además, la indeseabilidad y el efecto sobre las propiedades de emisión de estos pozos fueron previamente demostrados por microscopía electrónica de transmisión (TEM), catodeluminiscencia y fotoluminiscencia [3, 14, 15]. Por lo tanto, para la supresión de la formación de picaduras, se necesita una comprensión clara de los mecanismos de formación de picaduras y se debe evaluar en detalle la microestructura de las picaduras observadas en varias películas de nitruro III cultivadas sobre sustrato de zafiro. En este trabajo, investigamos la formación de fosas que se originan a partir de diferentes fuentes en heteroestructuras de InGaN / GaN y AlGaN / GaN con varias composiciones de In y Al utilizando TEM.
II. EXPERIMENTAL
Todas las muestras se cultivaron en sustratos de zafiro en plano c con una capa de nucleación de GaN de 25 nm de espesor nominal mediante un reactor horizontal de deposición de vapor químico metalorgánico que funcionaba a baja presión. Se utilizaron trimetilgalio, trimetilindio, trimetilaluminio y amoniaco como precursores de origen para Ga, In, Al y N, respectivamente. Para analizar el efecto de la deformación sobre el mecanismo de formación de fosas en los nitruros III, se cultivaron capas gruesas de InxGa1 − xN (∼ 800 ˚A) a temperaturas que oscilan entre 830 ◦C (xEn = 35%) a 880 ◦C (xEn = 10%) y capas gruesas de AlxGa1 − xN (1000 A) se cultivaron a 1040 ◦C después de hacer crecer la capa de GaN subyacente dopada con Si de ∼2 mm de espesor a 1080 ◦C. Las composiciones de In y Al en el InxGeorgia1 − xN y AlxGeorgia1 − xN capas fueron 10, 13, 19 y 35% y 16, 25, 44 y 54%, respectivamente.
Para caracterizar la formación de picaduras de nitruros III, se prepararon muestras de TEM en sección transversal a lo largo del eje de la zona [11-20] utilizando pulido mecánico Tripod seguido de molienda de iones de Ar a baja temperatura a 4.5 kV en un Gatan DuoMill 660 DIF con velocidad de sector control. La energía iónica se redujo gradualmente durante las etapas finales de adelgazamiento para minimizar el daño superficial de las muestras. Se registraron imágenes de campo claro (BF) e imágenes TEM de alta resolución (HRTEM) en un JEOL JEM-2000EX TEM a 200 kV y JEOL JEM-3010EX a 300 kV.
III. RESULTADOS Y DISCUSIÓN
Para investigar el efecto de la composición de Al en la formación de pozos, micrografías de TEM de campo brillante de sección transversal del AlxGeorgia1 − xN capas cultivadas con diversas composiciones de Al en la capa tampón de GaN se obtuvieron como se muestra en la Fig. 1. La composición crítica teórica de Al sobre la formación de la dislocación de desajuste en el 1000 A AlxGeorgia1 − xLa capa de N cultivada en capas de GaN es menos del 15% [16]. No se detectan hoyos en el AlxGeorgia1 − xN capas con hasta un 25% de composición de Al. Solo se observan fallas de apilamiento y grietas en las capas de AlGaN debido a la deformación por desajuste y la diferencia de coeficiente térmico, respectivamente (no se muestra). Para el Al0.44Georgia0.56Muestra de N / GaN, sin embargo, la superficie del Al0.44Georgia0.56La capa N muestra muchas picaduras que no están asociadas con defectos estructurales como dislocaciones de roscado, fallas de apilamiento, etc. [Figs. 1 (b) y (d)]. El tamaño de estos hoyos es muy pequeño, un diámetro promedio de 7 nm y una altura promedio de ~ 3 nm, en comparación con el de los hoyos en capas de InGaN cultivadas en GaN [13, 14, 16]. Se cree que la formación de hoyos en Al0.44Georgia0.56N / GaN se puede atribuir a la ondulación de la superficie por el aumento de la deformación por desajuste elástico como se observa en los sistemas de semiconductores III-V y II-VI [5, 6].
La densidad del pozo es más de 1010 cm−2 en la superficie. Por otro lado, las dislocaciones inadaptadas se generan en la interfaz del Al0.54Georgia0.46Muestra de N / GaN para relajar plásticamente la deformación inadaptada almacenada como se muestra en la Fig. 1 (c). Además, los hoyos en forma de V asociados con dislocaciones de roscado en los fondos se observan como heteroestructuras de InGaN / GaN. Estos pozos en forma de V tienen una pirámide invertida hexagonal abierta con paredes laterales [14, 16].
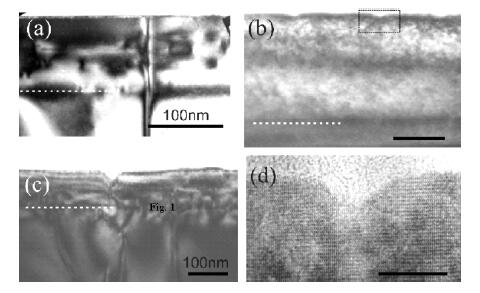
Fig.1 Imágenes TEM de campo claro en sección transversal usando g = 0002 de la AIxGeorgia1 − xN capas cultivadas con la composición de Al de (a) 16%, (b) 44% y (c) 54%. (d) Imagen HRTEM obtenida del rectángulo discontinuo en (b). Las líneas discontinuas indican la AlxGeorgia1 − xInterfaz N / GaN.
En consecuencia, clasificamos el origen de la formación de pozos en el AlxGeorgia1 − xN crecido en la capa tampón de GaN en dos modelos como se muestra en las Figs. 4 (a) y (d). Para el AlxGeorgia1 − xN capa con una composición de ~ 40% Al, las picaduras se generan por la ondulación de la superficie debido a la deformación por inadaptación elástica almacenada [Fig. 4 (d)]. Para el AlxGeorgia1 − xN capa con más de ~ 50% de composición de Al, sin embargo, las picaduras se generan principalmente en el vértice de las dislocaciones de roscado [Fig. 4 (a)].
La Figura 2 muestra las micrografías TEM de campo brillante de sección transversal de la InxGeorgia1 − xN capas cultivadas con diversas composiciones de In en la capa tampón de GaN. La composición crítica teórica sobre la formación de la dislocación inadaptada del ∼800˚A InxGeorgia1 − xEl N que crece en las capas de GaN es inferior al 5%, por debajo del cual las capas de InGaN muestran un crecimiento coherente [16]. Por lo tanto, esperamos que la composición In de todos los InxGeorgia1 − xN capas estudiadas aquí para tener un valor más que la composición crítica en la formación de la dislocación inadaptada. Para en0.1Georgia0.9N / GaN, no se observaron defectos estructurales tales como dislocaciones, fallas de apilamiento, picaduras, etc., dentro de la capa de In0.1Ga0.9N. Con un aumento adicional en la composición de InxGeorgia1 − xN capa (xEn = 13%), los hoyos en forma de V se generan para relajar la tensión inadaptada almacenada, como se informó anteriormente [14]. Se ha informado que un pozo en forma de V siempre está conectado con una dislocación de roscado de la capa de amortiguación de GaN en la parte inferior y solo una pequeña fracción de las dislocaciones de roscado causa la formación de los hoyos en forma de V en las capas de InGaN y los MQW de InGaN / GaN [14]. Sin embargo, la densidad de los hoyos en forma de V en el0.19Georgia0.81La capa N en la Fig.2 (c) tiene un valor mayor que la densidad de dislocación del hilo en la capa amortiguadora de GaN, lo que indica que la formación de hoyos en forma de V en la InGaN con alta composición de In tiene un origen diferente, como se informó anteriormente para los sistemas InGaN / GaN MQW [13]. Informamos que en los MQW de InGaN / GaN con alta composición de In (∼ 30% de composición), la mayoría de los pozos en forma de V se generan a partir de límites de desajuste de apilamiento inducidos por fallas de apilamiento [13]. Aunque el In0.19Georgia0.81El N / GaN utilizado aquí tiene una composición de In de menos del 20%, la parte de los pozos en forma de V se origina en los límites de desajuste de apilamiento inducidos por fallas de apilamiento debido al aumento del espesor de la capa de InGaN [Fig. 3 (a)] en comparación con InGaN / GaN MQW. Para en0.35Georgia0.65N / GaN, fosas en forma de V con una densidad de más de 1010 cm−2 se observan en la superficie. A diferencia de los pozos en el0.19Georgia0.81Muestra de N / GaN, el In0.35Georgia0.65Las regiones N con superficies superiores planas (0001) entre pozos tienen un gran número de fallas de apilamiento y límites de desajuste de apilamiento formados en la etapa de crecimiento inicial de InGaN [Fig. 3 (b)], es decir, estructuras de columnas que incluyen fallas de apilamiento. Para relajar el gran desajuste de celosía entre En0.35Georgia0.65N y GaN, el In inicial0.35Georgia0.65La capa N se cultivó con la morfología de islas facetadas tridimensionales (3D) [17]. Una alta densidad de fallas de apilamiento se ve claramente en las islas y los límites entre los subgranos por islas son visibles como el crecimiento de una capa de nucleación de GaN crecida sobre un sustrato de zafiro [18].
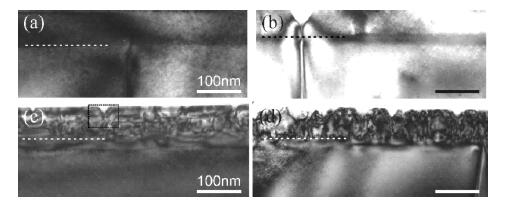
Fig.2 Imágenes TEM de campo claro en sección transversal usando g = 0002 de InxGeorgia1 − xN capas cultivadas con la composición de In de (a) 10%, (b) 13%, (c) 19% y (d) 35% en la capa tampón de GaN. Las líneas discontinuas indican el InxGeorgia1 − xInterfaz N / GaN.
Por lo tanto, creemos que los hoyos en el0.35Georgia0.65Las muestras de N / GaN son causadas por un crecimiento 3D de este tipo debido al desajuste de la red en el crecimiento inicial de la capa de InGaN.
Como resultado, clasificamos el origen de la formación de hoyos en elxGeorgia1-xN creció en la capa tampón de GaN en tres modelos, como se muestra en la Fig. 4 (a), (b) y (c). Para el enxGeorgia1-xN capa con baja composición de In, se generan hoyos en el vértice de las dislocaciones de roscado [Fig. 4 (a)]. Para el enxGeorgia1-xCapa N con composición media, los hoyos se generan principalmente a partir de los límites de desajuste de apilamiento inducidos por fallas de apilamiento [Fig. 4 (b)]. Un aumento adicional en la composición de InxGeorgia1-xLa capa N da como resultado el crecimiento de la isla 3D en la etapa inicial y la formación de pozos en el crecimiento continuo [Fig. 4 (c)].
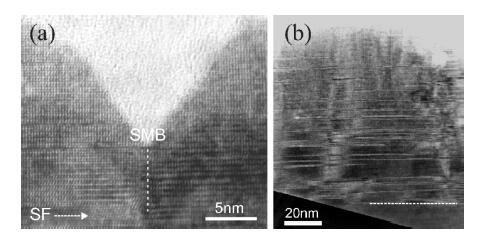
Fig. 3 (a) Imagen HRTEM obtenida del rectángulo discontinuo de la Fig. 2 (c). El pozo en forma de V observado tiene una falla de apilamiento en los planos (0001) en su posición más baja. (b) Imagen HRTEM obtenida del In0.35Georgia0.65N en la capa tampón de GaN.
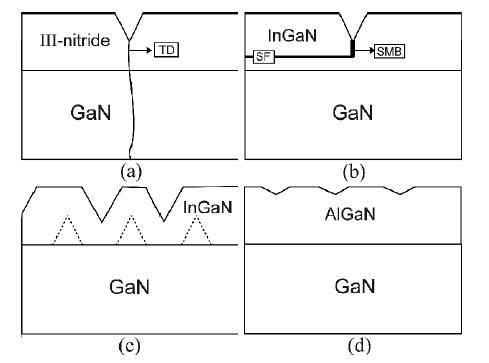
Fig.4 Modelos esquemáticos para la formación de pozos relacionados con (a) una dislocación de rosca observada en heteroestructuras de InGaN / GaN y AlGaN / GaN, (b) un límite de desajuste de apilamiento inducido por fallas de apilamiento y (c) el crecimiento de la isla 3d en la etapa inicial observado en una heteroestructura de InGaN / GaN, y (d) la ondulación de la superficie debido a la deformación por desajuste elástico observada en una heteroestructura de AlGaN / GaN.
IV. RESUMEN
La formación del pozo en InxGeorgia1-xN y AlxGeorgia1-xSe estudiaron capas N con diversas composiciones de In y Al cultivadas en las capas tampón de GaN usando TEM. Descubrimos que los pozos se formaron a partir de diversos orígenes, como dislocaciones de hilos, límites de desajuste de apilamiento, crecimiento de islas 3D y ondulación de la superficie según las composiciones de In y Al.
EXPRESIONES DE GRATITUD
Este trabajo fue apoyado por una subvención No. R01-2002- 000-00096-0 de la Fundación de Ciencia e Ingeniería de Corea y el Programa de Investigación Universitaria del Ministerio de Información y Comunicación de la República de Corea.
REFERENCIAS
[1] H. Morkoc, Semiconductores y dispositivos de nitruro (Springer, Heidelberg, 1999).
[2] YS Park, J. Korean Phys. Soc. 34, S199 (1999).
[3] HK Cho, JY Lee, CS Kim, GM Yang, N. Sharma y CJ Humphreys, J. Cryst. Growth 231, 466 (2001).
[4] HK Cho, JY Lee, KS Kim y GM Yang, J. Korean Phys. Soc. 39, S165 (2001).
[5] P. Desjardins, H. Marchand, L. Isnard y RA Masut, J. Appl. Phys. 81, 3501 (1997).
[6] M. Mitsuhara, M. Ogasawara y H. Sugiura, J. Cryst. Growth 210, 463 (2000).
[7] JM Hartmann, B. Gallas, J. Zhang y JJ Harris, Semicond. Sci. Technol. 15, 370 (2000).
[8] D. Doppalapudi, SN Basu, KF Ludwig, Jr. y TD Moustakas, J. Appl. Phys. 84, 1389 (1998).
[9] T. Takeuchi, H. Takeuchi, S. Sota, H. Sakai, H. Amano e I. Akasaki, Jpn. J. Appl. Phys. 36, L177 (1997).
[10] GB Stringfellow, J. Cryst. Growth 58, 194 (1982). [11] CA Tran, RF Karlicek, Jr., M. Schurman, A. Osinsky, V. Merai, Y. Li, I. Eliashevich, MG Brown, J. Nering, I. Ferguson y R. Stall, J. Cryst . Growth 195, 397 (1998).
[12] MG Cheong, RJ Choi, CS Kim, HS Yoon, C.-H. Hong, E.-K. Suh, HJ Lee, HK Cho y JY Lee, J. Korean Phys. Soc. 38, 701 (2001).
[13] HK Cho, JY Lee, GM Yang y CS Kim, Appl. Phys. Letón. 79, 215 (2001).
[14] XH Wu, CR Elsass, A. Abare, M. Mack, S. Keller, PM Petroff, SP DenBaars y JS Speck y SJ Rosner, Appl. Phys. Letón. 72, 692 (1998).
[15] G. Pozina, JP Bergman, B. Monemar, T. Takeuchi, H. Amano e I. Akasaki, J. Appl. Phys. 88, 2677 (2000).
[16] JW Matthews y AE Blakeslee, J. Cryst. Growth 32, 265 (1974).
[17] Z. Liliental-Weber, M. Benamara, J. Washburn, JZ Domagala, J. Bak-Misiuk, EL Piner, J. C. Roberts y SM Bedair, J. Electron. Mater. 30, 439 (2001).
[18] K. Lorenz, M. Gonsalves, Wook Kim, V. Narayanan y S. Mahajan, Appl. Phys. Letón. 77, 3391 (2000).
