チョ・ヒョンクン∗
東亜大学冶金工学科、釜山604-714
チョン・ヨンイ
材料科学工学科、
大田305-701韓国先端科学技術研究所
透過型電子顕微鏡を使用して、サファイア基板上に成長させたInGaN / GaNやAlGaN / GaNなどの窒化物膜におけるV字型ピットの形成を調査しました。 ピット形成のメカニズムは、Inのインジウム(In)とアルミニウム(Al)の組成に強く依存します。xジョージア1-xNとAlxジョージア1-xそれぞれN層。 インジウム組成の増加に伴い、V字型のピットは、貫通転位の頂点から、積層欠陥によって引き起こされた積層不整合境界と、大きな格子不整合による初期段階での3次元アイランド成長に起因していました。 アルミニウムの組成を増やすと、ピットの起源も、弾性ミスフィットひずみによる表面のうねりから、貫通転位の頂点まで変化しました。
PACS番号:61.72.Ff、68.55.Ln、68.55.-a
キーワード:ピット、窒化物、TEM、AlGaN、InGaN
I.はじめに
ウルツ鉱型GaNベース(GaN、InGaN、およびAlGaN)半導体は、大きな直接バンドギャップ、高い熱安定性、強力な原子間原子などのいくつかの特性により、オプトエレクトロニクス、高温、および高出力デバイスの有望な材料として現在、膨大な調査が行われています。結合[1、2]。 でxジョージア1-xNとAlxジョージア1-xGaN上に成長したN層、インジウム(In)およびアルミニウム(Al)の組成の増加は、必然的に膜の不適合ひずみを引き起こす可能性があります。 臨界厚さを超えると、不適合転位、積層欠陥、V字型ピットなどのいくつかの構造欠陥が塑性緩和によって生成されます[3、4]。 ただし、InGaP / InAsP、In0.77Ga0.23As / InGaAs、SiGe / Siなどで観察されるように、より薄い厚さでも、島の形成、表面のうねりなどによって弾性緩和が引き起こされる可能性があります[5–7 ]。さらに、In組成の増加は、Inの化学的不均一性を引き起こす可能性がありますxジョージア1-xInNとGaNの間の混和性が低いため、Nウェル層[8、9]。GaNへのInの低い溶解度は、Stringfellowのモデルを使用して800°Cで6%未満であると計算されました[10]。これらの特性は、デバイスの光学的および構造的特性に大きな影響を与える可能性があります[11、12]。
最近、我々は、高In組成のInGaN / GaN多重量子井戸(MQW)におけるV字型ピットの形成の2つのモデルを報告しました[13]。 また、これらのピットの望ましくないことと発光特性への影響は、透過型電子顕微鏡(TEM)、カソードルミネッセンス、およびフォトルミネッセンスによって以前に実証されました[3、14、15]。 したがって、ピット形成を抑制するためには、ピット形成のメカニズムを明確に理解する必要があり、サファイア基板上に成長したさまざまなIII族窒化物膜で観察されるピットの微細構造を詳細に評価する必要があります。 この作業では、TEMを使用して、さまざまなInおよびAl組成のInGaN / GaNおよびAlGaN / GaNヘテロ構造のさまざまなソースに起因するピット形成を調査しました。
II。 実験的
すべてのサンプルは、低圧で動作する水平有機金属化学蒸着反応器によって、公称25nmの厚さのGaN核形成層を備えたc面サファイア基板上で成長しました。 トリメチルガリウム、トリメチルインジウム、トリメチルアルミニウム、およびアンモニアは、それぞれGa、In、Al、およびNのソース前駆体として使用されました。 III族窒化物のピット形成のメカニズムに対するひずみの影響を分析するために、830°C(xで = 35%)〜880◦C(xで = 10%)および厚いAlxGa1-xN層(1000 A)は、1080°Cで約2 mmの厚さのSiドープ下層GaN層を成長させた後、1040°Cで成長しました。 InのInおよびAl組成xジョージア1-xNとAlxジョージア1-xN層はそれぞれ10、13、19、35%と16、25、44、54%でした。
III族窒化物のピット形成を特徴づけるために、TEM試料は、三脚機械研磨とそれに続くセクター速度のGatan DuoMill 660DIFでの4.5kVでの低温Arイオンミリングを使用して、[11-20]ゾーン軸に沿った断面で準備されました。コントロール。 イオンエネルギーは、サンプルの表面損傷を最小限に抑えるために、薄化の最終段階で徐々に減少しました。 明視野(BF)画像と高分解能TEM(HRTEM)画像は、200kVのJEOLJEM-2000EXTEMと300kVのJEOLJEM-3010EXで記録されました。
III。 結果と考察
ピット形成に対するAl組成の影響を調査するために、Alからの断面明視野TEM顕微鏡写真xジョージア1-x図1に示すように、GaNバッファ層上にさまざまなAl組成で成長したN層が得られました。1000AのAlにおけるミスフィット転位の形成に関する理論上の臨界Al組成xジョージア1-xGaN層上に成長したN層は15%未満です[16]。 Alにピットは検出されませんxジョージア1-x最大25%のAl組成のN層。 ミスフィットひずみと熱係数の違いにより、AlGaN層の積層欠陥と亀裂のみがそれぞれ観察されます(図には示されていません)。 アルのために0.44ジョージア0.56N / GaNサンプル、ただし、Alの表面0.44ジョージア0.56N層は、貫通転位や積層欠陥などの構造欠陥とは関係のない多くのピットを示しています[図。 1(b)および(d)]。 これらのピットのサイズは、GaN上に成長したInGaN層のピットのサイズと比較して、非常に小さく、平均直径は7 nm、平均高さは約3 nmです[13、14、16]。 アルのピットの形成と考えられています0.44ジョージア0.56N / GaNは、III-VおよびII-VI半導体システムで観察されるように、弾性ミスフィットひずみの増加による表面のうねりに起因する可能性があります[5、6]。
ピット密度が10以上10 CM−2 表面に。 一方、Alの界面ではミスフィット転位が発生します0.54ジョージア0.46図1(c)に示すように、蓄積されたミスフィットひずみを塑性的に緩和するためのN / GaNサンプル。 また、InGaN / GaNヘテロ構造のように、底部の貫通転位に関連するV字型のピットが観察されます。 これらのV字型のピットには、側壁が付いた開いた六角形の逆ピラミッドがあります[14、16]。
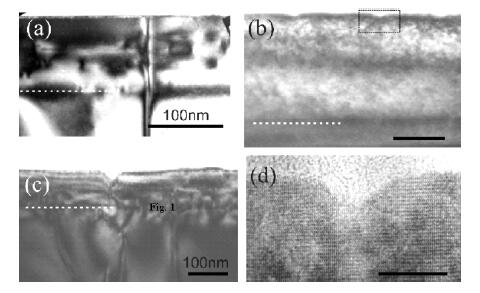
図1Alからのg = 0002を使用した断面明視野TEM画像xジョージア1-x(a)16%、(b)44%、および(c)54%のAl組成で成長したN層。 (d)(b)の破線の長方形から得られたHRTEM画像。 破線はAlを示しますxジョージア1-xN / GaNインターフェース。
その結果、Alのピット形成の起源を分類しましたxジョージア1-xGaNバッファ層上で成長したNは、図1および2に示すように2つのモデルになります。 4(a)および(d)。 アルのためにxジョージア1-xAl組成が約40%のN層では、蓄積された弾性ミスフィットひずみによる表面のうねりによってピットが発生します[図。 4(d)]。 アルのためにxジョージア1-xAl組成が約50%を超えるN層は、主に貫通転位の頂点にピットが発生します[図。 4(a)]。
図2は、Inの断面明視野TEM顕微鏡写真を示しています。xジョージア1-xGaNバッファ層上にさまざまなIn組成で成長したN層。 〜800°AのInのミスフィット転位の形成に関する理論的に重要なIn組成xジョージア1-xGaN層上に成長したNは5%未満であり、それを下回るとInGaN層はコヒーレント成長を示します[16]。 したがって、すべてのInのIn構成を期待しますxジョージア1-xここで研究したN層は、ミスフィット転位の形成に関する臨界In組成よりも高い値を持っています。 で0.1ジョージア0.9In0.1Ga0.9N層内では、N / GaN、ミスフィット転位、積層欠陥、ピットなどの構造欠陥は観察されませんでした。 InのIn組成がさらに増加するとxジョージア1-xN層(xで = 13%)、以前に報告されたように[14]、V字型のピットは保存された不適合ひずみを緩和するために生成されます。 V字型のピットは常に下部のGaNバッファ層からの貫通転位と接続されており、貫通転位のごく一部のみがInGaN層にV字型のピットを形成することが報告されています。 InGaN / GaNMQW [14]。 ただし、InのV字型ピットの密度0.19ジョージア0.81図2(c)のN層は、GaNバッファ層の貫通転位密度よりも大きな値を持っています。これは、以前に報告されたように、高In組成のInGaNでのV字型ピットの形成が異なる起源を持っていることを示しています。 InGaN / GaNMQWシステム[13]。 In組成が高い(In組成が約30%)InGaN / GaN MQWでは、ほとんどのV字型ピットが積層欠陥によって引き起こされる積層不整合境界から生成されることを報告しました[13]。 で0.19ジョージア0.81ここで使用したN / GaNのIn組成は20%未満であり、V字型ピットの一部は、InGaN層の厚さの増加による積層欠陥によって引き起こされた積層不整合境界に起因します[図。 3(a)] InGaN / GaNMQWと比較。 で0.35ジョージア0.65N / GaN、密度が10を超えるV字型ピット10 CM−2 表面に観察されます。 インのピットとは異なり0.19ジョージア0.81N / GaNサンプル、In0.35ジョージア0.65ピット間に平坦な(0001)上面を持つN領域には、InGaNの初期成長段階で形成された多数の積層欠陥と積層不整合境界があります[図。 3(b)]、すなわち、積層欠陥を含む柱状構造。 In間の大きな格子不整合を緩和する0.35ジョージア0.65NとGaN、最初のIn0.35ジョージア0.65N層は、3次元(3D)ファセットアイランドの形態で成長しました[17]。 高密度の積層欠陥が島にはっきりと見られ、島によるサブグレイン間の境界は、サファイア基板上に成長したGaN核形成層の成長のように見えます[18]。
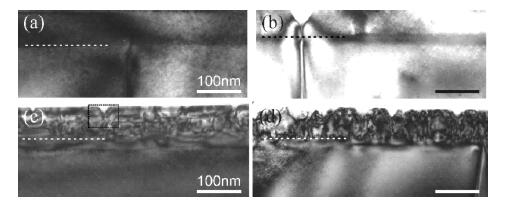
図2Inからのg = 0002を使用した断面明視野TEM画像xジョージア1-xGaNバッファ層上に(a)10%、(b)13%、(c)19%、(d)35%のIn組成で成長したN層。 破線はInを示しますxジョージア1-xN / GaNインターフェース。
したがって、私たちはインのピットを考えます0.35ジョージア0.65N / GaNサンプルは、InGaN層の初期成長時の格子不整合によるこのような3D成長によって引き起こされます。
その結果、ピット形成の起源をInに分類しました。xジョージア1-x図4(a)、(b)、(c)に示すように、NはGaNバッファ層上で3つのモデルに成長しました。 でxジョージア1-x低組成のN層では、貫通転位の頂点にピットが発生します[図。 4(a)]。 でxジョージア1-x中程度のN層組成では、ピットは主に積層欠陥によって引き起こされた積層不整合境界から生成されます[図。 4(b)]。 InのIn組成のさらなる増加xジョージア1-xN層は、初期の3Dアイランド成長と、連続成長のピット形成をもたらします[図。 4(c)]。
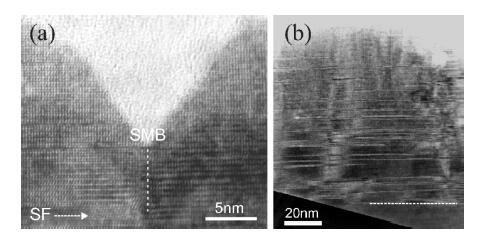
図3(a)図2(c)の破線の長方形から得られたHRTEM画像。 観測されたV字型のピットは、その低い位置にある(0001)面に積層欠陥があります。 (b)Inから得られたHRTEM画像0.35ジョージア0.65GaNバッファ層上のN。
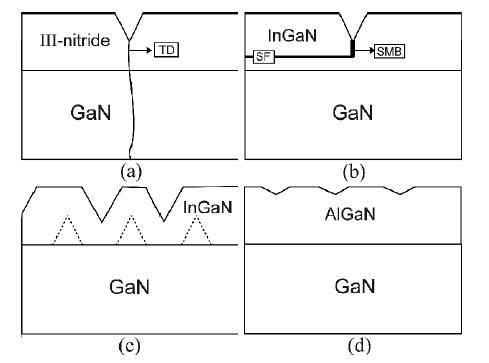
図4(a)InGaN / GaNおよびAlGaN / GaNヘテロ構造で観察された貫通転位、(b)積層欠陥によって誘発された積層不整合境界、および(c)初期段階での3dアイランド成長に関連するピット形成の概略モデルInGaN / GaNヘテロ構造で観察され、(d)AlGaN / GaNヘテロ構造で観察された弾性不適合ひずみによる表面のうねり。
IV。 まとめ
インのピット形成xジョージア1-xNとAlxジョージア1-xGaNバッファ層上に成長したさまざまなInおよびAl組成のN層を、TEMを使用して研究しました。 ピットは、InとAlの組成に応じて、貫通転位、積層ミスマッチ境界、3Dアイランド成長、表面のうねりなど、さまざまな起源から形成されていることがわかりました。
謝辞
この作品は、大韓民国の情報通信省からの韓国科学技術財団からの助成金番号R01-2002-000-00096-0と大学研究プログラムによってサポートされていました。
REFERENCES
[1] H. Morkoc、Nitride Semiconductors and Devices(Springer、Heidelberg、1999)。
[2] YS Park、J。KoreanPhys。 Soc。 34、S199(1999)。
[3] HK Cho、JY Lee、CS Kim、GM Yang、N。Sharma、CJ Humphreys、J。Cryst。 Growth 231、466(2001)。
[4] HK Cho、JY Lee、KS Kim、GM Yang、J.KoreanPhys。 Soc。 39、S165(2001)。
[5] P. Desjardins、H。Marchand、L。IsnardおよびRA Masut、J。Appl。 物理学81、3501(1997)。
[6]光原、小笠原、杉浦、J。Cryst。 Growth 210、463(2000)。
[7] JM Hartmann、B。Gallas、J。Zhang、およびJJ Harris、Semicond。 科学。 技術。 15、370(2000)。
[8] D. Doppalapudi、SN Basu、KF Ludwig、Jr。およびTD Moustakas、J.Appl。 物理学84、1389(1998)。
[9] T. Takeuchi、H。Takeuchi、S。Sota、H。Sakai、H。Amano、I。Akasaki、Jpn。 J.Appl。 物理学36、L177(1997)。
[10] GB Stringfellow、J。Cryst。 Growth 58、194(1982)。 [11] CA Tran、RF Karlicek、Jr.、M。Schurman、A。Osinsky、V。Merai、Y。Li、I。Eliashevich、MG Brown、J。Nering、I。Ferguson、R。Stall、J。Cryst 。 Growth 195、397(1998)。
[12] MG Cheong、RJ Choi、CS Kim、HS Yoon、C.-H。 ホン、E.-K。 Suh、HJ Lee、HK Cho and JY Lee、J。KoreanPhys。 Soc。 38、701(2001)。
[13] H. K. Cho, J. Y. Lee, G. M. Yang and C. S. Kim, Appl. Phys. Lett. 79, 215 (2001).
[14] X. H. Wu, C. R. Elsass, A. Abare, M. Mack, S. Keller, P. M. Petroff, S. P. DenBaars, and J. S. Speck and S. J. Rosner, Appl. Phys. Lett. 72, 692 (1998).
[15] G. Pozina, J. P. Bergman, B. Monemar, T. Takeuchi, H. Amano and I. Akasaki, J. Appl. Phys. 88, 2677 (2000).
[16] J. W. Matthews and A. E. Blakeslee, J. Cryst. Growth 32, 265 (1974).
[17] Z. Liliental-Weber, M. Benamara, J. Washburn, J. Z. Domagala, J. Bak-Misiuk, E. L. Piner, J. C. Roberts and S. M. Bedair, J. Electron. Mater. 30, 439 (2001).
[18] K. Lorenz, M. Gonsalves, Wook Kim, V. Narayanan and S. Mahajan, Appl. Phys. Lett. 77, 3391 (2000).
