SiC epitaxial wafer är tillgänglig för tillverkning av MOSFET-enheter, waferspecifikationer finns ihttps://www.powerwaywafer.com/sic-mosfet-structure.html
1. Epitaxiella gropar
Epitaxiella gropar, som en av de vanligaste ytmorfologiska defekterna, har en typisk ytmorfologi och strukturell profil som visas i Fig.1. Positionen för korrosionsgropar för tråddislokation (TD) som observerats efter KOH-korrosion på baksidan av enheten motsvarar väsentligt positionen för epitaxiella gropar före förberedelse av enheten, vilket indikerar att bildandet av epitaxiella gropdefekter är relaterat till tråddislokationer.
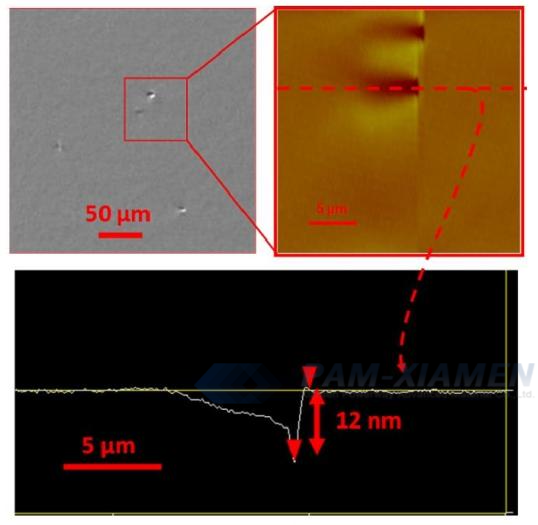
Fig. 1 Tvärsnittsdiagram av epitaxiella gropdefekter i SiC-epitaxialskiktet
2. Effekter av epitaxiella gropdefekter på SiC MOSFET
Inverkan av epitaxiella gropdefekter på egenskaperna hos MOSFET-enheter analyseras enligt följande:
Fig. 2 visar de statistiska fördelningshistogrammen för fem egenskaper hos enheter med epitaxiella gropdefekter. Den blå streckade linjen representerar segmenteringslinjen för enhetsdegradering och den röda streckade linjen representerar segmenteringslinjen för enhetsfel. Det kan ses av detta att antalet enheter med epitaxiella gropdefekter i SiC MOSFET-prover är ekvivalent med antalet enheter med triangulära defekter. Effekten av epitaxiella gropdefekter på enhetens egenskaper skiljer sig från triangulära defekter.
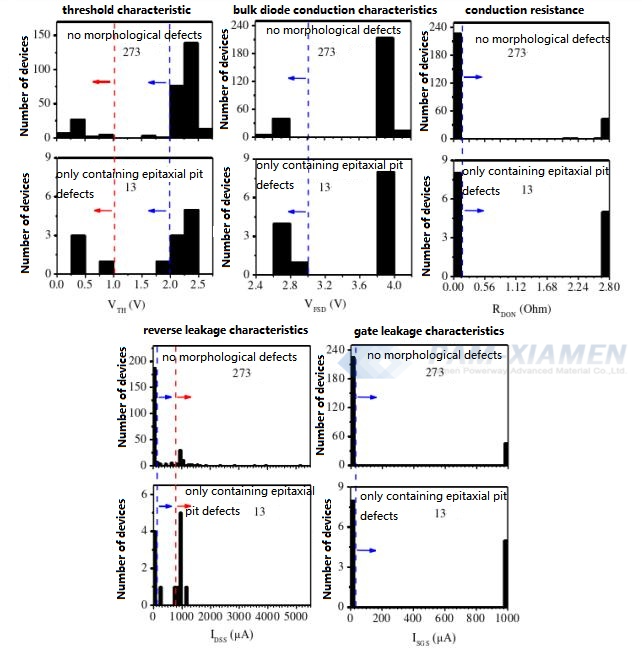
Fig. 2 Histogram över olika karakteristiska fördelningar av SiC MOSFET-enheter med epitaxiella gropdefekter
När det gäller enhetsfel är felfrekvensen för enheter som innehåller epitaxiella gropdefekter endast 47 %. Jämfört med triangulära defekter är inverkan av epitaxiella gropdefekter på de omvända läckageegenskaperna och gate-läckageegenskaperna hos enheten signifikant reducerad, med nedbrytningshastigheter på 53 % respektive 38 %, som visas i följande tabell. Å andra sidan är inverkan av epitaxiella gropdefekter på tröskelspänningsegenskaper, bulkdiodledningsegenskaper och ledningsresistans större än för triangulära defekter, med nedbrytningshastigheter som når 38 %.
| Tabell 1 Statistisk tabell över korrelationen mellan epitaxiella gropdefekter och SiC MOSFET-enhetsegenskaper | |||||
|
Defekt |
VTHnedbrytningshastighet | VFSDnedbrytningshastighet | RDONnedbrytningshastighet | IDSSnedbrytningshastighet | ISGSnedbrytningshastighet |
| Epitaxiell gropdefekt | 38% | 38% | 38% | 53 % | 38% |
Sammantaget har morfologiska defekter i epitaxiella gropar en betydande inverkan på fel och karakteristisk nedbrytning av SiC MOSFET-enheter. Enheter med epitaxiella gropdefekter har en lägre felfrekvens på 47 %. Emellertid är inverkan av epitaxiella gropdefekter på tröskelspänningen, bulkdiodens ledningsegenskaper och ledningsresistansen hos anordningen större än den för triangulära defekter.
För mer information, vänligen kontakta oss maila påvictorchan@powerwaywafer.com och powerwaymaterial@gmail.com.

