Enkristall 3C-SiC-substrat kan levereras med specifikationer som:https://www.powerwaywafer.com/3c-sic-wafer.html.
Kiselkarbid (SiC) har utmärkta egenskaper som brett bandgap, hög nedbrytningsfältstyrka, hög mättnadselektrondrifthastighet och hög värmeledningsförmåga, och har viktiga tillämpningar inom områden som nya energifordon, solceller och 5G-kommunikation. Jämfört med den allmänt använda 4H-SiC har kubisk SiC (3C SiC) högre bärarmobilitet (2-4 gånger), lägre gränssnittsdefekttäthet av tillstånd (en storleksordning lägre) och högre elektronaffinitet (3,7 eV). Användningen av 3C-SiC för att förbereda fälteffekttransistorer kan lösa problemet med dålig enhets tillförlitlighet orsakad av flera grindsyregränssnittsdefekter. Men utvecklingen av 3C-SiC-baserade transistorer är långsam, främst på grund av bristen på enkristallsubstrat. Tidigare studier har visat att 3C-SiC är benägen till fasövergång under tillväxt, och befintliga tillväxtmetoder kan inte erhålla kristaller med en enda kristallform.
1. Stabil tillväxt av 3C-SiC odlad på 4H-SiC via TSSG
Enligt den klassiska kristalltillväxtteorin, för jämna gränssnittskristaller, behöver homogen tvådimensionell kärnbildning övervinna kritiska potentiella barriärer, med förekomsten av kritisk Gibbs fri energi eller övermättnad, medan tillväxt kan ske vid vilken liten övermättnad som helst. För heterogen kärnbildning, på grund av införandet av ny fast-fast gränssnittsenergi, måste tvådimensionell kärnbildning övervinna högre kritiska potentiella barriärer. Därför, under samma övermättnad, är homogen kärnbildning och tillväxt betydligt bättre när det gäller energi än heterogen kärnbildning och tillväxt, vilket gör det senare svårt att inträffa.
Nyligen har ett forskarlag föreslagit den akademiska idén att reglera fast-vätskegränssnittsenergin för att prioritera kärnbildning och tillväxt på heterogena frökristaller jämfört med homogena frökristaller. Inkluderar huvudsakligen:
1) Gittermissanpassningen mellan 3C (111)-smältan och 4H (0001)-smältytorna är liten, och gränsytan mellan fast och fast ämne är mycket låg;
2) Skillnaden i Gibbs fria energi mellan 4H och 3C bulkfaser är relativt liten;
3) Om gränssnittsenergin för 3C (111) – smältan är tillräckligt låg jämfört med den för 4H (0001) – smälter genom att justera smältsammansättningen, är den tvådimensionella kärnbildningen och efterföljande tillväxt av Gibbs fria energi gynnsammare för 3C fas.
Teamet designade och byggde självständigt testutrustning för ytspänning och kontaktvinkel mellan fast och vätska för smältor med ultrahög temperatur. Ytspänningen för olika sammansättningar av smältor och kontaktvinkeln mellan smältan och 4H-SiC, 3C-SiC mättes vid höga temperaturer, och variationslagen för fast-vätska-gränssnittsenergi mellan 4H-SiC, 3C-SiC och hög- temperatursmälta erhölls, vilket verifierade genomförbarheten av gränssnittsenergireglering. Teamet använde högtemperaturvätskefasmetoden för att uppnå ett lägre Gibbs krav på fri energi för 3C-SiC under samma övermättnadsförhållanden, vilket undertryckte fasövergångar under tillväxt. För första gången internationellt odlades 3C-SiC-enkristaller med en diameter på 2-4 tum, en tjocklek på 4-10 mm och en enkristallform, som visas i Fig. 1.
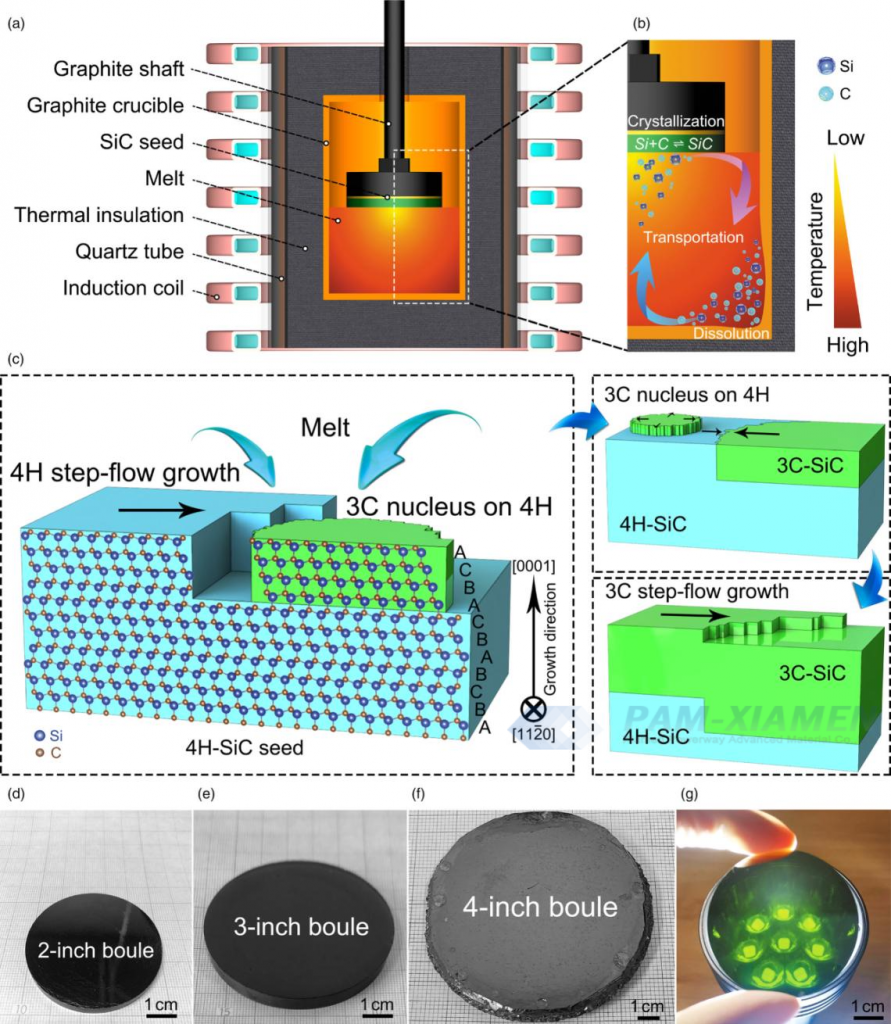
Fig. 1 Heterogen kärnbildning och stabil kristalltillväxt på 2-4 tum, 4-10 mm tjock 3C-SiC uppnåddes på 4H-SiC-frökristaller med användning av TSSG-metoden
2. Egenskaper för TSSG Grown 3C-SiC Single Crystal
Raman-spridningsspektroskopimätningarna längs kristalltjockleksriktningen indikerar att i början av tillväxten kärnar 3C-SiC och växer på 4H-SiC-frökristallen, med en samexistenszon på mindre än 20μm. Fig. 2 (ab) bekräftar ytterligare teorin ovan. Den genomsnittliga halva bredden av röntgenvaggningskurvan på (111) tillväxtytan är 30 bågar, vilket indikerar att den odlade 3C SiC har hög kristallkvalitet. Rumstemperaturresistiviteten för 3C SiC enkristall är endast 0,58 m Ω·cm, vilket är 1/40 av den kommersiella 4H-SiC waferresistiviteten (15-28 mΩ·cm) och förväntas minska enhetens energiförlust.

Fig. 2 Bestämning av 3C-SiC-kristallstruktur. a) Välj slumpmässigt 20 Raman-spridningsspektra från (111) tillväxtytan, och insättningen visar fördelningen av testpunkter på kristallen. b) Raman-spridningsspektra längs kristalltjocklekens riktning. c) Fotoluminescensspektrum (PL) mätt vid 300K. d) Hög vinkel ringformig mörkfältsskanningstransmissionselektronmikroskopi (HAADF-STEM) bild. Illustrationen visar det valda areaelektrondiffraktionsmönstret (SAED) längs [110] kristallbandaxeln.
Tillväxten av 3C-SiC-enkristaller på wafernivå fyller gapet globalt, vilket gör massproduktion av 3C-SiC-kristaller möjlig och ger nya möjligheter för utveckling av högpresterande kraftelektronikenheter. Samtidigt utökar mekanismen för preferentiell kärnbildning och tillväxt på heterogena frökristaller jämfört med homogena frökristaller den traditionella kristalltillväxtteorin.
För mer information, vänligen kontakta oss maila påvictorchan@powerwaywafer.com och powerwaymaterial@gmail.com.

