Nanofabrication Photoresist
PAM-XIAMEN Erbjuder fotoresistplatta med fotoresist
- Description
Produktbeskrivning
Nanotillverkning
PAM-XIAMEN Erbjudandenfotoresisttallrik medfotoresist
En fotoresist är ett ljuskänsligt material som används i flera processer, som t.exfotolitografioch fotogravering, för att bilda en mönstrad beläggning på en yta, vilket är avgörande i hela den elektroniska industrin.
En positiv resist är en typ av fotoresist där den del av fotoresisten som exponeras för ljus blir löslig för fotoresistframkallaren. Den oexponerade delen av fotoresisten förblir olöslig för fotoresistframkallaren.
En negativ fotoresist är en typ av fotoresist där den del av fotoresisten som exponeras för ljus blir olöslig för fotoresistframkallaren. Den oexponerade delen av fotoresisten löses upp av fotoresistframkallaren.
Baserat på den kemiska strukturen hos fotoresister kan de klassificeras i tre typer: fotopolymer, fotonedbrytande, fototvärbindning, fotoresist.
Fotoresistapplikationer:
Mikrokontakt utskrift
Tillverkning av kretskort (PCB)
Mönster och etsning av underlag
Mikroelektronik
fotoresist Microposit
Futurrex
andra fotoresists,
vänligen kontakta oss för detaljerad information
Silikonsubstrat 2″3″4″5″6″8″
kvartssubstrat SSP/DSP
glassubstrat N/P
Si02-substrat 100/110/111
annat substrat,
vänligen kontakta oss för detaljerad information
Skillnader mellan positiva och negativa motstånd
| Karakteristisk | Positiv | Negativ |
| Vidhäftning till kisel | Fair | Utmärkt |
| Relativ kostnad | Dyrare | Billigare |
| Utvecklarbas | Vattenhaltig | Organisk |
| Löslighet i utvecklaren | Exponerad region är löslig | Exponerad region är olöslig |
| Minsta funktion | 0,5 µm | 2 µm |
| Stegetäckning | Bättre | Lägre |
| Våtkemisk resistens | Fair | Utmärkt |
En enda iteration avfotolitografikombinerar flera steg i följd. Moderna renrum använder automatiserade, robotbaserade wafer track-system för att koordinera processen. Proceduren som beskrivs här utelämnar vissa avancerade behandlingar, såsom förtunningsmedel eller borttagning av kantpärlor. Grundläggande procedur
Rengöring
Om organiska eller oorganiska föroreningar finns på skivans yta, avlägsnas de vanligtvis genom våtkemisk behandling, t.ex. RCA-rengöringsproceduren baserad på lösningar som innehåller väteperoxid. Andra lösningar gjorda med trikloretylen, aceton eller metanol kan också användas för att rengöra.
Förberedelse
Skivan värms initialt till en temperatur som är tillräcklig för att driva bort eventuell fukt som kan finnas på skivans yta, 150 °C i tio minuter är tillräckligt. Wafers som har legat i lager måste rengöras kemiskt för att avlägsna kontaminering. En flytande eller gasformig "adhesionspromotor", såsom Bis(trimetylsilyl)amin ("hexamethyldisilazane", HMDS), appliceras för att främja vidhäftningen av fotoresisten till wafern. Ytskiktet av kiseldioxid på skivan reagerar med HMDS för att bilda tri-metylerad kiseldioxid, ett mycket vattenavvisande skikt inte olikt vaxskiktet på en bils lack. Detta vattenavvisande skikt hindrar den vattenhaltiga framkallaren från att tränga in mellan fotoresistskiktet och waferns yta och förhindrar därmed så kallade lyft av små fotoresiststrukturer i (framkallande) mönstret. För att säkerställa utvecklingen av bilden täcks den bäst och placeras över en varm platta och låt den torka samtidigt som temperaturen stabiliseras vid 120 °C.
Applicering av fotoresist
Skivan är täckt med fotoresist genom spinnbeläggning. En viskös, flytande lösning av fotoresist fördelas på skivan, och skivan snurras snabbt för att producera ett jämnt tjockt skikt. Spinnbeläggningen körs vanligtvis vid 1200 till 4800 rpm i 30 till 60 sekunder och producerar ett lager mellan 0,5 och 2,5 mikrometer tjockt. Spinnbeläggningsprocessen resulterar i ett enhetligt tunt skikt, vanligtvis med en enhetlighet inom 5 till 10 nanometer. Denna enhetlighet kan förklaras av detaljerad vätskemekanisk modellering, som visar att resisten rör sig mycket snabbare i toppen av skiktet än i botten, där viskösa krafter binder resisten till waferytan. Sålunda kastas det översta lagret av resist snabbt ut från waferns kant medan det undre lagret fortfarande kryper långsamt radiellt längs wafern. På detta sätt tas alla "bulor" eller "ryggar" av resist bort, vilket lämnar ett mycket plant lager. Slutlig tjocklek bestäms också av avdunstning av flytande lösningsmedel från resisten. För mycket små, täta detaljer (< 125 eller så nm), behövs lägre resisttjocklekar (< 0,5 mikrometer) för att övervinna kollapseffekter vid höga bildförhållanden; typiska bildförhållanden är < 4:1.
Den fotoresistbelagda skivan förgräddas sedan för att driva bort överskott av fotoresistlösningsmedel, vanligtvis vid 90 till 100 °C under 30 till 60 sekunder på en värmeplatta.
Exponering och utvecklande
Efter förbakning exponeras fotoresisten för ett mönster av intensivt ljus. Exponeringen för ljus orsakar en kemisk förändring som gör att en del av fotoresisten kan avlägsnas med en speciell lösning, kallad "framkallare" i analogi med fotografisk framkallare. Positiv fotoresist, den vanligaste typen, blir löslig i framkallaren när den exponeras; med negativ fotoresist är oexponerade områden lösliga i framkallaren.
En efterexponeringsbakning (PEB) utförs före framkallning, vanligtvis för att hjälpa till att minska stående vågfenomen som orsakas av det infallande ljusets destruktiva och konstruktiva interferensmönster. I djup ultraviolett litografi används kemiskt förstärkt resist (CAR) kemi. Denna process är mycket mer känslig för PEB-tid, temperatur och fördröjning, eftersom det mesta av "exponeringsreaktionen" (att skapa syra, vilket gör polymeren löslig i den grundläggande framkallaren) faktiskt sker i PEB.
Framkallningskemin levereras på en spinnare, ungefär som fotoresist. Utvecklare innehöll ursprungligen ofta natriumhydroxid (NaOH). Natrium anses dock vara en extremt oönskad förorening i MOSFET-tillverkning eftersom det försämrar de isolerande egenskaperna hos gateoxider (specifikt kan natriumjoner migrera in och ut ur gate, vilket ändrar transistorns tröskelspänning och gör det svårare eller lättare att vrida transistorn på över tiden). Metalljonfria framkallare som tetrametylammoniumhydroxid (TMAH) används nu.
Den resulterande skivan är sedan "hårdbakad" om en icke-kemiskt förstärkt resist användes, vanligtvis vid 120 till 180 °C [citat behövs] i 20 till 30 minuter. Den hårda bakningen stelnar den återstående fotoresisten för att skapa ett mer hållbart skyddsskikt vid framtida jonimplantation, våtkemisk etsning eller plasmaetsning.
Etsning
Vid etsning tar ett flytande (”vått”) eller plasma (”torrt”) kemiskt medel bort det översta lagret av substratet i de områden som inte är skyddade av fotoresist. Vid halvledartillverkning används vanligtvis torretsningstekniker, eftersom de kan göras anisotropa, för att undvika betydande underskärning av fotoresistmönstret. Detta är väsentligt när bredden på de egenskaper som ska definieras är liknande eller mindre än tjockleken på materialet som etsas (dvs när bildförhållandet närmar sig enhet). Våtetsningsprocesser är i allmänhet isotropa till sin natur, vilket ofta är oumbärligt för mikroelektromekaniska system, där suspenderade strukturer måste "frigöras" från det underliggande lagret.
Utvecklingen av anisotropisk torretsningsprocess med låg defekt har gjort det möjligt för de allt mindre egenskaperna som definieras fotolitografiskt i resisten att överföras till substratmaterialet.
Fotoresist borttagning
Efter att en fotoresist inte längre behövs måste den tas bort från substratet. Detta kräver vanligtvis en flytande "resist stripper", som kemiskt förändrar resisten så att den inte längre fäster på substratet. Alternativt kan fotoresist avlägsnas med en plasma som innehåller syre, som oxiderar den. Denna process kallas askning och liknar torretsning. Användning av 1-metyl-2-pyrrolidon (NMP) lösningsmedel för fotoresist är en annan metod som används för att ta bort en bild. När resisten har lösts upp kan lösningsmedlet avlägsnas genom uppvärmning till 80 °C utan att lämna några rester.
Microposit S1800 G2-serien fotoresist
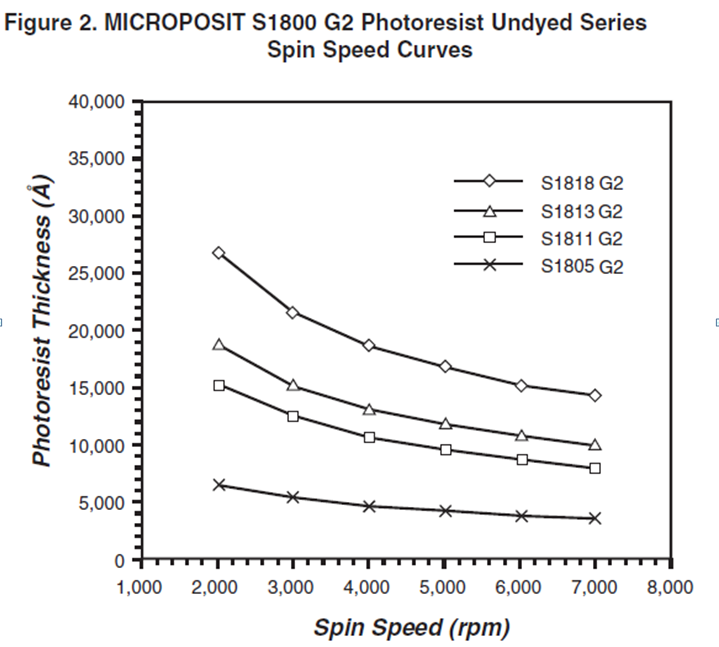
Microposit S1800 G2-serien fotoresist
NEGATIV RESIST NR9-6000PY

NEGATIV RESIST NR9-6000P