Enkristall AlN-substrat kan förses med specifikationer som finns ihttps://www.powerwaywafer.com/aln-substrate.html.
AlN enkristall är det direkta bandgap-halvledarmaterialet med den största bandgapbredden (6,2 eV), som har utmärkta egenskaper såsom extremt hög nedbrytningsfältstyrka, utmärkt värmeledningsförmåga, stabila fysikaliska och kemiska egenskaper. Dessutom har AlN enkristall mycket litet gitter och termisk obalans med GaN och AlGaN, och anses vara det bästa substratet för III-V epitaxialmaterial. Den har breda tillämpningsmöjligheter inom djupa ultravioletta detektorer, djupa ultravioletta lysdioder, djupa ultravioletta LD:er och högeffektsfält för mikrovågor.
För närvarande är den fysiska gastransportmetoden (PVT) den vanliga metoden för att framställa AlN-enkelkristaller i bulk. Den primära faktorn som begränsar utvecklingen av PVT-baserad AlN-enkristalltillväxtteknologi är dock förvärvet av högkvalitativa AlN-frökristaller, såväl som korrelationen mellan tillväxtförhållanden och tillväxtlägen när AlN-frökristaller växer homogent.
Forskare har använt PVT-metoden för att odla högkvalitativa AlN-enkristaller på egentillverkade AlN-frökristaller. Ytmorfologin för AlN-enkristaller under olika tillväxtlägen (tredimensionella ö- och enhelixtillväxtcentra) observerades. På basis av optimering av den termiska fältstrukturen fann man att yttemperaturen för AlN-frökristaller spelar en viktig roll i kristalltillväxt, och tillväxtförhållandena bestämmer direkt kristalltillväxtsättet. Det är värt att notera att halvbredden (FWHM) för (002) och (102) diffraktionstopparna för AlN-enkristaller som odlats i singelhelixtillväxtcentrummoden är 65 respektive 36 bågsekunder. Ett AlN-buffertskikt och en AlxGa1-xN-tunn film med hög Al-komponent epitaxiellt odlades sekventiellt på ett högkvalitativt AlN-enkristallsubstrat med användning av MOCVD. Ytan av AlN-buffertskiktet uppvisar god ytkristallisationskvalitet. Al-komponenten i AlxGal-xN epitaxiell tunnfilm är 0,54, och halvbredden vid halva maximum (FWHM) av (002) och (102) reflektioner av Al x Ga1-xN är 202 respektive 496 bågsekunder. Ovanstående forskningsresultat indikerar att jämfört med SiC eller safirsubstrat uppvisar AlN enkristallsubstrat överlägsna fördelar i homogen epitaxiell tillväxt av AlN och AlGaN-filmer med hög Al-komponent.
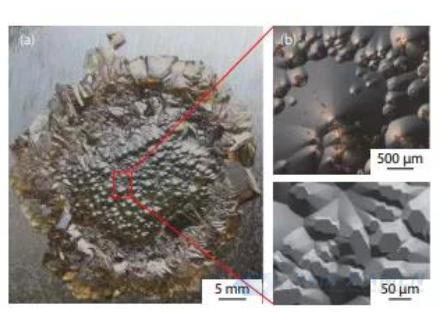
Fig. 1 Ytmorfologi för AlN enkristall
Denna studie kommer att ytterligare vägleda beredningen av högkvalitativa AlN-enkristaller och främja utvecklingen av AlGaN-epitaxi och relaterade enheter.
För mer information, vänligen kontakta oss maila påvictorchan@powerwaywafer.com och powerwaymaterial@gmail.com.

