Med den ökande utvecklingen av halvledarenheter visar kisel och kiselbaserade material fortfarande sina överlägsna egenskaper, och det kommer fortfarande att vara ett viktigt material för halvledarenheter och integrerade kretsar. Med den minskande storleken på enheter är resistiviteten, föroreningsfördelningen, filmtjockleken och kvalitetskontrollen av kisel och kiselbaserade material extremt viktiga. Att använda spridningsmotståndsprofilering (SRP) för att testa och analysera kisel- och kiselbaserade material är mer intuitivt och effektivt än andra testmetoder.PAM-XIAMEN kan erbjudakiselskivormed spridning av motståndsprofileringstjänster vid behov.
SRP är också känd som spridningsresistansanalys (SRA), det vill säga diffusionsresistansfördelning är en metod för att testa elektriska parametrar som diffusionsresistans, resistivitet, bärarkoncentrationsfördelning etc. av halvledarmaterial med högre upplösning, som tillhör en experimentell jämförelsemetod.
1. Grundläggande principer för SRP – profilering av spridningsmotstånd (Baserat på kiselskiva)
Stegen i spridningsmotståndsprofilen är att mäta spridningsresistansen för en serie punktkontakter (Rs är förhållandet mellan potentialfallet mellan den ledande metallsonden och en referenspunkt på kiselskivan och strömmen som flyter genom sonden), och använd sedan kalibreringskurvan för att bestämma resistiviteten hos det testade provet nära kontaktpunkten för spridningsmotståndssonden omvandlas till bärarkoncentrationen som motsvarar serien av testpunkter.
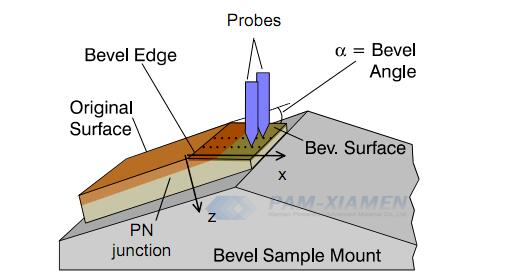
Schematisk profilering av spridningsmotståndsprobteknik
För att förbättra den rumsliga upplösningen och samtidigt i enlighet med de olika målmätdjupen, kan riktningen för provets tvärsnitt slipas i en serie vinklar och resistivitetsändringen inom 5 nm från upplösningsdjupet riktning kan mätas efter slipning av kiselskivan.
Ta den epitaxiella kiselskivan till exempel:
| Punkt | Parameter | spec | Enhet | |
| 1 | tillväxt Metod | CZ | ||
| 2 | Diameter | 100+/-0,5 | mm | |
| 3 | Typdopant | P- Bor | ||
| 4 | Resistivitet | 0,002 – 0,003 | ohm-cm | |
| 5 | Resistivitet Radiell variation | <10 | % | |
| 6 | kristallorientering | <111> 4 +/- 0,5 | grad | |
| 7 | Primär lägenhet | Orientering | Semi | grad |
| Längd | Semi | mm | ||
| 8 | Sekundär lägenhet | Orientering | Semi | grad |
| Längd | semi | mm | ||
| 9 | Tjocklek | 525 +/- 25 | um | |
| 10 | TTV | ≦10 | um | |
| 11 | Rosett | ≦40 | um | |
| 12 | Varp | ≦40 | um | |
| 13 | Framsida | polerad | ||
| 14 | Baksida | etsat | ||
| 15 | Ytans utseende | inga repor, dis, kantspån, apelsinskal, defekter, kontaminering | ||
| 16 | Kantprofil | Kantavrundning | ||
| 17 | Partikel (>0,3 μm) | N / A | ea/wf | |
| 18 | ||||
| 19 | Epilager 1 | N Phos | ||
| 20 | resistivitet | 3,8 – 5,2 | ohm cm | |
| 21 | Tjocklek | 29,0 – 35,0 | um | |
| 22 | Epi Layer 2 | N Phos | ||
| 23 | resistivitet | 0,0014 – 0,0026 | ohm cm | |
| 24 | Tjocklek | 36,0 – 44,0 | ||
Note:The epi wafer can be processed and fabricated into Circuit Protection TVS Diodes, they are very similar to that of a schottky diode. When the first epi layer is too thin to get the proper performance and break down Voltage and the TVS circuit won’t regulate. Transient voltage suppressor diodes are very popular devices used to instantaneously clamp transient voltages (e.g., ESD events) to safe levels before they can damage a circuit. The are designed to react much faster then your typical zener or schottky diode.
Vi testar ovanstående specifikation genom SRP-test och erhåller resistansen och tjockleken på epilagren. Se diagrammet nedan:
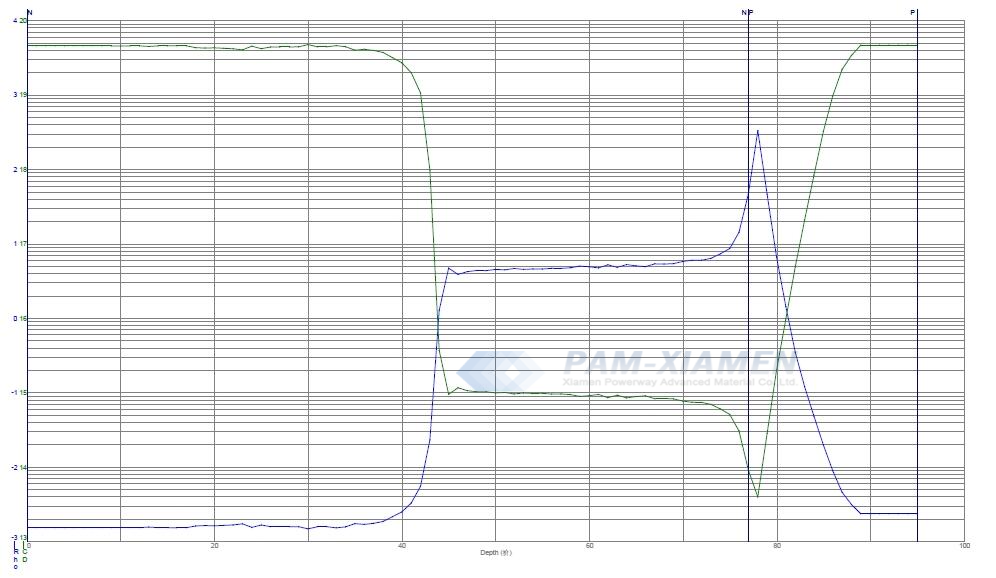
2. För- och nackdelar med mätning av spridningsmotståndsprofiler
Fördelar:
- Utmärkt rumslig upplösning;
- Kortfattad och intuitiv testning;
- Brett resistivitetstestområde;
- Kan användas som en flerskiktsprofil
Nackdelar:
- Destruktivt test
3. Tillämpningar av profilering och analys av spridningsmotstånd
SRP används mer och mer vid testning av epitaxiella wafer och IC-mönster på grund av dess överlägsna rumsliga upplösning. SRP-teknologi kan mäta inte bara den longitudinella resistansförändringen av epitaxial skiva, utan också epitaxiell skikttjocklek, övergångsområde och mellanskiktsbredd.
Resistiviteten (eller koncentrationen) och djupfördelningen av epitaxiella skikt såsom Si, InP, GaAs, SiC, etc., testas med spridningsmotståndsprofileringsmetoden. Genom att känna till det epitaxiella lagrets tjocklek, övergångsområdets bredd och substratets resistivitet och den epitaxiella skivans resistivitet på ett visst djup är det möjligt att diagnostisera kvaliteten på den epitaxiella skivan.
Observera att SRP endast mäter den aktiverade partiella dopningskoncentrationen.

För mer information, vänligen kontakta oss maila påvictorchan@powerwaywafer.com och powerwaymaterial@gmail.com.
