Nanofabrication Photoresist
PAM-XIAMEN Offres plaque de résine photosensible avec résine photosensible
- La description
Description du produit
nanofabrication
Offres PAM-XIAMENrésine photosensibleplaque avecrésine photosensible
Une résine photosensible est un matériau photosensible utilisé dans plusieurs processus, tels quephotolithographieet photogravure, pour former un revêtement à motif sur une surface, ce qui est crucial dans toute l'industrie électronique.
Une réserve positive est un type de résine photosensible dans laquelle la partie de la résine photosensible qui est exposée à la lumière devient soluble à thephotoresist développeur. La partie non exposée de la résine photosensible reste insoluble pour le développeur d'agent photorésistant.
Une résine photosensible négative est un type de résine photosensible dans laquelle la partie de la résine photosensible qui est exposée à la lumière devient insoluble à son développeur d'agent photorésistant. La partie non exposée de la résine photosensible est dissoute par le développeur d'agent photorésistant.
Sur la base de la structure chimique des résines photosensibles, ils peuvent être classés en trois types: photopolymères, photodecomposing, photoréticulation, résine photosensible.
Applications de photorésine :
impression microcontact
La fabrication de cartes de circuits imprimés (PCB)
Modeler et graver des substrats
Microelectronics
photoréserve Microposit
Futurrex
autres photoréserves,
s'il vous plaît nous contacter pour plus d'informations
Substrat substrat de silicium 2 "3" 4 "5" 6 "8"
quartz substrat SSP / DSP
de verre N / P
SiO2 substrat 100/110/111
un autre substrat,
s'il vous plaît nous contacter pour plus d'informations
Les différences entre positif et négatif Resist
| Caractéristiques | Positif | Négatif |
| L'adhésion à la Silicon | Juste | Excellent |
| Coût relatif | Plus cher | Moins cher |
| Base développeur | Aqueux | Organique |
| Solubilité dans le révélateur | région exposée est soluble | région exposée est insoluble |
| Fonction minimum | 0,5 pm | 2 pm |
| étape couverture | Mieux | Inférieur |
| Résistance chimique humide | Juste | Excellent |
Une seule itération dephotolithographiecombine plusieurs étapes successives. Les salles blanches modernes utilisent des systèmes automatisés et robotisés de suivi des plaquettes pour coordonner le processus. La procédure décrite ici omet certains traitements avancés, tels que les agents d'éclaircissage ou l'élimination des bourrelets.Procédure de base
Nettoyage
Si les contaminations organiques ou inorganiques sont présentes sur la surface de la tranche, ils sont habituellement éliminés par traitement chimique par voie humide, par exemple, la procédure de nettoyage RCA basée sur des solutions contenant du peroxyde d'hydrogène. D'autres solutions faites avec le trichloréthylène, l'acétone ou le méthanol peut également être utilisé pour nettoyer.
Préparation
La plaquette est initialement chauffée à une température suffisante pour chasser toute trace d'humidité qui peut être présente sur la surface de la tranche, 150 ° C pendant dix minutes est suffisante. Gaufrettes qui ont été entreposés doivent être nettoyés chimiquement pour éliminer la contamination. Un « promoteur d'adhérence » liquide ou gazeux, tels que le bis (triméthylsilyl) amine ( « hexaméthyldisilazane », HMDS), est appliquée pour favoriser l'adhérence de la résine photosensible de la plaquette. La couche superficielle de dioxyde de silicium sur la tranche réagit avec HMDS pour former le tri-méthylé-dioxyde de silicium, une couche repoussant fortement l'eau semblable à la couche de cire sur la peinture de la voiture. Cette couche hydrophobe empêche le révélateur aqueux de pénétrer entre la couche de résine photosensible et la surface de la plaquette, ce qui empêche que l'on appelle le levage de petites structures de photorésist dans le motif (en développement). Afin d'assurer le développement de l'image, il est préférable couvert et placé sur une plaque chauffante et laisser sécher tout en stabilisant la température à 120 ° C.
l'application photoresist
La tranche est recouverte de résine photosensible par revêtement par centrifugation. A visqueux, solution liquide de résine photosensible est distribué sur la tranche, et la tranche est filé rapidement pour produire une couche d'épaisseur uniforme. Le revêtement par centrifugation fonctionne typiquement à 4 800 tours par minute à 1,2 mille pendant 30 à 60 secondes, et produit une couche de 0,5 à 2,5 micromètres d'épaisseur. Le procédé de revêtement par centrifugation se traduit par une mince couche uniforme, généralement avec l'uniformité de moins de 5 à 10 nanomètres. Cette uniformité peut être expliquée par la modélisation de fluide mécanique détaillé, ce qui montre que la réserve se déplace plus rapidement dans la partie supérieure de la couche que dans le bas, où les forces visqueuses se lient au résistent à la surface de la plaquette. Ainsi, la couche supérieure de réserve est rapidement éjecté du bord de la plaquette tandis que la couche inférieure glisse radialement encore lentement le long de la tranche. De cette façon, toute « bosse » ou « crête » de réserve est retiré, laissant une couche très plat. épaisseur finale est également déterminée par l'évaporation des solvants liquides à partir de la réserve. Pour les très petites caractéristiques denses (<125 nm ou plus), baissez résister à des épaisseurs (<0,5 micromètre) sont nécessaires pour surmonter les effets de l'effondrement à haut rapport d'aspect; des rapports d'aspect typique sont <4: 1.
La résine photosensible revêtue de plaquette est ensuite précuite pour chasser l'excès de solvant de photoresist, typiquement à 90 à 100 ° C pendant 30 à 60 secondes sur une plaque chauffante.
L'exposition et le développement
Après précuisson, la résine photosensible est exposée à un motif de lumière intense. L'exposition à la lumière provoque un changement chimique qui permet une partie de la résine photosensible à enlever par une solution spéciale, appelée « développeur » par analogie avec le développeur photographique. résine photosensible positive, le type le plus commun, devient soluble dans le révélateur lorsqu'il est exposé; avec photorésist négatif, les régions non exposées sont solubles dans le révélateur.
Une cuisson post-exposition (PEB) est effectuée avant le développement, généralement pour aider à réduire les phénomènes d'ondes stationnaires causées par les modèles destructeurs et une interférence constructive de la lumière incidente. Dans la lithographie ultraviolet profond, chimiquement amplifiée chimie est utilisée (CAR). Ce procédé est beaucoup plus sensible aux temps de PEB, la température, et le retard, comme la plupart de la réaction « d'exposition » (création d'acide, ce qui rend le polymère soluble dans le révélateur de base) se produit en fait dans le PEB.
Le développement de la chimie est livrée sur une fileuse, un peu comme résine photosensible. Les développeurs d'hydroxyde de sodium à l'origine souvent contenue (NaOH). Toutefois, le sodium est considéré comme un contaminant extrêmement indésirable dans la fabrication MOSFET car elle dégrade les propriétés isolantes des oxydes de grille (en particulier, les ions sodium peuvent migrer dans et hors de la porte, en changeant la tension de seuil du transistor et qui rend plus difficile ou plus facile à allumer le transistor à l'heure plus). développeurs sans ions métalliques tels que l'hydroxyde de tétraméthylammonium (TMAH) sont maintenant utilisés.
La pastille résultante est ensuite « hard-cuit » si un non-chimiquement amplifiée de résist a été utilisé, typiquement de 120 à 180 ° C [citation nécessaire] pendant 20 à 30 minutes. La solidification de la cuisson dure le restant de résine photosensible, pour faire une couche de protection plus durable à l'avenir une implantation ionique, gravure chimique humide ou une gravure plasma.
Gravure
Dans la gravure, un agent chimique liquide ( « humide ») ou plasma ( « sec ») enlève la couche supérieure du substrat dans les zones qui ne sont pas protégées par le photorésist. Dans la fabrication de semi-conducteurs, les techniques de gravure à sec de sont généralement utilisés, car ils peuvent être anisotropes, afin d'éviter une sous-cotation importante du motif de résine photosensible. Ceci est essentiel lorsque la largeur des éléments à définir est similaire ou inférieure à l'épaisseur du matériau étant gravé (par exemple lorsque le rapport d'aspect se rapproche de l'unité). Les processus de humides sont généralement isotrope dans la nature, ce qui est souvent indispensable pour les systèmes microélectromécaniques, où les structures suspendues doivent être « libérés » de la couche sous-jacente.
Le développement de anisotrope faible Défectivité processus de gravure à sec a permis aux fonctionnalités toujours plus petites définies par photolithographie dans le résister à transférer au matériau de substrat.
l'enlèvement photoresist
Après une résine photosensible n'est plus nécessaire, il doit être retiré du substrat. Cela nécessite généralement un liquide « résister décapant », qui chimiquement altère le résist de sorte qu'il ne adhère plus au substrat. En variante, photoresist peut être éliminé par un plasma contenant de l'oxygène qui oxyde lui. Ce processus est appelé décendrage, et ressemble à la gravure à sec. Utilisation de 1-méthyl-2-pyrrolidone (NMP) solvant pour résine photosensible est une autre méthode utilisée pour supprimer une image. Lorsque le résist a été dissous, le solvant peut être éliminé par chauffage à 80 ° C sans laisser de résidu.
Microposit S1800 G2 Series Photorésistance
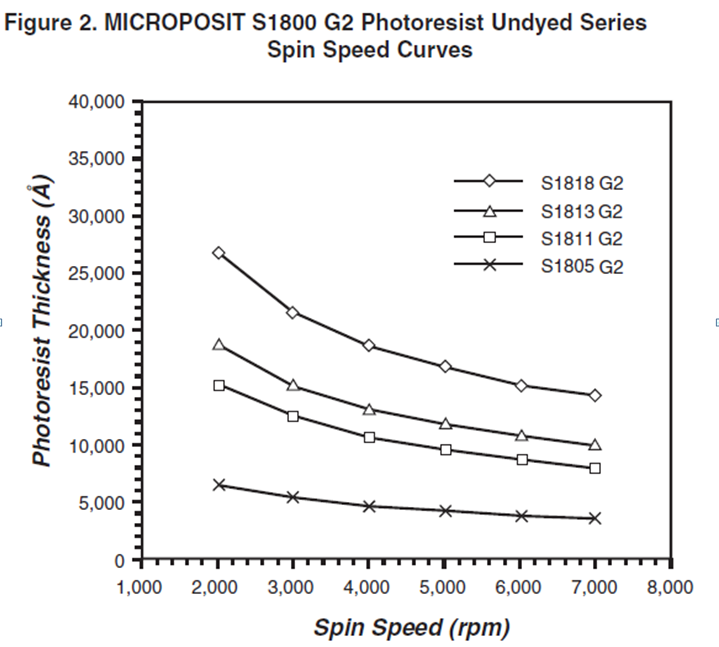
Microposit S1800 G2 Series Photorésistance
RESIST NEGATIF NR9-6000PY

RESIST NEGATIF NR9-6000P