Nanofabrication Photoresist
PAM-XIAMEN offre piastra fotoresist con fotoresist
- Descrizione
Descrizione del prodotto
nanofabbricazione
Offerte PAM Xiamenfotoresistpiastra confotoresist
Un fotoresist è un materiale fotosensibile utilizzato in molti processi, come ad esempiofotolitografiae fotoincisione, per formare un rivestimento su una superficie modellata, che è cruciale per tutta l'industria elettronica.
Un resist positivo è un tipo di fotoresist in cui la porzione del photoresist che è esposto alla luce diventa solubile thephotoresist sviluppatore. La porzione non esposta del fotoresist rimane insolubile allo sviluppatore photoresist.
Un fotoresist negativo è un tipo di fotoresist in cui la porzione del photoresist che è esposto a luce diventa insolubile allo sviluppatore photoresist. La porzione non esposta del fotoresist viene sciolto dallo sviluppatore photoresist.
Sulla base della struttura chimica di fotoresist, possono essere classificati in tre tipi: fotopolimeriche, photodecomposing, fotoreticolazione, fotoresist.
Applicazioni fotoresist:
stampa microcontact
Fabbricazione di circuiti stampati (PCB)
Patterning e incisione di substrati
Microelectronics
fotoresist Microposit
Futurrex
altri fotoresist,
non esitate a contattarci per informazioni dettagliate
substrato di silicio substrato 2 "3" 4 "5" 6 "8"
quarzo substrato SSP / DSP
substrato di vetro N / P
SiO2 substrato 100/110/111
altro substrato,
non esitate a contattarci per informazioni dettagliate
Differenze tra positivo e negativo Resistere
| Caratteristica | Positivo | Negativo |
| Adesione al silicone | Fiera | Eccellente |
| costo relativo | Più costoso | Meno caro |
| Developer Base | acquoso | Organico |
| Solubilità nello sviluppatore | regione esposta è solubile | regione esposta è insolubile |
| Caratteristica minima | 0,5 micron | 2 micron |
| Passaggio di copertura | Meglio | Basso |
| Wet Resistenza chimica | Fiera | Eccellente |
Una singola iterazionefotolitografiacombina diversi passaggi in sequenza. Le moderne camere bianche utilizzano sistemi robotizzati e automatizzati di binari per wafer per coordinare il processo. La procedura qui descritta omette alcuni trattamenti avanzati, come agenti diluenti o rimozione dei cordoni dei bordi. Procedura di base
Pulizia
Se contaminazioni organiche o inorganiche sono presenti sulla superficie del wafer, di solito sono rimossi mediante trattamento chimico ad umido, ad esempio, la procedura di pulizia RCA basato su soluzioni contenenti perossido di idrogeno. Altre soluzioni a base di trielina, acetone o metanolo possono anche essere utilizzati per pulire.
Preparazione
Il wafer viene inizialmente riscaldato ad una temperatura sufficiente ad allontanare l'umidità eventualmente presente sulla superficie del wafer, 150 ° C per dieci minuti è sufficiente. Wafer che sono stati in deposito devono essere puliti chimicamente per rimuovere la contaminazione. Un liquido o gassoso “promotore di adesione”, quale bis (trimetilsilil) ammina ( “esametildisilazano”, HMDS), viene applicato per favorire l'adesione del fotoresist al wafer. Lo strato superficiale di biossido di silicio sul wafer reagisce con HMDS per formare ossido di silicio tri-metilata, uno strato repellente acqua altamente non dissimile strato di cera sulla vernice di un'auto. Questo strato idrorepellente impedisce lo sviluppatore acquoso penetri tra lo strato di resina fotosensibile e la superficie del wafer, impedendo così il cosiddetto sollevamento di piccole strutture photoresist in (sviluppo) modello. Al fine di garantire lo sviluppo dell'immagine, è meglio coperto e collocato su una piastra calda e lasciare asciugare stabilizzando la temperatura a 120 ° C.
applicazione fotoresist
Il wafer viene ricoperto con fotoresist per spin coating. Una viscoso, soluzione liquida di fotoresist viene erogata sul wafer, e il wafer è filata rapidamente per produrre uno strato di spessore uniforme. Il rivestimento per rotazione funziona tipicamente da 1200 fino a 4800 rpm per 30 a 60 secondi, e produce un livello tra 0,5 e 2,5 micrometri di spessore. Il processo di rivestimento mediante centrifugazione si traduce in uno strato sottile uniforme, di solito con uniformità di meno di 5 a 10 nanometri. Questa uniformità può essere spiegato dalla modellazione fluidodinamica dettagliata, che dimostra che la muove resistere molto più veloce nella parte superiore dello strato che in fondo, dove le forze viscose legano il resist alla superficie del wafer. Così, lo strato superiore di resist viene rapidamente espulso dal bordo del wafer mentre lo strato inferiore insinua ancora lentamente radialmente lungo il wafer. In questo modo, qualsiasi 'urto' o 'cresta' di resist viene rimosso, lasciando uno strato molto piatta. spessore finale è determinata anche dalla evaporazione dei solventi liquidi dal resistere. Per molto piccole, dense caratteristiche (<125 o così nm), inferiore resistere spessori (<0,5 micrometri) sono necessari per superare gli effetti di collasso ad alti rapporti di aspetto; proporzioni tipici sono <4: 1.
La pellicola fotosensibile rivestita wafer è quindi precotto per allontanare il solvente in eccesso photoresist, tipicamente fra 90 e 100 ° C per 30 a 60 secondi su una piastra.
Esposizione e sviluppo
Dopo precottura, il fotoresist è esposto a un modello di luce intensa. L'esposizione alla luce provoca un cambiamento chimico che consente alcuni fotoresist da rimuovere da una soluzione speciale, chiamato “developer” per analogia con sviluppo fotografico. photoresist positivo, il tipo più comune, diventa solubile nello sviluppatore quando esposti; con fotoresist negativo, le regioni non esposte sono solubili nello sviluppatore.
A cottura post-esposizione (PEB) viene eseguita prima di sviluppare, tipicamente per ridurre i fenomeni onda stazionaria causati dai modelli di interferenza distruttiva e costruttive della luce incidente. In profonda litografia ultravioletta, amplificato chimicamente resistere (CAR) chimica è utilizzata. Questo processo è molto più sensibile al tempo PEB, la temperatura, e il ritardo, come la maggior parte della reazione di “esposizione” (creando acido, rendendo il polimero solubile nello sviluppatore base) si verifica effettivamente in PEB.
La chimica sviluppare viene consegnato su un filatore, molto simile fotoresist. Sviluppatori idrossido di sodio originariamente spesso contenute (NaOH). Tuttavia, sodio è considerato un contaminante estremamente indesiderabile MOSFET fabbricazione perché degrada le proprietà isolanti di ossidi di gate (specificamente, ioni sodio possono migrare dentro e fuori dal cancello, cambiando la tensione di soglia del transistore e rendendo più difficile o più facile da girare il transistor nel tempo). sviluppatori privo di ione metallico come idrossido di tetrametilammonio (TMAH) vengono ora utilizzati.
Il wafer risultante è poi “hard-cotto” se non chimicamente amplificata resist è stato utilizzato, tipicamente a 120 a 180 ° C [citazione necessaria] per 20 a 30 minuti. La cottura duro solidifica il fotoresist rimanente, per fare uno strato protettivo più durevole nel futuro impiantazione ionica, attacco chimico umido o attacco in plasma.
acquaforte
In attacco, un liquido ( “wet”) o plasma ( “dry”) agente chimico rimuove lo strato superiore del substrato nelle aree non protette da fotoresist. In fabbricazione di semiconduttori, le tecniche di incisione a secco sono generalmente utilizzati, in quanto possono essere realizzati anisotropo, per evitare notevole riduzione del modello di fotoresist. Ciò è essenziale quando la larghezza delle caratteristiche da definire è simile o inferiore allo spessore del materiale che viene inciso (cioè quando il rapporto di formato avvicina all'unità). I processi di incisione bagnati sono generalmente isotropa in natura, che è spesso indispensabile per sistemi microelettromeccanici, in cui le strutture sospese dovranno essere “rilasciati” dallo strato sottostante.
Lo sviluppo di bassa difettosità anisotropo processo a secco-etch ha permesso a tutti i servizi sempre più piccole definite fotolitograficamente nel resist da trasferire al materiale del substrato.
rimozione di photoresist
Dopo un fotoresist non è più necessario, deve essere rimosso dal substrato. Ciò richiede di solito un liquido “resistere stripper”, che altera chimicamente il resist in modo che non aderisce al substrato. In alternativa, fotoresist può essere rimosso da un plasma contenente ossigeno, che ossida. Questo processo è chiamato incenerimento, e assomiglia incisione a secco. Uso di 1-metil-2-pirrolidone (NMP) solvente per fotoresist è un altro metodo utilizzato per rimuovere un'immagine. Quando il resist è stato sciolto, il solvente può essere rimosso mediante riscaldamento a 80 ° C senza lasciare residui.
Photoresist Microposit S1800 G2 Series
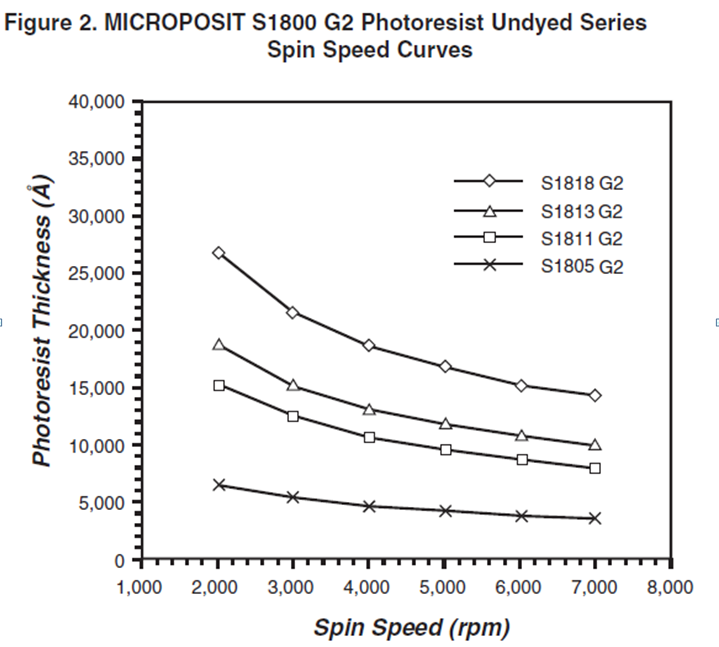
Photoresist Microposit S1800 G2 Series
NEGATIVO RESIST NR9-6000PY

NEGATIVO RESIST NR9-6000P