Nanofabrication Photoresist
PAM-하문은 포토 레지스트와 포토 레지스트 판을 제공
- 기술
제품 설명
나노
PAM-하문 행사포토 레지스트플레이트포토 레지스트
포토 레지스트는 여러 프로세스에 사용 된 감광성 물질, 예컨대 인석판 술및 제판은, 전체 전자 산업에서 매우 중요하다 표면에 패턴 화 된 코팅을 형성한다.
레지스트 포지티브 광에 노출되는 포토 레지스트의 부분 thephotoresist 현상액에 가용성이되는 레지스트의 유형이다. 미노 광 부분의 포토 레지스트는 포토 레지스트 현상 제에 불용성 남아있다.
네가티브 포토 레지스트를 광에 노출되는 포토 레지스트의 부분은 상기 포토 레지스트 현상액에 불용성이되는 포토 레지스트의 유형이다. 미노 광 부분의 포토 레지스트는 포토 레지스트 현상 제에 의해 용해된다.
Photopolymeric, photodecomposing, 광 가교, 포토 레지스트 : 포토 레지스트의 화학 구조에 기초하여, 그들 세 가지 유형으로 분류 될 수있다.
포토레지스트 애플리케이션:
미세 접촉 인쇄
인쇄 회로 기판의 제조 (PCB)
패터닝 기판의 에칭
포토레지스트 Microposit
Futurrex
다른 포토 레지스트,
자세한 내용은 문의하시기 바랍니다
기판, 실리콘 기판 (2) "3"4 "5"6 "8"
석영 기판 SSP / DSP
유리 기판을 N / P
의 SiO2 기판 100/110/111
다른 기판
자세한 내용은 문의하시기 바랍니다
긍정과 부정의 차이는 저항
| 특성 | 양 | 부정 |
| 실리콘으로 접착 | 공정한 | 우수한 |
| 상대 비용 | 더 비싼 | 저렴 |
| 개발자 자료 | 물의 | 본질적인 |
| 개발자의 용해도 | 노출 된 영역은 용해된다 | 노출 된 지역은 불용성 |
| 최소 기능 | 이 0.5㎛ | 2 μm의 |
| 단계 적용 | 보다 나은 | 보다 낮은 |
| 습식 화학 저항 | 공정한 | 우수한 |
의 단일 반복석판 술여러 단계를 순서대로 결합합니다. 현대식 클린룸은 자동화된 로봇 웨이퍼 추적 시스템을 사용하여 프로세스를 조정합니다. 여기에 설명된 절차는 희석제 또는 가장자리 비드 제거와 같은 일부 고급 처리를 생략합니다.기본 절차
청소
유기 또는 무기 오염물이 웨이퍼 표면 상에 존재하는 경우, 이들은 일반적으로 과산화수소를 함유하는 용액에 기초 RCA 깨끗한 절차 예컨대, 습식 화학 처리에 의해 제거된다. 트리클로로 에틸렌, 아세톤, 메탄올로 만든 다른 솔루션은 청소하는 데 사용할 수 있습니다.
예비
웨이퍼가 처음 십분 웨이퍼 표면에 존재할 수있는 습기, 150 ° C를 유도하기에 충분한 온도로 가열되는 것은 충분하다. 저장에 있었던 웨이퍼는 화학적으로 오염을 제거하기 위해 청소해야합니다. 액체 또는 기체 "접착 촉진제", 비스 (트리메틸 실릴) 아민 ( "헥사 메틸 디 실라 잔"HMDS)로서, 웨이퍼에 포토 레지스트의 밀착성을 증진인가된다. 웨이퍼상의 실리콘 다이옥사이드의 표면 층은 트라이 메틸화 이산화 규소가 아닌 자동차의 페인트에 왁스 층 달리 높은 발수 층을 형성하기 위해 HMDS와 반응한다. 이 발수 층 따라서 (현상) 패턴의 작은 포토 레지스트 구조의 소위 리프팅을 방지 포토 레지스트 층과 상기 웨이퍼의 표면 사이에 침투하는 수성 현상을 방지한다. 화상의 개발이 보장되도록하기 위해, 가장 피복하고, 핫 플레이트 위에 놓고 120 ℃로 온도를 안정화하면서 건조하자.
포토 레지스트 응용 프로그램
웨이퍼를 스핀 코팅 법에 의해 포토 레지스트로 피복된다. 포토 레지스트의 점성 액체 용액을 웨이퍼 상에 분배되고, 상기 웨이퍼를 균일 한 두께의 층을 제조 빠르게 회전시킨다. 스핀 코팅은 통상 1200 30 내지 60 초 동안 4800 rpm으로 실행되며, 두께 0.5 내지 2.5 마이크로 미터 사이의 층을 생성한다. 스핀 코팅 방법은 일반적으로 내 5 내지 10 나노 미터의 균일 성, 균일 한 박막을 초래한다. 이러한 균일 성은 점성력이 웨이퍼 표면에 레지스트 결합 하단에서보다 층의 상부에서 더 빨리 이동 레지스트 도시 상세한 유체 역학 모델에 의해 설명 될 수있다. 바닥층은 여전히 웨이퍼 반경 방향을 따라 서서히 크립 동안 따라서, 레지스트의 상층 빠르게, 웨이퍼의 에지로부터 토출된다. 이러한 방식으로, 임의의 "범프"또는 레지스트의 '리'매우 평탄한 층을 남기고 제거된다. 최종 두께는 레지스트 액으로부터 용매를 증발에 의해 결정된다. 매우 작고 조밀 기능 (<125 nm의 정도)의 경우, 하부 고 종횡비의 축소 효과를 극복하기 위해 필요하다 (<0.5 마이크로 미터) 두께의 레지스트 일반적인 종횡비 4 <: 1.
포토 레지스트 - 코팅 된 웨이퍼를 핫 플레이트상에서 30 내지 60 초 동안 100 ° C로 90에서 일반적으로 과량의 포토 레지스트 용매를 구동하는 프리 베이크한다.
노출 및 개발
프리 베이크 한 후, 포토 레지스트를 강렬한 광 패턴에 노출된다. 빛에 노출은 사진 개발자 유추에 의해 "개발자"라고 포토 레지스트의 일부는 특별한 솔루션으로 제거 할 수있는 화학 변화를 야기한다. 포지티브 포토 레지스트에 노출 될 때, 가장 일반적인 형태는, 현상 제에 가용성이된다; 네가티브 포토 레지스트, 미노 광 영역이 현상액에 용해된다.
노광 후 베이크 (PEB)은 전형적으로 입사하는 빛의 상쇄 및 보강 간섭 패턴에 의한 정재파 현상을 줄이기 위해 개발되기 전에 수행된다. 원 자외선 리소그래피에서, 화학적 (CAR) 화학 증폭 레지스트에 사용된다. 이 과정은 "노출"반응의 대부분으로 실제로 발생 PEB (산을 만드는 기본적인 현상액에 가용성 인 중합체를 제조), PEB 시간, 온도, 지연에 더 민감하다.
개발자 용 화학 훨씬 포토 레지스트처럼, 스피너에 전달된다. 개발자들은 원래 함유 된 수산화 나트륨 (NaOH로). 이 게이트 산화물 (즉, 나트륨 이온이 트랜지스터의 임계 전압을 변경하고 단단하거나 쉽게 회전 할 수있게, 및 게이트에서 이주 할 수의 절연성이 저하하기 때문에, 나트륨 MOSFET의 제조에 매우 바람직하지 못한 오염물 간주 시간 경과에 트랜지스터). 테트라 메틸 암모늄 하이드 록 사이드 (TMAH) 등의 금속 이온이없는 개발자는 이제 이용된다.
얻어진 웨이퍼는 "하드 베이킹"이면 비 화학적으로 20 내지 30 분 동안 120 ° C 내지 180 [필요 인용]에 일반적으로 사용 된 레지스트 증폭. 하드 베이크 향후 이온 주입, 습식 에칭 또는 플라즈마 에칭에 내구성 보호 층을 만들기 위해, 남은 포토 레지스트를 고화.
에칭
에칭에서, 액체 ( "젖은") 또는 플라즈마 ( "건조") 화학 제가 포토 레지스트에 의해 보호되지 않은 영역에서 상기 기판의 최상부 층을 제거한다. 이들은 포토 레지스트 패턴의 중요한 언더컷을 방지하기 위해 이방성으로 할 수 있기 때문에, 반도체 제조에있어서, 건식 에칭 기법은 일반적으로 사용된다. 정의 할 수있는 기능의 폭이 유사한 또는 물질의 두께는 에칭되는 미만이면이 필수적이다 (즉, 종횡비가 단일성에 접근 할 때). 습식 에칭 공정은 종종 정지 구조를 기본 계층으로부터 "해제"해야 마이크로 전자 기계 시스템에 불가결 자연에서 일반적으로 등방성이다.
낮은 결함률 이방성 건식 식각 공정의 개발은 포토 리소그라피가 기판 재료에 전사되도록 레지스트 정의 갈수록 작은 피처를 가능하게했다.
포토 레지스트 제거
포토 레지스트가 더 이상 필요하지 후에는 기판에서 제거해야합니다. 이것은 일반적으로 화학적으로는 더 이상 기판을 준수 너무 저항하지 변경하는 액체 "스트리퍼 저항"을 필요로한다. 대안으로, 포토 레지스트를 산화시켜 산소 함유 플라즈마에 의해 제거 될 수있다. 이 과정은 회화라는, 드라이 에칭과 유사합니다. 포토 레지스트 용 용매 N- 메틸 -2- 피 롤리 돈 (NMP)을 사용하는 화상을 제거하기 위해 사용되는 또 다른 방법이다. (가)에 용해 된 레지스트 때, 용매의 잔류 물을 남기지 않고 80 ° C로 가열함으로써 제거 될 수있다.
된 MicroPosit S1800 G2 시리즈 포토 레지스트
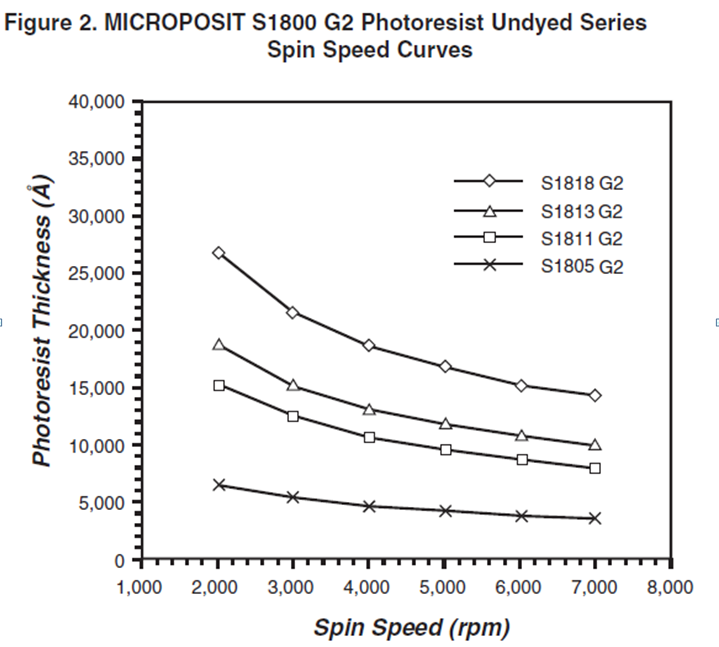
된 MicroPosit S1800 G2 시리즈 포토 레지스트
NEGATIVE는 NR9-6000PY 레지스트

NEGATIVE는 NR9-6000P 레지스트