Nanofabrication Photoresist
PAM-XIAMEN Ofertas placa de resina fotosensible con fotorresistencia
- Descripción
Descripción del Producto
nanofabricación
Ofertas PAM-XIAMENfotoprotectorplaca confotoprotector
Un fotoprotector es un material sensible a la luz usado en varios procesos, tales comofotolitografíay fotograbado, para formar un recubrimiento modelado en una superficie, que es crucial en toda la industria electrónica.
Un positivo resistir es un tipo de resina fotosensible en la que la porción de la resina fotosensible que se expone a la luz se vuelve soluble a thephotoresist desarrollador. La parte no expuesta de la resina fotosensible permanece insoluble al promotoras de fotorresistencia.
A fotorresistente negativa es un tipo de resina fotosensible en la que la porción de la resina fotosensible que se expone a la luz se convierte en insoluble al promotoras de fotorresistencia. La parte no expuesta de la resina fotosensible se disuelve por el desarrollador fotorresistente.
Sobre la base de la estructura química de las resinas fotosensibles, que se pueden clasificar en tres tipos: de fotopolímero, photodecomposing, fotorreticulación, fotorresistente.
Aplicaciones fotoprotectoras:
microcontacto impresión
La fabricación de placas de circuito impreso (PCB)
Patrones y grabado de substratos
Microelectrónica
fotoprotector Microposit
Futurrex
otras resinas fotosensibles,
Por favor, póngase en contacto con nosotros para obtener información detallada
sustrato de silicio del sustrato 2 "3" 4 "5" 6 "8"
cuarzo SSP sustrato / DSP
sustrato de vidrio N / P
sustrato SiO2 100/110/111
otro sustrato,
Por favor, póngase en contacto con nosotros para obtener información detallada
Las diferencias entre positivo y negativo Resist
| Característica | Positivo | Negativo |
| La adhesión a Silicon | Feria | Excelente |
| Coste relativo | Más caro | Menos costoso |
| Base desarrollador | Acuoso | Orgánico |
| Solubilidad en el revelador | región expuesta es soluble | región expuesta es insoluble |
| Característica mínimo | 0,5 micras | 2 micras |
| Cobertura paso | Mejor | Inferior |
| Resistencia química húmeda | Feria | Excelente |
Una única iteración defotolitografíacombina varios pasos en secuencia. Las salas limpias modernas utilizan sistemas de seguimiento de obleas robóticos y automatizados para coordinar el proceso. El procedimiento descrito aquí omite algunos tratamientos avanzados, como agentes diluyentes o eliminación de rebordes. Procedimiento básico
Limpieza
Si contaminaciones orgánicas o inorgánicas están presentes en la superficie de la oblea, se eliminan generalmente por tratamiento químico en húmedo, por ejemplo, el procedimiento de limpieza RCA basado en soluciones que contienen peróxido de hidrógeno. Otras soluciones hechas con tricloroetileno, acetona o metanol también se pueden utilizar para limpiar.
Preparación
La oblea se calienta inicialmente a una temperatura suficiente para eliminar cualquier humedad que pueda estar presente en la superficie de la oblea, 150 ° C durante diez minutos es suficiente. Obleas que han estado en almacenamiento deben limpiarse químicamente para eliminar la contaminación. Un “promotor de adhesión” líquido o gaseoso, tal como bis amina (trimetilsilil) ( “hexametildisilazano”, HMDS), se aplica para promover la adhesión de la resina fotosensible a la oblea. La capa superficial de dióxido de silicio sobre la oblea reacciona con HMDS para formar dióxido de silicio-tri metilado, un altamente capa repelente al agua no muy diferente de la capa de cera en la pintura de un automóvil. Esta capa repelente al agua evita que el revelador acuoso de penetrar entre la capa de resina fotosensible y la superficie de la oblea, evitando así llamada elevación de estructuras fotorresistentes pequeños en el patrón (en desarrollo). Con el fin de asegurar el desarrollo de la imagen, lo mejor es cubierta y se coloca sobre una placa caliente y dejar secar mientras se estabiliza la temperatura a 120 ° C.
aplicación de resina fotosensible
La oblea se cubre con fotoresist mediante recubrimiento por rotación. Una solución viscosa, líquido de resina fotosensible se dispensa sobre la oblea, y la oblea se hace girar rápidamente para producir una capa de grosor uniforme. El recubrimiento por rotación típicamente funciona a 1200-4800 rpm durante 30 a 60 segundos, y produce una capa de entre 0,5 y 2,5 micrómetros de espesor. El proceso de recubrimiento por rotación se traduce en una capa delgada uniforme, por lo general con la uniformidad de dentro de 5 a 10 nanómetros. Esta uniformidad puede explicarse por el modelado fluido-mecánica detallada, que muestra que la capa protectora se mueve mucho más rápido en la parte superior de la capa que en la parte inferior, donde las fuerzas viscosas se unen la capa protectora a la superficie de la oblea. Por lo tanto, la capa superior de resistir se expulsa rápidamente desde el borde del oblea mientras que la capa inferior todavía se arrastra lentamente radialmente a lo largo de la oblea. De este modo, cualquier 'protuberancia' o 'cresta' de resistir se elimina, dejando una capa muy plana. espesor final se determina también por la evaporación de disolventes líquidos de la capa protectora. Para características muy pequeñas y densas (<125 o así nm), resistir inferior espesores (<0,5 micrómetros) son necesarios para superar los efectos de colapso en altas relaciones de aspecto; relaciones de aspecto típicos son <4: 1.
La oblea foto resistir recubierto es luego prebaked para eliminar el exceso de disolvente fotorresistente, típicamente de 90 a 100 ° C durante 30 a 60 segundos sobre una placa caliente.
La exposición y el desarrollo
Después de horneado previo, el fotoprotector se expone a un patrón de luz intensa. La exposición a la luz provoca un cambio químico que permite algo de la resina fotosensible a ser eliminado por una solución especial, llamado “revelador” por analogía con el revelador fotográfico. fotoprotector positivo, el tipo más común, se hace soluble en el revelador cuando se expone; con fotoprotector negativo, las regiones no expuestas son solubles en el revelador.
A bake post-exposición (PEB) se realiza antes de desarrollar, típicamente para ayudar a reducir los fenómenos de ondas estacionarias causadas por los patrones de interferencia destructivos y constructivos de la luz incidente. En la litografía ultravioleta profundo, amplifica químicamente resistir se utiliza (CAR) química. Este proceso es mucho más sensible a tiempo PEB, la temperatura, y el retardo, ya que la mayoría de la reacción de la “exposición” (ácido creando, haciendo que el polímero soluble en el revelador básico) en realidad ocurre en el PEB.
La química desarrollar se entrega en una ruleta, al igual que fotoprotector. Los desarrolladores de hidróxido de sodio originalmente menudo contenida (NaOH). Sin embargo, el sodio se considera un contaminante extremadamente indeseable en la fabricación de MOSFET porque degrada las propiedades aislantes de óxidos de puerta (específicamente, los iones de sodio pueden migrar dentro y fuera de la puerta, el cambio de la tensión de umbral del transistor y por lo que es difícil o más fácil para encender el transistor en el tiempo). se utilizan ahora los desarrolladores de metal y libre de iones tales como hidróxido de tetrametilamonio (TMAH).
La oblea resultante es luego “duro-horneado” si un amplificado no químicamente resistir fue utilizado, típicamente a 120 a 180 ° C [citación necesaria] durante 20 a 30 minutos. El bake duro solidifica el fotoprotector restante, para hacer una capa de protección más duradera en el futuro la implantación de iones, ataque químico húmedo, o grabado por plasma.
Aguafuerte
En el grabado, un líquido ( “húmeda”) o plasma ( “seco”) agente químico elimina la capa superior del sustrato en las áreas que no están protegidas por fotorresistente. En la fabricación de semiconductores, las técnicas de grabado en seco se utilizan generalmente, ya que se pueden hacer anisotrópico, a fin de evitar subvaloración significativa del patrón fotorresistente. Esto es esencial cuando la anchura de las características que se define es similar a o menor que el espesor del material que se grabado (es decir, cuando la relación de aspecto aproxima a la unidad). procesos de ataque químico húmedos son generalmente isotrópico en la naturaleza, que es a menudo indispensable para los sistemas microelectromecánicos, donde las estructuras suspendidas deben ser “liberado” de la capa subyacente.
El desarrollo de bajo Defectibilidad anisotrópico proceso seco de grabado ha habilitado las características de cada vez más pequeñas definidas fotolitográficamente en la capa protectora para ser transferido al material de sustrato.
eliminación de resina fotosensible
Después de un fotoprotector ya no es necesaria, tiene que ser retirado del sustrato. Esto por lo general requiere un líquido “resistir separador”, que altera químicamente la capa protectora de manera que ya no se adhiere al sustrato. Alternativamente, fotorresistente puede ser eliminado por un plasma que contiene oxígeno, que oxida. Este proceso se llama reducción a cenizas, y se asemeja grabado en seco. El uso de 1-metil-2-pirrolidona (NMP) disolvente para fotorresistente es otro método utilizado para eliminar una imagen. Cuando la capa protectora se ha disuelto, el disolvente se puede eliminar mediante calentamiento a 80 ° C sin dejar ningún residuo.
Fotorresina Microposit S1800 Serie G2
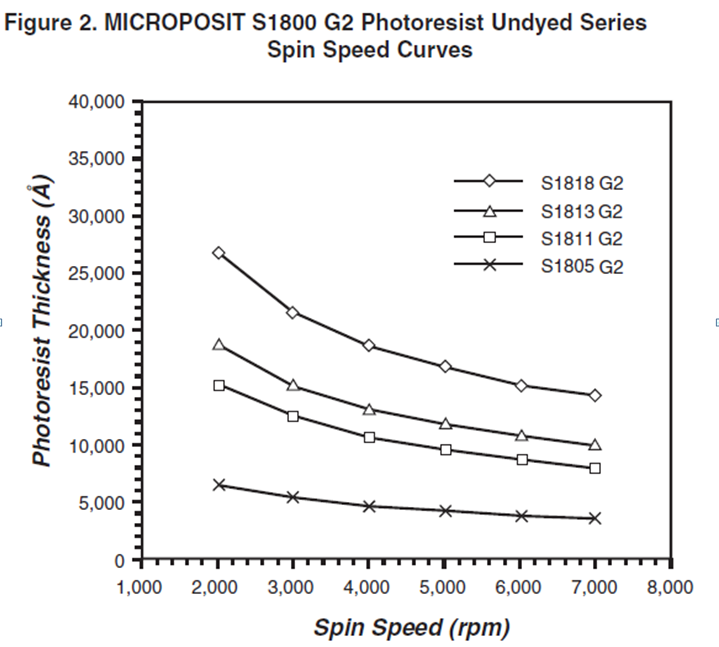
Fotorresina Microposit S1800 Serie G2
NEGATIVO RESIST NR9-6000PY

NEGATIVO RESIST NR9-6000P