PAM-XIAMEN pode oferecer wafers SiC, especificações e parâmetros específicos podem ser encontrados em:https://www.powerwaywafer.com/sic-wafer
O cristal único 4H-SiC possui excelentes características, como amplo bandgap, alta mobilidade de portadora, alta condutividade térmica e boa estabilidade. Possui amplas perspectivas de aplicação em eletrônica de alta potência, eletrônica de radiofrequência/microondas e informação quântica. Após anos de desenvolvimento, substratos de cristal único 4H SiC de 6 polegadas e filmes finos epitaxiais homogêneos foram aplicados industrialmente. No entanto, a densidade total de discordâncias em wafers de SiC 4H ainda é tão alta quanto 103~104cm-2, o que prejudica todo o potencial dos wafers 4H-SiC. Como os deslocamentos afetam as propriedades dos wafers e dispositivos 4H-SiC? A análise específica é a seguinte:
1. O efeito dos deslocamentos nas propriedades elétricas em wafers e dispositivos 4H-SiC
A pesquisa analisou a relação entre o desempenho de wafers e dispositivos 4H-SiC e a distribuição de deslocamentos dentro da região funcional, sugerindo que a presença de deslocamentos pode ter efeitos adversos no desempenho do dispositivo. Portanto, estudar as propriedades elétricas das próprias discordâncias é de grande importância para a compreensão de seu comportamento em dispositivos.
1.1 Efeito dos deslocamentos nas propriedades elétricas no substrato 4H-SiC
Ao combinar a corrosão alcalina fundida e a microscopia de força da sonda Kelvin (KPFM), pode-se observar que o deslocamento da borda de rosqueamento (TED) e o deslocamento do plano basal (BPD) exibem estados aceitadores em substratos de SiC 4H semi-isolantes de alta pureza (HPSI) e estados doadores em substratos 4H SiC tipo n (ver Figura 1). Na camada epitaxial 4H SiC com baixa concentração de dopagem, também foi descoberto que as luxações penetrantes apresentam características aceitadoras. Os cálculos dos primeiros princípios descobriram que TED e BPD introduzem níveis de energia defeituosos, com o nível de energia próximo à parte inferior da banda de valência sendo a banda vazia. Devido à predominância de defeitos de nível profundo, como átomos de impureza, vacâncias de carbono (VC), ou pares de vagas (VC-VSi) no HPSI 4H SiC, a banda de vacância introduzida pelas discordâncias pode receber elétrons de nível profundo, e as discordâncias exibem características aceitadoras. No substrato tipo n, os cálculos mostram que os átomos de N são mais estáveis na ligação às discordâncias TED e BPD, portanto os átomos de N tendem a agregar-se perto das discordâncias. Devido à dominância de átomos dopados em substratos condutores, a agregação de átomos de N pode causar características doadoras de deslocamentos.
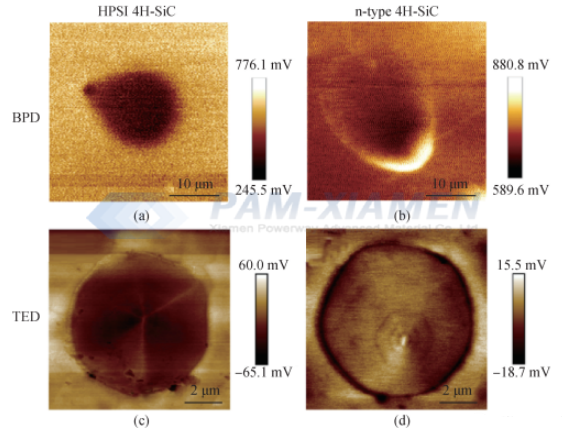
Fig. 1 Distribuição de potencial de superfície de BPD e TED em HPSI e 4H-SiC tipo n
1.2 Efeito dos deslocamentos nas propriedades elétricas de dispositivos 4H-SiC
Ao escanear os micro furos causados pelo deslocamento do parafuso de rosqueamento (TSD), os resultados do teste C-AFM mostraram um aumento significativo na corrente na parte inferior dos micro furos, enquanto a corrente superficial em outras áreas dentro dos micro furos não foi significativamente diferente daquele fora dos micro poços. Isto indica que as linhas de deslocamento de TSD em 4H SiC aumentam o efeito de vazamento. Além disso, os deslocamentos como centros de recombinação podem causar recombinação de buracos de elétrons em dispositivos de potência 4H-SiC e também levar a uma diminuição na confiabilidade do dispositivo.
As linhas de deslocamento não apenas têm um impacto no desempenho do dispositivo, mas também causam micro-perfurações superficiais em profundidade em nanoescala na superfície da camada epitaxial devido à perturbação do fluxo externo causado pelas linhas de deslocamento. A presença de micro pits também pode afetar o desempenho do dispositivo. Por exemplo, sob alta pressão, o microplasma aparece na posição da microcratera causada pelo deslocamento roscado (TD), indicando que o oxigênio da porta na posição da microcratera é primeiro quebrado. A presença de micro pits também pode levar a uma diminuição na vida útil dos portadores minoritários, um aumento na corrente de fuga reversa e uma diminuição na tensão direta, que têm efeitos adversos nos diodos de barreira Schottky (SBDs) baseados em SiC 4H, diodos de junção pn (PNDs) e fotodiodos de avalanche (ver Fig. 2 (a) e (b)).
Portanto, alguns pesquisadores acreditam que o impacto atual dos deslocamentos no desempenho do dispositivo é causado principalmente por micro-covas, e o impacto das próprias linhas de deslocamento é secundário. Através de simulações e experimentos, descobriu-se que a exclusão da presença de micro pits pode reduzir o impacto do TSD em dispositivos baseados em 4H-SiC (ver Fig. 2 (c)). O BPD também pode servir como centro composto em 4H-SiC. Ao operar em dispositivos bipolares 4H-SiC, a injeção elétrica pode causar deslizamento de deslocamentos incompletos no núcleo de silício, levando à expansão de falhas de empilhamento e afetando seriamente o desempenho direto e reverso do dispositivo. Acredita-se geralmente que as falhas de empilhamento causadas por deslocamentos incompletos no núcleo de silício no BPD são desenvolvidas na interface entre o substrato e a camada epitaxial e se expandem para fora na superfície da camada epitaxial. Considerando o movimento direcional de duas discordâncias incompletas no BPD, a expansão das falhas de empilhamento causadas pelo BPD é complexa. A pesquisa descobriu que as falhas de empilhamento causadas pelo BPD também podem se mover em direção à interface entre o substrato e a camada epitaxial (ver Fig. 2 (d)).
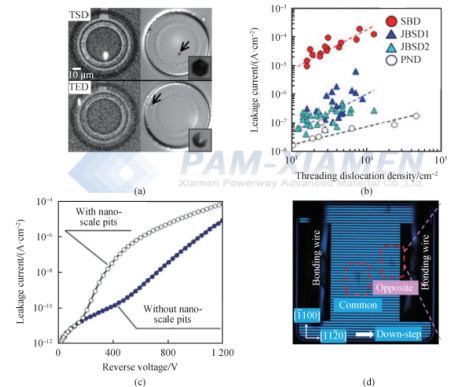
2 O efeito dos deslocamentos na corrente de fuga de dispositivos de potência 4H-SiC e a expansão de falhas de empilhamento em 4H-SiC: (a) imagens EL de diodos de avalanche (esquerda) e imagens DIC após fusão da corrosão KOH (direita); (b) A relação entre corrente de fuga de diferentes dispositivos e densidade de TDs; (c) O comportamento de vazamento reverso dos diodos 4H-SiC e sua dependência de nano pits; (d) Imagem EL do dispositivo 4H SiC PIN observado pelo filtro de 420 nm
2. Efeito das luxações nas propriedades ópticas em 4H-SiC
Como centro de recombinação radiativa, as luxações em 4H-SiC exibem fotoluminescência, e o contraste da fotoluminescência das luxações (PL) depende do tempo de vida dos portadores minoritários. Quando a concentração de defeitos de nível profundo no cristal é baixa, o tempo de vida dos portadores minoritários é longo e um número suficiente de portadores minoritários move-se para a região de discordância para se recombinarem e emitirem luz. Neste momento, a intensidade de luminescência da região de discordância é maior que a de outras regiões, aparecendo como um ponto brilhante. Quando a concentração de defeitos de nível profundo no cristal é alta, o tempo de vida do portador minoritário é baixo e combina-se com defeitos de nível profundo próximos para emitir luz. A recombinação na discordância é suprimida e a intensidade de emissão na região da discordância é mais fraca do que em outras regiões, exibindo uma mancha escura. O experimento descobriu que nos testes de PL, para o 4H-SiC com vida útil dos portadores minoritários inferior a 0,5μs, a maioria dos portadores minoritários não pode migrar para deslocamentos, e um pequeno número de portadores minoritários são capturados por defeitos inerentes. As luxações não apresentam contraste significativo na imagem de varredura da superfície PL. Quando o tempo de vida dos portadores minoritários é superior a 0,5μs, a recombinação do buraco de elétrons no deslocamento pode distinguir significativamente o contraste do deslocamento de outras regiões.
TSD e TED exibem diferentes tamanhos de pontos escuros ou brilhantes nas imagens de varredura de superfície PL de 4H-SiC. Os picos intrínsecos de emissão de PL de TED e TSD estão localizados em 600 nm e 800-850 nm, respectivamente. BPD aparece como linhas escuras ou brilhantes na imagem de varredura de superfície PL de 4H-SiC (ver Fig.3 (a)). Os picos de emissão de PL dos BPDs originam-se dos picos de emissão de PL de discordâncias incompletas e falhas de empilhamento que compõem os BPDs. Os picos de emissão de deslocamentos incompletos do núcleo de silício, deslocamentos incompletos do núcleo de carbono e falhas de empilhamento estão localizados em 670-700nm, 720-850nm e 420nm, respectivamente. Ao ajustar o comprimento de onda da luz emitida, a exibição de deslocamentos incompletos únicos e falhas de empilhamento pode ser obtida separadamente.
Recentemente, os pesquisadores também descobriram que os TDs podem aumentar a luminescência D1 do 4H-SiC, como mostrado na Fig.3 (b) e (c), que representam a intensidade de luminescência dos poços de corrosão TED e TSD, respectivamente. Isto significa que a intensidade da luminescência D1 também pode refletir a densidade e distribuição das luxações no substrato 4H-SiC e na camada epitaxial.

Fig. 3 Propriedades luminescentes de discordâncias em 4H-SiC: (a) Imagens de varredura de superfície PL de microárea de filmes finos epitaxiais de 4H SiC obtidas usando um filtro passa-faixa de 900 nm; (b) imagens de varredura de superfície PL da microrregião TED e (c) imagens de varredura de superfície PL da microrregião TSD em substrato 4H-SiC tipo N obtido na emissão de 450 nm ~ 750 nm.
Aumentar o tamanho do material e reduzir a densidade de deslocamento são as direções gerais para o desenvolvimento de substratos 4H-SiC e filmes finos epitaxiais. Para reduzir a densidade de deslocamento, por um lado, é necessário otimizar o projeto de campos térmicos e de fluxo, projetar técnicas de tratamento de cristal semente ou substrato e otimizar tecnologias de cristal único ou processo epitaxial para reduzir a densidade de deslocamento; Por outro lado, com base nas tecnologias de processo cada vez mais maduras, é necessária uma investigação mais aprofundada sobre como promover a transformação ou reacção entre diferentes tipos de discordâncias para reduzir a baixa densidade de discordâncias. Em termos de regulação do desempenho das discordâncias, são necessárias mais pesquisas sobre como promover a reação entre impurezas e defeitos pontuais com discordâncias, ajustando assim a posição do nível de energia do defeito e o comportamento dinâmico das discordâncias.
Referência:
Jiajun Li, Guang Yang, Xiaoshuang Liu, Hao Luo, Lingbo Xu, Yiqiang Zhang, Can Cui, Xiaodong Pi, Deren Yang e Rong Wang
Luxações em carboneto de silício 4H
Para mais informações, entre em contato conosco pelo e-mailvictorchan@powerwaywafer.com e powerwaymaterial@gmail.com.

