PAM-XIAMEN kan leverera AlN enkristallsubstrat, se ytterligare specifikationhttps://www.powerwaywafer.com/aln-substrate.html.
De huvudsakliga n-typ AlN-kandidaterna är syre (O) och kisel (Si), medan de för p-typ AlN är magnesium (Mg) och beryllium (Be). Hittills har framgångsfrekvensen för Mg- och O-dopning varit mycket låg. O är dock en viktig kompenserande förorening för både Mg och Be, eftersom både dopämnen och Al själv tenderar att absorbera syre. För att förstå dopningen av AlN är det nödvändigt att förstå rollerna för kvävevakanser (VN) och aluminiumvakanser (VAl) och deras relaterade komplex. Den nuvarande förståelsen av defekt- och orenhetskemi, såväl som icke-jämviktsdopningsmetoder, kommer att betraktas som ett lovande tillvägagångssätt för att övervinna nuvarande tekniska begränsningar.
1. DonorDöppning av AlN:Sikon
För n-typ AlN är kisel den optimala teoretiska katjondonatorn eftersom dess atomradie är mycket nära den för Al, som visas i fig. 1 (Al är 118 pm, Si är 111 pm). Även om kisel är en ytlig donator i GaN med en aktiveringsenergi ED på cirka 17 meV, i AlGaN, med en ökning av Al-innehåll, ökar dess ED från 24 meV i Al0.85Ga0.15N till 211 meV i Al0.96Ga0.04N. Kisel, som en ersättningsförorening i AlN, orsakar en teoretisk sammandragning på 6 % i den närmast intilliggande basalplanets N-bindning. Detta indikerar en minskning av positionen för kiselgittret, närmare de tre basala bindningarna, under vilken Si-N c-axelbindningarna sträcks. När kisel fångar en sekundär elektron och genomgår geometrisk omarrangering, bildas ett DX-centrum, vilket inkluderar en 2% kontraktion av Si-N-bindningar vid tre basala positioner och en c-axel Si-N-bindningsbrott, som visas i Fig. 1, leder till en övergång från grunda till djupa nivåer. När c-axelns Si-N-bindning under spänning bryts, kommer ett kompenserat djupt tillstånd att genereras. Trots förekomsten av sådana kompensationsdefekter har dopning av n-typ av AlN genom jonimplantation i området nära ytan visat lovande resultat. Men vid dopning av n-typ av okompenserade MOCVD AlN-tunna filmer, endast en reproducerbar elektronkoncentration på upp till 1015centimeter-3visas, vilket endast är tillämpligt på områden med hög avdrift i enheten.

Fig. 1 Positionerna och relativa storlekarna (i proportion) av (a) Mg- och Be-acceptorer i AlN, (b) Si-föroreningar omarrangerade av Si-donatorer och DX, och (c) positioner och relativa storlekar av syredefekter som ersätter syre och DX-omarrangemang (i proportion)
Med tanke på att en teknik visar genomförbarheten av dopning medan en annan inte gör det, kan inte kisel i sig vara problemet. Hypotesen att icke-jämvikt och lågtemperatur MBE bidrar till n-typ dopning av AlN är baserad på följande två punkter:
1) vid användning av låg temperatur uppnås den minsta termiska expansionen, därför är den minsta ytterligare c-axelns Si-N-bindningsförlängning önskvärd;
2) Minimera metallanrikningsförhållandena för Al-vakans Si-komplex, dessa komplex uppvisar beteende liknande Al-vakans O-komplex, vilket leder till självkompensation av givardopning vid höga Si-dopningsnivåer.
Det spekuleras i att denna Si-självkompensation beror på gittermjukning orsakad av VAl, vilket gör det lättare att bryta c-axelns Si-N-bindning och därmed bilda ett kompenserat Si-DX-centrum. I likhet med O, på grund av laddningsneutralitet, måste VAl-XSiAl-komplexet också beaktas, där X är ett heltal. Att hävda icke-jämvikts-, lågtemperatur- och metallberikad MBE är därför mycket värdefullt för dopning av n-typ av AlN.
2. AcceptorDöppning av AlN:Mg, Vara, Och C
För p-typ AlN anses acceptorer, såsom anjonsubstituerat kol (C) och katjonsubstituerat Be och Mg som möjligt. När man närmar sig utspädningsgränsen resulterar isolerade acceptorenergier i att dessa acceptorer betraktas som receptorer på djupa nivåer, med teoretiskt rapporterade enkelvärdade acceptoraktiveringsenergier för Mg och Be som sträcker sig från 510 till 630 meV respektive 220 till 340 meV. Om det inte finns någon förmåga att bilda föroreningsband för att minska dessa stora aktiveringsenergier, förväntas ingen signifikant porkoncentration.
Men som visas av Bohrs orbitalöverlappning vid höga dopningskoncentrationer i GaN, är det möjligt för den effektiva aktiveringsenergin för Mg att minska från cirka 210 meV till cirka 50 meV, vilket resulterar i en porkoncentration på 1 x 1020centimeter-3. Detta har också visat sig vara effektivt för AlGaN med upp till cirka 60 % Al, och tunneldioder har visats.
Förutom en porkoncentration på cirka 1010 centimeter-3, Mg har inte använts framgångsrikt för dopning av AlN. De senaste resultaten av att använda Be för att få en porkoncentration i rumstemperatur på cirka 3 x 1018centimeter-3(rapporteras här som cirka 4,4 x 1018centimeter-3) och en effektiv aktiveringsenergi på cirka 37 meV indikerar att en minskning av aktiveringsenergin kan uppnås.
De relativa dielektriska konstanterna för galliumnitrid (GaN), aluminiumnitrid (AlN) och indiumnitrid (InN) är 8,9, 8,5 respektive 15,3. De rapporterade effektiva massorna av tunga hål är 0,8 mo, 3,53 mo respektive 1,63 mo. Detta betyder att de Mott-kritiska koncentrationerna som bildas av acceptorbanden för GaN, AlN och InN är ungefär 4×1019centimeter-3, 4×1021centimeter-3och 6,5×1019centimeter-3, respektive. Denna förenklade approximation stämmer väl överens med dopningsresultaten från metallmodulerad epitaxi (MME) experiment för GaN, där hålkoncentrationer i intervallet 1019centimeter-3kan uppnås rutinmässigt. På liknande sätt indikerar dessa förutsägelser att AlN och InN kommer att vara svårare att genomgå degenererad dopning av p-typ, var och en kräver en högre dopningskoncentration för att bilda föroreningsband.
För AlN kan det initialt anses omöjligt att uppnå den höga dopningskoncentration som krävs för att bilda orenhetsband, vilket strider mot nuvarande experimentella resultat. Det är emellertid nödvändigt att överväga den unika valensbandstrukturen hos AlN, där det avsplittrade bandet faktiskt är högre än hålbandet och lätthålsbandet (se fig. 2) och har hög anisotropi. På grund av bristen på d-orbitala elektroner är tecknet på kristallfältsdelningsenergi motsatt det för GaN. Avdelningsbandet uppvisar större krökning och är placerat på ett bredare utbud av tunga och lätta hålband när det gäller energi. Fig. 2 visar beräkningen av densitetsfunktionella teorin (DFT) med hänsyn till denna effekt. De effektiva massorna beräknade med densitetsfunktionsteori (DFT) är 3,66 mo för den parallella komponenten och 0,24 mo för den vertikala komponenten, vilket resulterar i Mott kritiska koncentrationer på 4,3 × 1021centimeter-3och 1,2×1018centimeter-3, respektive. De övre och nedre gränserna för Motts kritiska koncentration ges för att betona att när man överväger det unika med AlN-bandstrukturen är det möjligt att förutsäga bildandet av föroreningsband i AlN, vilket kan leda till högre hålrörlighet än GaN, vilket ger hopp för p-kanal och bipolära AlN-enheter.
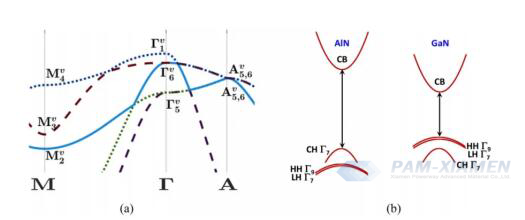
Fig. 2 (a) Densitetsfunktionella elektronspridningen av den linjära banan för det obetonade AlN-valensbandet (spinfritt) av wurtzite längs M-, Γ- och A-symmetripunkterna inom Brillouin-zonen. I mitten av regionen är avsplittrade bandtillstånd ΓV1 singlettdegeneration, medan tunga och lätta håltillstånd ΓV 6 är dubbelt degenererade. (b) Kvalitativ elektronspridning av obetonad wurtzit AlN och GaN längs k⊥-riktningen. Till skillnad från GaN är det högsta valensbandet i AlN dissociationsbandet, som uppvisar en mindre effektiv massa. Införandet av spinnomloppsinteraktion lindrar degenereringen av tunga och lätta hålband i regionens centrum, vilket resulterar i uppkomsten av ett enda degenererat tillstånd ΓV; 17, ΓV9 och ΓV;27.
För mer information, vänligen kontakta oss maila påvictorchan@powerwaywafer.com och powerwaymaterial@gmail.com.

