PAM XIAMEN offre wafer epitassiali HEMT in GaN (nitruro di gallio) da 2 pollici su diversi substrati come substrato di silicio, substrato di zaffiro, substrato di carburo di silicio (SiC). Questo wafer epitassiale GaN è per transistor ad alta mobilità elettronica (HEMT).
Vendiamo direttamente dalla fabbrica, e quindi possiamo offrire i migliori prezzi sul mercato per epi-wafer GaN HEMT di alta qualità. I clienti di tutto il mondo si sono affidati a PAM XIAMEN Supplies come produttore preferito di wafer epi GaN e produttori di nitruro di gallio.
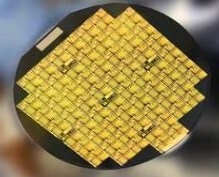
1. Specifiche di GaN Epi Wafer per HEMT
AlGaN/GaN HEMT su 2 in Wafer SiC conduttivo (GaN/SiC)
AlGaN/GaN HEMT su 2 in Zaffiro Wafer
HEMT AlGaN/GaN su wafer SiC semiisolante da 2 pollici (GaN/SiC)
HEMT AlGaN/GaN su wafer Si da 2 pollici (GaN/Si)
Inoltre, PAM-XIAMEN può offrire il wafer epi GaN HEMT come segue:
GaN su Si per potenza, modalità D: La struttura del wafer epitassico GaN HEMT su substrato di silicio ha un'importante proprietà di elevata mobilità degli elettroni dovuta al GaN/AlGaN. struttura di eterogiunzione.
GaN su Si per alimentazione, modalità E: Un dispositivo HEMT avanzato può essere ottenuto fabbricando su GaN su wafer di Si senza tensione applicata.
GaN su Si per RF: L'HEMT di GaN su wafer di Si ha ovvi vantaggi nei dispositivi ad alta potenza e alta frequenza su wafer epitassiale HEMT di GaN su silicio.
GaN su Sapphire per il potere: Il GaN HEMT Epitaxy Wafer su zaffiro è per dispositivi di potenza.
GaN su Zaffiro per RF: Questo epi-wafer HEMT GaN è per la fabbricazione di dispositivi a radiofrequenza.
GaN su SiC per RF: Stack HEMT cresciuti su wafer SiC semi-isolante per la crescita di materiali e dispositivi III-N.
2. Standard di settore per HEMT Epi Wafer da 2" basato su GaN
Il nitruro di gallio fornisce una tecnologia robusta e affidabile per lavorare ad alta tensione e ad alta temperatura, il che rende il GaN molto mirato ad aprire molte applicazioni industriali, di difesa, mediche e commerciali.
2.1 Qualità della superficie dell'Epiwafer al nitruro di gallio
Non ci dovrebbe essere contaminazione sulla superficie del wafer epitassiale e la superficie del wafer epitassiale dovrebbe essere liscia e brillante.
2.2 Dimensioni del wafer di nitruro di gallio
Le dimensioni esterne del wafer epitassiale GaN devono soddisfare i requisiti della Tabella 1.
Tabella 1 Dimensioni esterne del wafer epitassiale GaN HEMT
| Parametri | Diametro | Appartamento |
| Specificazione | 50,8 mm ± 0,5 mm | 16,0 mm ± 1,0 mm |
Tabella 2 Proprietà elettriche del wafer epitassiale AlGaN / GaN HEMT
| No. | Proprietà | Parametri | Requisiti | |
| Minimo | Massimo | |||
| HALL Test | Mobilità del vettore | 1800 cm2/ Vs | / | |
| Densità areale 2DEG | 6*1012centimetro-2 | / | ||
| Resistenza quadrata | / | 500 /□ | ||
| 2 | XRD Curva a dondolo Larghezza mezza altezza | 002 | / | 250 secondi |
| 102 | / | 250 secondi | ||
| 3 | Test AFM | Rugosità | / | 0,5 nm |
2.3 Spessore dello strato epitassiale GaN e deviazione standard dello spessore
Lo spessore dello strato epitassiale viene misurato utilizzando il sistema di test di mappatura PL:
Il diametro dell'area visualizzabile di prova: ≤50mm;
Risoluzione di prova: 0,1 mm~5 mm;
Velocità di scansione di prova: 1~30pt/s;
Lunghezza d'onda del laser: 266 nm;
Potenza laser: 4,1 mW~22,24 mW;
Densità di potenza laser: 52 W/cm2~283.5 W/cm2;
Larghezza della fessura: 0,01 mm ~ 2 mm.
I parametri sono conformi alle proprietà elettriche nella tabella 2.
2.4 Test Hall per wafer epitassiale GaN HEMT
Il test di Hall misura la mobilità del portatore, la densità areale di 2DEG e la resistenza quadrata del wafer di nitruro di gallio per HEMT:
Intensità del campo magnetico: magnete permanente 0,45 T;
Gamma di resistività: 1u ohm*cm~10M ohm*cm;
Gamma di resistenza: 0,1 m ohm ~ 10 G ohm;
Concentrazione portante: 1E+7cm-3~1E+21cm-3
Mobilità: 1E-2cm2/(volt*sec)~1E+7cm2/(volt*sec);
Il risultato del test è conforme ai requisiti della tabella 2.
2.5 TEST XRD per wafer epitassiale GaN con stack HEMT
La diffrazione a doppio cristallo viene utilizzata per misurare le curve di oscillazione 002 e 102 del materiale sfuso:
L'ampio intervallo di scansione a mezza altezza è -35°~170°;
Velocità di scansione 0,006°/min~120°/min;
Angolo di passo minimo 0,0001°;
Precisione di misura ≤0,0002°;
ripetibilità angolo 2ѳ 0,0005°;
Velocità di posizionamento angolare 1500°/min(20).
Il risultato della larghezza di mezza altezza della curva di oscillazione XRD per il wafer epitassiale in GaN soddisfa il requisito nella tabella 2.
3. Sviluppo GaN / AIGaN HEMT Epi Wafer
Nel mercato dei wafer epitassiali GaN, lo sviluppo iniziale della tecnologia GaN/AIGaN HEMT si concentra principalmente in tre aree principali, incluso il miglioramento della qualità dei materiali dello strato epitassiale, la selezione del miglior materiale di substrato e lo sviluppo del processo dell'unità di sviluppo. Nel campo dell'optoelettronica, molti sviluppi del nitruro di gallio e del nitruro di gallio di alluminio eteroepitassiale si basano sul metodo di deposizione di vapore chimico organico dei primi metalli. Tuttavia, per i dispositivi elettronici multi-nitruro di gallio, i metodi di crescita MBE e MOCVD sono considerati fattibili. A causa della disponibilità di zaffiro, i metodi più avanzati di crescita epitassiale GaN HEMT sono stati realizzati su zaffiro. Tuttavia, i dispositivi HEMT commerciali sulla fabbricazione di nitruro di gallio utilizzano substrati Si a basso costo o substrati SiC 4H e 6H con prestazioni ad alta potenza superiori e conduttività termica superiore. Il livello tecnologico dei dispositivi di potenza su substrati SiC può raggiungere i 500 W a 2,9 GHz, 800 W e 3,5 GHz.
Gli HEMT AlGaN/GaN hanno un'elevata tensione di rottura, che consente l'utilizzo di una grande tensione di dispersione, che porta a una grande impedenza di uscita dell'inverter di potenza RF e porta a circuiti di adattamento facili e a bassa perdita. L'elevata carica superficiale porta a una grande densità di corrente, la riduzione dell'area del transistor porta a una grande densità di potenza sulla superficie del gate e un'elevata velocità di deriva di saturazione porta a un'elevata densità di corrente di saturazione e densità di potenza del gate, che a sua volta porta per diminuire la capacità unitaria della potenza di uscita. La bassa capacità di uscita e l'impedenza drain-source rendono HEMT su wafer epitassiale GaN molto adatto per la commutazione di amplificatori.
Per ulteriori informazioni, contattaci tramite e-mail all'indirizzo victorchan@powerwaywafer.com e powerwaymaterial@gmail.com.

