PAM-XIAMEN può fornire wafer epitassiali SiC, ulteriori specifiche sui wafer si prega di leggere:https://www.powerwaywafer.com/sic-wafer/sic-epitaxy.html.
Sebbene i wafer epitassiali SiC presentino caratteristiche eccellenti nei dispositivi ad alta tensione e corrente elevata, esistono ancora diversi tipi di difetti che hanno un impatto negativo sulle prestazioni elettriche dei dispositivi SiC. Tra questi, i pozzi superficiali hanno un impatto su diversi tipi di dispositivi SiC come SBD e MOS. Gli avvallamenti superficiali sul wafer SiC causeranno il deterioramento delle caratteristiche del dispositivo a causa dell'affollamento del campo elettrico. Gli studiosi hanno dimostrato che gli avvallamenti superficiali generano corrente di dispersione in SBD, ma la causa e il meccanismo di formazione degli avvallamenti superficiali non sono ancora chiari. Pertanto, è significativo studiare gli effetti dei parametri di crescita primitivi ed epitassiali sulle fosse superficiali.
1.Eeffetto diGrowthTtemperatura attivataSuperficie Psuodell'epitassia 4H-SiC
Innanzitutto è stata studiata l'influenza della temperatura di crescita sulla densità superficiale delle fosse. Sotto la condizione di un rapporto C/Si di 1,05, le temperature di crescita epitassiale di 4H-SiC sono rispettivamente 1575, 1600 e 1625 ℃. Come mostrato in Fig. 1, la temperatura epitassiale non ha alcun effetto significativo sulla densità delle cavità. La densità dei difetti di fusione non mostra una tendenza al ribasso significativa con le variazioni di temperatura. Se la temperatura continua a salire o scendere, causerà altri problemi come difetti triangolari e accumuli di gradini.

Fig.1 Effetto della temperatura di crescita sugli alveoli superficiali dell'epitassia SiC
2. Influenza diC/SiRazione suSiC epitassiale Sla tua facciaPsuo
Successivamente è stato studiato l'effetto del rapporto C/Si sulla densità superficiale delle cavità. Come mostrato in Fig. 2, la densità degli alveoli superficiali diminuisce con la diminuzione del rapporto C/Si. Quando il rapporto C/Si aumenta a 1,05, la densità alveolare aumenta ulteriormente, mentre quando il rapporto C/Si diminuisce a 0,9, la densità alveolare diminuisce rapidamente fino a circa 30/cm2. I risultati sono simili alla ricerca precedente. Quando il rapporto C/Si è elevato, un'atmosfera ricca di C favorisce la formazione di alveoli superficiali e la forma degli alveoli superficiali forma gradualmente alveoli profondi. Tuttavia, quando il rapporto C/Si è troppo basso, può causare un aumento della concentrazione di fondo e una diminuzione del Si. Pertanto, è necessario cercare altri parametri per ridurre ulteriormente la densità superficiale del SiC. Sulla base di un rapporto C/Si di 0,9, continuare a ottimizzare la densità dei pit del wafer Epi 4H-SiC.
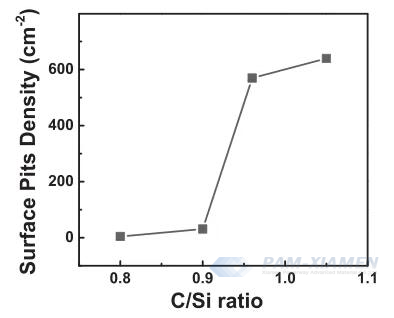
Fig. 2 Influenza del rapporto C/Si sui solchi superficiali epitassiali 4H-SiC
3. Cl/SiRazioUrtoSUSla tua facciaPè diEpistrato 4H-SiC
Sono state condotte ulteriori indagini sull'effetto del rapporto Cl/Si sugli alveoli superficiali, con un rapporto C/Si di 0,9, come mostrato in Fig. 3. All'aumentare del rapporto Cl/Si, la densità degli alveoli superficiali diminuisce. Quando il rapporto Cl/Si è 8, la densità degli alveoli superficiali diminuisce a 1 cm-2. All'aumentare del rapporto Cl/Si, gli atomi di Cl possono ridurre efficacemente la nucleazione uniforme degli atomi di Si, formando un ambiente ricco di Si sulla superficie del chip. Pertanto, il rapporto C/Si effettivo sulla superficie del substrato è stato ridotto, la crescita del flusso a gradini è stata migliorata e la formazione di difetti simili a cavità è stata soppressa.
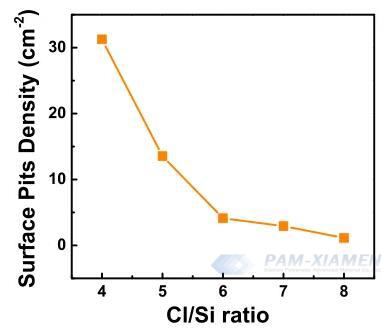
Fig. 3 Impatto del rapporto Cl/Si sui pozzi superficiali epitassiali 4H-SiC
Durante il processo di crescita epitassiale 4H-SiC, il rapporto C/Si e il rapporto Cl/Si hanno un impatto significativo sugli alveoli superficiali. Un rapporto C/Si inferiore e un rapporto Cl/Si più elevato formeranno un ambiente ricco di silicio sulla superficie del wafer durante il processo di crescita, che è fondamentale per ridurre le cavità superficiali sui wafer epitassiali 4H-SiC. Ottimizzando il processo, la densità delle cavità è stata ridotta al di sotto di 1/cm2ed è stato garantito che la densità dei difetti fatali superficiali (inclusi difetti triangolari, difetti della carota, cadute, ecc.) rientrasse in un determinato intervallo, ottenendo wafer epitassiali SiC di alta qualità, soddisfacendo i requisiti dei dispositivi di potenza SiC.
Per ulteriori informazioni potete contattarci via e-mail all'indirizzovictorchan@powerwaywafer.com e powerwaymaterial@gmail.com.

