PAM-XIAMEN kann SiC-Epitaxiewafer liefern. Weitere Waferspezifikationen finden Sie hier:https://www.powerwaywafer.com/sic-wafer/sic-epitaxie.html.
Obwohl epitaktische SiC-Wafer hervorragende Eigenschaften in Hochspannungs- und Hochstromgeräten aufweisen, gibt es immer noch verschiedene Arten von Defekten, die sich negativ auf die elektrische Leistung von SiC-Geräten auswirken. Unter anderem haben Oberflächengruben Auswirkungen auf verschiedene Arten von SiC-Bauelementen wie SBD und MOS. Oberflächenvertiefungen auf dem SiC-Wafer führen zu einer Verschlechterung der Geräteeigenschaften aufgrund der Überfüllung des elektrischen Feldes. Wissenschaftler haben gezeigt, dass Oberflächengruben bei SBD Leckstrom erzeugen, aber die Ursache und der Entstehungsmechanismus von Oberflächengruben sind noch unklar. Daher ist es wichtig, die Auswirkungen primitiver und epitaktischer Wachstumsparameter auf Oberflächengruben zu untersuchen.
1. EWirkung vonGReiheTTemperatur aufOberfläche Pseineder 4H-SiC-Epitaxie
Zunächst wurde der Einfluss der Wachstumstemperatur auf die Oberflächengrubendichte untersucht. Unter der Bedingung eines C/Si-Verhältnisses von 1,05 betragen die epitaktischen Wachstumstemperaturen von 4H-SiC 1575, 1600 bzw. 1625 ℃. Wie in Abb. 1 dargestellt, hat die Epitaxietemperatur keinen wesentlichen Einfluss auf die Pitdichte. Die Dichte der Schmelzfehler zeigt bei Temperaturänderungen keinen signifikanten Abwärtstrend. Wenn die Temperatur weiter steigt oder fällt, führt dies zu anderen Problemen wie Dreiecksdefekten und Stufenbündeln.

Abb.1 Einfluss der Wachstumstemperatur auf Oberflächengrübchen der SiC-Epitaxie
2. Einfluss vonC/SiRatio aufSiC Epitaxie SDein GesichtPseine
Anschließend wurde die Auswirkung des C/Si-Verhältnisses auf die Grübchendichte an der Oberfläche untersucht. Wie in Abb. 2 dargestellt, nimmt die Dichte der Oberflächengrübchen mit abnehmendem C/Si-Verhältnis ab. Wenn das C/Si-Verhältnis auf 1,05 ansteigt, nimmt die Grübchendichte weiter zu, während bei einem Absinken des C/Si-Verhältnisses auf 0,9 die Grübchendichte schnell auf etwa 30/cm abnimmt2. Die Ergebnisse ähneln früheren Untersuchungen. Wenn das C/Si-Verhältnis hoch ist, begünstigt eine reiche C-Atmosphäre die Bildung von Oberflächengrübchen, und die Form der Oberflächengrübchen bildet allmählich tiefe Grübchen. Wenn das C/Si-Verhältnis jedoch zu niedrig ist, kann dies zu einem Anstieg der Hintergrundkonzentration und einer Abnahme des Si führen. Daher ist es notwendig, nach anderen Parametern zu suchen, um die Grübchendichte auf der SiC-Oberfläche weiter zu unterdrücken. Optimieren Sie auf der Grundlage eines C/Si-Verhältnisses von 0,9 weiterhin die Pit-Dichte des 4H-SiC-Epi-Wafers.
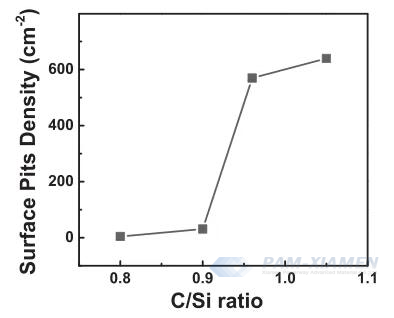
Abb. 2 Einfluss des C/Si-Verhältnisses auf epitaktische Oberflächenvertiefungen von 4H-SiC
3. Cl/SiRVerhältnisWirkungaufSDein GesichtPEs ist von4H-SiC-Epischicht
Weitere Untersuchungen wurden zum Einfluss des Cl/Si-Verhältnisses auf Oberflächengrübchen durchgeführt, mit einem C/Si-Verhältnis von 0,9, wie in Abb. 3 dargestellt. Mit zunehmendem Cl/Si-Verhältnis nimmt die Dichte der Oberflächengrübchen ab. Wenn das Cl/Si-Verhältnis 8 beträgt, sinkt die Dichte der Oberflächengrübchen auf 1 cm-2. Mit zunehmendem Cl/Si-Verhältnis können Cl-Atome die gleichmäßige Keimbildung von Si-Atomen wirksam reduzieren und so eine Si-reiche Umgebung auf der Chipoberfläche bilden. Daher wurde das effektive C/Si-Verhältnis auf der Substratoberfläche verringert, das Stufenflusswachstum verstärkt und die Bildung von grubenartigen Defekten unterdrückt.
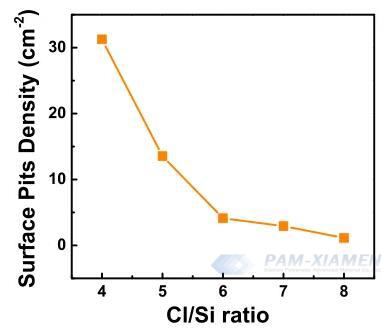
Abb. 3 Einfluss des Cl/Si-Verhältnisses auf epitaktische 4H-SiC-Oberflächenvertiefungen
Während des epitaktischen 4H-SiC-Wachstumsprozesses haben das C/Si-Verhältnis und das Cl/Si-Verhältnis einen erheblichen Einfluss auf Oberflächenlöcher. Ein niedrigeres C/Si-Verhältnis und ein höheres Cl/Si-Verhältnis bilden während des Wachstumsprozesses eine siliziumreiche Umgebung auf der Oberfläche des Wafers, was für die Reduzierung von Oberflächengruben auf epitaktischen 4H-SiC-Wafern von entscheidender Bedeutung ist. Durch Optimierung des Prozesses konnte die Grübchendichte auf unter 1/cm reduziert werden2Es wurde sichergestellt, dass die Dichte schwerwiegender Oberflächendefekte (einschließlich Dreiecksdefekte, Karottendefekte, Stürze usw.) innerhalb eines bestimmten Bereichs liegt, wodurch qualitativ hochwertige SiC-Epitaxiewafer erhalten werden, die den Anforderungen von SiC-Leistungsgeräten entsprechen.
Für weitere Informationen kontaktieren Sie uns bitte per E-Mail untervictorchan@powerwaywafer.com und powerwaymaterial@gmail.com.

