Disponibile fotomaschera in bianco con cromo antiriflesso. Le fotomaschere vengono utilizzate principalmente in circuiti integrati, display a schermo piatto (inclusi LCD, LED, OLED), circuiti stampati e altri campi. La fotomaschera è una maestro del modello utilizzato nel processo di fotolitografia nella produzione di microelettronica. Ecco le specifiche della maschera fotografica vuota come riferimento:
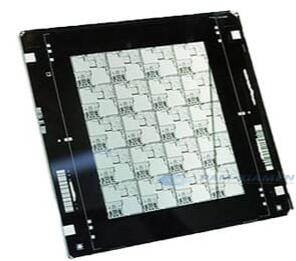
N. 1 Maschere fotografiche PAM190302-MASKH
N. 1-1 Wafer di silicio con strutture IC (ASIC11) a standard di progettazione di 0,35 micron;
No.1-2 Wafer di silicio con strutture IC (ASIC12) a standard di progettazione di 0,35 micron;
Nota:
Il diametro del substrato >= 150mm. il tipo/miscela di drogaggio, orientamento, spessore, resistività, superficie anteriore, superficie posteriore, piatto (i) è determinato dal produttore per fornire i parametri di base dell'elemento richiesti (transistor, resistori, condensatori) specificati nel kit di progettazione. Il produttore fornisce un kit di progettazione adatto allo sviluppo della topologia IC. Il cliente esegue lo sviluppo in conformità con il Design Kit e trasmette le informazioni al produttore in formato GDS. Il produttore produce una serie di fotomaschere in conformità con le informazioni nel formato GDS. Il produttore produce le lastre utilizzando un set di fotomaschere e secondo i requisiti del kit di progettazione.
N. 1-3 Fotomaschera vuota
dimensioni 152 x 152 x mm, scala 5: 1, progettato per fotolitografia con standard di progettazione di 0,35 μm;
Requisiti del modello di base
Scopo: modelli binari per la proiezione f / l
Dimensione del supporto: 6 "x6" x0.25 ", quarzo
Tipo di attrezzatura: 5x, NIKON NSR 2205i11D
Campo di esposizione: 110 mm x 110 mm
Pellicola: Sì, NIK49P-122-1K17 / HFLC, protezione da un lato dal cromo (protezione da due vie su richiesta)
Dimensione critica minima: 1,75 micron
Riproducibilità delle dimensioni critiche: 0,05 µm (3σ)
Precisione di registrazione (Registrazione): 0,1 µm
Difetto: 0,1 / cm2 (1 micron)
N. 2 Fotomaschera Cromo su Quarzo PAM200313-MASKH
N. 2-1 Il meno complesso: Strip & Ship;
CD >= 5um;
Ampi spazi aperti; Griglia di scrittura: Standard
Materiale: quarzo, cromo antiriflesso. Nessuna pellicola.
No. 2-2 Moderato:
reticolo 5x; 6”x6”x0.12” Quarzo;
Nessun difetto maggiore di 2,5um;
Difetto inferiore a 1,25um
CD >= 5um; linee/spazi/ottagoni;
Griglia di scrittura: dovrebbe mantenere il CD
Materiale: quarzo, cromo antiriflesso. Nessuna pellicola.
N. 2-3Quello più complesso:
reticolo 5x; 6”x6”x0.12” Quarzo;
Nessun difetto maggiore di 1,25um;
Difetto inferiore a 0,625um
CD >= 2,5um; linee/spazi/ottagoni;
Griglia di scrittura: dovrebbe mantenere il CD
Materiale: quarzo, cromo antiriflesso. Nessuna pellicola.
Non ci sarà alcuna pellicola necessaria in questi spazi vuoti per fotomaschere e la dimensione della maschera del reticolo sarà di 6 "x 6" e 0,12 pollici di spessore. Le dimensioni minime delle caratteristiche sulle maschere sono 2,5um e 5um. La fotomaschera (reticolo) serve per la fabbricazione del processo di litografia da utilizzare nelle macchine stepper.
I parametri tecnici del bianco della fotomaschera soddisfano i requisiti della Tabella 1 e della Tabella 2.
|
Tabella 1 Parametri del livello di qualità della maschera fotografica |
||||||||||||||||
| Grado | D | C | B | A | S | T | U | V | W | W+P | X | X+P | Y | Y+P | Z | Z+P |
| Tolleranza | ±0.3 | ±0.3 | ±0.2 | ±0.15 | ±0.1 | ±0.1 | ±0.05 | ±0.04 | ±0.035 | ±0.035 | ±0.032 | ±0.032 | ±0.028 | ±0.028 | ±0.022 | ±0.022 |
| Significa mirare | ±0.3 | ±0.3 | ±0.2 | ±0.15 | ±0.1 | ±0.075 | ±0.05 | ±0.04 | ±0.03 | ±0.03 | ±0.028 | ±0.028 | ±0.025 | ±0.025 | ±0.02 | ±0.02 |
| Uniformità | 0.2 | 0.2 | 0.2 | 0.15 | 0.1 | 0.075 | 0.05 | 0.04 | 0.035 | 0.035 | 0.035 | 0.035 | 0.03 | 0.03 | 0.025 | 0.025 |
| Registrazione | ±0.4 | ±0.3 | ±0.2 | ±0.15 | ±0.1 | ±0.075 | ±0.05 | ±0.06 | ±0.055 | ±0.055 | ±0.05 | ±0.05 | ±0.045 | ±0.045 | ±0.04 | ±0.04 |
| Dimensione difettosa | 1.5 | 1.5 | 1 | 0.8 | 0.6 | 0.4 | 0.4 | 0.35 | 0.3 | 0.3 | 0.25 | 0.25 | 0.2 | 0.2 | 0.2 | 0.2 |
| Densità del difetto | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 | 0 |
| Difetto del bordo | / | / | / | / | / | / | / | 0.3 | 0.3 | 0.3 | 0.25 | 0.25 | 0.2 | 0.2 | 0.2 | 0.2 |
| Rugosità del bordo | / | / | / | / | / | / | / | 0.3 | 0.3 | 0.3 | 0.25 | 0.25 | 0.2 | 0.2 | 0.2 | 0.2 |
| Arrotondamento d'angolo | / | / | / | / | / | / | / | 0.3 | 0.3 | 0.3 | 0.25 | 0.25 | 0.2 | 0.2 | 0.2 | 0.2 |
| Fase PSM | / | / | / | / | / | / | / | / | / | 180±4 | / | 180±3 | / | 180±3 | / | 180±3 |
| PSM trans | / | / | / | / | / | / | / | / | / | 6±0.4 | / | 6±0.3 | / | 6±0.3 | / | 6±0.3 |
Nota:
I parametri sono applicabili al reticolo in scala; il livello di qualità è classificato da basso ad alto:
- Il processo 0.5um supporta fino al livello S; Il processo 0,35um supporta fino al livello U, il processo 0,18um supporta fino al livello X;
- La maschera di vetro ordinaria è applicabile solo alla Classe D.
| Tabella 2 Requisiti per la qualità della fotomaschera | ||||||||
| Maschera principale 1:1 | Scansione a fascio di elettroni 1:1 | maschera UT | ||||||
| Grado | PB | PA | EB | EA | ES | uc | UB | UA |
| Specifiche del CD | >2.5 | 1.2~2.5 | >1.5 | 1.2~1.5 | <1.2 | >2 | 1.5~2.0 | <1.5 |
| Tolleranza | ±0.25 | ±0.2 | ±0.2 | ±0.15 | ±0.1 | ±0.25 | ±0.2 | ±0.15 |
| Uniformità | 0.3 | 0.3 | 0.3 | 0.25 | 0.2 | 0.25 | 0.2 | 0.15 |
| Registrazione | ±0.8 | ±0.8 | ±0.2 | ±0.15 | ±0.1 | ±0.2 | ±0.15 | ±0.1 |
| Dimensione difettosa | 2 | 2 | 1.5 | 1.5 | 1.0 | 2 | 1.5 | 1 |
| Densità del difetto (pz/pollici)2) | 2 | 1 | 2 | 1 | 0.5 | 0 | 0 | 0 |
Nota:
Il requisito è applicabile alla maschera 1:1 e il livello di qualità è classificato dal basso all'alto;
La maschera UT è applicabile solo al materiale al quarzo; la normale maschera di vetro è applicabile al livello più alto B.
N.3 Blank per fotolitografia PAM200326-MASKH
Substrato di vetro:
Dimensioni: 50x50 mm +/- 0,2 mm;
Spessore: 3,67 mm +/- 0,02 mm
Materiale: QUARZO
Nessuna specifica sulla planarità: 1/4 ~ 1/2 lunghezza d'onda
Privo di scheggiature sui bordi
Substrato iniziale 7X7inch X 150mil
Blank reticolo standard Rivestimento 3.0 OD AR Chrome
Maschera fotografica n. 4 su quarzo PAM200602-MASKH
No. 4-1 Maschera fotografica
Dimensione maschera 5 "X5"
MATERIALI SUBSTRATO MASCHERA: Quarzo
Litografia: fascio di elettroni
Polarità maschera: BF
Tolleranza caratteristica: 0.02um
Dimensione caratteristica: 0.4um
Precisione: 0,12 um
Griglia di produzione: 0.005um, 0.02um
No. 4-2 Fotomaschera vuota
Dimensione maschera 5 "X5"
MATERIALI SUBSTRATO MASCHERA Quarzo
Litografia: laser
Polarità maschera: DF
Tolleranza caratteristica: 0,5um
Dimensione caratteristica: 10 um, 3 um o 5 um
Precisione: 0,12 um
Griglia di produzione: 0.02um
No. 5 Quarzo con LR Chrome PAM200811-MASKH
Dimensione della maschera = 5 "x 5" x 0,09 "
Materiale = Quarzo con LR Chrome
Orientamento: RR Giù.
Dati scuri.
Dimensione critica (CD): 4 µm +/- 0,5 µm (per tutte le maschere)
Difetti: 0 > 5 µm
Notare che:
Il quarzo con LR Chrome è per la fabbricazione di Mask Aligner (litografia fotografica NUV 350-450 nm di lunghezza d'onda);
I dati per il ridimensionamento della maschera sono 1:01 perché l'allineatore della maschera ha il ridimensionamento 1:1, invece di 5:1;
Il materiale della maschera è quarzo con LR Chrome e il lato cromato è rivolto verso il basso (Real Read (RR) verso il basso);
Nella progettazione del layout, viene utilizzato lo strato di metallo numero 28 e l'area dello strato di metallo nei layout di progettazione dovrebbe essere cromata sulla maschera fotografica.
Per ulteriori informazioni, contattaci tramite e-mail all'indirizzo victorchan@powerwaywafer.com e powerwaymaterial@gmail.com.

