Эпитаксиальная пластина SiC доступна для изготовления устройств MOSFET, характеристики пластин можно найти вhttps://www.powerwaywafer.com/sic-mosfet-structure.html
1. Эпитаксиальные ямки
Эпитаксиальные ямки, как один из наиболее распространенных дефектов морфологии поверхности, имеют типичную морфологию поверхности и структурный профиль, как показано на рис.1. Положение коррозионных ямок резьбовых дислокаций (ТД), наблюдаемых после коррозии КОН на задней стороне устройства, в значительной степени соответствует положению эпитаксиальных ямок до подготовки устройства, что указывает на то, что образование эпитаксиальных ямок связано с дислокациями резьбы.
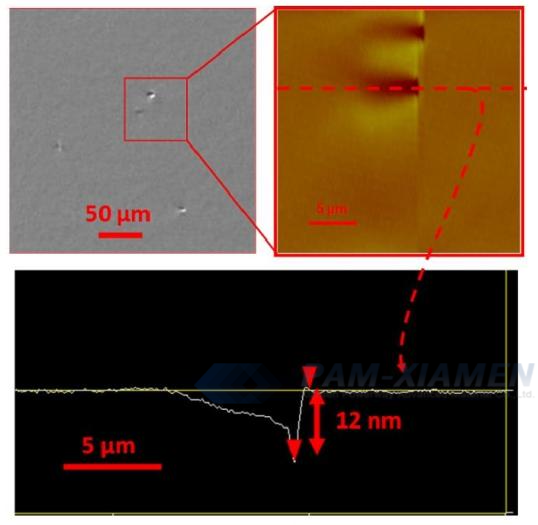
Рис. 1. Схема сечения эпитаксиальных ямок в эпитаксиальном слое SiC.
2. Влияние эпитаксиальных дефектов на SiC MOSFET.
Влияние эпитаксиальных дефектов ямок на характеристики МОП-транзисторов анализируется следующим образом:
На рис.2 представлены статистические гистограммы распределения пяти характеристик устройств с эпитаксиальными ямками. Синяя пунктирная линия представляет собой линию сегментации деградации устройства, а красная пунктирная линия представляет собой линию сегментации неисправности устройства. Из этого видно, что количество устройств с эпитаксиальными ямками в образцах SiC MOSFET эквивалентно количеству устройств с треугольными дефектами. Влияние эпитаксиальных ямок на характеристики устройства отличается от влияния треугольных дефектов.
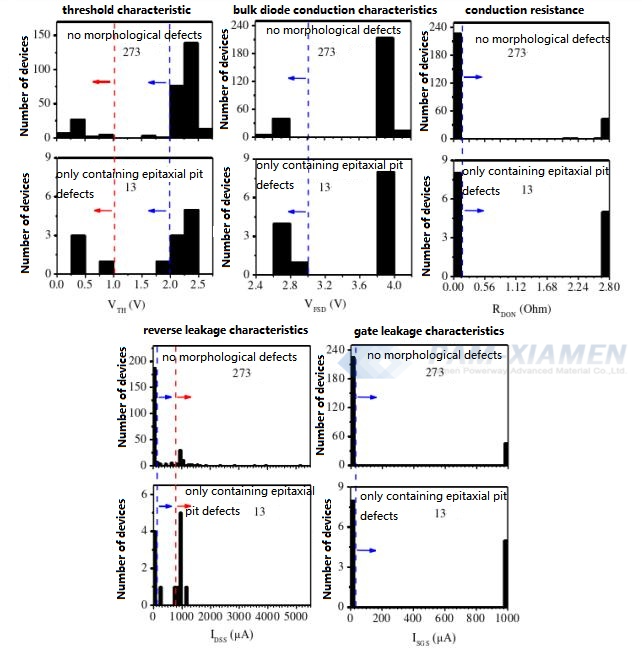
Рис. 2. Гистограммы различных характеристических распределений устройств SiC MOSFET с эпитаксиальными дефектами ямок.
Что касается отказов устройств, частота отказов устройств, содержащих эпитаксиальные дефекты, составляет всего 47%. По сравнению с треугольными дефектами влияние эпитаксиальных дефектов на характеристики обратной утечки и характеристики утечки затвора устройства значительно снижается со степенью деградации 53% и 38% соответственно, как показано в следующей таблице. С другой стороны, влияние эпитаксиальных дефектов на пороговые напряжения, характеристики проводимости объемного диода и сопротивление проводимости больше, чем у треугольных дефектов, при этом скорость деградации достигает 38%.
| Таблица 1 Статистическая таблица корреляции между эпитаксиальными дефектами ямок и характеристиками устройства SiC MOSFET | |||||
|
Дефект |
VTHскорость деградации | VFSDскорость деградации | RДОНскорость деградации | IDSSскорость деградации | IСГСскорость деградации |
| Дефект эпитаксиальной ямки | 38% | 38% | 38% | 53% | 38% |
В целом, дефекты морфологии эпитаксиальных ямок оказывают существенное влияние на выход из строя и характерную деградацию устройств SiC MOSFET. Устройства с эпитаксиальными дефектами имеют меньший процент отказов — 47%. Однако влияние эпитаксиальных дефектов ямок на пороговое напряжение, характеристики проводимости объемного диода и сопротивление проводимости устройства больше, чем у треугольных дефектов.
Для получения дополнительной информации, пожалуйста, свяжитесь с нами по электронной почте по адресуvictorchan@powerwaywafer.com и powerwaymaterial@gmail.com.

