Монокристаллическая подложка 3C-SiC может поставляться со следующими характеристиками:https://www.powerwaywafer.com/3c-sic-wafer.html.
Карбид кремния (SiC) обладает превосходными свойствами, такими как широкая запрещенная зона, высокая напряженность поля пробоя, высокая скорость дрейфа электронов насыщения и высокая теплопроводность, и имеет важные применения в таких областях, как новые энергетические транспортные средства, фотоэлектрическая энергетика и связь 5G. По сравнению с широко используемым 4H-SiC кубический SiC (3C SiC) имеет более высокую подвижность носителей (в 2-4 раза), меньшую плотность интерфейсных дефектных состояний (на порядок ниже) и большее сродство к электрону (3,7 эВ). Использование 3C-SiC для изготовления полевых транзисторов может решить проблему низкой надежности устройств, вызванную множественными дефектами кислородного интерфейса затвора. Но развитие транзисторов на основе 3C-SiC идет медленно, в основном из-за отсутствия монокристаллических подложек. Предыдущие исследования показали, что 3C-SiC склонен к фазовому переходу в процессе роста, а существующие методы роста не позволяют получить кристаллы монокристаллической формы.
1. Стабильный рост 3C-SiC, выращенного на 4H-SiC через TSSG
Согласно классической теории роста кристаллов, для кристаллов с гладкой поверхностью раздела гомогенное двумерное зародышеобразование должно преодолевать критические потенциальные барьеры при наличии критической свободной энергии Гиббса или пересыщения, тогда как рост может происходить при любом небольшом пересыщении. Для гетерогенной нуклеации из-за введения новой энергии на границе твердого тела двумерная нуклеация должна преодолеть более высокие критические потенциальные барьеры. Следовательно, при одном и том же пересыщении гомогенное зародышеобразование и рост значительно лучше с точки зрения энергии, чем гетерогенное зародышеобразование и рост, что затрудняет протекание последнего.
Недавно исследовательская группа предложила академическую идею регулирования энергии границы раздела твердое тело и жидкость, чтобы отдать приоритет зарождению и росту гетерогенных затравочных кристаллов по сравнению с гомогенными затравочными кристаллами. В основном в том числе:
1) Несоответствие решеток между поверхностями расплава 3C (111) и расплава 4H (0001) невелико, а энергия границы раздела твердое тело очень мала;
2) Разница в свободной энергии Гиббса между объемными фазами 4H и 3C относительно невелика;
3) Если энергия границы раздела 3C (111) – расплав достаточно мала по сравнению с энергией 4H (0001) – расплав за счет регулирования состава расплава, то двумерное зарождение и последующий рост свободной энергии Гиббса более благоприятны для 3C. фаза.
Команда самостоятельно спроектировала и изготовила оборудование для испытаний поверхностного натяжения и угла контакта твердого тела и жидкости сверхвысокотемпературных расплавов. Измерены поверхностное натяжение расплавов различного состава и контактный угол между расплавом и 4H-SiC, 3C-SiC при высоких температурах, а также закон изменения энергии границы раздела твердое тело и жидкость между 4H-SiC, 3C-SiC и высокотемпературными жидкостями. Получена температура расплава, подтверждающая возможность регулирования энергии интерфейса. Команда использовала метод высокотемпературной жидкой фазы, чтобы добиться более низкой потребности в свободной энергии Гиббса для 3C-SiC в тех же условиях пересыщения, подавляя фазовые переходы во время роста. Впервые в мире были выращены монокристаллы 3C-SiC диаметром 2-4 дюйма, толщиной 4-10 мм и монокристаллической формой, как показано на рис. 1.
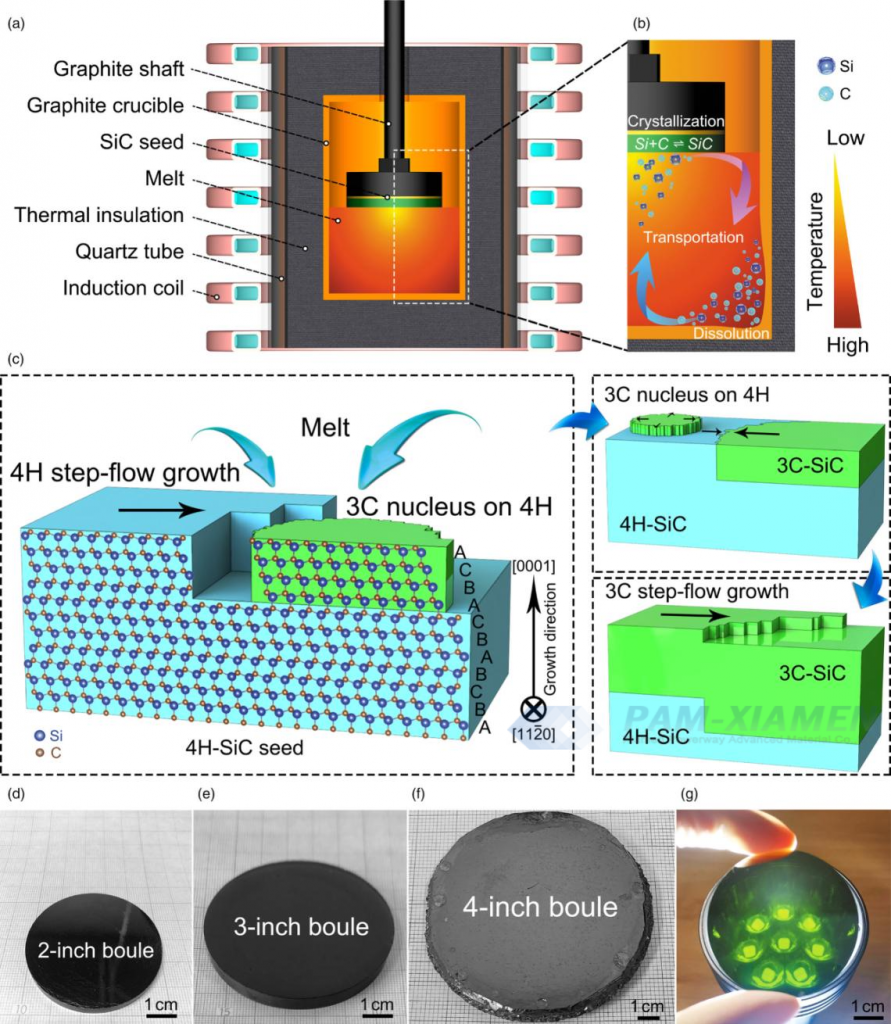
Рис. 1. Гетерогенное зародышеобразование и стабильный рост кристаллов 3C-SiC толщиной 2–4 дюйма и толщиной 4–10 мм были достигнуты на затравочных кристаллах 4H-SiC с использованием метода TSSG.
2. Свойства монокристалла 3C-SiC, выращенного TSSG.
Измерения спектроскопии комбинационного рассеяния света вдоль направления толщины кристалла показывают, что в начале роста 3C-SiC зарождается и растет на затравочном кристалле 4H-SiC с зоной сосуществования менее 20 мкм. Рис. 2 (а) дополнительно подтверждает изложенную выше теорию. Средняя полуширина рентгеновской кривой качания на поверхности роста (111) составляет 30 угловых секунд, что указывает на высокое кристаллическое качество выращенного 3C-SiC. Удельное сопротивление монокристалла 3C SiC при комнатной температуре составляет всего 0,58 м Ом·см, что составляет 1/40 от удельного сопротивления коммерческой пластины 4H-SiC (15–28 мОм·см) и, как ожидается, уменьшит потери энергии в устройстве.

Рис. 2. Определение кристаллической структуры 3C-SiC. а) Случайным образом выберите 20 спектров комбинационного рассеяния света с поверхности роста (111), на вставке показано распределение контрольных точек на кристалле. б) Спектры комбинационного рассеяния света вдоль направления толщины кристалла. в) Спектр фотолюминесценции (ФЛ), измеренный при 300К. d) Изображение, полученное под большим углом кольцевой сканирующей трансмиссионной электронной микроскопии в темном поле (HAADF-STEM). На иллюстрации показана картина дифракции электронов выбранной области (SAED) вдоль оси полосы кристалла [110].
Рост монокристаллов 3C-SiC на уровне пластин заполняет глобальный пробел, делая возможным массовое производство кристаллов 3C-SiC и открывая новые возможности для разработки высокопроизводительных силовых электронных устройств. Между тем, механизм преимущественного зарождения и роста гетерогенных затравочных кристаллов по сравнению с гомогенными затравочными кристаллами расширяет традиционную теорию роста кристаллов.
Для получения дополнительной информации, пожалуйста, свяжитесь с нами по электронной почте по адресуvictorchan@powerwaywafer.com и powerwaymaterial@gmail.com.

