Благодаря технологии туннельного перехода GaAs мы предлагаем эпитаксиальные пластины однопереходных и двухпереходных солнечных элементов InGaP/GaAs с различной структурой эпитаксиальных слоев (AlGaAs, InGaP), выращенных на GaAs, для применения в солнечных элементах. А теперь мы предлагаемGaAs EPI вафельныес туннельным переходом InGaP следующим образом:
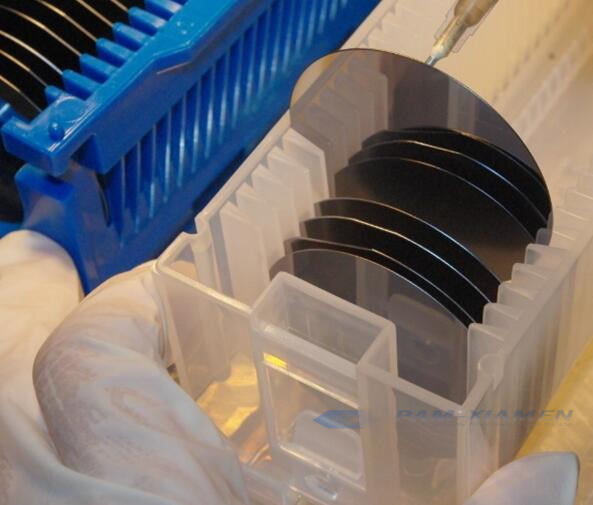
1. Эпиструктура солнечного элемента InGaP/GaAs
| просветляющее покрытие MgF2/ZnS | Au | Передний контакт | ||
| Au-Ge/Ni/Au | ||||
| n+-GaAs 0,3 мкм | ||||
| ┏ | n+-АлИнП | – | <2×1018см-3(Si), | Окно |
| InGaP | n+-InGaP | – | – | n |
| (Например = 1,88 эВ) | p+-InGaP | – | – | p |
| верхняя ячейка | p+-InGaP | – | – | p+ |
| ┗ | p+-АлИнП | – | – | BSF, диф.барьер |
| Туннель | p+-InGaP | 0,015 мкм | – | TN(p+) |
| соединение | n+-InGaP | – | – | TN(n+) |
| ┏ | n+-АлИнП | 0,05 мкм | – | Окно,диф.барьер |
| GaAs (Eg=1,43 эВ) нижняя ячейка | n+-GaAs | – | – | n |
| р-GaAs | – | – | p | |
| ┗ | p+-InGaP | – | – | BSF |
| p+-GaAs | – | 7,0×1018см-3(Зн) | ||
| p+-подложка GaAs <1,0×1019см-3(Зн) | подложка | |||
| Au | ||||
| Обратный контакт | ||||
Примечание:Светодиоды, лазеры и многопереходные солнечные элементы на основе InGaP/GaAs могут использовать туннельные переходы для повышения производительности. Расчет влияния этого соединения сложен, но есть способы точно смоделировать характеристики чипа и экономически эффективно оптимизировать конструкцию структуры солнечного элемента.
2. Эпитаксиальный рост пластин солнечных батарей InGaP/GaAs
С развитием оборудования MOCVD и MBE солнечный элемент с двойным переходом InGaP / GaAs можно выращивать наПодложки GaAsс согласованием решетки, обеспечивающим качество кристалла эпитаксиальной тонкой пленки. Субэлемент может использовать материалы InAIP и AlGaAs в качестве оконного слоя и слоя заднего поля, что может эффективно снизить скорость рекомбинации поверхности и интерфейса. При условии определенного состава ширина запрещенной зоны InGaP может быть изменена между 1,82 эВ и 1,92 эВ путем регулировки таких параметров, как температура роста и скорость роста, в зависимости от степени порядка кристаллической структуры.
В сочетании с конструкцией толщины поглощающего слоя фотогенерируемые токи, генерируемые двухпереходными субэлементами InGaP и GaAs, могут быть лучше согласованы. Благодаря этим факторам солнечные элементы с двойным переходом InGaP/GaAs обладают высокой эффективностью преобразования. Высокоэффективные тонкопленочные солнечные элементы InGaP/GaAs могут быть изготовлены по технологии переноса подложки.
Когда эпитаксиальный материал солнечного элемента с двойным переходом GaInP / GaAs выращивается с помощью технологии выращивания при низком давлении, давление в реакционной камере должно поддерживаться на уровне 42 торр, а в качестве газа-носителя используется H2 высокой чистоты. Рост материала двухпереходного солнечного элемента начинали при постоянной температуре 650 °C в течение 4 минут. Температура роста арсенида и фосфида установлена на уровне 620 ° C, но рост высоколегированного туннельного перехода склонен к высокотемпературной диффузии, поэтому он выращивается при низкой температуре 560 ° C.
3. FAQ about Epitaxial Wafer of InGaP / GaAs
Q: Can you tell us how to cut the solar cell epi of AlGaP/GaAs?
A: The AlGaP/GaAs epi wafer for solar cell can be cut by wafer scriber.
Для получения дополнительной информации, пожалуйста, свяжитесь с нами по электронной почте по адресу victorchan@powerwaywafer.com и powerwaymaterial@gmail.com.

