Четырехкомпонентные материалы с прямой запрещенной зоной, такие как InGaAsP и AlGaInAs, можно выращивать на подложке из InP, решетка которой совпадает с InP. В настоящее время в различных областях исследователи разработали полупроводниковые лазеры, оптические усилители, детекторы и т. д., используя эти два типа материалов, выращенных на подложке InP. Для оптических усилителей идеальным источником накачки является мощный полупроводниковый лазер с длиной волны 1460 нм на основе МКЯ AlGaInAs/InP. PAM-XIAMEN может выращивать насос AlGaInAs / InP с длиной волны 1460 нмэпитаксиальная пластина с лазерным диодомдля оптического усиления. Точную структуру эпитаксиального слоя лазера накачки см. в таблице ниже:

1. Структура эпитаксии лазерного диода накачки 1460 нм
ПАМ230509 - 1460ЛД
| Слой No. | Материал | Толщина (нм) | добавка | Тип |
| 6 | InP | – | – | – |
| 5 | GAIN (х) Как | – | – | – |
| 4 | GaIn(x)As(y)P | – | – | – |
| 3 | InP | 2100 | – | – |
| 2 | AlGaInAs MQW + SCH
пл 1430~1460нм |
– | – | – |
| 1 | Буфер InP | – | кремний | N |
| Подложка InP |
Для структур с квантовыми ямами с длинами волн генерации в диапазоне от 1300 до 1700 нм мы обычно эпитаксиально накачиваем пластину лазерного диода на основе подложки InP и используем материал InGaAlAs в качестве квантовой ямы. Регулируя состав AlGaInAs и выбирая подходящую толщину квантовой ямы, мы можем свободно проектировать длину волны диодного лазера накачки в широком диапазоне. Из рис. 1 видно, что регулируемая соответствующая длина волны системы материалов AlGaInAs/InP для рамановского лазера накачки может составлять от 1,3 мкм до 1,5 мкм.
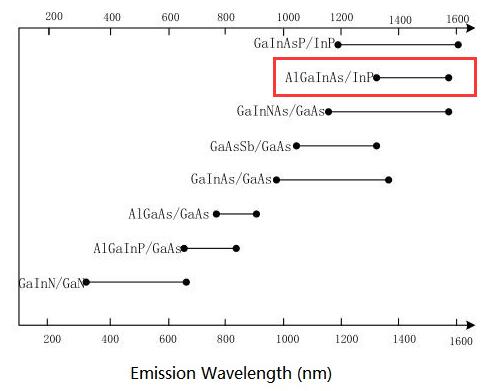
Рис. 1 Диапазон длин волн, соответствующий материалу AlGaInAs/InP
2. Проблемы роста материала AlGaInAs на InP
Сложность эпитаксиального роста AlGaInAs в основном включает:
1) компонент Al легко окисляется и образует с O глубокие энергетические уровни;
2) На границе раздела Al(Ga)InAs/InP имеет место взаимодиффузия As и P, влияющая на качество эпитаксиального слоя. Повышая температуру и соотношение V/II, можно получить высококачественные Al-содержащие материалы. Однако высокие температуры вредны для роста материалов, содержащих индий. При высоких температурах предреакция In и десорбция ростовой поверхности протекают более интенсивно, что легко приводит к формированию капельного распределения In на поверхности, что влияет на люминесцентную эффективность материала. Более того, чем выше температура роста, тем острее проблема взаимной диффузии As и P на границе между AlGaInAs и InP, что влияет на однородность и плоскостность границы. Поэтому диапазон температур роста высококачественных материалов AIGalnAs очень ограничен и требует точного контроля.
3. Оптимизация структуры энергетических зон лазера AlGalnAs/InP с квантовыми ямами
В целях дальнейшего улучшения температурных характеристик волоконных усилителей лазеров накачки и повышения ограничивающей способности носителей по обеим сторонам активной области лазера в последние годы была оптимизирована энергетическая зонная структура деформационных лазеров с квантовыми ямами AIGalnAs/InP. . Подводя итог кратко:
1) Слой электронного барьера (ESL) вводится в слой волновода с градиентным показателем преломления или ограничивающий слой, чтобы предотвратить утечку электронов в ограничивающий слой. Характеристическая температура и эффективность наклона лазерного диода накачки могут быть улучшены путем добавления электронного барьерного слоя p-AllnAs между слоями MQW и p-SCH;
2) Ввести InP на N-стороне активной области для улучшения удерживающей способности отверстий на N-стороне;
3) Внедрение множественных квантовых барьеров AllInAs/AlGalnAs (MQB) в ограничивающий слой для повышения удерживающей способности носителей заряда.
Для получения дополнительной информации, пожалуйста, свяжитесь с нами по электронной почте по адресуvictorchan@powerwaywafer.com и powerwaymaterial@gmail.com.

