PAM-XIAMEN может поставлять эпитаксиальные пластины SiC для устройств MOSFET. Дополнительную информацию можно прочитать:https://www.powerwaywafer.com/sic-mosfet-structure.html. Эпитаксиальный процесс SiC неизбежно приводит к образованию различных дефектов, которые влияют на производительность и надежность силовых устройств SiC. Ниже мы специально исследуем влияние дефектов треугольника на производительность устройств SiC MOSFET.
1. Что такое дефекты треугольника?
Треугольный дефект представляет собой включение политипа 3C-SiC, простирающееся вдоль направления базисной плоскости к поверхности эпитаксиального слоя SiC. Он может быть вызван падением частиц на поверхность эпитаксиального слоя SiC в процессе эпитаксиального роста. Частицы внедряются в эпитаксиальный слой и мешают процессу роста, в результате чего образуются включения политипа 3C-SiC, которые имеют острые треугольные особенности поверхности, причем частицы расположены в вершинах треугольной области. Многие исследования также объясняют происхождение полиморфных включений неправильными параметрами, такими как царапины на поверхности, микротрубочки и процессы роста.
Однако из-за разных механизмов роста существуют существенные различия в морфологии многих треугольных дефектов на поверхности эпитаксиального слоя. Условно его можно разделить на следующие виды:
1.1 Треугольный дефект с крупными частицами наверху
Этот тип треугольного дефекта имеет сферическую частицу большого размера наверху, что может быть вызвано падением предметов в процессе роста. В направлении вниз от вершины можно наблюдать небольшую треугольную область с шероховатой поверхностью. Это связано с тем, что во время эпитаксиального процесса в треугольной области последовательно формировались два разных слоя 3C-SiC, причем первый слой зарождался на границе раздела и рос в результате ступенчатого течения 4H-SiC. По мере увеличения толщины эпитаксиального слоя второй слой политипа 3C зарождается и растет в меньших треугольных ямках, но стадия роста 4H не полностью покрывает область политипа 3C, что делает V-образную область канавок 3C-SiC все еще четкой. виден, как показано на рис. 1.

Рис. 1. Морфология поверхности треугольных дефектов с крупными частицами вверху.
1.2. Мелкие частицы сверху и шероховатые треугольные дефекты на поверхности.
Частицы в вершинах такого треугольного дефекта значительно меньше, как показано на рис. 2. При этом большая часть треугольных областей покрыта ступенчатым течением 4H-SiC, то есть весь слой 3C-SiC полностью встроен под слой 4H-SiC. На поверхности треугольных дефектов видны только ступени роста 4H SiC, но эти ступени намного больше, чем обычные ступени роста кристаллов 4H.
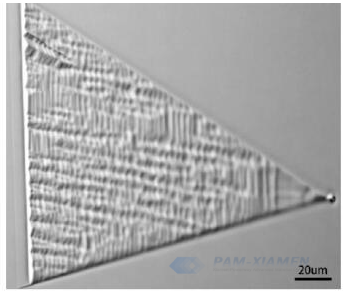
Рис. 2. Схема мелких частиц вверху и грубых треугольных дефектов на поверхности.
1.3. Сглаженные треугольные дефекты на поверхности.
Этот тип треугольных дефектов имеет гладкую морфологию поверхности, как показано на рис. 3. Для таких треугольных дефектов слой 3C-SiC покрывается ступенчатым потоком 4H-SiC, а рост кристаллов 4H на поверхности становится более тонким и гладким.
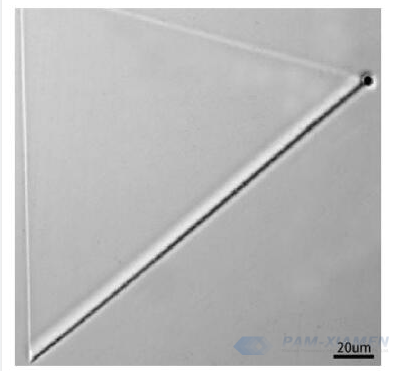
Рис. 3. Морфология поверхности гладких треугольных дефектов на поверхности.
2. Влияние треугольных дефектов на характеристики SiC MOSFET-устройств.
Исследователи изучили влияние треугольных дефектов на характеристики SiC MOSFET, и результаты представлены на рис. 4, на котором показана гистограмма статистического распределения пяти характеристик устройств с треугольными дефектами. Синяя пунктирная линия представляет собой линию сегментации деградации устройства, а красная пунктирная линия представляет собой линию сегментации неисправности устройства. На отказы устройств, показанные в Таблице 1, значительное влияние оказывают треугольные дефекты: частота отказов превышает 93%. В основном это связано с влиянием треугольных дефектов на характеристики обратной утечки устройств: до 93% устройств, содержащих треугольные дефекты, испытывают значительное увеличение обратной утечки. Кроме того, влияние треугольных дефектов на характеристики утечки затвора также очень серьезное, степень деградации составляет 60%. Как показано в таблице 1, на ухудшение порогового напряжения и характеристик корпусного диода влияние треугольных дефектов относительно невелико, со степенью ухудшения 26% и 33% соответственно. С точки зрения увеличения сопротивления проводимости влияние треугольных дефектов относительно слабое, со скоростью деградации около 33%.
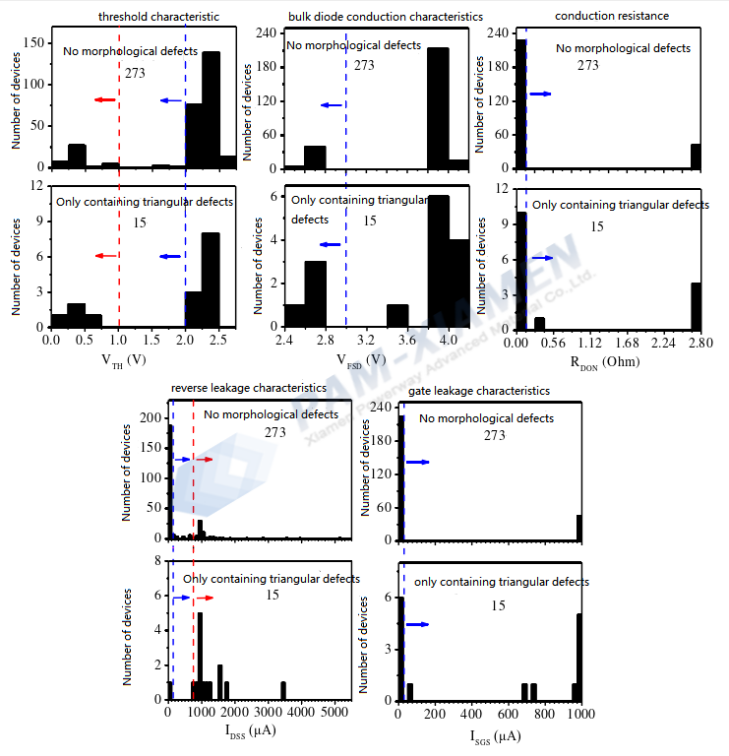
Рис. 4. Гистограммы различных характеристических распределений SiC MOSFET с треугольными дефектами.
| Таблица 1 Статистическая таблица корреляции между дефектами треугольника и характеристиками устройства SiC MOSFET | |||||
| Характеристики устройства | VTHскорость деградации | VFSDскорость деградации | RДОНскорость деградации | IDSSскорость деградации | IСГСскорость деградации |
| Дефект треугольника | 26% | 33% | 33% | 93% | 60% |
В целом исследование показало, что треугольные дефекты оказывают существенное влияние на выход из строя и ухудшение характеристик устройств SiC MOSFET. Наличие дефектов-треугольников является наиболее фатальным, частота отказов достигает 93%, проявляется в основном в значительном увеличении обратной протечки устройства.
Для получения дополнительной информации, пожалуйста, свяжитесь с нами по электронной почте по адресуvictorchan@powerwaywafer.com и powerwaymaterial@gmail.com.

