Các vật liệu hỗn hợp vùng cấm trực tiếp bậc bốn, chẳng hạn như InGaAsP và AlGaInAs, có thể được phát triển trên đế InP, là mạng tinh thể phù hợp với InP. Hiện nay, trong nhiều lĩnh vực khác nhau, các nhà nghiên cứu đã thiết kế laser bán dẫn, bộ khuếch đại quang, máy dò, v.v. sử dụng hai loại vật liệu này phát triển trên đế InP. Đối với bộ khuếch đại quang, laser bán dẫn 1460nm công suất cao dựa trên AlGaInAs / InP MQW là nguồn bơm lý tưởng. PAM-XIAMEN có thể phát triển máy bơm AlGaInAs / InP 1460nmwafer epiticular laserđể khuếch đại quang học. Cấu trúc epi laser bơm chính xác vui lòng tham khảo bảng dưới đây:

1. Cấu trúc epitaxy điốt laser bơm 1460nm
PAM230509 – 1460LD
| Số lớp | Chất liệu | Độ dày (nm) | dopant | Loại |
| 6 | InP | – | – | – |
| 5 | GaIn (x) Như | – | – | – |
| 4 | Tăng(x)Như(y)P | – | – | – |
| 3 | InP | 2100 | – | – |
| 2 | AlGaInAs MQW + SCH
PL 1430~1460nm |
– | – | – |
| 1 | Bộ đệm trong P | – | Silicon | N |
| chất nền InP |
Đối với các cấu trúc giếng lượng tử có bước sóng phát quang từ 1300 đến 1700nm, chúng tôi thường bơm epitaxy tấm wafer laser diode dựa trên chất nền InP và sử dụng vật liệu InGaAlAs làm giếng lượng tử. Bằng cách điều chỉnh thành phần AlGaInAs và chọn độ dày giếng lượng tử thích hợp, chúng ta có thể tự do thiết kế bước sóng laser bơm diode trên một phạm vi lớn. Từ hình 1, có thể thấy rằng bước sóng tương ứng có thể điều chỉnh của hệ vật liệu AlGaInAs / InP cho laser bơm Raman có thể từ 1,3 μm đến 1,5 μm.
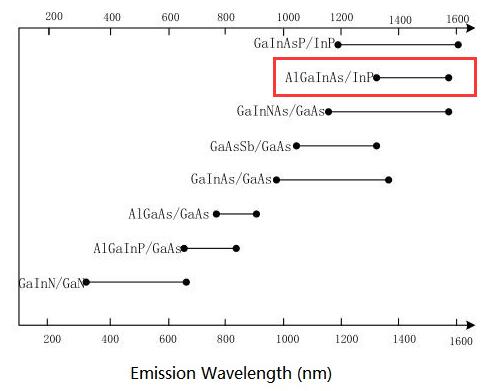
Hình 1 Phạm vi bước sóng tương ứng với vật liệu AlGaInAs / InP
2. Những thách thức đối với sự tăng trưởng vật chất của AlGaInAs trên InP
Khó khăn trong quá trình tăng trưởng epiticular của AlGaInAs chủ yếu bao gồm:
1) Thành phần Al dễ bị oxy hóa và hình thành các mức năng lượng sâu với O;
2) Tại giao diện Al (Ga) InAs / InP, dễ xảy ra hiện tượng khuếch tán xen kẽ As và P, ảnh hưởng đến chất lượng của lớp epitaxy. Bằng cách tăng nhiệt độ và tỷ lệ V/II, có thể thu được vật liệu chứa Al chất lượng cao. Tuy nhiên, nhiệt độ cao có hại cho sự phát triển của vật liệu chứa In. Ở nhiệt độ cao, phản ứng trước của In và quá trình giải hấp của bề mặt phát triển diễn ra nghiêm trọng hơn, dễ dẫn đến hình thành sự phân bố giọt In trên bề mặt, ảnh hưởng đến hiệu suất phát quang của vật liệu. Hơn nữa, nhiệt độ tăng trưởng càng cao thì vấn đề khuếch tán xen kẽ As và P tại giao diện giữa AlGaInAs và InP càng nghiêm trọng, ảnh hưởng đến tính đồng nhất và độ phẳng của giao diện. Do đó, phạm vi nhiệt độ tăng trưởng của vật liệu AIGalnAs chất lượng cao rất hạn chế và cần được kiểm soát chính xác.
3. Tối ưu hóa cấu trúc dải năng lượng của Laser giếng lượng tử AlGalnAs / InP
Để cải thiện hơn nữa các đặc tính nhiệt độ của các thiết bị khuếch đại sợi laser bơm và tăng cường khả năng hạn chế chất mang ở cả hai phía của vùng hoạt động của laser, cấu trúc dải năng lượng của laser giếng lượng tử biến dạng AIGalnAs / InP đã được tối ưu hóa trong những năm gần đây. . Để tóm tắt ngắn gọn:
1) Lớp rào cản điện tử (ESL) được đưa vào lớp ống dẫn sóng chỉ số phân loại hoặc lớp giới hạn để ngăn các electron rò rỉ vào lớp giới hạn. Nhiệt độ đặc trưng và hiệu suất độ dốc của diode laser bơm có thể được cải thiện bằng cách thêm lớp rào cản điện tử p-AllnAs giữa các lớp MQW và p-SCH;
2) Đưa InP vào phía N của vùng hoạt động để cải thiện khả năng giam cầm các lỗ ở phía N;
3) Giới thiệu nhiều rào cản lượng tử (MQB) AllInAs/AlGalnAs trong lớp giam giữ để nâng cao khả năng giam cầm của các hạt mang điện.
Để biết thêm thông tin, xin vui lòng liên hệ với chúng tôi email tạivictorchan@powerwaywafer.com và powerwaymaterial@gmail.com.

