PAM-XIAMEN может предложить пластины SiC, конкретные характеристики и параметры можно найти в:https://www.powerwaywafer.com/sic-wafer
Монокристалл 4H-SiC обладает превосходными характеристиками, такими как широкая запрещенная зона, высокая подвижность носителей, высокая теплопроводность и хорошая стабильность. Он имеет широкие перспективы применения в мощной электронике, радиочастотной и микроволновой электронике, а также в квантовой информации. После многих лет разработок в промышленности были применены 6-дюймовые монокристаллические подложки 4H SiC и гомогенные эпитаксиальные тонкие пленки. Однако общая плотность дислокаций в пластинах 4H SiC по-прежнему достигает 103~104см-2, что препятствует реализации полного потенциала пластин 4H-SiC. Как дислокации влияют на свойства пластин и устройств 4H-SiC? Конкретный анализ заключается в следующем:
1. Влияние дислокаций на электрические свойства пластин и устройств 4H-SiC.
Исследования проанализировали взаимосвязь между характеристиками пластин и устройств 4H-SiC и распределением дислокаций внутри функциональной области, предполагая, что наличие дислокаций может оказывать неблагоприятное влияние на производительность устройства. Поэтому изучение электрических свойств самих дислокаций имеет большое значение для понимания их поведения в устройствах.
1.1 Влияние дислокаций на электрические свойства подложки 4H-SiC
Комбинируя коррозию расплавленного щелочного металла и зондовую силовую микроскопию Кельвина (KPFM), можно наблюдать, что краевая дислокация резьбы (TED) и дислокация базисной плоскости (BPD) проявляют акцепторные состояния в полуизолирующих (HPSI) подложках 4H SiC высокой чистоты и донорные состояния. в подложках 4H SiC n-типа (см. рисунок 1). В эпитаксиальном слое 4H SiC с низкой концентрацией легирования также обнаружено, что проникающие дислокации обладают акцепторными свойствами. Расчеты из первых принципов показали, что TED и BPD вводят уровни энергии дефектов, причем уровень энергии вблизи нижней части валентной зоны является пустой зоной. Из-за доминирования дефектов глубоких уровней, таких как атомы примесей, углеродные вакансии (VC) или пары вакансий (VC-Vси) в HPSI 4H SiC вакансионная зона, введенная дислокациями, может принимать электроны глубоких уровней, а дислокации проявляют акцепторные характеристики. В подложке n-типа расчеты показывают, что атомы N более стабильны при связывании с дислокациями TED и BPD, поэтому атомы N имеют тенденцию агрегировать вблизи дислокаций. Из-за преобладания легированных атомов в проводящих подложках агрегация атомов N может обуславливать донорные характеристики дислокаций.
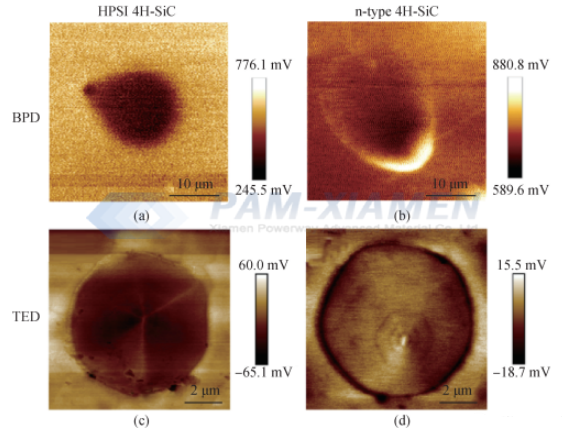
Рис. 1. Распределение поверхностного потенциала BPD и TED в HPSI и 4H-SiC n-типа.
1.2 Влияние дислокаций на электрические свойства устройств 4H-SiC
При сканировании микроямок, вызванных резьбо-винтовой дислокацией (TSD), результаты теста C-AFM показали значительное увеличение тока на дне микроямок, в то время как поверхностный ток в других областях внутри микроямок существенно не отличался. от этого за пределами микроям. Это указывает на то, что дислокационные линии ТСД в 4H SiC усиливают эффект утечки. Кроме того, дислокации как центры рекомбинации могут вызывать электронно-дырочную рекомбинацию в силовых устройствах 4H-SiC, а также приводить к снижению надежности устройств.
Линии дислокаций не только влияют на производительность устройства, но и вызывают появление поверхностных микроямок наноразмерной глубины на поверхности эпитаксиального слоя из-за нарушения внешнего ступенчатого течения, вызванного дислокационными линиями. Наличие микроямок также может повлиять на работу устройства. Например, под высоким давлением в месте микрократера появляется микроплазма, вызванная резьбовой дислокацией (TD), что указывает на то, что кислород затвора в положении микрократера сначала разрушается. Наличие микроямок также может приводить к уменьшению срока службы неосновных носителей, увеличению обратного тока утечки и уменьшению прямого напряжения, что оказывает неблагоприятное воздействие на диоды Шоттки с барьером Шоттки (SBD) на основе 4H SiC, диоды с pn-переходом. (ПНД) и лавинные фотодиоды (см. рис. 2 (а), (б)).
Поэтому некоторые исследователи полагают, что нынешнее влияние дислокаций на работоспособность устройств в основном обусловлено микроямками, а влияние самих дислокационных линий вторично. Путем моделирования и экспериментов было обнаружено, что исключение наличия микроямок может снизить влияние TSD на устройства на основе 4H-SiC (см. рис. 2 (в)). BPD также может служить композиционным центром в 4H-SiC. При работе в биполярных устройствах 4H-SiC электрическая инжекция может вызвать скольжение неполных дислокаций в кремниевом сердечнике, что приводит к расширению дефектов упаковки и серьезно влияет на работу устройства в прямом и обратном направлении. Обычно считается, что дефекты упаковки, вызванные неполными дислокациями в кремниевом сердечнике при BPD, развиваются на границе между подложкой и эпитаксиальным слоем и расширяются наружу на поверхности эпитаксиального слоя. Учитывая направленное движение двух неполных дислокаций при БПД, расширение дефектов упаковки, вызванное БПД, является сложным. Исследования показали, что дефекты упаковки, вызванные BPD, также могут перемещаться к границе раздела между подложкой и эпитаксиальным слоем (см. рис. 2 (d)).
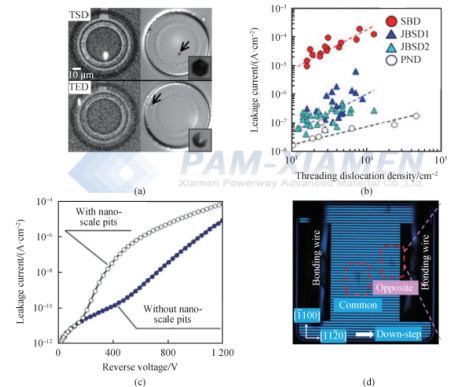
Рис. 2. Влияние дислокаций на ток утечки силовых устройств 4H-SiC и расширение дефектов упаковки в 4H-SiC: (а) ЭЛ-изображения лавинных диодов (слева) и ДИК-изображения после плавления КОН-коррозией (справа); (б) Связь между током утечки различных устройств и плотностью ТД; (в) Поведение обратной утечки диодов 4H-SiC и их зависимость от наноямок; (г) ЭЛ-изображение PIN-устройства 4H SiC, наблюдаемое с помощью фильтра 420 нм.
2. Влияние дислокаций на оптические свойства 4H-SiC.
Являясь центром излучательной рекомбинации, дислокации в 4H-SiC проявляют фотолюминесценцию, причем контраст дислокационной фотолюминесценции (ФЛ) зависит от времени жизни неосновных носителей носителей. Когда концентрация дефектов глубоких уровней в кристалле мала, время жизни неосновных носителей велико, и достаточное количество неосновных носителей перемещается в область дислокации, чтобы рекомбинировать и излучать свет. В это время интенсивность люминесценции дислокационной области выше, чем у других областей, и проявляется в виде яркого пятна. Когда концентрация дефектов глубоких уровней в кристалле высока, время жизни неосновных носителей мало, и они объединяются с близлежащими дефектами глубоких уровней, излучая свет. Рекомбинация на дислокации подавлена, интенсивность излучения в области дислокации слабее, чем в других областях, и проявляется темное пятно. Эксперимент показал, что при тестировании ФЛ для 4H-SiC со временем жизни неосновных носителей менее 0,5 мкс большинство неосновных носителей не могут мигрировать к дислокациям, а небольшое количество неосновных носителей захватывается собственными дефектами. Дислокации не показывают значительного контраста на изображении сканирования поверхности ФЛ. При времени жизни неосновных носителей более 0,5 мкс рекомбинация электронов и дырок на дислокации может существенно отличать контрастность дислокации от других областей.
TSD и TED демонстрируют темные или светлые пятна разного размера на изображениях сканирования поверхности ФЛ 4H-SiC. Пики эмиссии собственной ФЛ TED и TSD расположены при 600 нм и 800–850 нм соответственно. BPD выглядит как темные или яркие линии на сканированном изображении поверхности ФЛ 4H-SiC (см. Рис. 3 (а)). Пики эмиссии ФЛ BPD возникают из пиков эмиссии ФЛ неполных дислокаций и дефектов упаковки, из которых состоят BPD. Пики эмиссии неполных дислокаций кремниевого ядра, неполных дислокаций углеродного ядра и дефектов упаковки расположены при 670–700 нм, 720–850 нм и 420 нм соответственно. Регулируя длину волны излучаемого света, можно добиться отдельного отображения одиночных неполных дислокаций и дефектов упаковки.
Недавно исследователи также обнаружили, что TD могут усиливать люминесценцию D1 4H-SiC, как показано на рис. 3 (b) и (c), которые представляют интенсивность люминесценции коррозионных язв TED и TSD соответственно. Это означает, что интенсивность люминесценции D1 может также отражать плотность и распределение дислокаций в подложке 4H-SiC и эпитаксиальном слое.

Рис. 3. Люминесцентные свойства дислокаций в 4H-SiC: (а) ФЛ-изображения поверхности микроструктур эпитаксиальных тонких пленок 4H SiC, полученные с использованием полосового фильтра 900 нм; (b) Изображения сканирования поверхности ФЛ микрообластей TED и (c) изображения сканирования поверхности ФЛ микрообластей TSD в подложке 4H-SiC N-типа, полученные при излучении 450–750 нм.
Увеличение размера материала и снижение плотности дислокаций являются основными направлениями разработки подложек 4H-SiC и тонких эпитаксиальных пленок. Для снижения плотности дислокаций, с одной стороны, необходимо оптимизировать конструкцию тепловых полей и полей течения, разработать методы обработки затравочных кристаллов или подложек, а также оптимизировать технологии монокристаллических или эпитаксиальных процессов для снижения плотности дислокаций; С другой стороны, на основе все более зрелых технологических процессов необходимы дальнейшие углубленные исследования того, как стимулировать трансформацию или реакцию между различными типами дислокаций, чтобы уменьшить низкую плотность дислокаций. Что касается регулирования производительности дислокаций, необходимы дальнейшие исследования того, как стимулировать реакцию между примесями и точечными дефектами с дислокациями, тем самым регулируя положение уровня энергии дефектов и динамическое поведение дислокаций.
Ссылка:
Цзяцзюнь Ли, Гуан Ян, Сяошуан Лю, Хао Ло, Линбо Сюй, Ицян Чжан, Цань Цуй, Сяодун Пи, Дерен Ян и Ронг Ван
Дислокации в карбиде кремния 4H
Для получения дополнительной информации, пожалуйста, свяжитесь с нами по электронной почте по адресуvictorchan@powerwaywafer.com и powerwaymaterial@gmail.com.

