Хён Кон Чо ∗
Кафедра металлургической инженерии, Университет Донг-А, Пусан 604-714
Чон Ён Ли
Департамент материаловедения и инженерии,
Корейский передовой институт науки и технологий, Тэджон 305-701
Мы исследовали образование V-образных ямок в нитридных пленках, таких как InGaN / GaN и AlGaN / GaN, выращенных на сапфировой подложке, с помощью просвечивающей электронной микроскопии. Механизм образования ямок сильно зависит от состава индия (In) и алюминия (Al) в InxДжорджия1-хN и AlxДжорджия1-хN слоев соответственно. С увеличением состава индия образовывались V-образные ямки от вершины прорастающих дислокаций до границ рассогласования упаковки, вызванные дефектами упаковки и трехмерным ростом островков на начальной стадии из-за большого рассогласования решеток. С увеличением состава алюминия происхождение ямок также изменялось от волнистости поверхности из-за упругой деформации несоответствия до вершины пронизывающих дислокаций.
Номера PACS: 61.72.Ff, 68.55.Ln, 68.55.-a
Ключевые слова: пит, нитрид, ПЭМ, AlGaN, InGaN.
ВВЕДЕНИЕ
Полупроводники на основе вюрцита GaN (GaN, InGaN и AlGaN) в настоящее время интенсивно исследуются как перспективные материалы для оптоэлектронных, высокотемпературных и мощных устройств благодаря некоторым свойствам, таким как большая прямая запрещенная зона, высокая термическая стабильность и сильное межатомное взаимодействие. облигации [1, 2]. Для ВxДжорджия1-хN и AlxДжорджия1-хN-слоев, выращенных на GaN, увеличение составов индия (In) и алюминия (Al) неизбежно может вызвать деформации несоответствия в пленках. За пределами критической толщины в результате пластической релаксации возникают некоторые структурные дефекты, такие как дислокации несоответствия, дефекты упаковки, V-образные ямки и т. Д. [3, 4]. Однако и при меньшей толщине упругая релаксация может быть вызвана образованием островков, волнистости поверхности и т. Д., Как это наблюдается в InGaP / InAsP, In0.77Ga0.23As / InGaAs, SiGe / Si и т. Д. [5–7 ].Кроме того, увеличение состава In может вызвать химическую неоднородность InxДжорджия1-хN-ямные слои из-за плохой смешиваемости между InN и GaN [8, 9].Согласно расчетам, низкая растворимость In в GaN составляет менее 6% при 800 ◦C с использованием модели Стрингфеллоу [10].Эти свойства могут существенно влиять на оптические и структурные свойства устройств [11, 12].
Недавно мы сообщили о двух моделях образования V-образных ямок в множественных квантовых ямах (МКЯ) InGaN / GaN с высоким содержанием индия [13]. Также нежелательность и влияние на эмиссионные свойства этих ямок ранее были продемонстрированы методами просвечивающей электронной микроскопии (ПЭМ), катоделюминесценции и фотолюминесценции [3, 14, 15]. Следовательно, для подавления образования ямок необходимо четкое понимание механизмов образования ямок, и необходимо детально оценить микроструктуру ямок, наблюдаемых в различных пленках III-нитрида, выращенных на сапфировой подложке. В данной работе мы исследовали образование ямок, возникающих из разных источников в гетероструктурах InGaN / GaN и AlGaN / GaN с различным составом In и Al, с помощью ПЭМ.
II. ЭКСПЕРИМЕНТАЛЬНАЯ
Все образцы были выращены на сапфировых подложках c-плоскости с номинальной толщиной зародышевого слоя GaN 25 нм в горизонтальном реакторе для осаждения из газовой фазы металлоорганических соединений, работающем при низком давлении. Триметилгаллий, триметилиндий, триметилалюминий и аммиак использовали в качестве исходных предшественников для Ga, In, Al и N соответственно. Чтобы проанализировать влияние деформации на механизм образования ямок в III-нитридах, толстые слои InxGa1 − xN (∼ 800 ˚A) были выращены при температурах от 830 ◦C (xВ = 35%) до 880 ◦C (xВ = 10%) и толстые слои AlxGa1 − xN (1000 A) были выращены при 1040 ◦C после выращивания легированного Si нижележащего слоя GaN толщиной ∼2 мм при 1080 ◦C. Составы In и Al в InxДжорджия1-хN и AlxДжорджия1-хN слоев составляли 10, 13, 19, 35% и 16, 25, 44 и 54% соответственно.
Чтобы охарактеризовать образование ямок III-нитридов, образцы ПЭМ были приготовлены в поперечном сечении вдоль оси зоны [11-20] с использованием механической полировки штатива с последующим низкотемпературным измельчением ионами Ar при 4,5 кВ на Gatan DuoMill 660 DIF с секторной скоростью. контроль. Энергия ионов постепенно уменьшалась на заключительных этапах утонения, чтобы минимизировать повреждение поверхности образцов. Изображения в светлом поле (BF) и изображения TEM с высоким разрешением (HRTEM) были записаны на JEOL JEM-2000EX TEM при 200 кВ и JEOL JEM-3010EX при 300 кВ.
III. РЕЗУЛЬТАТЫ И ОБСУЖДЕНИЕ
Чтобы исследовать влияние состава Al на образование ямок, снимки поперечного сечения, полученные методом просвечивающей электронной микроскопии (ПЭМ) из AlxДжорджия1-хСлои N, выращенные с различным составом Al на буферном слое GaN, были получены, как показано на рис. 1. Теоретический критический состав Al для образования дислокации несоответствия в 1000 A AlxДжорджия1-хСлой N, выращенный на слоях GaN, составляет менее 15% [16]. Ямок в Al не обнаружено.xДжорджия1-хN слоев с содержанием алюминия до 25%. Наблюдаются только дефекты упаковки и трещины в слоях AlGaN из-за деформации несоответствия и разницы тепловых коэффициентов соответственно (не показаны). Для Al0.44Джорджия0.56N / GaN, однако поверхность Al0.44Джорджия0.56Слой N показывает множество ямок, которые не связаны со структурными дефектами, такими как проницаемые дислокации, дефекты упаковки и так далее [Рис. 1 (б) и (г)]. Размер этих ямок очень мал, средний диаметр 7 нм и средняя высота ~ 3 нм, по сравнению с ямками в слоях InGaN, выращенных на GaN [13, 14, 16]. Считается, что образование ямок в Al0.44Джорджия0.56N / GaN можно отнести к волнистости поверхности из-за повышенной упругой деформации несоответствия, наблюдаемой в полупроводниковых системах III-V и II-VI [5, 6].
Плотность ямок более 1010 см−2 на поверхности. С другой стороны, дислокации несоответствия генерируются на границе раздела Al0.54Джорджия0.46Образец N / GaN для пластической релаксации сохраненной деформации несоответствия, как показано на рис. 1 (c). Кроме того, как в гетероструктурах InGaN / GaN, наблюдаются V-образные ямки, связанные с пронизывающими дислокациями на дне. Эти V-образные ямы имеют открытую шестиугольную перевернутую пирамиду с боковыми стенками [14, 16].
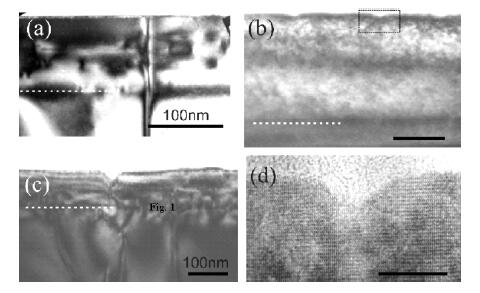
Рис.1 Поперечное сечение изображений ПЭМ в светлом поле с использованием g = 0002 от AlxДжорджия1-хСлои N, выращенные с составом Al 16% (а), 44% (б) и 54% (в). (d) Изображение HRTEM, полученное из пунктирного прямоугольника на (b). Пунктирными линиями обозначены AlxДжорджия1-хИнтерфейс N / GaN.
Вследствие этого мы классифицировали происхождение ямочного образования в AlxДжорджия1-хN, выращенный на буферном слое GaN, в две модели, как показано на рис. 4 (а) и (г). Для AlxДжорджия1-хВ слое N с содержанием алюминия около 40% ямки возникают из-за волнистости поверхности из-за накопленной упругой деформации несоответствия [Рис. 4 (d)]. Для AlxДжорджия1-хСлой N с составом более ∼50% Al, однако ямки в основном образуются на вершине пронизывающих дислокаций [Рис. 4 (а)].
На рис.2 представлены микрофотографии просвечивающей электронной микроскопии в светлом поле в поперечном сечении из InxДжорджия1-хN слоев, выращенных с различным составом In на буферном слое GaN. Теоретический критический состав In по образованию дислокации несоответствия ∼800˚A InxДжорджия1-хN, выращенный на слоях GaN, составляет менее 5%, ниже которого слои InGaN демонстрируют когерентный рост [16]. Таким образом, мы ожидаем, что в составе всех InxДжорджия1-хИзученные здесь слои N имеют значение, превышающее критический состав In для образования дислокации несоответствия. Для В0.1Джорджия0.9N / GaN, в слое In0.1Ga0.9N не наблюдались структурные дефекты, такие как дислокации несоответствия, дефекты упаковки, ямки и т. Д. При дальнейшем увеличении In-состава InxДжорджия1-хN слой (xВ = 13%), V-образные ямки создаются для ослабления сохраненной деформации несоответствия, как сообщалось ранее [14]. Сообщалось, что V-образная ямка всегда связана с проникающей дислокацией из буферного слоя GaN внизу, и только небольшая часть пронизывающих дислокаций вызывает образование V-образных ямок в слоях InGaN и МКЯ InGaN / GaN [14]. Однако плотность V-образных ямок в In0.19Джорджия0.81Слой N на рис. 2 (c) имеет большее значение, чем плотность пронизывающих дислокаций в буферном слое GaN, что указывает на то, что образование V-образных ямок в InGaN с высоким содержанием In имеет другое происхождение, как сообщалось ранее для системы InGaN / GaN с МКЯ [13]. Мы сообщали, что в МКЯ InGaN / GaN с высоким составом In (~ 30% In) большая часть V-образных ямок возникает из-за границ несоответствия упаковки, вызванных дефектами упаковки [13]. Хотя в0.19Джорджия0.81Используемый здесь N / GaN имеет состав In менее 20%, часть V-образных ямок возникает из-за границ несоответствия упаковки, вызванных дефектами упаковки из-за увеличенной толщины слоя InGaN [рис. 3 (а)] по сравнению с МКЯ InGaN / GaN. Для В0.35Джорджия0.65N / GaN, V-образные ямки плотностью более 1010 см−2 наблюдаются на поверхности. В отличие от ям в In0.19Джорджия0.81N / GaN образец In0.35Джорджия0.65N областей с плоскими (0001) верхними поверхностями между питами имеют большое количество дефектов упаковки и границ несоответствия упаковки, сформированных на начальной стадии роста InGaN [рис. 3 (б)], то есть столбчатые структуры, включая дефекты упаковки. Чтобы ослабить большое рассогласование решеток между In0.35Джорджия0.65N и GaN исходный In0.35Джорджия0.65Слой N был выращен с морфологией трехмерных (3D) ограненных островков [17]. На островках отчетливо видна высокая плотность дефектов упаковки, а границы между субзеренами островками видны как рост зародышевого слоя GaN, выращенного на сапфировой подложке [18].
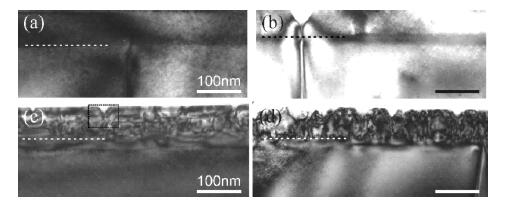
Рис.2 Поперечное сечение изображений ПЭМ в светлом поле с использованием g = 0002 из InxДжорджия1-хСлои N, выращенные с составом In: (а) 10%, (б) 13%, (в) 19% и (г), 35% на буферном слое GaN. Пунктирными линиями обозначен входнойxДжорджия1-хИнтерфейс N / GaN.
Таким образом, мы думаем, что ямы в In0.35Джорджия0.65Образцы N / GaN вызваны таким трехмерным ростом из-за несоответствия решеток при начальном росте слоя InGaN.
В результате мы классифицировали происхождение ямкообразования в InxДжорджия1-хN, выращенный на буферном слое GaN, в трех моделях, как показано на рис. 4 (a), (b) и (c). Для ВxДжорджия1-хВ слое N с низким содержанием In в вершинах пронизывающих дислокаций образуются ямки [рис. 4 (а)]. Для ВxДжорджия1-хСлой N со средним составом ямки в основном образуются из-за границ несоответствия упаковки, вызванных дефектами упаковки [Рис. 4 (б)]. Дальнейшее увеличение содержания InxДжорджия1-хСлой N приводит к росту трехмерных островков на начальной стадии и образованию ямок при непрерывном росте [рис. 4 (с)].
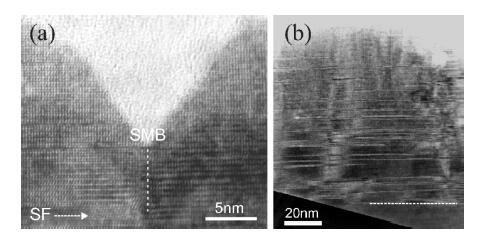
Рис. 3 (a) Изображение HRTEM, полученное из пунктирного прямоугольника на рис. 2 (c). Наблюдаемая V-образная яма в нижнем положении имеет дефект упаковки в плоскостях (0001). (б) Изображение HRTEM, полученное из In0.35Джорджия0.65N на буферном слое GaN.
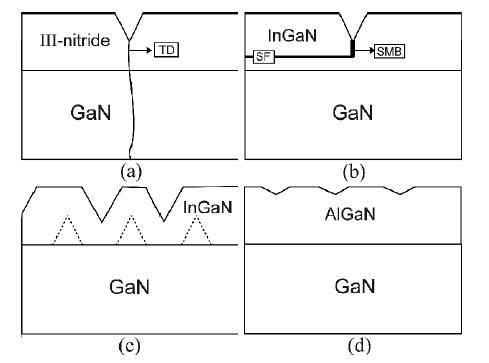
Рис.4 Схематические модели образования ямок, связанных с (а) пронизывающей дислокацией, наблюдаемой в гетероструктурах InGaN / GaN и AlGaN / GaN, (б) границей несоответствия упаковки, вызванной дефектами упаковки, и (в) ростом 3d-островков на начальной стадии наблюдается в гетероструктуре InGaN / GaN, и (d) волнообразность поверхности из-за упругой деформации несоответствия, наблюдаемой в гетероструктуре AlGaN / GaN.
IV. РЕЗЮМЕ
Ямочная формация в г.xДжорджия1-хN и AlxДжорджия1-хСлои N с различным составом In и Al, выращенные на буферных слоях GaN, исследовались методом просвечивающей электронной микроскопии. Мы обнаружили, что ямки образовывались из различных источников, таких как пронизывающие дислокации, границы несоответствия упаковки, рост трехмерных островков и волнистость поверхности в зависимости от составов In и Al.
БЛАГОДАРНОСТЬ
Работа поддержана грантом № R01-2002- 000-00096-0 Корейского научно-технического фонда и Университетской исследовательской программой Министерства информации и коммуникаций Республики Корея.
РЕКОМЕНДАЦИИ
[1] Х. Моркок, Нитридные полупроводники и устройства (Springer, Heidelberg, 1999).
[2] YS Park, J. Korean Phys. Soc. 34, S199 (1999).
[3] Х. К. Чо, Дж. Я. Ли, К. С. Ким, Г. М. Янг, Н. Шарма и С. Дж. Хамфрис, Дж. Крист. Рост 231, 466 (2001).
[4] HK Cho, JY Lee, KS Kim, GM Yang, J. Korean Phys. Soc. 39, S165 (2001).
[5] P. Desjardins, H. Marchand, L. Isnard, RA Masut, J. Appl. Phys. 81, 3501 (1997).
[6] М. Мицухара, М. Огасавара и Х. Сугиура, J. Cryst. Рост 210, 463 (2000).
[7] JM Hartmann, B. Gallas, J. Zhang и JJ Harris, Semicond. Sci. Technol. 15, 370 (2000).
[8] Д. Доппалапуди, С. Н. Басу, К. Ф. Людвиг-младший и Т. Д. Мустакас, J. Appl. Phys. 84, 1389 (1998).
[9] Т. Такеучи, Х. Такеучи, С. Сота, Х. Сакаи, Х. Амано и И. Акасаки, Jpn. J. Appl. Phys. 36, L177 (1997).
[10] Г.Б. Стрингфеллоу, J. Cryst. Рост 58, 194 (1982). [11] CA Tran, RF Karlicek, Jr., M. Schurman, A. Osinsky, V. Merai, Y. Li, I. Eliashevich, MG Brown, J. Nering, I. Ferguson и R. Stall, J. Cryst . Рост 195, 397 (1998).
[12] MG Cheong, RJ Choi, CS Kim, HS Yoon, C.-H. Хонг, Э.-К. Suh, HJ Lee, HK Cho, JY Lee, J. Korean Phys. Soc. 38, 701 (2001).
[13] HK Cho, JY Lee, GM Yang и CS Kim, Appl. Phys. Lett. 79, 215 (2001).
[14] XH Wu, CR Elsass, A. Abare, M. Mack, S. Keller, PM Petroff, SP DenBaars, and JS Speck, SJ Rosner, Appl. Phys. Lett. 72, 692 (1998).
[15] Г. Позина, Дж. П. Бергман, Б. Монемар, Т. Такеучи, Х. Амано и И. Акасаки, J. Appl. Phys. 88, 2677 (2000).
[16] Дж. У. Мэтьюз и А. Э. Блейксли, J. Cryst. Рост 32, 265 (1974).
[17] Z. Liliental-Weber, M. Benamara, J. Washburn, JZ Domagala, J. Bak-Misiuk, EL Piner, J. C. Roberts, SM Bedair, J. Electron. Mater. 30, 439 (2001).
[18] К. Лоренц, М. Гонсалвес, Ук Ким, В. Нараянан и С. Махаджан, Appl. Phys. Lett. 77, 3391 (2000).
