原子層エピタキシー(ALE)としても知られる原子層堆積(ALD)は、原子スケールの薄膜調製技術です。 均一な厚さ、制御可能な厚さ、調整可能な組成の超薄膜を堆積させることができます。 ナノテクノロジーと半導体マイクロエレクトロニクスの発展に伴い、デバイスと材料のサイズ要件は継続的に減少し、デバイス構造のアスペクト比は継続的に増加し、使用される材料の厚さを10ナノメートルから数ナノメートルのオーダーに減らす必要があります。ナノメートル。 原子層堆積技術は、関連する製造分野で徐々にかけがえのない技術になりました。 その利点は、それが巨大な開発の可能性とより広いアプリケーションスペースを持っていることを決定します。 金属シリコンウェーハALDによる提供はPAM-XIAMENによって提供されます。
1.原子層堆積技術の動作原理
原子層堆積技術とは、気相前駆体のパルスを反応チャンバーに交互に注入し、堆積基板の表面に気相化学吸着反応を起こすことによって薄膜を形成する方法を指します。 図1に示すように、原子層堆積プロセスは、4つの基本ステップでの2つの半反応AとBで構成されます。
1)前駆体パルス吸着反応;
2)不活性ガスで過剰な反応物と副生成物をパージする。
3)前駆体Bパルス吸着反応;
4)過剰な反応物と副生成物は不活性ガスによってパージされ、次に順番に循環されて、基板の表面上での薄膜の層ごとの成長を実現します。
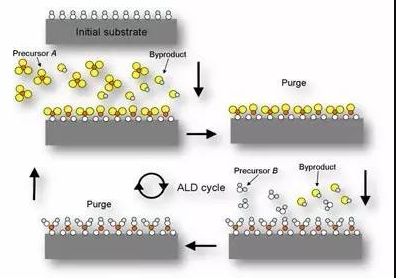
図1.ALDの動作原理
次のような多種多様な材料を原子層堆積によって堆積させることができます。
酸化物:HfO2、HfSiO、Al2O3、Ta2O5、TiO2、La2O3、SiO2、ZnOを含む
TiN、TaN、AlN、SiNx、HfNを含む窒化物
Ru、Cu、W、Moを含む金属
2. ALD、PVD、CVDの比較
従来の薄膜作製技術と比較して、原子層堆積技術には明らかな利点があります。 従来の溶液化学的方法およびスパッタリングまたは蒸発(PVD)などの物理的方法は、表面制御の欠如またはスパッタされた影領域の存在のために、3次元の複雑な基板の表面への堆積および膜形成には適していません。 化学蒸着(CVD)法では、前駆体の拡散と反応チャンバーの温度均一性を厳密に制御する必要があり、薄膜の均一性と厚さの正確な制御の要件を満たすことは困難です。 対照的に、ALDテクノロジーは、表面の自己制限および自己飽和吸着反応に基づいており、表面を制御します。 底面は、正確なサブ単分子膜の厚さ制御を保証しながら、膜を形成するために堆積されます。 したがって、ALD技術は、マイクロエレクトロニクス、エネルギー、情報、その他の分野で広く使用されています。
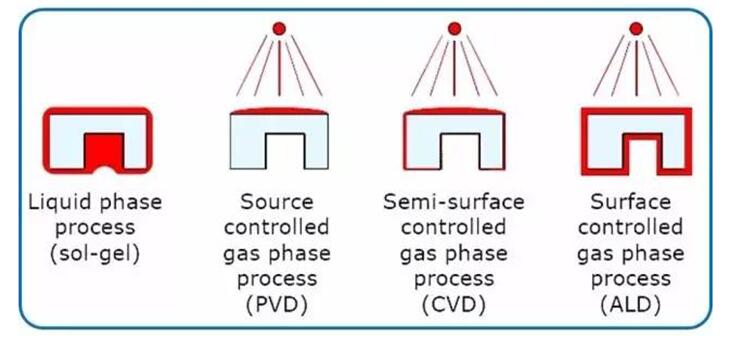
図2.ALD、PVD、CVDなどの比較
3.原子層堆積技術の基本的な応用
原子層堆積技術の開発は、半導体産業の台頭と切り離せないものです。 チップ統合の継続的な改善により、さまざまなコンポーネントのサイズは縮小し続け、半導体業界のテクノロジーノードはナノ時代に入りました。 人々はまた、半導体技術と互換性のあるナノスケールの薄膜調製技術に対するますます高い要件を提唱しています。 ALDテクノロジーの主な用途は次のとおりです。
1)トランジスタゲート誘電体(high-k)およびメタルゲート電極。
2)微小電気機械システム(MEMS);
3)オプトエレクトロニクス材料およびデバイス。
4)集積回路相互接続拡散バリア。
5)フラットパネルディスプレイ(例:有機発光ダイオード材料、OLED);
6)相互接続バリア層。
7)銅電気めっき堆積シード層を相互接続します。
8)DRAM、MRAM誘電体層。
9)埋め込みコンデンサ;
10)電磁記録ヘッド;
11)さまざまな種類の薄膜(<100nm)。
詳細については、メールでお問い合わせください。 victorchan@powerwaywafer.com と powerwaymaterial@gmail.com.

