PAM-厦門用品GaN HEMTエピタキシャルウェーハおよびGaN製造サービス。 提供されるGaN製造サービスには、前工程と後工程が含まれます。 HEMT の GaN 製造プロセスの詳細については、以下を参照してください。

1. OEM サービス – パワーおよび RF 電子デバイス用の Si ベース GaN エピタキシャルウェーハ
当社の GaN ファブは、OEM の構造要件に応じて、パワー、RF 電子デバイスに適した 4 ~ 8 インチの GaN ウェーハをエピタキシー処理できます。
2. パワーおよび RF デバイス向けの GaN チップ ファウンドリー サービス
フォトリソグラフィー、反応性イオン エッチング、反応性イオン エッチング (SiO2、Si3N4)、PECVD (SiO2、Si3N4)、電子ビーム蒸着 (Au、Ni、Cr、Al、Ti)、電子ビーム蒸着 (ITO)、急速アニール、 HEMTデバイスのGaN製造工程におけるCMP(薄化、研削、研磨)等のサービス。
2.1 フォトリソグラフィー
4インチ以下のサイズのGaNウェーハを1μm単位で正確にフォトリソグラフィーを制御できます。 また、お客様のご要望に応じた精密なフォトリソ加工も承ります。
2.2 誘導結合プラズマエッチング (ICP)
GaN、AlN、AlGaN材料のパターンエッチングが可能です。
2.3 反応性イオンエッチング (RIE)
パターンエッチングにより、GaN HEMTウエハー上にSiO2およびSiNx薄膜を堆積できます。
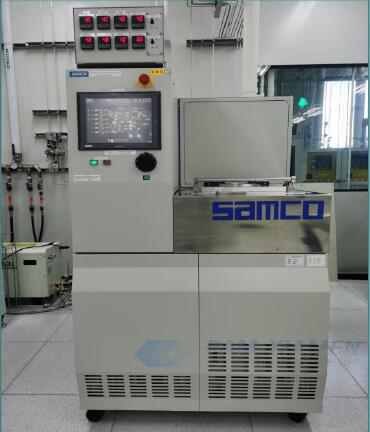
2.4 プラズマ強化化学蒸着 (PECVD)
プラズマ化学気相成長法により、6 インチ以下の GaN HEMT エピの表面に、均一で緻密で厚さ制御可能な SiO2 または SiNx 膜をエピタキシーすることができます。
2.5 電子ビーム蒸着コーティング(E-Beam)
ターゲット材に電子銃の電子ビームを照射し、GaN表面にITO膜(Au、Ni、Cr、Al、Tiなど)を蒸着します。
または、AgやPtなどの金属膜を蒸着します。
2.6 ラピッドアニーリング (RTA)
プロセス要件に合わせて N2 や O2 などのガスを選択し、お客様のニーズに基づいて急速アニーリングを行うことができます。
現時点では、必要なGaNデバイスの電気的要件を達成するために、金属電極を合金化および融合するために、さまざまな加熱および冷却速度、アニーリング温度、および時間を設定します。
3. GaNテストサービス
当社は、GaN 製造プロセスの品質を確保するために、次のような GaN エピタキシャル ウェーハのテスト サービスを提供しています。
3.1 半導体薄膜材料のXRD試験
ω-スキャンを使用して、2 ~ 4 インチの GaN 薄膜 HEMT 材料のさまざまな結晶面をスキャンします。 ロッキングカーブテストの反転空間イメージング原理に基づき、反転空間マッピング測定を実現し、AlGaNの組成と応力を求め、膜厚測定を行います。
3.2 エピウェーハの AFM テスト
AFM テストには、タッピングとコンタクトの 2 つのモードがあります。 C-AFM モジュールを搭載した AFM は、GaN の表面トポグラフィーを検出でき、GaN の電流チャネルをプローブすることもできます。
金属材料の仕事関数と GaN 半導体の表面電位は、KPFM によってテストできます。 GaNエピのマイクロドメインの摩擦力は、LFM機能によって測定できます。 磁区分布については、MFM機能を使用してテストできます。

3.3 エピタキシャルウェーハ PL スペクトルスキャンイメージャー
ファウンドリーにあるエピタキシャルウェーハPLスペクトルスキャンイメージャーは、6インチ以下のサイズの半導体ウェーハをテストできます。
テスト内容には、エピタキシャル膜厚と反射率 (PR) が含まれます。 各測定パラメータの平均値(Mean)、平均二乗誤差(Std)、標準偏差率(CV)などを表示・出力します。また、各パラメータのマッピング分布やウェーハの反りなども表示できます。
3.4 ケルビンプローブフォース顕微鏡
原子間力顕微鏡にはKPFMの検査機能があります。 金属材料の仕事関数やGaN HEMTウエハーの表面電位を測定できます。 光アシスト試験システムを搭載した場合、照明下でのHEMTデバイスの表面電位の変化を試験できます。
3.5 高温および低温ホール効果試験
半導体薄膜材料の高温ホール測定が可能です。 テスト温度は 90 ~ 700K、磁石の磁場強度は 0.5 T、最大測定シート抵抗は 10^11 オーム/平方、最小テスト電流は 1μA、DC 範囲は 1μA ~ 20 mA、 ACモードも搭載(高抵抗試料はACモードでは測定不可)。
3.6 深いレベルの過渡スペクトル
当社は、高温深準位過渡分光法および光支援深準位過渡分光法試験を提供しており、半導体の深層エネルギー準位と、媒体および微量の不純物と欠陥の界面状態を検出できます。 深いレベルの過渡スペクトルは、半導体のバンド ギャップを特徴付けるために与えられます。温度による分布内の不純物、深い欠陥レベル、および界面状態の DLTS スペクトル。
3.7 量子輸送試験
低温強磁場量子輸送試験、線磁気抵抗試験、ホール試験を行っております。 サンプルは、まず可変温度 IV を測定し、次に磁気抵抗を測定します。 磁気抵抗測定範囲は0.1ohm-100ohmです。
III-V半導体の場合、温度によるサンプルの移動度と電子濃度の変化は、低温および強磁場ホール測定によってテストできます。
2次元電子ガスなどのサブ閉じ込め効果の量のサンプルの場合、暖かくて強い磁場がゼーマン分裂につながる可能性があるため、SdH振動などの量子効果を測定し、さまざまなサブバンドの輸送特性(移動度電子濃度Spend ) 取得できる。
3.8 半導体薄膜材料および構造の電気的パラメータの解析
半導体薄膜材料および構造の電気的パラメータ解析が提供されます。 次の電気的パラメータに基づいて分析します
DCソース測定ユニットインジケーター:最大電圧210V、最大電流100mA、最大電力2W。 パルス測定ユニットインジケータ: システムパルス発生器周波数: 50MHz-1Hz; 最小パルス幅: 10ns; 最大パルス電圧: 80V、-40V-40V。
3.9 先端増強ラマン分光計
マイクロエリアのラマンテストを行うことができ、10nm の空間分解能とラマン強度の増加を備えた Neaspec チップ増強ラマン分光計 (TERS) を所有しています。
テスト装置は 1000 倍以上の強度があり、3 次以上の近接場強度とビット信頼度を測定できます。
Remark:
The Chinese government has announced new limits on the exportation of Gallium materials (such as GaAs, GaN, Ga2O3, GaP, InGaAs, and GaSb) and Germanium materials used to make semiconductor chips. Starting from August 1, 2023, exporting these materials is only allowed if we obtains a license from the Chinese Ministry of Commerce. Hope for your understanding and cooperation!
詳細については、電子メールでお問い合わせください。victorchan@powerwaywafer.com と powerwaymaterial@gmail.com.

