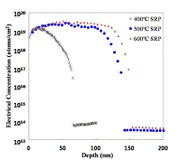
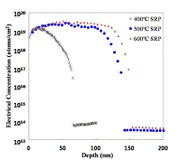
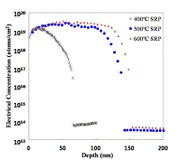
PAM-NIS CZT radionuclide recognizer is compact and portable with following advantages: 1) The energy resolution is less than 1.8% at 662keV, which is higher than scintillator detectors; 2) The detector size is smaller than Ge detector, working at room temperature without cooling; 3) It can be recharged [...]
PAM XIAMEN offers 3″ FZ Prime Silicon Wafer. 3″ Si FZ 39-47Ωcm about 1.5mil is etched from the surfaces in order to remove any surface damage 1.5mil = 1.5*25.4= 38.1μm For more information, please visit our website: https://www.powerwaywafer.com, send us email at sales@powerwaywafer.com and [...]
Highlights •N-polar InAlN thin films were grown on GaN substrates by molecular beam epitaxy. •Surface morphology transitioned from quasi-3D to step-flow at high temperature. •Indium saturation was observed for increasing indium flux at high temperature. •Increased aluminum flux helped increase indium incorporation efficiency. •N-polar InAlN films with 0.19 nm [...]
PAM-XIAMEN is able to offer you high-performance silicon wafers, additional wafer information you can find in https://www.powerwaywafer.com/silicon-wafer. Heat treatment refers to the heat treatment of silicon single crystals (or silicon wafers) for a certain period of time at a certain temperature and protective atmosphere, with [...]
IR Transmittance Report A test report is necessary to show the compliance between custom description and our final wafers data. We will test the wafer characerization by equipment before shipment, testing surface roughness by atomic force microscope, type by Roman spectra instrument, resistivity by non-contact [...]
PAM XIAMEN offers Nb:SrTiO3 Niobium doped Strontium Titanate Crystal and Substrates. Nb: SrTiO3, Niobium doped Strontium Titanate Crystal and Substrates Main Parameters Nb:SrTiO3 A B C D Nb Concentration (wt%) Customized 0.7 0.5 0.05 Resistivity ohm-cm Customized 0.007 0.05 0.08 Migration rates cm2/vs Customized 8.5 8.5 6.5 Characteristics Nb: SrTiO3 and SrTiO3 have a similar structure, but Nb: STO has an high electrical conductivity. Typical STO are insulators Size 10×3, 10×5, 10×10, 15×15, 20×15, 20×20 mm Ф15, Ф20, Ф [...]
| Cookie | Duration | Description |
|---|---|---|
| cookielawinfo-checkbox-analytics | 11 months | This cookie is set by GDPR Cookie Consent plugin. The cookie is used to store the user consent for the cookies in the category "Analytics". |
| cookielawinfo-checkbox-functional | 11 months | The cookie is set by GDPR cookie consent to record the user consent for the cookies in the category "Functional". |
| cookielawinfo-checkbox-necessary | 11 months | This cookie is set by GDPR Cookie Consent plugin. The cookies is used to store the user consent for the cookies in the category "Necessary". |
| cookielawinfo-checkbox-others | 11 months | This cookie is set by GDPR Cookie Consent plugin. The cookie is used to store the user consent for the cookies in the category "Other. |
| cookielawinfo-checkbox-performance | 11 months | This cookie is set by GDPR Cookie Consent plugin. The cookie is used to store the user consent for the cookies in the category "Performance". |
| viewed_cookie_policy | 11 months | The cookie is set by the GDPR Cookie Consent plugin and is used to store whether or not user has consented to the use of cookies. It does not store any personal data. |
